多晶硅真空區熔提純技術研究
欒國旗,張殿朝,閆萍,高穎,馬玉通
(中國電子科技集團公司第四十六研究所,天津 300220)
高電阻率、高少數載流子壽命真空區熔硅單晶作為一種新型的基礎材料,除具備一般高阻材料純度高,補償度低的特點外,更由于其在真空下生長,是制備高靈敏度探測器件的首選。在真空單晶研制過程中,需要對多晶硅進行真空區熔提純。通過真空區熔提純,可以對多晶硅的電阻率、型號及外型等參數加以控制,是成功研制真空單晶的關鍵步驟之一。
1 實驗條件
多晶提純設備:L4375-ZE型區熔硅單晶爐。
真空區熔提純時的爐內真空度≤1×10-2Pa。
原料:美國ASiMI多晶硅料,基硼電阻率≥9000 Ω·cm,基磷電阻率≥1000 Ω·cm,少子壽命≥1000μs,原始電阻率≥3000Ω·cm,直徑50mm。
熱場:單匝平板線圈。線圈為偏心結構,內徑短軸28mm、長軸32mm,外徑90mm;
籽晶:5mm×5mm×60mm的正〈111〉晶向;
針對研制直徑30mm、P型電阻率10~20 kΩ·cm真空區熔單晶,多晶硅提純目標參數為:電阻率20~40 kΩ·cm;直徑 30~32mm。
試驗過程中,我們分別對對應多晶編號為A,B,C,D,E,F的 6棵多晶進行了提純,提純速率1~4mm/min。
2 結果與討論
真空區熔提純過程中,熔區移動速度(即提純速率)與熔區長度對單次提純效果起到決定性的作用,提純速率與提純次數的配合對提純效率起到決定性的作用,同時上下軸的相對移動速度是調節多晶直徑的必然手段,上下軸轉速等工藝參數對整個提純過程也起到了重要的影響。
2.1 多晶硅電學參數的控制
2.1.1 提純速率對提純效果的影響
熔區移動速度越慢,熔區內雜質蒸發和分凝的效果越好,熔區長度越長,雜質的分凝效果也越好。在提純過程中,多晶電阻率會隨著多晶內主要電活型雜質磷的含量的變化呈現出先升高后降低的變化過程,多晶型號也會隨之由N型轉為P型。首先,我們看一下一次提純后多晶內雜質分布情況,見圖1。
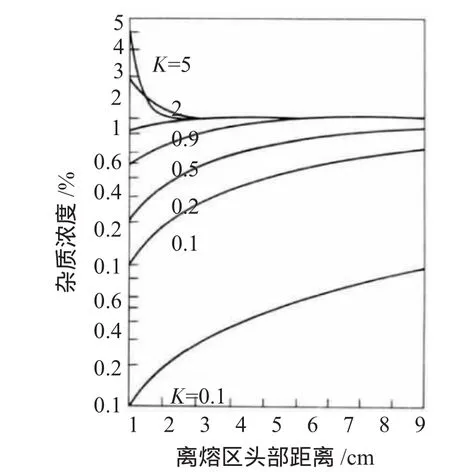
圖1 多晶一次提純雜質分布圖
從圖1中可以看出,當雜質分凝系數K小于1時,雜質向多晶尾部移動,K越小,分布變化越明顯。由于硅中磷雜質的分凝系數K小于1,因此雜質應向尾部移動匯集,多晶型號應在頭部首先發生變化。由各提純參數記錄表也可看出,實際提純過程中,多晶亦是從頭部首先發生轉型,從而也表明,提純過程未有沾污情況發生。由于提純過程中我們采用的加熱功率適中,熔區長度基本一致,因此,我們主要對不同熔區移動速度下的提純效果加以對比,見圖2。

圖2 不同熔區移動速度下首次提純效果對比示意圖
從圖2中(其中VF代表真空提純)可以看出,D、E、F的首次提純效果要明顯好于A、B、C,熔區移動速度越慢,提純效果越明顯。盡管A、B、C的首次提純效果略低,但相對于原始材料的電阻率,A、B、C的提純效果也很明顯,說明在首次提純過程中,由于材料內雜質含量較高,即使采用稍快的熔區移動速度,材料內雜質的真空蒸發作用和分凝作用仍然非常明顯。但這種提純速率的影響并非無止境的,在我們所做的其它實驗中發現,當提純速率大于4mm/min時,提純效果非常不明顯,提純速率小于2mm/min時,提純效果與2mm/min相比幾乎相同,沒有明顯的變化。
2.1.2 提純速率與提純次數的結合
較快的熔區移動速度可以縮短提純時間,提高提純速度;較慢的熔區移動速度可以獲得更好的提純效果。綜合考慮,為獲得最佳提純效率,我們應在保證提純效果的情況下,使盡量快的熔區移動速度與盡量少的提純次數相結合,獲得最佳的提純效率。在多數的提純過程中,我們采用了2~2.5mm/min的提純速率,這個速率下多晶的提純效果表現的非常好。
由數據表格可以看出,各棵多晶最終參數均達到了目標要求,但所使用的提純次數不同,A用6次,B、C用5次,D、E、F用4次。我們首先根據圖3對A進行分析:

圖3 多晶A提純過程中電阻率變化示意圖
由圖3都可以看出,多晶A在提純過程中電阻率及型號變化正常,電阻率首先升高后降低,型號由N型逐漸轉為P型。按照目標電阻率參數,A-VF-4基本達到要求,但由于測試中發現有個別點電阻率較高,我們對其進行了提純,通過提純發現,A-VF-5、A-VF-6均達到目標參數范圍,但與A-VF-4相比電阻率變化非常小,我們認為,對此種多晶而言,在多晶硅轉化為P型后,整體電阻率達到40 KΩ·cm左右時,已接近提純極限,且在單晶生長的過程中,電阻率平均下降1倍,多晶繼續提純已經意義不大,對此,我們在B、C的提純過程中加以了驗證,通過實驗發現,在編號B的多晶經4次提純基本達到目標參數(低于40 KΩ·cm)的情況下,繼續對其提純,編號B多晶在第五次提純后電阻率變化仍然非常小,對最終單晶電阻率控制實際意義不大。且我們在編號C多晶的第5次提純過程中,采用非常低的提純速率1mm/min,也驗證了過低的提純速率對多晶提純效果貢獻并不大。
對于多晶A、B、C,按照設定的提純速率,通過4次提純,基本可以達到目標參數,但由于A、B、C經過4次提純后,經檢測發現個別點電阻率高于目標電阻率,我們決定降低首次提純速率,因為除首次提純速率外都采用了較低的提純速率。通過降低首次提純速率由編號A、B、C多晶的2.5mm/min至編號D、E、F多晶的2mm/min左右,在編號D、E、F多晶的提純過程中我們發現,在其余提純速率基本不變的情況下,多晶硅經過4次提純完全可以達到目標參數,同時,由于降低了首次提純速率,為后面提純速率預留了調整的空間。
2.2 多晶硅提純過程中其他參數的控制
2.2.1 上下軸轉速控制
在真空提純過程中,熔區依靠熔體的表面張力、電磁托浮力、重力及氣氛對熔體的托浮力等各項因素達到平衡狀態來維持一個穩定的熔區,熔體表面各點應滿足以下力的平衡方程:

式中:F張為表面張力;
F磁為電磁托浮力;
F離為旋轉離心力;
F靜為液柱靜壓力;
F附為氣氛環境的附加壓力。
其中,F離為不穩定力,轉速越大,F離越大,由于是在真空環境下,不穩定力離心力影響放大,因此,我們降低了下軸轉速,一般控制在6~8 r/min,以防止塌爐事故的發生。
在提純過程中,通過上軸旋轉可以有效的防止硅刺的產生,同時對晶體的徑向電阻率均勻性調節有一定好處,但對于真空單晶用多晶硅提純來說,上軸旋轉并不適合,因為上軸帶動上棒旋轉過程中,由于多晶熔化界面不是絕對的對稱,整個熔區內熔硅量隨之變化,導致下棒多晶直徑收放,呈現規則起伏變化。由于真空單晶生長過程中對熔區飽滿程度要求非常高,上棒直徑的起伏變化將直接影響其對熔區的送料多少,進而影響單晶的生長,因此,我們在多晶提純過程中盡量不采用上軸旋轉的方式,對于硅刺,我們通過設計改造線圈,采用線圈偏心及臺階設計,調整加熱功率,最大程度的避免硅刺的產生。
2.2.2 多晶直徑的控制
在多晶提純過程中,需要對多晶直徑進行調整,由于原始多晶直徑為50mm,我們在提純過程中逐步對多晶直徑進行調整,由于每次提純后需要甩掉尾部約40~50mm的多晶,因此,多晶越細,損失越小,但若一次將50mm多晶拉細至30mm左右,有以下缺點:
(1)由于上下棒直徑相差太大,功率難以匹配,熔區難以控制,同時容易產生硅刺,導致提純中斷;
(2)由于提純速率是決定提純效果的重要因素,相同提純速率下,相同重量的多晶,直徑越細所需提純時間越長,提純效率越低;
(3)上下棒直徑相差太大,若出現上棒直徑若稍有起伏或功率突然變化等情況,下棒直徑將不易控制,造成多晶直徑不均勻。
通過實驗,我們制定了直徑調整方案,按照原始直徑50mm,提純4次計算:第1次提純至42~44mm,第2次提純至37~39mm,第3次提純至33~35mm,第4次提純至30~32mm。即保證了提純的順利進行,又可以調整好直徑。
3 結論
(1)熔區移動速度是決定提純效果的重要參數,對于真空區熔提純,當提純速率位于2~2.5mm/min區間時,提純效率較高;當提純速率低于2mm/min時,提純效果較前者速率無明顯改善;當提純速率高于2.5mm/min時,提純效果逐漸降低;當提純速率高于4mm/min時,提純效果很低;
(2)對所用多晶而言,在提純初期,雜質蒸發和分凝的效果非常明顯,待提純到4次以上時,雜質去除效果已不明顯,繼續提純無實際意義;
(3)在提純初期采用較低的提純速率,可為后期的提純預留提純速率調整空間,使提純速率與提純次數達到最佳配比;
(4)為使多晶獲得均勻的直徑,在提純過程中盡量不采用上軸旋轉。采用偏心線圈設計及臺階設計,同時調整加熱功率,保持較飽滿的熔區,有效避免硅刺的產生;
(5)提純過程中,不采用一次到位的方式拉細多晶,避免上下多晶尺寸相差過大,而是逐漸將多晶拉細至目標直徑范圍,即保證了提純的效果,降低意外發生幾率,又可以提高工作效率。
[1]張寶豐.電子工業生產技術手冊(6)半導體與集成電路卷[M].電子工業生產技術手冊編委會,國防工業出版社,1989.

