陶瓷基板金屬化制備技術(shù)的研究進(jìn)展
張明昌 辛成來(lái) 李東亞
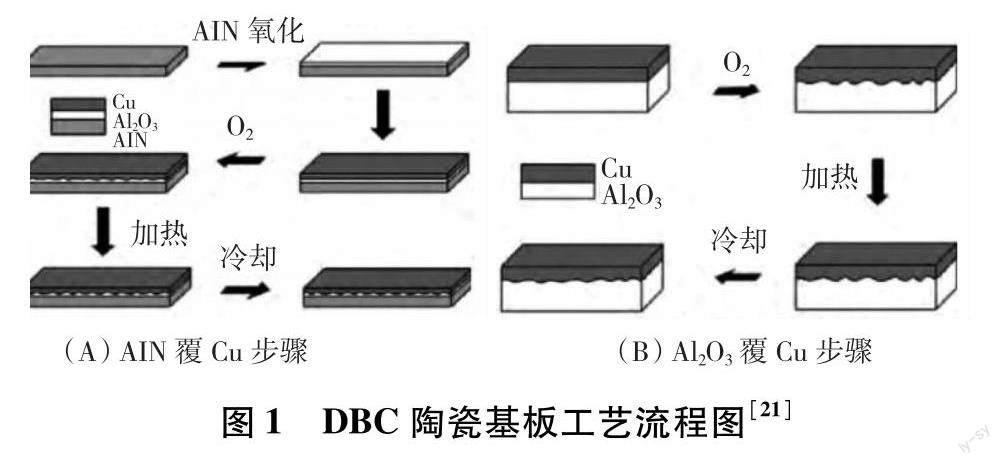


摘 要:從陶瓷基板制備工藝等方面綜述了提高陶瓷基板可靠性的工藝與方法,主要包括直接鍍銅金屬化法、厚膜金屬化法、直接覆銅金屬化法、直接覆鋁金屬化法和活性釬焊金屬化法5種陶瓷基板制備方法,此外還綜述了基于上述金屬化方法加以創(chuàng)新的制備工藝及結(jié)合強(qiáng)度,并對(duì)不同工藝所制備的陶瓷基板在實(shí)際應(yīng)用中的缺點(diǎn)與不足進(jìn)行了闡述,最后對(duì)陶瓷基板金屬化的發(fā)展趨勢(shì)進(jìn)行了展望.
關(guān)鍵詞:陶瓷基板;金屬化;功率模塊;結(jié)合強(qiáng)度
中圖分類號(hào):TB333
文獻(xiàn)標(biāo)志碼:A
0 引 言
在集成電路產(chǎn)業(yè)中,陶瓷基板材料起到連接與支撐電子器件的作用,在集成電路發(fā)展的過(guò)程中占據(jù)著舉足輕重的地位,可以說(shuō)陶瓷基板的性能決定了集成電路的性能.陶瓷基板是將金屬和陶瓷基片通過(guò)不同的工藝實(shí)現(xiàn)鍵合,銅(Cu)具有優(yōu)良的導(dǎo)電性和載流能力,陶瓷具有較好的機(jī)械強(qiáng)度,化學(xué)性質(zhì)穩(wěn)定,陶瓷和Cu兩者具有良好的導(dǎo)熱性,所以陶瓷基板既具有陶瓷的熱穩(wěn)定性又有金屬的電學(xué)性能等優(yōu)點(diǎn).集成電路產(chǎn)業(yè)進(jìn)入快速發(fā)展期,集成電路產(chǎn)業(yè)中電力電子功率模塊向著更高頻、更小尺寸、更大功率與更大電流方向發(fā)展,因此,對(duì)陶瓷基板的可靠性也提出了更高的要求.本文從陶瓷基板傳統(tǒng)制備工藝出發(fā),綜述了提高陶瓷基板可靠性的方法,并簡(jiǎn)述了新制備工藝及性能評(píng)價(jià),最后對(duì)陶瓷基板金屬化的發(fā)展趨勢(shì)進(jìn)行了展望.
1 陶瓷基板的制備工藝
1.1 直接鍍Cu金屬化法(DPC)
DPC是在陶瓷表面注入種子層再通過(guò)電鍍使銅層達(dá)到一定厚度,種子層的注入是利用物理氣相沉積(磁控濺射與真空蒸鍍等)方法在陶瓷表面沉積一層金屬層.物理氣相沉積屬于低溫工藝(300℃以下),完全避免了高溫對(duì)材料或結(jié)構(gòu)的不利影響,也降低了制造工藝成本,但是此時(shí)制備的基板也有不足,例如,載流能力差,通常限制在幾至幾十安培.金屬薄膜與陶瓷的結(jié)合力決定了陶瓷基板的實(shí)用性與可靠性,結(jié)合力則受到范德華力和化學(xué)鍵力等影響,其中,化學(xué)鍵力為主要因素.因此,選用鉻(Cr)、鈦(Ti)、鋁(Al)和Cu等一些活性較高、有一定擴(kuò)散率的金屬作為過(guò)渡層可以達(dá)到較好的附著性能.從導(dǎo)電性能考慮,應(yīng)選擇Cu、銀(Ag)和金(Au)等低電阻率的金屬;從焊接性能的要求來(lái)考慮,應(yīng)使用鎳(Ni)和Cu等高溫穩(wěn)定的金屬[1].DPC有以下特點(diǎn):工藝操作溫度低,一般在300℃以下,有效避免了高溫對(duì)材料的不利影響;電鍍沉積Cu層的厚度有限;鍍液對(duì)環(huán)境污染大;金屬層與陶瓷層的結(jié)合強(qiáng)度相對(duì)低,導(dǎo)致基板的可靠性較低[2].Huang等[3]首先通過(guò)磁控濺射在陶瓷襯底沉積一層Ti薄膜,然后再通過(guò)電鍍形成一層Cu膜,最后將基板在860℃燒制30 min,以確保金屬膜和陶瓷之間的結(jié)合,通過(guò)這種方式制備出了氧化鋁(Al2O3)-DPC基板和氮化鋁(AlN)-DPC基板.除利用物理氣相沉積制備陶瓷基板外,還有學(xué)者直接利用化學(xué)鍍Cu工藝在陶瓷表面附著一層Cu薄膜.胡光輝等[4]研究了溫度與陶瓷基體上化學(xué)鍍Cu沉積速度的關(guān)系,計(jì)算出了Cu沉積的活化能,并且改善了鍍液,使鍍層性能得到提高.Cai等[5]利用密度泛函理論研究了Cu和AlN表面間的鍵合特性,研究表明,在沉積過(guò)程中,金屬原子沉積到N的位置比沉積到Al的位置更穩(wěn)定.
DPC陶瓷基板還可以實(shí)現(xiàn)垂直方向的電互聯(lián),但難以滿足大功率電路的需求,主要應(yīng)用于激光與光通信領(lǐng)域小電流器件封裝[6].
1.2 厚膜金屬化法(TFC)
TFC采用絲網(wǎng)印刷技術(shù)將金屬化漿料涂覆在陶瓷基片表面,經(jīng)過(guò)干燥、高溫?zé)Y(jié)使金屬層附著在陶瓷基體上的一種制備技術(shù).金屬化漿料一般由金屬粉末、有機(jī)體和玻璃粉或金屬氧化物等組成.目前可選擇的金屬粉末有Ag、Ag/鈀(Pd)、Au、Au/鉑(Pt)、Cu、Ni和Al等[7-8].其中,Ag和Cu電阻低,抗電遷移性能好,并且成本低,較為適合工業(yè)化生產(chǎn)[9],Ag導(dǎo)電漿料占金屬市場(chǎng)80%以上的份額[10].金屬化漿料中的玻璃粉充當(dāng)黏結(jié)劑的作用,使金屬和陶瓷基體結(jié)合,并且降低金屬漿料的燒結(jié)溫度.玻璃粉或金屬氧化物是厚膜漿料制作中的關(guān)鍵原料,決定了漿料和陶瓷基體的附著性能.經(jīng)高溫?zé)Y(jié)后,有機(jī)體起到分散功能相和黏結(jié)相的作用,并且使?jié){料保持一定黏度,有機(jī)體會(huì)在燒結(jié)過(guò)程中被燃燒掉,剩下的幾乎都是純金屬[11].
加入的玻璃粉雖然能降低加工溫度、降低生產(chǎn)成本和基板的熱應(yīng)力,但是商用玻璃粉幾乎都含有鉛元素,對(duì)環(huán)境和人體都有害.Zhang等[12]提出了一種在厚膜漿料中不使用玻璃粉制備AlN陶瓷基板的方法,通過(guò)在AlN底部涂覆一層氧化銅(CuO),隨后進(jìn)行熱處理,通過(guò)生成氧化亞銅(Cu2O)和中間相組成的界面,實(shí)現(xiàn)了CuO和AlN之間的可靠結(jié)合.Zou等[13]認(rèn)為界面處生成的鋁酸銅(CuAl2O4)可以很大程度提高結(jié)合強(qiáng)度,通過(guò)在金屬化漿料中摻入金屬氧化物,例如,氧化鎂(MgO)、四氧化三鈷(Co3O4)和氧化鐵(Fe2O3)可提高金屬化基板的性能,納米MgO顆粒的摻入會(huì)大大降低表面金屬層的孔隙率,使金屬Cu層和基板之間結(jié)合更加緊密,對(duì)金屬化基板的結(jié)合強(qiáng)度有著進(jìn)一步提高[14].燒結(jié)溫度也會(huì)影響結(jié)合的性能,張鵬飛[15]采用反應(yīng)結(jié)合型厚膜工藝制備了AlN陶瓷基板并研究了不同燒結(jié)溫度對(duì)其界面間結(jié)合力的影響,結(jié)果表明,經(jīng)過(guò)1 075℃燒結(jié)30 min,可獲得最佳的結(jié)合強(qiáng)度,Cu層和基板的最佳結(jié)合強(qiáng)度為11.9 MPa.目前,對(duì)于Al2O3厚膜漿料的研究已經(jīng)趨于成熟,但是Al2O3厚膜漿料的研究還是有較大的空間,原因是多數(shù)的金屬對(duì)Al2O3的潤(rùn)濕性效果不好.鄭洪雷[16]選擇二硼化鈦(TiB2)為AlN厚膜金屬化主要反應(yīng)黏結(jié)劑,獲得了令人滿意的結(jié)合強(qiáng)度.Ji等[17]采用含二氧化碲(TeO2)-五氧化二釩(V2O5)-CuO玻璃熔塊的Cu漿制備了Cu/AlN陶瓷基板,結(jié)果表明,在700℃熱處理使Cu顆粒密實(shí)堆積,從而獲得最佳的拉伸強(qiáng)度和最低的電阻率.
金屬粉末顆粒的粒徑和形貌等對(duì)結(jié)合性能有著很大的影響.Chen等[18]采用三氧化二鉍(Bi2O3)-二氧化硅(SiO2)-三氧化二硼(B2O3)-Al2O3-氧化鋅(ZnO)系的玻璃粉制備金屬Ag漿,研究發(fā)現(xiàn),該漿料對(duì)氮化硅(Si3N4)有著良好的潤(rùn)濕性和結(jié)合強(qiáng)度.Zhou等[19]研究了不同尺寸、結(jié)構(gòu)的金屬粉末對(duì)結(jié)合性能的影響,結(jié)果表明,金屬層結(jié)合率和電阻率隨著金屬Ag粉末的尺寸減小而增加,小顆粒的Ag漿形成更加致密的接觸面,結(jié)合性能更高,并且片狀A(yù)g顆粒的性能要優(yōu)于同尺寸球形Ag顆粒.
厚膜陶瓷基板采用絲網(wǎng)印刷工藝印刷金屬布線層燒結(jié)后的金屬層厚度一般在10~20 μm,該工藝的制造成本低,操作簡(jiǎn)單,對(duì)加工設(shè)備和環(huán)境要求低,并且生產(chǎn)效率高,但由于絲網(wǎng)印刷工藝精度限制,同時(shí)存在鍍層穩(wěn)定性易受漿料均勻性影響,附著力不易控制等缺點(diǎn),因此,厚膜印刷陶瓷基板的使用范圍受到一定限制.
1.3 直接覆Cu金屬化法(DBC)
DBC是Al2O3陶瓷和AlN陶瓷鍵合Cu的一種表面金屬化方法,其工藝流程如圖1所示.DBC技術(shù)最早出現(xiàn)在20世紀(jì)70年代,其原理是先在Cu與陶瓷表面處引入少量氧(O)元素,然后在1 000~1 100℃的溫度范圍內(nèi),Cu和O可以形成Cu2O的共晶液相,以此達(dá)到潤(rùn)濕的作用,實(shí)現(xiàn)陶瓷基板與Cu的冶金結(jié)合.Li等[20]通過(guò)在Al2O3陶瓷表面涂CuO的方式引入O元素制備了Cu/Al2O3,并研究了預(yù)處理溫度對(duì)潤(rùn)濕性的影響,結(jié)果表明,當(dāng)預(yù)處理溫度為1 100℃時(shí),接觸角減小到22°左右,中間層中連續(xù)的偏鋁酸亞銅(CuAlO2)有利于Cu熔體與Al2O3之間的潤(rùn)濕性.而對(duì)于AlN非氧化物陶瓷,是強(qiáng)共價(jià)鍵化合物,Cu/O共晶液相對(duì)AlN的潤(rùn)濕性較差,所以要先對(duì)AlN陶瓷基板表面改性來(lái)增加Cu/O共晶液相對(duì)陶瓷基體的潤(rùn)濕性,以確保Cu和AlN之間結(jié)合力,通常采用的方法是進(jìn)行預(yù)氧化處理,使AlN陶瓷表面形成厚度一定、分散均勻且結(jié)構(gòu)致密的Al2O3層,這樣覆接的界面就變成為AlN-Al2O3-Cu界面,以確保AlN和Cu之間結(jié)合的可靠.
在DBC陶瓷基板的制備過(guò)程中,Cu板氧化時(shí)間、氧化溫度和氧分壓對(duì)鍵合的強(qiáng)度也有著較大的影響.王彩霞等[22]研究了預(yù)氧化溫度和氧分壓對(duì)Cu箔氧化層物相和厚度的影響,結(jié)果表明,當(dāng)氧分壓為500×10-6kPa,預(yù)氧化時(shí)間為1 h,溫度為600℃時(shí),Cu箔表面可以獲得均勻致密的Cu2O薄膜,并且氧化膜與Cu結(jié)合緊密,有效地提高了DBC基板的結(jié)合性能.在過(guò)高的氧化溫度和氧分壓的條件下,Cu箔表面就會(huì)生成CuO物相,而且氧化膜會(huì)變厚,表面變得疏松,局部出現(xiàn)氧化膜脫落的現(xiàn)象,不利于DBC基板的制備.許昕睿等[23]探究了AlN陶瓷基板表面氧化狀態(tài)對(duì)覆接強(qiáng)度的影響,結(jié)果表明,界面結(jié)合強(qiáng)度與氧化工藝密切相關(guān),受熱應(yīng)力的影響,空氣條件氧化試樣的覆接強(qiáng)度大于N2∶O2=10∶1氧化試樣的覆接強(qiáng)度,這是因?yàn)樵贜2∶O2=10∶1的氣氛下氧化時(shí),氧化層厚度太厚且結(jié)構(gòu)疏松,同時(shí),由于Al2O3與AlN之間的熱膨脹系數(shù)不匹配,在氧化的過(guò)程中產(chǎn)生了張應(yīng)力,應(yīng)力隨著氧化層厚度的增加而增加,導(dǎo)致覆接強(qiáng)度較差,當(dāng)氧化層的厚度超過(guò)一定值后,在張應(yīng)力的作用下,AlN和氧化層之間容易產(chǎn)生微裂紋.潘文霞等[24]對(duì)AlN陶瓷基板進(jìn)行了減壓直流等離子體噴涂Al,然后在900℃下氧化24 h,結(jié)果表明,AlN基板上形成了均勻且與基體附著良好的Al2O3層,有效地改善了AlN與Cu基板的結(jié)合性能.謝建軍等[25]通過(guò)預(yù)氧化并在1 000~1 060℃下制備Cu/AlN陶瓷基板時(shí)發(fā)現(xiàn),Cu箔和AlN陶瓷之間存在厚度約為2 μm的過(guò)渡層,過(guò)渡層中主要含有Al2O3、CuAlO2和Cu2O化合物,界面結(jié)合強(qiáng)度可以通過(guò)提高覆接溫度來(lái)提高,最大結(jié)合強(qiáng)度超過(guò)了8.0 N/mm.Hu等[26]采用壓力輔助DBC法制備了Cu/Si3N4基板,并研究了預(yù)氧化SiO2層厚度對(duì)顯微組織和熱力學(xué)性能的影響,結(jié)果表明,薄的SiO2層導(dǎo)致界面產(chǎn)物分布不連續(xù),而厚的SiO2導(dǎo)致空隙的形成,當(dāng)SiO2和Cu2O厚度分別為5 μm和5.9 μm時(shí),具有最佳的綜合性能,其熱導(dǎo)率為92 W/(m·k),
剪切強(qiáng)度為102 MPa.Barlak等[27]采用離子注入法作為AlN-DBC的預(yù)處理方法,取代了傳統(tǒng)的熱氧化工藝,結(jié)果表明,在15 kV的加速電壓下,以密度為5×1016ions/cm2的數(shù)量注入Ti可獲得最佳的結(jié)果,制備的AlN基板具有良好的界面結(jié)合力,優(yōu)于傳統(tǒng)熱氧工藝制備的AlN基板.Cu和O的覆接溫度超過(guò)1 000℃時(shí),界面會(huì)形成較硬的產(chǎn)物CuAlO2,導(dǎo)致覆接的Al2O3基板的內(nèi)應(yīng)力較大,抗熱震動(dòng)性能減弱[28].張珊珊等[29]對(duì)陶瓷基板在受到反復(fù)熱沖擊過(guò)程中的變形情況進(jìn)行了研究,通過(guò)實(shí)驗(yàn)發(fā)現(xiàn),在反復(fù)受到熱沖擊的過(guò)程中,存在類似金屬材料在周期載荷作用下出現(xiàn)的棘輪效應(yīng)和包辛格效應(yīng).在陶瓷基板經(jīng)受熱沖擊時(shí),Cu層的厚度也會(huì)較大程度地影響覆接的可靠性,Cu層越厚在熱沖擊實(shí)驗(yàn)中就越容易出現(xiàn)裂紋與分層,有些學(xué)者已經(jīng)通過(guò)實(shí)驗(yàn)和有限元模擬來(lái)證明[30].
DBC陶瓷基板應(yīng)用范圍很廣,例如,電力半導(dǎo)體模塊、太陽(yáng)能電池板組件和絕緣柵雙極二極管(IGBT)等封裝器件.但也有如下缺點(diǎn):制備的過(guò)程是利用高溫下Cu和O的共晶反應(yīng),對(duì)設(shè)備和工藝要求較高[6];DBC的覆接強(qiáng)度還未能滿足某些應(yīng)用場(chǎng)景的需要.
1.4 直接覆Al金屬化法(DBA)
DBA是由DBC工藝技術(shù)發(fā)展而來(lái)的一種陶瓷基片金屬化工藝,覆接過(guò)程就是利用Al在液態(tài)對(duì)陶瓷有較好的潤(rùn)濕性實(shí)現(xiàn)的,在溫度到達(dá)Al的熔點(diǎn)(約660℃)以上時(shí),固態(tài)Al會(huì)發(fā)生液化,隨著溫度的降低Al就直接在陶瓷表面提供的晶核結(jié)晶生長(zhǎng),冷卻到室溫實(shí)現(xiàn)兩者結(jié)合[31],工藝流程如圖2所示.
Al具有較低的熔點(diǎn),優(yōu)良的塑性,可以緩解界面因熱膨脹系數(shù)不同引起的熱應(yīng)力,但Al的化學(xué)性質(zhì)活潑,在高溫下非常容易生成一層氧化膜.氧化膜的化學(xué)性質(zhì)穩(wěn)定,結(jié)構(gòu)致密,厚度通常在幾十納米左右,會(huì)覆在液態(tài)Al的表面,很大程度上降低了液態(tài)Al對(duì)Al2O3陶瓷的潤(rùn)濕性[32],阻礙陶瓷和Al的結(jié)合,使得陶瓷和Al的結(jié)合強(qiáng)度降低,可靠性變差.要避免氧化膜的產(chǎn)生,可采用隔絕O2的方法,阻止液態(tài)Al表面產(chǎn)生氧化膜從而保證Al和陶瓷的覆接,但在這個(gè)工藝過(guò)程中或多或少還是存在液態(tài)Al與O接觸產(chǎn)生氧化膜的現(xiàn)象.因此,將氧化膜去除是保證覆接成功的關(guān)鍵.對(duì)此,在覆接過(guò)程中需要對(duì)液態(tài)Al施加一定的壓力,來(lái)打破表面上的氧化膜實(shí)現(xiàn)成功覆接[33].彭榕等[28,34]使用石墨模具,在充滿N2的氣氛下,將固體Al在660~750℃熔化,然后利用壓頭將融化的液態(tài)Al壓入預(yù)先放置好陶瓷基片的模具中,660~750℃時(shí)氧化膜不會(huì)隨著液態(tài)Al一起流動(dòng)而是留在熔池內(nèi),不含氧化膜的液態(tài)Al將會(huì)在Al2O3上鋪展開(kāi)并潤(rùn)濕,冷卻后就可以獲得覆接良好的Al/Al2O3陶瓷基板,此方法在AlN陶瓷上也可以實(shí)現(xiàn)覆接.Ksiazek等[35]研究了潤(rùn)濕和黏合性能之間的相關(guān)性,結(jié)果表明,當(dāng)溫度在1 000℃以下時(shí),潤(rùn)濕角<90°,當(dāng)溫度在1 000~1 100℃之間,潤(rùn)濕角為52~54°,因此潤(rùn)濕角也會(huì)影響覆接的質(zhì)量.
近年來(lái),DBA得到了進(jìn)一步的發(fā)展,并取得了一定的研究成果.井敏[31]采用金屬過(guò)渡法,在Al2O3陶瓷表面上先覆接一層Cu膜,根據(jù)Cu-Al的共晶反應(yīng),在低于Al的熔點(diǎn)情況下實(shí)現(xiàn)Al2O3陶瓷與Al覆接,制備的DBA基板覆接強(qiáng)度達(dá)到11.9 MPa.Wang等[36]在Al與Al2O3之間通過(guò)沉積Ni層,在界面附近形成共晶液相潤(rùn)濕基體,實(shí)現(xiàn)Al與Al2O3的牢固結(jié)合;該研究結(jié)果還表明,沉積500 nm厚的Ni膜最高剪切強(qiáng)度可以達(dá)到31.5 MPa,導(dǎo)熱率可達(dá)37.8W/(m·K).Lei等[37]研究了AlN-DBA基板的熱循環(huán)可靠性,結(jié)果表明,在-55~250℃下進(jìn)行熱循環(huán)AlN-DBA基板未出現(xiàn)分層,但在此期間發(fā)現(xiàn)Al表面發(fā)生粗糙化,這被認(rèn)為是循環(huán)熱應(yīng)力下晶界滑動(dòng)引起的.Ning等[38]在DBA的基礎(chǔ)上采用連續(xù)鑄造鍵合(CCB)方法制備出了高質(zhì)量的AlN/Al、Al2O3/Al、Si3N4/Al和碳化硅(SiC)/Al基板.李明鶴等[39]在DBA基礎(chǔ)上采用磁控濺射制備了Al/AlN復(fù)合基板,當(dāng)陽(yáng)極Al2O3膜厚約10 μm,AlN膜約1 μm時(shí),制備的復(fù)合基板擊穿電壓超過(guò)了1 350 V,絕緣電阻率達(dá)到了17.×106 MΩ,結(jié)合強(qiáng)度超過(guò)8 MPa.
DBA基板使用Al代替Cu作為金屬層,Al2O3-DBA基板和AlN-DBA基板具有優(yōu)異的導(dǎo)熱特性,良好的抗疲勞性能,在熱循環(huán)的實(shí)驗(yàn)中表現(xiàn)出比DBC基板更高的性能[40],為大功率電子陶瓷基板提供了新的選擇.但有如下缺點(diǎn):DBA技術(shù)對(duì)O含量的控制非常嚴(yán)格,對(duì)設(shè)備要求也比較高,基板制作成本比較高;DBA工藝的Al厚度一般在100 μm以上,不適合精密電路的制作.
1.5 活性釬焊金屬化法(AMB)
AMB是在DBC工藝上進(jìn)一步優(yōu)化的一種工藝,AMB陶瓷基板的結(jié)構(gòu)穩(wěn)定性優(yōu)于DBC陶瓷基板,其原理是利用絲網(wǎng)印刷工藝將含有少量活性元素的釬料涂刷在陶瓷基板的表面上,然后再覆蓋一層Cu放到真空釬焊爐里進(jìn)行燒結(jié),在高溫下釬焊漿料與陶瓷發(fā)生化學(xué)反應(yīng)實(shí)現(xiàn)冶金結(jié)合,工藝流程如圖3所示.其中,覆接的Cu可分為無(wú)氧Cu和普通Cu,Cu中的O和Cu反應(yīng)后以Cu2O的形式存在,當(dāng)與氫氣(H2)接觸并遇到高溫時(shí),Cu中會(huì)產(chǎn)生很大的壓力,會(huì)順著晶格間隙產(chǎn)生裂紋,這個(gè)現(xiàn)象稱為氫脆現(xiàn)象,而無(wú)氧Cu則不會(huì)出現(xiàn)這個(gè)問(wèn)題.若采用活性釬焊法對(duì)AlN進(jìn)行金屬化,則不需要對(duì)AlN進(jìn)行預(yù)氧化,這是因?yàn)殁F料直接與AlN基體反應(yīng)[41].
釬料中常用的活性元素應(yīng)選擇在元素周期表過(guò)渡區(qū)間具有很強(qiáng)的化學(xué)活性、對(duì)氧化物和硅酸鹽等有較大親和力的元素,比如Ti、鋯(Zr)、釩(V)、Cr、鈮(Nb)和鉿(Hf)等.這些活性元素在一定溫度下與Cu形成液態(tài)合金,潤(rùn)濕陶瓷表面.Ti的活性較好、線膨脹系數(shù)高及彈性模量大,因此,含有Ti的活性釬料是最常用的,也正是因?yàn)門(mén)i的活性較高,純Ti微粉易被氧化,不易保存,而氫化鈦(TiH2)很穩(wěn)定,在常溫空氣中不吸潮,不發(fā)生化學(xué)變化,在真空加熱時(shí),分解的還原性H2對(duì)表面還有清潔的作用,更有利于金屬化,因此可用TiH2替代純Ti[42].
常用的含Ti釬料有Ag-Cu-Ti、Cu-Zn-Ti、Ti-Zr-Cu、錫(Sn)-Ag-Ti和Ni-Pd-Ti等[43],在多年的發(fā)展過(guò)程中,Ag-Cu-Ti釬料是研究最為廣泛、成熟的,Ag-Cu-Ti釬料幾乎對(duì)所有的陶瓷都會(huì)發(fā)生反應(yīng),能夠潤(rùn)濕大部分的陶瓷,應(yīng)用范圍廣,連接強(qiáng)度高,性能穩(wěn)定[44].Rajendran等[45]研究了Ti和Sn在Ag-Cu-Zr釬料中對(duì)Cu/Al2O3-AMB的協(xié)同作用,結(jié)果表明,含有Ti釬料的潤(rùn)濕角比不含Ti釬料的潤(rùn)濕角要低15°,這說(shuō)明Ti的存在促進(jìn)了釬料的鋪展.釬料中Ti的含量是決定結(jié)合強(qiáng)度的關(guān)鍵因素,Ti含量的增加會(huì)使釬料的潤(rùn)濕性能增加,但過(guò)多的Ti會(huì)使脆性化合物增加,共晶組織減少.Yang等[46]研究了Ti含量對(duì)Ag-Cu-Ti/SiC體系潤(rùn)濕角的影響,Ti的加入提高了釬料的潤(rùn)濕性能,當(dāng)Ti含量從0 wt.%增加到4.5 wt.%時(shí),潤(rùn)濕角從原來(lái)的78°減小到26°.吳雙[47]改進(jìn)了Ag-Cu-Ti活性釬料的占比,結(jié)果表明,當(dāng)Ag∶Cu∶Ti=71.25∶23.75∶5時(shí),所獲得的陶瓷基板結(jié)構(gòu)致密,未發(fā)現(xiàn)空洞等缺陷,并且獲得適合此配方的最佳釬焊溫度為850℃.Jin等[48]用Ag-Cu-Ti釬料分別與烏(W)箔和鉭(Ta)箔制備Al2O3/Cu-AMB,結(jié)果表明,含W箔和Ta箔的陶瓷基板剪切強(qiáng)度明顯高于不含W箔和Ta箔的陶瓷基板,這是因?yàn)閃和Ta金屬層的熱膨脹系數(shù)與Al2O3接近.Fan等[49]采用Ag-Cu-Ti+Zn復(fù)合釬料釬焊Al2O3陶瓷和Cu,結(jié)果表明,釬焊過(guò)程中Zn原子的揮發(fā)可以促進(jìn)液體釬料在Al2O3陶瓷表面的鋪展,形成均勻的樹(shù)枝狀界面結(jié)構(gòu),添加了Zn的復(fù)合填料在900℃下釬焊20 min,Al2O3/Cu接頭的拉伸強(qiáng)度提高到20.89 MPa.
除此之外,釬焊的溫度也會(huì)影響結(jié)合的性能.王帥超[50]研究了不同的釬焊溫度對(duì)AlN/Cu界面之間微觀結(jié)構(gòu)的影響,結(jié)果表明,當(dāng)釬焊溫度較低時(shí),陶瓷和釬料之間不能充分反應(yīng),生成了一層不連續(xù)的反應(yīng)層,導(dǎo)致了釬料的潤(rùn)濕性較差,當(dāng)釬焊溫度為830~870℃時(shí),界面沒(méi)有空洞、裂紋等缺陷,隨著溫度的升高,釬縫中Ag-Cu共晶組織的含量逐漸減少且變得更加粗大.
AMB陶瓷基板的結(jié)構(gòu)穩(wěn)定性優(yōu)于DBC陶瓷基板[29],并且AMB工藝過(guò)程在1次升溫中完成,時(shí)間周期短,對(duì)陶瓷的適用范圍廣,廣泛應(yīng)用于絕緣柵雙極型晶體管模塊及新能源汽車(chē)功率模塊.
2 熱疲勞可靠性的研究
陶瓷金屬熱膨脹系數(shù)不匹配,會(huì)在陶瓷金屬界面處產(chǎn)生交變熱應(yīng)力[51].交變熱應(yīng)力使陶瓷金屬層界面處萌生裂紋,最終導(dǎo)致陶瓷基板熱疲勞失效,如金屬化層脫皮、翹曲和脫落等(見(jiàn)圖4)[52],嚴(yán)重影響高性能電子裝置的可靠性,也已成為大功率陶瓷基板失效的主要原因.因此,廣大研究學(xué)者對(duì)陶瓷基板的熱疲勞性能進(jìn)行了廣泛研究.
Miyazakia等[51]研究了在-40~250℃熱循環(huán)下Si3N4-AMB和AlN-AMB基板的可靠性.研究表明,Si3N4-AMB的可靠性優(yōu)于AlN-AMB基板,Cu層厚度為0.15 mm和0.30 mm的Si3N4/Cu基板即使經(jīng)過(guò)1 000次熱循環(huán)也未出現(xiàn)分層;而Cu層厚度為0.15 mm厚的AlN/Cu基板經(jīng)過(guò)50次熱循環(huán)已出現(xiàn)裂紋,Cu厚度為0.30 mm厚的AlN/Cu基板僅在7次熱循環(huán)后就表現(xiàn)出來(lái)明顯的分層,如圖5所示.Lang等[52]研究了Si3N4/Cu-AMB陶瓷基板在惡劣環(huán)境下可靠性的問(wèn)題,在300℃的溫度下儲(chǔ)存3 000 h,Si3N4-AMB基板表現(xiàn)出較高的可靠性,但在-40~300℃下進(jìn)行熱沖擊3 000次,Cu層發(fā)生了嚴(yán)重變形,極大地降低了結(jié)合的可靠性.Dupont等[53]研究了Cu/AlN-DBC陶瓷基板Cu層厚度對(duì)可靠性和壽命的影響,在-30~180℃范圍內(nèi),當(dāng)Cu層厚度為200 μm時(shí),僅在90次熱循環(huán)后就已經(jīng)出現(xiàn)了分層,結(jié)果表明,陶瓷的斷裂是金屬材料應(yīng)變硬化的結(jié)果,當(dāng)陶瓷中的力學(xué)約束超過(guò)陶瓷的拉伸強(qiáng)度時(shí),就會(huì)發(fā)生陶瓷斷裂,Cu層的厚度越低,陶瓷基體的壽命越高.
3 陶瓷基板制備新工藝
科研人員在上述的陶瓷表面金屬化工藝中做了改良及創(chuàng)新,如本課題組提出了一種新型陶瓷金屬化的方法實(shí)現(xiàn)了Si3N4/Cu的界面結(jié)合,其工藝流程是在陶瓷基片上利用磁控濺射技術(shù)濺射一層Ti,然后在放電等離子燒結(jié)爐(SPS)中制備納米Cu/Ti-Si3N4陶瓷基板,在等離子體活化作用下,納米Cu粉末熱壓在Si3N4陶瓷表面上,成功實(shí)現(xiàn)陶瓷和Cu的覆接,并且研究了界面結(jié)合機(jī)制,結(jié)果表明,由分散的鈦銅氧化合物(Ti4Cu2O和Ti3Cu3O)和Ti2O層組成的雙層結(jié)構(gòu)的接頭具有最好的結(jié)合性能,同時(shí)還認(rèn)為,在界面處Cu2O會(huì)被還原生成由納米孿晶Cu構(gòu)成的納米Cu晶粒,這可能提高界面結(jié)合強(qiáng)度[54].同時(shí)也有學(xué)者認(rèn)為,納米Cu層可以有效抑制熱疲勞斷裂[55],Song等[56]采用激光對(duì)Si3N4表面改性,形成的Si和Cu在高溫下反應(yīng),獲得了無(wú)缺陷的Si3N4/Cu結(jié)合界面,測(cè)試結(jié)果表明,獲剪切強(qiáng)度為18.3 MPa,并且經(jīng)過(guò)1 000次熱循環(huán)測(cè)試后,仍保持99.4%的結(jié)合面積.Liu等[57]采用納米激光輻照AlN表面,對(duì)AlN陶瓷進(jìn)行熱分解,通過(guò)Al與Cu的共晶反應(yīng),成功地將AlN陶瓷與Cu進(jìn)行了共晶連結(jié).張學(xué)斌[58]以薄膜法為基礎(chǔ)在界面處添加一層薄膜黏附材料作為過(guò)渡層以解決接合強(qiáng)度不足的問(wèn)題,研究表明,WTi作為黏附層的結(jié)合強(qiáng)度最高,Ti次之,且結(jié)合強(qiáng)度隨黏附層厚度的增加先增大后減小,當(dāng)采用厚度為200 nm的WTi作為黏附層,制備的Al2O3陶瓷基板的結(jié)合力強(qiáng)度大于97.20 N.陽(yáng)極Al2O3膜作為緩沖層有效地緩解了AlN與Al的熱膨脹系數(shù)失配的問(wèn)題,在260℃熱沖擊下,Al未發(fā)生形變,并且AlN膜也沒(méi)發(fā)生破裂.Fei等[59]提出了一種制備Al/AlN陶瓷基板的新方法,在AlN表面覆一層CuO厚膜并進(jìn)行燒結(jié),將Al放在預(yù)處理完后的AlN上,通過(guò)400℃預(yù)熱和660℃最終加熱,最后在N2-H2氣氛中與AlN結(jié)合,力學(xué)實(shí)驗(yàn)結(jié)果表明,剝離強(qiáng)度可以達(dá)到15.4 MPa.Atil等[60]采用摩擦堆焊技術(shù)實(shí)現(xiàn)了Si3N4陶瓷與Al基復(fù)合材料結(jié)合,Al基層的厚度取決于所用的轉(zhuǎn)速,但結(jié)合強(qiáng)度也受到橫向速度的影響,涂層厚度達(dá)到2.03 mm,結(jié)合強(qiáng)度達(dá)到42.5 MPa.
最近幾年涌現(xiàn)的陶瓷基板金屬化方法主要是對(duì)陶瓷表面進(jìn)行處理,例如,在陶瓷表面加工一層活性金屬層,以及對(duì)陶瓷表面進(jìn)行改性.但也有學(xué)者采用傳統(tǒng)的焊接方法,例如,摩擦堆焊來(lái)實(shí)現(xiàn)陶瓷基板金屬化的.不過(guò),很多陶瓷基板金屬化的新方法由于自身局限性和目前技術(shù)水平的限制無(wú)法實(shí)現(xiàn)量產(chǎn),還需加深研究已達(dá)到新方法的實(shí)用化.
4 結(jié) 語(yǔ)
本文從陶瓷基板傳統(tǒng)制備工藝出發(fā),綜述提高陶瓷基板可靠性的方法,并簡(jiǎn)述了一些最新的制備工藝及性能評(píng)價(jià).陶瓷基板金屬化方法主要有DPC、TFC、DBC、DBA和AMB.高新技術(shù)的發(fā)展對(duì)于陶瓷基板的服役要求越來(lái)越高(如使用周期延長(zhǎng),服役環(huán)境條件更加苛刻等),這對(duì)陶瓷基板提出了更苛刻的性能指標(biāo).從現(xiàn)有的研究來(lái)看,未來(lái)陶瓷基板的發(fā)展趨勢(shì)主要有:
1)目前,國(guó)內(nèi)外學(xué)者雖然對(duì)陶瓷基板金屬化的研究比較活躍,但很少涉及由于熱疲勞引起的界面微觀結(jié)構(gòu)變化的問(wèn)題.微觀結(jié)構(gòu)的變化會(huì)很大程度上影響結(jié)合強(qiáng)度,因此,還需對(duì)熱疲勞過(guò)程中界面微觀結(jié)構(gòu)的演化機(jī)制進(jìn)行深入研究,這對(duì)提高陶瓷基板的結(jié)合強(qiáng)度具有重要意義.
2)在陶瓷基板的實(shí)際服役過(guò)程中,有些參數(shù)難以通過(guò)儀器進(jìn)行實(shí)時(shí)測(cè)量,例如,隨時(shí)間變化的應(yīng)變、應(yīng)力分布和疲勞壽命等,這些參數(shù)可通過(guò)數(shù)學(xué)建模并利用仿真軟件進(jìn)行運(yùn)算,利用仿真結(jié)果對(duì)實(shí)際情況進(jìn)行預(yù)測(cè),從而達(dá)到提升金屬化質(zhì)量的目的.因此,利用仿真軟件對(duì)殘余應(yīng)力和熱力學(xué)過(guò)程進(jìn)行模擬仿真為進(jìn)一步認(rèn)識(shí)陶瓷基板的抗疲勞提供了研究思路,是以后值得深入研究的方向之一.
參考文獻(xiàn):
[1]董政.功率型LED陶瓷基印刷電路板的研究[D].杭州:浙江大學(xué),2012.
[2]程浩,陳明祥,郝自亮,等.功率電子封裝用陶瓷基板技術(shù)與應(yīng)用進(jìn)展[J].電子元件與材料,2016,35(1):7-11.
[3]Huang D,Liu Z,Harris J,et al.High thermal conductive AlN substrate for heat dissipation in high-power LEDs[J].Ceram Int,2019,45(1):1412-1415.
[4]胡光輝,楊防祖,林昌健,等.陶瓷基上化學(xué)鍍銅[J].電鍍與涂飾,2001,20(2):1-4.
[5]Cai X M,Luo Y.Adhesive properties study on the interfaces of AlN and metal of Pd,Ag and Cu[J].Sci China Technol Sc,2011,54(1):11-14.
[6]程浩,陳明祥,羅小兵,等.電子封裝陶瓷基板[J].現(xiàn)代技術(shù)陶瓷,2019,40(4):265-292.
[7]Wang S F,Dougherty J P,Huebner W,et al.Silver-palladium thick-film conductors[J].J Am Ceram Soc,1994,77(12):3051-3072.
[8]江成軍,張振忠,趙芳霞,等.漿料成分對(duì)銀導(dǎo)體漿料性能的影響[J].特種鑄造及有色合金,2008,29(10):804-806.
[9]錢(qián)斐.大功率LED用Al2O3陶瓷封裝基板的金屬化和致密化研究[D].南京:南京航空航天大學(xué),2014.
[10]楊穎,何為,王守緒,等.環(huán)氧樹(shù)脂-銀粉復(fù)合導(dǎo)電銀漿的制備[J].電子元件與材料,2010,29(5):54-56.
[11]Reboun J,Hromadka K,Hermansky V,et al.Properties of power electronic substrates based on thick printed copper technology[J].Microelectron Eng,2017,167:58-62.
[12]Zhang P,F(xiàn)u R,Tang Y,et al.Morphology of thick film metallization on aluminum nitride ceramics and composition of interface layer[J].Ceram Int,2015,41(10):13381-13388.
[13]Zou Y,F(xiàn)u R,Liu X,et al.Enhanced adhesion strength of silver paste on AlN ceramic substrate via sintered nano-CuO[J].Ceram Int,2021,47(7):9471-9476.
[14]Tsai C J,Tseng W J,Hsi C S.Interfacial adhesion and microstructure of thick film metallized aluminum nitride substrates[J].Ceram Int,2002,28(1):23-28.
[15]張鵬飛.大功率LED用AlN金屬化陶瓷基板的制備及性能研究[D].南京:南京航空航天大學(xué),2016.
[16]鄭洪雷.反應(yīng)結(jié)合法厚膜金屬化AlN陶瓷的研究[D].天津:天津大學(xué),2007.
[17]Ji S,Shi Y,Chen C,et al.Investigation of interfacial properties of Cu/AlN composite ceramic substrates derived from copper paste containing TeO2-V2O5-CuO glass frit[J].J Mater Sci:Mater Electron,2022,33(16):13339-13351.
[18]Chen Q,Yang H,Lu L,et al.Preparation of lead-free nanoglass frit powder for crystalline silicon solar cells[J].Appl Energy,2013,112:657-662.
[19]Zhou J,Xu N,Yang H,et al.Effect of Ag Powder and Glass Frit in Ag Paste on Front Contract of Silicon Solar Cells[J].Proc Eng,2014,94:1-5.
[20]Li F,Wang W,Dang W,et al.Wetting mechanism and bending property of Cu/Al2O3laminated composites with pretreated CuO interlayer[J].Ceram Int,2020,46(11):17392-17399.
[21]王文君,王雙喜,張丹,等.大功率LED封裝基板研究進(jìn)展[J].材料導(dǎo)報(bào),2016,30(17):44-50.
[22]王彩霞,傅仁利,朱海洋,等.直接敷銅技術(shù)中銅箔預(yù)氧化層的檢測(cè)與控制[J].電子元件與材料,2018,37(2):69-74.
[23]許昕睿,莊漢銳,李文蘭,等.AlN陶瓷基板覆銅技術(shù)的研究[J].無(wú)機(jī)材料學(xué)報(bào),2003,18(4):837-842.
[24]潘文霞,吳承康,岡本平.氮化鋁基板與Cu和Al的接合及其表面改質(zhì)效果[J].金屬學(xué)報(bào),2000,45(1):67-71.
[25]謝建軍,王宇,汪暾,等.直接敷銅工藝制備Cu/AlN材料的界面結(jié)構(gòu)及結(jié)合性能[J].機(jī)械工程材料,2017,41(1):61-64.
[26]Hu J,Wu Y,Li C,et al.Pressure-assisted direct bonding of copper to silicon nitride for high thermal conductivity and strong interfacial bonding strength[J].J Mater Sci,2021,56(32):17994-18005.
[27]Barlak M,Olesińska W,Piekoszewski J,et al.Ion implantation as a pre-treatment method of AlN substrate for direct bonding with copper[J].Vacuum,2005,78(2/4):205-209.
[28]彭榕,周和平,寧曉山,等.鋁/氮化鋁電子陶瓷基板的制備及性能的研究[J].無(wú)機(jī)材料學(xué)報(bào),2002,17(6):1203-1208.
[29]張珊珊,楊理航,王燕斌,等.覆銅氮化鋁陶瓷基板失效機(jī)理分析[J].真空電子技術(shù),2018,60(4):1-7.
[30]Tsai M Y,Lin C H,Chuang K F,et al.Failure and stress analysis of through-aluminum-nitride-via substrates during thermal reliability tests for high power LED applications[J].Microelectron Reliab,2016,67:120-128.
[31]井敏.金屬直接敷接陶瓷基板制備方法與性能研究[D].南京:南京航空航天大學(xué),2009.
[32]陳建,潘復(fù)生.氧化鋁膜對(duì)鋁基復(fù)合材料潤(rùn)濕行為的影響[J].材料科學(xué)與工程,1999,17(2):85-90.
[33]Kara-Slimane A,Juve D,Leblond E,et al.Joining of AlN with metals and alloys[J].J Eur Ceram Soc,2000,20(11):1829-1836.
[34]彭榕,周和平,寧曉山,等.Al/Al2O3陶瓷接合基板的制備及性能研究[J].無(wú)機(jī)材料學(xué)報(bào),2002,17(4):731-736.
[35]Ksiazek M,Sobczak N,Mikulowski B,et al.Wetting and bonding strength in Al/Al2O3system[J].Mater Sci Eng A,2002,324(1/2):162-167.
[36]Wang Y T,Cheng Y H,Lin C C,et al.Direct bonding of aluminum to alumina using a nickel interlayer for power electronics applications[J].Res Mater,2020,6:100093-1-100093-7.
[37]Lei T G,Calata J N,Ngo K D T,et al.Effects of large-temperature cycling range on direct bond aluminum substrate[J].IEEE T Device Mat Re,2009,9(4):563-568.
[38]Ning X S,Lin Y B,Peng R,et al.Manufacture and analyses of ceramic/aluminum laminated composites[J].Key Eng Mater,2002,224/226:413-416.
[39]李明鶴,彭雷,王文峰.氮化鋁-鋁復(fù)合封裝基板的制備[J].電子與封裝,2014,14(4):5-8.
[40]Khazaka R,Mendizabal L,Henry D,et al.Survey of High-Temperature Reliability of Power Electronics Packaging Components[J].IEEE T Power Electr,2015,30(5):2456-2464.
[41]Hlina J,Reboun J,Hamacek A,et al.Study of copper thick film metallization on aluminum nitride[J].Scripta Mater,2020,173:23-27.
[42]王洪瀟.氧化鋁陶瓷與金屬活性封接技術(shù)研究[D].大連:大連交通大學(xué),2006.
[43]Zou J,Jiang Z,Zhao Q,et al.Brazing of Si3N4with amorphous Ti40Zr25Ni15Cu20filler[J].Mater Sci Eng:A,2009,507(1/2):155-160.
[44]楚建新,林晨光,葉軍.陶瓷—金屬活性連接用銀—銅—鈦釬料[J].電子工藝技術(shù),1993,14(3):10-12.
[45]Rajendran S H,Hwang S J,Jung J P.Active brazing of alumina and copper with multicomponent Ag-Cu-Sn-Zr-Ti filler[J].Metals,2021,11(3):509.
[46]Yang J,Huang J,Ye Z,et al.Influence of interfacial reaction on reactive wettability of molten Ag-Cu-X wt.% Ti filler metal on SiC ceramic substrate and mechanism analysis[J].Appl Surf Sci,2018,436:768-778.
[47]吳雙.陶瓷覆銅板用TiAgCu釬焊電子漿料制備及焊接性能研究[D].南昌:江西科技師范大學(xué),2020.
[48]Jin B,Huang X,Zou M,et al.Joining of Al2O3ceramic to Cu using refractory metal foil[J].Ceram Int,2022,48(3):3455-3463.
[49]Fan B,Xu J,Lei H,et al.Microstructure and mechanical properties of Al2O3/Cu joints brazed with Ag-Cu-Ti+Zn composite fillers[J].Ceram Int,2022,48(13):18551-18557.
[50]王帥超.氮化鋁陶瓷和銅的活性釬焊研究[D].長(zhǎng)春:長(zhǎng)春工業(yè)大學(xué),2022.
[51]Miyazakia H,Iwakiri S,Hirao K,et al.Effect of high temperature cycling on both crack formation in ceramics and delamination of copper layers in silicon nitride active metal brazing substrates[J].Ceram Int,2017,43(6):5080-5088.
[52]Lang F,Yamaguchi H,Nakagawa H,et al.Cyclic thermal stress-induced degradation of Cu metallization on Si3N4substrate at -40℃ to 300℃[J].J Electron Mater,2015,44(1):482-489.
[53]Dupont L,Khatir Z,Lefebvre S,et al.Effects of metallization thickness of ceramic substrates on the reliability of power assemblies under high temperature cycling[J].Microelectron Reliab,2006,46(9/11):1766-1771.
[54]Xin C,Yuan R,Wu J,et al.Fabrication and joining mechanism of Nano-Cu/Si3N4 ceramic substrates[J].Ceram Int,2021,47(3):3411-3420.
[55]Fushimi T,Tanaka Y,Soda S,et al.Thermal fatigue properties of ultrasonically bonded copper joints[J].Appl Sci,2019,9(8):1556-1-1556-10.
[56]Song Y,Liu D,Jin G,et al.Fabrication of Si3N4/Cu direct-bonded heterogeneous interface assisted by laser irradiation[J].J Mater Sci Technol,2022,99:169-177.
[57]Liu D,Chen N,Song Y,et al.Mechanical and heat transfer properties of AlN/Cu joints based on nanosecond laser-induced metallization[J].J Eur Ceram Soc,2023,43(5):1897-1903.
[58]張學(xué)斌.鍍銅陶瓷基板制備與LED封裝應(yīng)用研究[D].武漢:華中科技大學(xué),2014.
[59]Fei M,F(xiàn)u R,Agathopoulos S,et al.A preparation method for Al/AlN ceramics substrates by using a CuO interlayer[J].Mater Design,2017,130:373-380.
[60]Atil H B,Leonhardt M,Grant R J,et al.Mechanical and microstructural analysis of friction surfaced aluminum coatings on silicon nitride ceramic substrates[J].Metall Mater Trans A,2023,54(1):121-140.
(責(zé)任編輯:伍利華)
Research Progress in Metallization of Ceramic Substrate
ZHANG Mingchang1,XIN Chenglai2,LI Dongya1
(1.School of Mechanical Engineering,Chengdu University,Chengdu 610106,China;
2.School of Architecture and Civil Engineering,Chengdu University,Chengdu 610106,China)
Abstract:This paper summarizes the processes and techniques to enhance the reliability of ceramic substrates from the perspective of their manufacturing,including direct copper plating metallization (DPC),thick film metallization (TFC),direct bonding copper metallization (DBC),direct bonding aluminum metallization (DBA) and active metal brazing metallization (AMB).Additionally,the paper outlines the innovative production processes and bonding strength based on the above mentioned metallization methods,as well as elaborates on the drawbacks and shortcomings of ceramic substrates prepared through different processes in practical applications.Finally,it predicts the development trend of ceramic substrate metallization.
Key words:ceramic substrate;metallization;power module;bonding strength

