銦砷銻紅外探測器的研究進展
陳冬瓊,楊文運,鄧功榮,龔曉霞,范明國,肖婷婷,尚發蘭,余瑞云
銦砷銻紅外探測器的研究進展
陳冬瓊,楊文運,鄧功榮,龔曉霞,范明國,肖婷婷,尚發蘭,余瑞云
(昆明物理研究所,云南 昆明 650223)
InAs1-Sb屬于III-V族化合物半導體合金材料,隨Sb組分含量的不同,室溫下可覆蓋3~12mm波長,并且InAsSb材料具有載流子壽命長、吸收系數大、載流子遷移率高等優點,是一種具有廣闊應用前景的紅外光電材料。探測器可以在150K甚至近室溫下工作,具有較高的靈敏度和探測率,是低功耗、小型化、高靈敏度和快響應中長波紅外探測系統的良好選擇,InAsSb中長波紅外探測器受到廣泛的關注和研究。本文首先簡要概述了InAsSb材料的基本性質。其次,對國內外InAsSb紅外探測器發展狀況進行了介紹。最后,對InAsSb紅外探測技術的發展進行了總結與展望。
紅外探測器;InAsSb;高工作溫度
0 引言
1958年Woolley等人最早研究了基于InSb的InAs1-Sb合金,確定了InAs-InSb的混溶性[1]、偽二元相位圖[2]、帶隙[3]和有效質量等基本性質對成分的依賴性[3]。InAsSb具有高電子遷移率、較高的吸收系數、低熱產生率等優點,此外,隨Sb組分含量的不同,其光譜響應截止波長可在1~14mm范圍內變化,是中長波紅外探測的理想材料。分子束外延(molecular beam epitaxy, MBE)、液相外延(liquid phase epitaxy, LPE)、和金屬有機化學氣相外延(metal-organic chemical vapor deposition, MOCVD)技術的出現解決了InAsSb材料生長液-固相分離、固相擴散速率低以及InAs和InSb晶格失配等問題,極大地促進了InAsSb材料的發展。當前對InAsSb紅外探測器的研究主要集中在以下幾個方面:在二元GaSb或GaAs襯底上延伸響應波長;高溫工作紅外探測器;采用勢壘結構、浸沒透鏡、等離子增強技術提高紅外探測器性能等。
1 InAsSb合金性質
相比于HgCdTe材料襯底昂貴、大面積組分不均勻,器件需制冷降低俄歇復合,InAs1-Sb的In與As及Sb為共價鍵結合,材料穩定性均勻性更好,外延生長采用GaSb或GaAs襯底材料,制造成本較低,同時具有超高的電子遷移率以及很小的有效質量,介電常數較低(≈11.5),室溫下自擴散系數低(≈5.2×10-16cm2/s)[4-5]。相比于InAs/GaSb超晶格材料,InAsSb材料的肖克萊-里德復合壽命更長,InAsSb體材料少數載流子遷移率各向同性,采用InAs/InAsSb II 類超晶格,由于不含有Ga元素,非輻射復合中心減小,載流子壽命長于InAs/GaSb材料[6-7]。此外,采用勢壘結構器件可顯著降低器件的肖克萊-里德霍爾復合暗電流和隧穿電流,提升器件工作溫度。
1.1 帶隙
III-V族半導體材料具有閃鋅礦結構,在布里淵區中心為直接帶隙。InAs1-Sb三元合金的帶隙與組分、能帶彎曲系數的關系可以表示為:
g()=gInSb+(1-)gInAs-(1-) (1)
文獻[8-16]報道的InAs1-Sb材料低溫和室溫下Sb組分與帶隙的關系如圖1所示。根據不同文獻計算結果,在=0.6附近,InAs1-Sb材料的禁帶寬度最小。InAs1-Sb早期報道InAsSb材料在溫度接近或高于100K下的能帶彎曲系數為0.58~0.67eV。Svensson博士在GaSb襯底上通過變質緩沖層外延InAsSb薄膜,通過實驗結果擬合計算得到能帶彎曲系數=0.87eV[14]。Webster[10]在GaSb襯底上外延生長的InAs0.911Sb0.089材料在低溫下彎曲系數為0.938eV,是目前報道的最高值,室溫下的能帶彎曲系數為0.75eV。

圖1 InAs1-xSbx禁帶寬度(Eg)與其成分(x)的關系曲線:(a) 低溫;(b) 室溫
注:實線所示是文獻[8-16]報道的實驗數據,為能帶彎曲系數
Note: Experimental data from the literature are shown as solid symbols. The bandgap bowing parameters, are noted


Y. Lin等人[18]擬合出用MBE法在GaSb襯底采用變質緩沖層生長的InAs0.8Sb0.2的g(0)=0.26eV,=3.2meV/K,=100.4K,生長的InAs0.56Sb0.44的g(0)=0.119eV,=1.2meV/K,=33.3K。Soibel等人[19]在GaSb襯底上生長InAs0.91Sb0.09的g(0)=0.33eV,=0.4meV/K,=310K。Lancaster大學Craig等[20]報道的在晶格失配GaAs襯底生長的InAs0.90Sb0.1的g(0)=0.42eV,=0.942meV/K,=641K和晶格匹配GaSb襯底上生長的InAs0.92Sb0.08的g(0)=0.39eV,=0.747meV/K,=610K。
InAs1-Sb材料的帶隙不僅與材料組分、生長方法、生長條件等相關,還與材料內部結構有序化程度有關,1989年,Jen等人[21]在InAs或InSb上采用有機金屬氣相外延(organo-metallic vapor phase epitaxy, OMVPE)生長InAsSb(0.12≤≤0.78),通過透射電子顯微鏡首先在InAsSb中觀察到CuPt型有序化結構,即<111>方向的{111}最密排面是按一層InAs一層InSb交替排列的。文獻[22-23]研究表明CuPt型有序化結構可以明顯減小InAsSb的禁帶寬度,有序化程度越高,材料的光學彎曲效應越明顯,禁帶寬度越小。到目前為止,InAs1-Sb材料的禁帶寬度還沒有完全統一,文獻中報道的結果還不完全一致。
1.2 InAsSb能帶排列
兩種不同的半導體構成異質結時,界面處能帶不連續,已知半導體材料的能隙,能帶偏移可以用導帶偏移Dc和價帶偏移Dv來標志。Wei和Zunger[24]利用第一性原理計算方法研究了InAs1-Sb與InSb、InAs的能帶排列。高有序化Cu-Pt結構使富As的InAs1-Sb/InAs能帶排列為I型,當不存在Cu-Pt結構有序化且材料存在應力時,InAs1-Sb/InAs能帶排列為II型。2012年,Steenbergen等人[25]研究了InAs/InAs1-Sb的價帶差模型,InAs1-Sb價帶彎曲系數隨Sb組分變化線性變化Cv=1.58-0.62eV(=0.28~0.4)。InAs1-Sb(0.20<Sb<0.40)材料,12K下價帶彎曲系數為-0.38eV[26],室溫下價帶彎曲系數為-0.3eV[18]。InAs1-Sb導價帶邊與Sb組分的關系如圖2所示。InAs和InSb的價帶邊VB分別為-0.59eV和0eV,推薦使用的InAs1-Sb禁帶彎曲系數和價帶彎曲系數為0.87eV和-0.35eV。
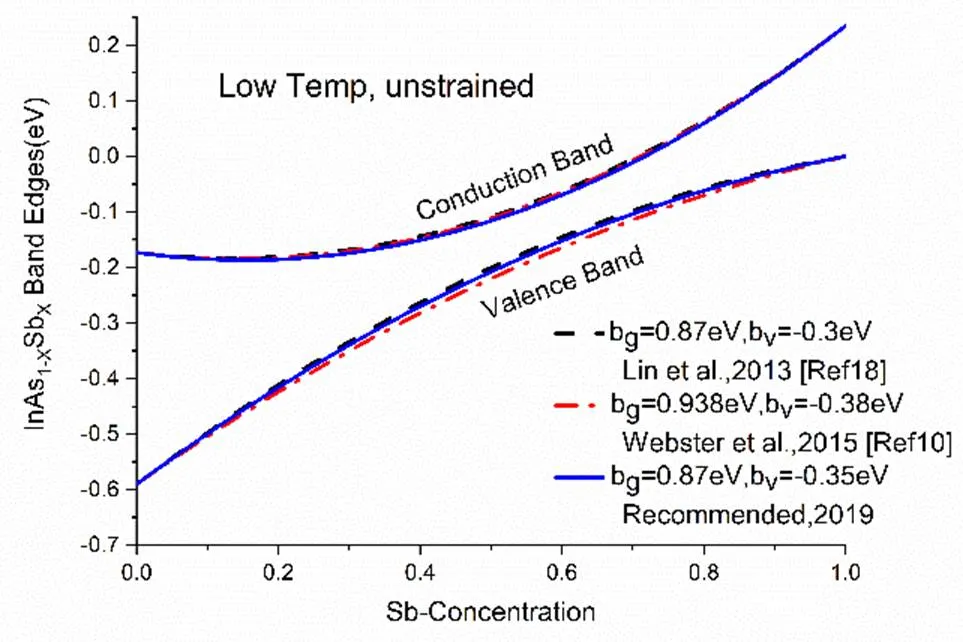
圖2 InAs1-xSbx帶邊與其成分x的關系曲線
1.3 InAsSb材料的輸運特性
Rogalski和Jozwikowski在k·p理論的基礎上考慮了導帶價帶混合對有效質量的影響,將導帶有效質量表示為[27]:

式中:=gv-g,gv=0.351-0.176,D=0.39+0.42。lh*,hh*,s*分別為輕空穴,重空穴和分裂帶有效質量。最后,ce*不考慮帶隙混溶的導帶有效質量,由Kane方程計算得出。采用上式計算得出的e*與實驗數據吻合很好。
Rogalski考慮導帶價帶混合對InAs1-Sb的本征載流子濃度的影響,得出InAs1-Sb本征載流子濃度表示為成分和溫度的關系[27]:

式中:為玻爾茲曼常數。當≈0.63時,i值最大。
InAs1-Sb薄膜的電子遷移率主要受位錯散射、電離雜質散射和極性光學聲子散射的影響,而空穴遷移率主要受位錯散射、合金散射和電離雜質散射的影響。InAs1-Sb總載流子遷移率可以表示為[28]:

式中:totInSb、totInAs為InSb和InAs總載流子遷移率;tot為InAs1-Sb總載流子遷移率,第一、二項源自線性插值法,第三項考慮了合金擴散的影響。
Egan等人[29]理論計算了InAsSb的電子遷移率,考慮了聲子、合金散射、位錯及電離雜質散射對電子遷移率的影響,并與實驗結果相比較。結果表明,溫度較低時,位錯散射和電離雜質散射對電子遷移率起主要作用;合金散射、位錯散射和電離雜質散射對空穴遷移率起主要作用。Dixit等人[30]用旋轉Bridgman法生長Sb組分0.9的InAs0.1Sb0.9單晶,15K和室溫下電子遷移率為3.37×104cm2·V-1·s-1和5.6×104cm2·V-1·s-1,15K下空穴遷移率降為175cm2·V-1·s-1。由于生長方式、組分、襯底材料選取等的差別,不同文獻[31-33]報道的遷移率值不一致,室溫下電子遷移率多為(1~4)×104cm2·V-1·s-1,且隨溫度的降低而減小。
2 InAsSb紅外探測器國內外研究現狀
2.1 國外研究現狀
早期報道的InAsSb器件結構主要為簡單的pn結、p-i-n結構,勢壘型器件(nBn、pBnn、nBnn等)通過抑制吸收層的產生-復合電流有效降低器件暗電流提高器件工作溫度,近十幾年報道的InAsSb器件多采用勢壘結構,工作在150~300K。表1[34-41]為國外InAsSb紅外探測器研究結果。
1980年,Bubulac等人[42]在GaSb襯底上生長晶格匹配或近似晶格匹配的n型InAs1-Sb(0.09≤≤0.15)材料,再生長摻雜Zn的p型InAs1-Sb材料,光子穿過寬禁帶的GaSb襯底,被InAsSb光敏層吸收。短波長截止值取決于GaSb襯底,長波長截止值取決于InAsSb吸收層。77K溫度下,器件暗電流密度為10-9A/cm2(@-100mV)。
Kim等人[43]首次報道了工作在室溫下以InAsSb為基礎的長波(8~14mm)光敏二極管。利用分子束外延技術在(100)GaAs襯底上生長n+-InAsSb/p-InAsSb/p+-InAsSb異質結,300K溫度下,器件的響應波長達7~8mm,300K時峰值電壓響應度是0.32V/W。同時,他們還研究了GaAs襯底上外延p+Al0.07In0.93Sb/InAs0.06Sb0.94/n+Al0.07In0.93Sb異質結光電器件的室溫特性,300K下,器件截止波長為8mm,峰值電流響應度是0.3A/W,探測率為2×108Jones。Chakrabarti等人[44],采用LPE技術在(100)InAs上生長p+InAs0.96Sb0.04/i-InAs0.96Sb0.04/n+InAs0.96Sb0.04結構光電探測器,器件響應率5.57×108Jones,材料中SRH缺陷、高摻雜吸收層使器件隧穿電流增大,探測率降低。

表1 國外InAs1-xSbx紅外探測器研究結果
新加坡南洋理工大學張道華教授研究團隊[45]在p-i-n異質結的基礎上,在p型接觸層和吸收層之間插入重摻雜寬帶隙的AlGaSb電子勢壘層,進而抑制器件暗電流,引入AlInAsSb層能顯著改善界面質量,提高器件性能,器件結構及能帶結構如圖3所示。室溫下沒有抗反射膜的探測器、-0.5V偏置電壓、3.5mm處的光譜探測率達8.9×109cmHz1/2/W。此外,該團隊設計了一種二維亞波長金屬孔陣等離子結構增強的室溫中波紅外探測器,該器件利用金屬表面等離子體增強技術提高量子效率,實現室溫工作的InAsSb中波紅外探測。
2006年,英國羅徹斯特大學S. Maimon和G. W. Wicks教授首次提出nBn結構器件[46],即“n型窄帶隙吸收層-寬帶隙勢壘層-n型窄帶隙接觸層”,勢壘層設置在少數載流子收集層附近遠離光學吸收層,能帶圖如圖4(a)所示,大的導帶偏移Dc阻擋多數載流子空穴流向接觸區,減小器件暗電流,較小的價帶偏移Dv使光生少數載流子空穴在低偏壓下流向未受阻的接觸區形成光電流。此外,導帶中的大能量勢壘起到自鈍化作用能夠抑制表面漏泄電流。如圖4(b)所示,與傳統pn結器件相比,相同的工作溫度下,nBn器件具有更高的信噪比。

圖3 (a) 光電探測器截面結構示意圖(不按實際比例),右邊的插圖是一個350mm正方形臺面結構的光學顯微鏡圖;(b) 室溫零偏壓下結構的能帶結構示意圖[45]

圖4 nBn結構器件:(a) 能帶圖;(b) 普通(實線)與nBn器件(虛線)暗電流溫度特性理論曲線[46]
目前,國外從事InAsSb紅外探測器研究的主要有以色列SCD公司、美國噴氣推進實驗室(JetPropulsionLaboratory,JPL)、美國DRS技術公司和HRL實驗室以及波蘭的AntoniRogalski課題組等。
2008年以來,以色列SCD公司[47-48]采用XBn勢壘型器件以抑制器件的暗電流,從而提高器件的工作溫度,器件采用GaSb襯底或GaAs襯底,包括1.5~3mm的n型InAsSb吸收層,0.2~0.35mm的n型AlAsSb勢壘層,0.2~0.5mm的n型InAsSb或p型GaSb接觸層,器件少數載流子壽命約為700 ns,150 K下獲得成像清晰的焦平面陣列器件。
美國噴氣推進實驗室AlexanderSoibel[49]等人制備InAs0.915Sb0.085-AlAs0.1Sb0.9nBn結構器件,溫度為77~325K時,器件的量子效率保持不變為35%,當溫度為150~325K時,器件暗電流為擴散限電流,當溫度低于150K時,產生-復合電流占支配地位。溫度為77~220K時器件少數載流子壽命為300ns,溫度升高器件少數載流子壽命變短,溫度升高至325K時,少數載流子壽命為100ns。300K工作溫度下*=1×109cmHz1/2/W,250K工作溫度下*=5×109cmHz1/2/W。
美國DRS技術公司和HRL實驗室報道了可見光至中波(0.5~5mm)InAsSb高工作溫度、低暗電流大面陣紅外探測器[50]。在GaAs襯底上外延InAsSb材料,采用新型錐體狀吸收層設計和AlSb基復合勢壘層設計,降低器件暗電流,探測器*>1×1010cmHz1/2/W,200K工作溫度下,內量子效率>80%。
波蘭的Antoni Rogalski組研發人員[51-52]從理論上分析測試GaAs襯底上外延InAs1-Sb材料禁帶寬度的溫度特性,采用APSYS軟件仿真分析高工作溫度InAsSb/AlAsSb nBn結構器件的光電特性,室溫工作下,當組分>0.15時,與p-on-n InAs1-Sb器件相比,nBnn n+InAs1-Sb/AlAsSb器件相比具有更高的探測率。
Sb組分為0.09的InAs0.91Sb0.09材料與GaSb襯底晶格匹配,而高Sb組分InAs1-Sb材料由于缺乏與之晶格匹配的襯底材料,可以通過外延緩沖層來消除InAs1-Sb材料與襯底之間的晶格失配。
美國石溪大學和陸軍實驗室,在GaSb襯底上MBE外延生長GaInSb和AlInSb緩沖層,消除InAs0.6Sb0.4與GaSb襯底之間的晶格失配,然后生長1mm厚的吸收層,勢壘層采用AlInAsSb四元合金材料,圖5(a)為平衡態下長波異質結的能帶圖,圖5(b)為偏置電壓下能帶分布,箭頭表示少子空穴輸運方向[53-55]。77K溫度下,光譜探測率2×1011cm·Hz1/2/W(=8mm),吸收層InAs0.6Sb0.4的帶隙約為90meV,響應波長8~12mm,少數載流子(空穴)壽命為185ns、擴散長度為9mm、遷移率為~103cm2/Vs[53-55]。
波蘭VIGO公司[56]采用MBE技術在(100)GaAs襯底上外延In0.74Al0.26Sb緩沖層,實現InAs0.3Sb0.7體材料生長,在n+接觸層和InAs0.3Sb0.7吸收層之間生長一薄層InAs層,作為空穴勢壘層阻擋空穴從n+接觸層進入吸收層。器件結構和能帶示意圖如圖6所示[56]。300K溫度下,器件50%截止波長為14.2mm。
美國俄亥俄州立大學[57]采用Al0.6In0.4Sb/AlSb數字合金和Al0.6In0.4Sb/AlSb短周期超晶格InAs1-Sb緩沖層,把穿透位錯限制在界面附近,提高外延層質量,數字合金技術(digital alloy, DA)生長材料表面光滑、位錯密度小,結構與體材料相似。
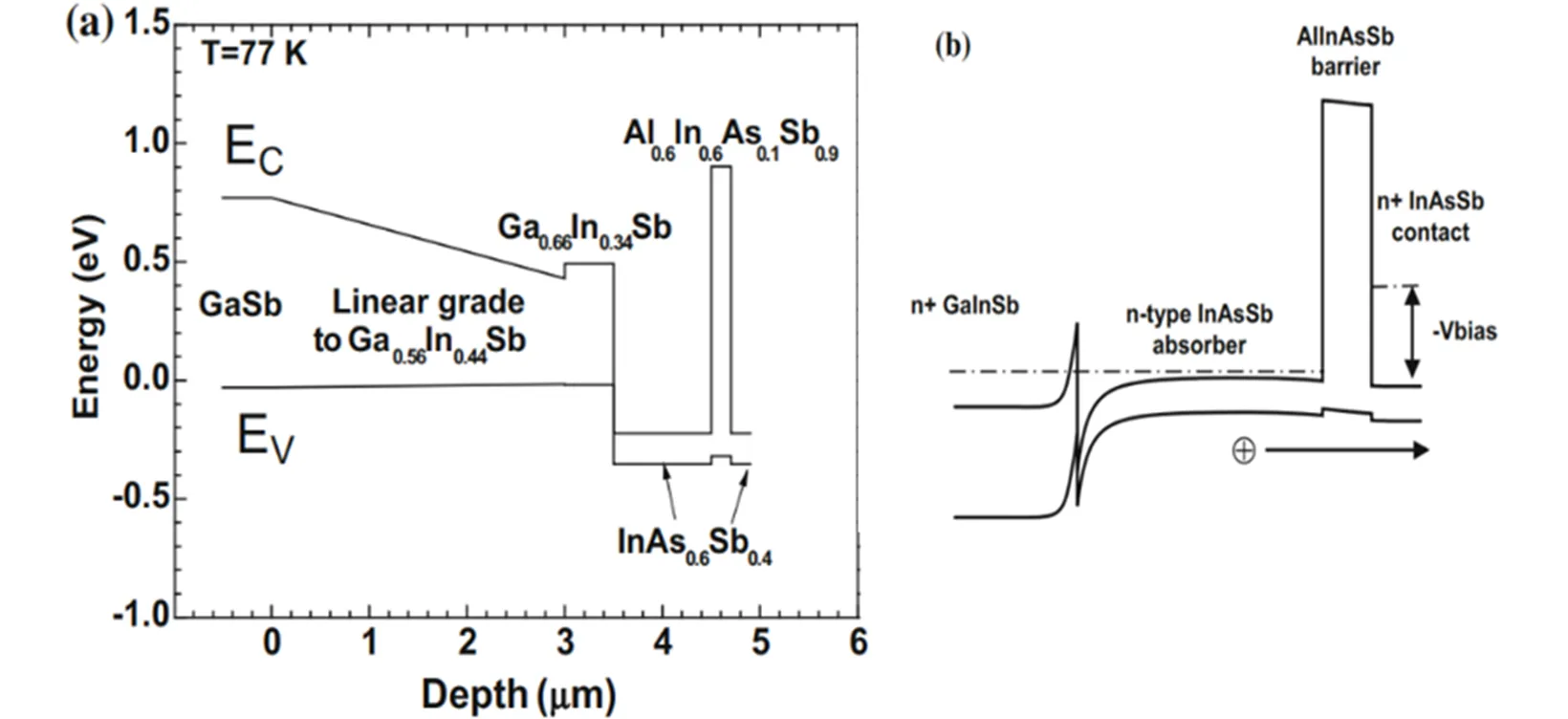
圖5 長波勢壘探測器異質結的能帶結構示意圖:(a) 導帶和價帶能級;(b) 偏置電壓下能帶分布,少子(空穴),箭頭表示少子空穴輸運方向[55]
目前,InAsSb中波紅外焦平面探測器已出現實用化商品。最為典型的是以色列SCD公司,2013年,SCD[58]推出第一款nBn中波高溫產品Kinglet,焦平面陣列規模為640×512,像元中心距為15mm,響應波長3.6~4.2mm;2014年,SCD推出第二款nBn中波高溫產品HOTHerclues,焦平面陣列規模為1280×1024,像元中心距為15mm,響應波長3.4~4.2mm。
2.2 國內研究現狀
國內對InAsSb光電子探測器的研究與國際先進水平存在較大的差距,大部分的研究集中在材料的制備、表征、材料特性分析上,極少數對制備的探測器性能進行了表征分析。
2010年,同濟大學高玉竹等人[59]采用熔體外延技術在InAs襯底上獲得了50mm厚層的InAsSb外延層,用該材料制作了光導探測器,在探測器上安裝了鍺(Ge)浸沒透鏡。非制冷條件下,InAs0.06Sb0.94探測器在波長8.0mm及9.0mm處的探測率*分別為1.3×109cmHz1/2/W及2.8×108cmHz1/2/W,而在波長6.5mm處,InAs0.06Sb0.94和InAs0.02Sb0.98的峰值探測率*均大于1.0×109cmHz1/2/W,可應用在紅外探測和成像領域。
2012年,中國科學院上海技術物理研究所孫常鴻[60]利用水平滑移LPE生長系統,采用改進型液相外延技術成功在高晶格失配的(100)GaAs襯底上生長了InAs0.05Sb0.95多晶厚膜材料,分析結果表明外延膜橫向與縱向組分均勻,與GaAs襯底界限清晰,外延膜室溫截止波長可達12.5mm。2014年,黃亮博士針對InAsSb薄膜和器件進行了光譜、性能和少數載流子壽命的研究[61]。
基于銻化物材料MOCVD生長的基礎,2016年,哈爾濱工業大學寧振動博士[62]探索InAs1-Sb體材料nBn結構中波紅外探測器的制備并對制備的器件進行簡單的測試分析。器件設計采用與GaSb襯底晶格匹配的InAs0.91Sb0.09作為有源區,而勢壘材料則選擇InPSb0.37。器件在77K及300K時的截止波長分別為4.29mm和5.35mm;在-0.8V偏壓下,77K的黑體歸一化探測率最高為1.2×109cm?Hz1/2/W。
中國科學院蘇州納米技術與納米仿生研究所的王婷婷等人[63]在(001)GaAs襯底上生長n型InAs0.81Sb0.19薄膜材料,通過Zn擴散形成p+n結,該平面結構避免了因臺面刻蝕帶來的器件的側壁漏電流,85K工作溫度,-0.1V偏置電壓,器件暗電流為0.01A/cm2,5.5mm處的光譜探測率為5.0×1011cmHz1/2W-1。
2019年,中國科學院半導體研究所張璇等人[64-65]研究了InAsSb薄膜材料的生長及InAs0.91Sb0.09/ AlAs0.08Sb0.92nBn結構中波紅外探測器性能,-0.2V偏壓300K,器件的量子效率為~63.4%,峰值探測率為2.3×109cmHz1/2W-1。
2020年,謝浩博士[66]采用液相外延技術(LPE)制備InAs1-Sb基pBin器件結構室溫中波紅外探測器,=0.06和=0.11兩種Sb組分探測器,室溫下的暗電流密度分別為1.4A/cm2、1.7A/cm2,峰值探測率分別為1.39×109cmHz1/2/W、1.2×109cmHz1/2/W。
2020年,昆明物理研究所鄧功榮等人[67-68]引入AlAsSb/AlSb復合勢壘,成功制備XCBn結構的InAsSb640×512中波紅外焦平面探測器,150K、-0.4V偏置電壓,暗電流密度~3.9×10-6A/cm2,探測器峰值探測率為1.06×1012cmHz1/2W-1,器件結構及熱成像圖如圖7所示[68]。
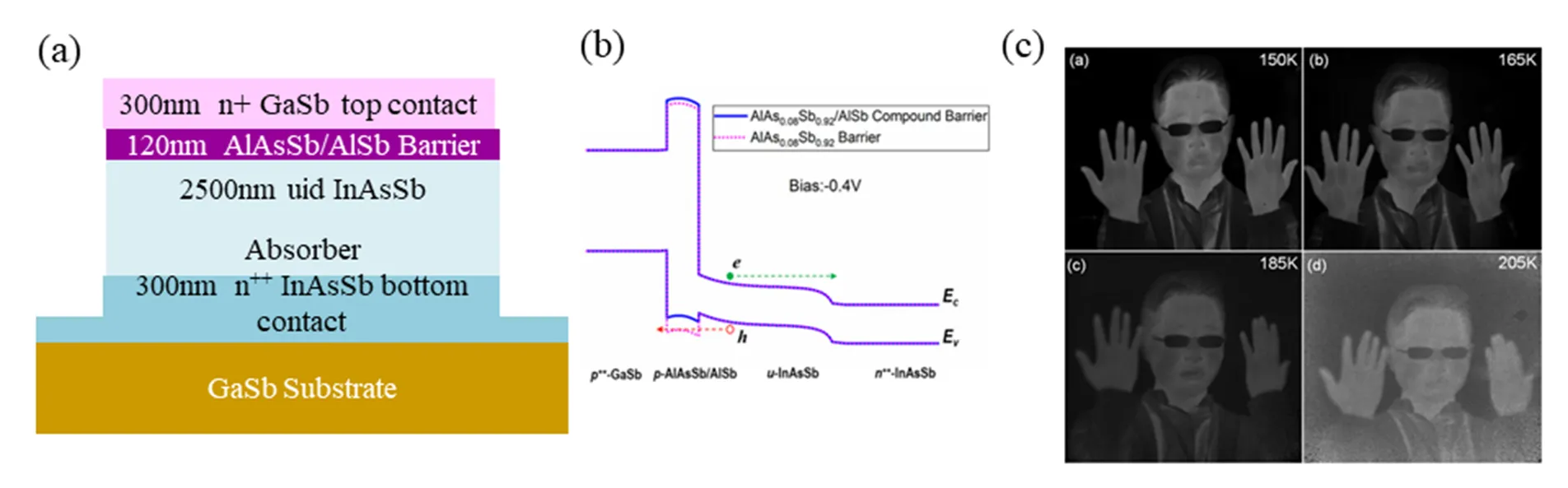
圖7 XCBn結構器件:(a) 器件結構;(b) 仿真得到能帶圖[68];(c) 150-205K焦平面器件熱成像圖[68]
3 總結與展望
綜上所述,本文簡要概述了InAsSb材料的基本性質,表明其是一種具有廣闊應用前景的中長波紅外光電探測材料。InAs0.91Sb0.09材料與GaSb襯底和AlAsSb寬帶隙材料晶格完全匹配,國外以nBn結構為代表的中波高溫工作InAs0.91Sb0.09焦平面陣列技術已經發展成熟并獲得了廣泛的應用;而在國內,InAsSb焦平面陣列的研究起步較晚,還未能實現工程化應用。未來的工作應集中在:一是提升InAsSb外延薄膜材料質量優化器件結構,提高器件性能,進一步提高器件的工作溫度,實現TEC制冷,器件規模向更大焦平面陣列發展。二是繼續探索InAsSb、Ga1-InSb或者Al1-InSb等高質量緩沖層生長方法以消除高Sb組分長波InAs1-Sb薄膜與GaSb襯底之間的晶格失配,使光譜響應范圍向長波范圍拓展。深入研究InAsSb材料及新型結構器件的物理特性,對推進InAsSb焦平面探測器的發展具有重要作用。
[1] Wooley J C, Smith B A. Solid solution in III-V compounds[C]//, 1958, 72: 214-223.
[2] Wooley J C, Warner J. Preparation of InAs-InSb Alloys[J]., 1964, 111: 1142-1145.
[3] Wooley J C, Warner J. Optical energy-cap variation in InAs-InSb alloys[J]., 1964, 42: 1879-1885.
[4] Joel M Fastenau, Dmitri Lubyshev, QIU Yueming, et al. Sb-based IR photodetector epi wafers on 100 mm GaSb substrates manufactured by MBE[J]., 2013, 59: 158-162.
[5] Denghy H Y, Hong X K, Fag W Z, et al. Microstructure characterization of InAs0.93Sb0.07films grown by ramp-cooled liquid phase epitaxy[J]., 2007, 58(3): 307-311.
[6] Tian Z B, Schuler-Sandy T, Godoy S E, et al. High-operating-temperature MWIR detectors using type II superlattices[C]//, 2013, 8867: 88670S.
[7] Manijeh Razeghi, Siamak Abdollahi Pour, Edward Huang, et al. High operating temperature MWIR photon detectors based on type II InAs/GaSb superlattice[C]//, 2011, 8012: 80122Q.
[8] Smith S N, Phillips C C, Thomas R H, et al. Interband magneto-optics of InAs1-xSbSemicond[J]., 1992(7): 900-906.
[9] Balenky G, Donetsky D, Kipshidze G, et al. Properties of unrelaxed InAs1-xSballoys grown on compositionally graded buffers[J]., 2011, 99(14): 141116.
[10] Webster P T, Riordan N A, LIU S, et al. Measurement of InAsSb bandgap energy and InAs/InAsSb band edge positions using spectroscopic ellipsometry and photoluminescence spectroscopy[J]., 2015, 118(24): 245706.
[11] Suchalkin S, Ludwig J, Belenky G, et al. Electronic properties of unstrained unrelaxed narrow gap InAsSb1?xalloys[J]., 2016, 49(10): 105101.
[12] Osbourn G C. InAsSb strained-layer superlattices for long wavelength detector applications[J]., 1984, B2(2): 176-178.
[13] FANG Z M, MA K Y, JAW D H, et al. Photoluminescence of InSb, InAs, and InAsSb grown by organometallic vapor phase epitaxy[J]., 1990, 67: 7034.
[14] Svensson S P, Sarney W L, Hier H. Band gap of InAs1?xSbwith native lattice constant[J]., 2012, B86: 245205.
[15] Wieder H H, Clawson A R. Photo-electronic properties of InAs0.07Sb0.93films[J]., 1973, 15: 217-221.
[16] Thompson A G, Woolley J C. Energy-gap variation in mixed III-V alloys[J]., 1967, 45(2): 255-261.
[17] Ravindra N M, Srivastava V K. Temperature dependence of the energy gap in semiconductors[J]., 1979, 40: 791-793.
[18] LIN Youxi, WANG Ding, Donetsky Dmitry, et al. Conduction-and valence-band energies in bulk InAs1?xSband type II InAs1?xSb/InAs strained-layer superlattices[J]., 2013, 42(5): 1-9.
[19] Alexander Soibel, Cory J Hill, Sam A Keo, et al. Room temperature performance of mid-wavelength infrared InAsSb nBn detectors[J]., 2014, 105(2): 023512.
[20] Craig A P, Thompson M D, Tian Z-B, et al. InAsSb-based nBn photodetectors: lattice mismatched growth on GaAs and low frequency noise performance[J].., 2015, 30: 105011.
[21] Jen H R, Ma K Y, Stringefellow G B. Long range order in InAsSb[J]., 1989, 54: 1154-1159.
[22] Stradling R A. InSb-based materials for detectors[J].., 1991, 6: C52-55.
[23] Kurtz S R, Dawson L D, Biefekl R M, et al. Ordering-induced band-gap reduction in InAs1?xSb(≈0.4) alloys and superlattices[J]., 1992, 46(3): 1909-1912.
[24] Su-Huai, Alex Zunger. InAsSb/InAs: A type-I or a type-II band alignment[J]., 1995, 52: 12039-12044.
[25] Elizabeth H Steenbergen, Oray O Cellek, Dmitri Lubyshev, et al. Study of the valence band offsets between InAs and InAs1?xSballoys[C]//, 2012, 8268: 82680K.
[26] Webster P T, LIU S, Steenbergen E H, et al. Absorption properties of type-II InAs/InAsSb superlattices measured by spectroscopic ellipsometry[J]., 2015, 106(6): 061907.
[27] Rogalski A, Jozwikowski K. Intrinsic carrier concentration and effective mass in InAs1?xSb[J]., 1989, 29(1): 35-42.
[28] Safa Kasap, Peter Capper.[M]. 2nd: Springer International Publishing: New York, USA, 2017.
[29] Egan R J, Chin V W L, Tansley T L. Dislocation scattering effects on electron mobility in InAsSb[J]., 1994, 75(5): 2473-2476.
[30] Dixit V K, Bansal B, Venkataraman V, et al. Structural, optical and electrical properties of bulk single crystals of InAs1?xSbgrown by rotatory Bridgman method[J]., 2002, 81(9): 1630-1632.
[31] YEN M Y. Molecular-beam epitaxial growth and electrical properties of lattice mismatched InAs1?xSbon (100) GaAs[J]., 1988, 64(6): 3306-3309.
[32] Chyi J H, Kalem S, Kumar N S, et al. Growth of InSb and InAs1?xSbon GaAs by molecular beam epitaxy[J]., 1988, 53(12): 1092-1094.
[33] Tsukamoto S, Bhattacharya P, Chen Y C, et al. Transport properties of InAsSb1?x(0≤≤0.55) on InP grown by molecular-beam epitaxy[J].., 1990, 67(11): 6819-6822.
[34] Yoram Karni, Eran Avnon, Michael Ben Ezra, et al. Large format 15mm pitch XBn detector[C]//, 9070: 90701F.
[35] D’Souza A I, Robinson E, Ionescu A C, et al. InAsSb detector & FPA data and analysis[C]//, 2014, 9100: 91000B.
[36] David Z Ting, Sam A Keo, John K Liu, et al. Barrier infrared detector research at the jet propulsion laboratory[C]//, 2012, 8511: 851104.
[37] Alexander Soibel, Cory J Hill, Sam A Keo, et al. Room temperature performance of mid-wavelength infrared InAsSb nBn detectors[J]., 2015, 70: 121-124.
[38] Emilia Gomó?ka, Ma?gorzata Kopytko, Olga Markowska, et al.Electrical and optical performance of midwave infrared InAsSb heterostructure detectors[J].., 2018, 57(2): 027107.
[39] Kubiszyn ?, Michalczewskib K, Benyahiab D, et al. High operating temperature LWIR and VLWIR InAs1?xSboptically immersed photodetectors grown on GaAs substrates[J]., 2018, 97: 116-122.
[40] DING Wang, Dmitry Donetsky, Gela Kipshidze, et al. Metamorphic InAsSb-based barrier photodetectors for the long wave infrared region[J]., 2013, 103: 0511201-05112013.
[41] TONG Jinchao, Landobasa Y M Tobing , LI Qian, et al. InAs0.9Sb0.1-based hetero-p-i-n structure grown on GaSb with high mid-infrared photodetection performance at room temperature[J].., 2018, 53: 13010-13017.
[42] Bubulac L O, Andrews A M, Gertner E R, et al. Backside-illuminated InAsSb/GaSb broadband detectors[J]., 1980, 36(9): 734-736.
[43] Kim J D, Mohseni H, Wojkowski J S, et al. Growth of InAsSb alloys on GaAs and Si substrate for uncooled infrared photodetector applications [C]//, 1999, 3629: 338-344.
[44] Chakrabarti P, Krier A, HUANG X L, et al. Fabrication and characterization of an InAs0.96Sb0.04photodetector for MIR application[J]., 2004, 25(5): 283-285.
[45] TONG Jinchao, Landobasa Y M Tobing, NI Peinan, et al. High quality InAsSb-based heterostructure n-i-p mid-wavelength infrared photodiode[J]., 2018, 427: 605-608.
[46] Maimon S, Wicks G W. nBn detector, an infrared detector with reduced dark current and higher operating temperature[J]., 2006, 89(15): 151109.
[47] Klipstein P, Klin O, Seve G, et al. MWIR InAsSb XBn detectors for high operating temperatures[C]/XXXVI, 2008, 7660: 76602Y.
[48] Klipstein P,Klin O, Seve G, et al. XBn barrier detectors for high operating temperatures[C]/VII, 2010, 7608: 7608-65.
[49] Alexander Soibel, Cory J Hill, Sam A Keo, et al. Room temperature performance of mid-wavelength infrared InAsSb nBn detectors[J]., 2015, 70: 121-124.
[50] Ionescu A C, Salcido M, T J de Lyon, et al. InAsSb detectors for visible to MWIR high operating temperature applications[C]//, 2011, 8012: 80122S.
[51] Martyniuk P, Antoni R. Theoretical investigation of propertiesof InAsSb mid-wave infrareddetectors[C]//, 2018, 10830: 108300U.
[52] Martyniuk P, Antoni R. Modeling of InAsSb/AlAsSb nBn HOT detector's performance limit[C]//, 2013,8704: 87041X.
[53] LIN Youxi, Donetsky Dmitry, WANG Ding, et al. Development of bulk InAsSb alloy and barrier heterostryctures for long-wave infrared detectors[J]., 2015, 44(10): 3360-3366.
[54] Gregory Belenky, WANG Ding, LIN Youxi, et al. Metamorphic InAsSb/AlInAsSb heterostructures for optoelectronic applications[J]., 2013, 102: 1111081.
[55] WANG Ding, Donestsky Dmitry, Kipshidze Gela, et al. Metamorphic InAsSb-based barrier photodetectors for the long wave infrared region[J]., 2013, 103: 0511201-0511203.
[56] Kubiszyn ?, Michalczewski K, Benyahia D, et al. High operation temperature LWIR and VLWIR InAs1-xSboptically immersed photodetectors grown on GaAs substrate[J]., 2018, 12(25): 1-9.
[57] Vinita Dahiya, Julia I Deitz, David A. Hollingshead, et al. Investigation of digital alloyed AlInSb metamorphic buffers[J].,:,,,, 2018, 36: 02D1111-02D1117.
[58] Klipstein P C, Gross Y, Aronov D, et al. Low SWaP MWIR detector based on XBn focal plane array[C]//, 2013, 8704: 87041S.
[59] 高玉竹, 龔秀英. 室溫InAsSb長波紅外探測器的研制[J]. 光電子激光, 2010, 21(12): 1751-1754.
GAO Yuzu, GONG Xiuying, WU Guanghui, et al. Fabrication of room temperature InAsSb infrared detector with long-wavelength[J]., 2010, 21(12): 1751-1754.
[60] SUN Changhong, HU Shuhong, WANG Qiwei, et al. Single crystalline InAsSb grown on (100) InSb substrate by liquid phase epitaxy[C]//,2012, 8419: 1-5.
[61] 黃亮. 基于In、As、Ga、Sb的新型紅外探測材料及器件的光譜研究[D]. 上海: 中國科學院上海技術物理研究所, 2014.
HUANG Liang. Spectroscopic Research of New Infrared DetectionMaterials and Devices Based on In, As, Ga, Sb[D]. Shanghai: Shanghai Institute of Technical Physics, Chinese Academy of Sciences, 2014.
[62] 寧振動. 銻化物紅外探測材料的MOCVD生長及光電性能研究[D]. 哈爾濱: 哈爾濱工業大學, 2016.
NING Zhendong. Research on MOCVD Growth and Opto-electric Characterization of Antimonide Infrared Detection Materials[D]. Harbin: Harbin Institute of Technology, 2016.
[63] WANG Tingting, XIONG Min, ZHAO Yingchun, et al. Planar mid-infrared InAsSb photodetector grown on GaAs substrate by MOCVD[J]., 2019, 12: 122009.
[64] REN Yang, HAO Ruiting, LIU Sijia, et al. High Lattice match growth of InAsSb based materials by molecular beam epitaxy[J].., 2016, 33(12): 1281021-1281023.
[65] ZHANG Xuan, JIA Qingxuan, SUN Ju, et al. High-performance mid-wavelength infrared detectors based on InAsSb nBn design[J]., 2020, 29(6): 0685011-0685014.
[66] 謝浩. InAsSb中波室溫紅外探測器材料的LPE生長及其器件[D]. 上海: 中國科學院上海技術物理研究所, 2020.
XIE Hao. LPE Growth and Device Fabrication of InAsSb Medium Wave Infrared Detector at Room Temperature[D]. Shanghai: Shanghai Institute of Technical Physics, Chinese Academy of Sciences, 2020.
[67] DENG Gongrong, YANG Wenyun, ZHAO Peng, et al. High operating temperature InAsSb-based mid-infrared focal plane array with a band-aligned compound barrier[J]., 2020, 113: 031104.
[68] DENG Gongrong, YANG Wenyun, GONG Xiaoxia, et al. High-performance uncooled InAsSb-based pCBn mid-infrared photo-detectors[J]., 2020, 105: 1032601-1032605.
Research Progress of InAsSb Infrared Detectors
CHEN Dongqiong,YANG Wenyun,DENG Gongrong,GONG Xiaoxia,FAN Mingguo,XIAO Tingting,SHANG Falan,YU Ruiyun
(,650223,)
The cut-off wavelength of the spectral responses of the III–V semiconductor alloys InAs1-xSbcan be changed from 3 to 12μm by tuning the relative amount of antimony in the alloy at room temperature. In addition, with longer carrier lifetime, higher optical absorption coefficient and higher carrier mobility can be achieved. InAsSb is a type of prospective MWIR and LWIR detector material that has potential applications. InAsSb detector can work at 150K even at near room temperature with higher sensitivity and detectivity. Hence, it is one of the best choices for low-power, miniaturized, low-cost, highly sensitive, and fast-response MWIR and LWIR detection systems. InAsSb detectors have been widely studied and developed. In this paper, the fundamental material properties are described. Next, the status of the InAsSb infrared photodetectors domestic and abroad is introduced.Finally, the development of the InAsSb infrared detection technology is summarized and prospected.
infrared photodetector, InAsSb, high operation temperature
TN216
A
1001-8891(2022)10-1009-09
2021-01-22;
2021-06-16.
陳冬瓊(1989-),女,博士研究生,研究方向是光電材料與器件。E-mail: dqchensci@163.com。
楊文運(1968-),男,研高工,研究方向是光電材料與器件。E-mail:yangwenyun@olied.com。
云南省中青年學術和技術帶頭人后備人才項目(202205AC160054)。

