砷化鎵熱氧化法制備β-Ga2O3體塊薄膜
刁肇悌,陳 威,董 鑫,焦 騰,李政達
(吉林大學電子科學與工程學院集成光電子學國家重點聯合實驗室,吉林長春 130012)
1 引 言
作為第三代半導體材料,氧化鎵(Ga2O3)近年來得到了業界廣泛的關注。與傳統半導體相比,Ga2O3具有諸多優勢。β-Ga2O3禁帶寬度很大,為4.9 eV[1-3],Ga2O3的擊穿場強理論值為8 MV/cm[4],巴 利 伽 優 值(εμEb3)為3 444[5]。以 上 特 點 使 得Ga2O3在高壓功率器件的制備方面極具優勢。另外,Ga2O3納米結構薄膜具有更大的比表面積與亞尺度效應,在光電和氣體傳感方面也表現出明顯的優勢[6]。目前納米結構β-Ga2O3薄膜制備方法較多,常見的方法主要有水熱法[7]、金屬有機化學氣相 沉 積(MOCVD)[8-9]、熱 氧 化 法[10-12]、MBE[13]法 和CVD[14]法等。目前的報道中,納米線結構的β-Ga2O3制備工藝復雜、成本高,且未完全氧化的β-Ga2O3薄膜與襯底材料間仍存在較大的晶格失配,易與襯底產生分層,晶體質量差[15-17]。與之相比,熱氧化法制備β-Ga2O3體塊薄膜工藝簡單、成本較低,且完全氧化的β-Ga2O3體塊薄膜具有納米島狀形貌,具有更高的晶體質量。本實驗以p-GaAs 單晶為襯底,利用高溫熱氧化工藝將襯底完全氧化為β-Ga2O3體塊薄膜,并總結了β-Ga2O3體塊薄膜的生長機理,探討了氧化過程中O2流量等對β-Ga2O3薄膜的晶體結構等特性的影響。該方法為制備β-Ga2O3材料提供了一種新思路,并為制備Ga2O3基器件提供了更多選擇。
2 實 驗
2.1 樣品制備
本文以(100)晶向的p 型GaAs 晶片為襯底,采用高溫熱氧化法制備β-Ga2O3體塊薄膜。由于GaAs 是一種在高溫下不穩定的半導體材料,根據Langmuir 蒸發效應,當溫度超過600 ℃時,GaAs 晶格開始分解后,As 原子會從襯底表面優先析出[18]。同時,O 原子會根據濃度梯度取代As 原子,在高溫下遷移到穩定的位置,與Ga 原子結合成β-Ga2O3分子。
實驗設備采用水平管式快速退火爐(KJMTI, OTF 1200X-4-RTP)。采用高純O2(5N)作為氧源,高純N2(5N)作為載氣。實驗操作過程如下:(1)依次用丙酮、乙醇、去離子水清潔GaAs 襯底(清洗時間5 min),并用N2吹干,去除襯底表面雜質;(2)將GaAs 襯底置于水平管式退火爐中,用N2對反應腔進行洗氣,重復三次,將腔內剩余氧氣排出;(3)分別在0.2,0.4,0.6,0.8 L/min 的O2流速下,將GaAs 襯底加熱到900 ℃,然后高溫氧化30 min。樣品分別命名為a、b、c、d。
2.2 樣品表征
我們對制得的β-Ga2O3薄膜進行了測試與表征。采用掃描電子顯微鏡(SEM,JOEL,JSM-7610)研究樣品表面形貌;使用光學顯微鏡(BX53M,OLMPUS)觀測樣品截面形貌;利用共聚焦顯微拉曼光譜儀(Raman,LabRAM HR Evolution,Horiba)測定樣品的晶體結構;使用X 射線衍射儀(XRD,SmartLabSE, Rigaku)測定β-Ga2O3薄膜的晶體質量;通過PL 光譜儀(Horiba iHR550)分析樣品的光學特性。
3 結果與討論
3.1 表面形貌與生長機理
為了分析樣品的表面微觀形貌,我們對樣品a~d 進行掃描電子顯微鏡測試,測試結果如圖1 所示。可以發現,當O2流速為0.2 L/min 時,樣品表面存在較多的Ga2O3納米線(圖1(a)),納米線直徑約為75 nm,長度范圍為0.1 ~1.4 μm。當O2流速超過0.4 L/min 時,Ga2O3主要以納米島狀形式生長,極少部分以較短的納米線或納米顆粒形式生長。β-Ga2O3納米線的生長機理為氣-液-固(VLS)模式[19]。在低氧氣氛下,反應速率較慢,樣品表面存在大量的Ga 液滴,與O 原子緩慢結合,有助于形成一維納米材料。在高氧氣氛下,大量O 原子迅速與Ga 液滴反應,生成Ga2O3體塊薄膜,剩余極少數Ga 液滴與O 原子結合,形成Ga2O3納米線或納米顆粒。當O2流速升高至0.8 L/min 時,島狀結構增多,高度升高,表面缺陷增多。這表明在高氧氣濃度下,O 原子與Ga 原子反應劇烈,造成表面粗糙度增大。

圖1 (a)~(d)β-Ga2O3樣品的SEM 照片Fig.1 (a)-(d)SEM images of β-Ga2O3 sample
在0.8 L/min 的氧氣流速、900 ℃的溫度下,將GaAs 襯底分別氧化5,10,20,30 min,使用光學顯微鏡對Ga2O3斷面進行表征,探討了Ga2O3厚度隨氧化時間的變化。圖2(a)~(e)為不同氧化時間的樣品斷面顯微照片,圖2(f)為樣品氧化過程示意圖。從圖2(a)~(b)中可以看出,當氧化時間較短時,樣品斷面光滑,明亮部分為GaAs,圖2(b)中較暗部分為Ga2O3。從圖2(c)~(e)中可以看出,當氧化時間較長時,樣品斷面粗糙,其中明亮部分為Ga2O3,較暗部分為GaAs。測試結果表明,熱氧化反應呈現滲透與擴散的過程,GaAs 正面首先開始氧化,隨著氧化時間的延長,與氧氣接觸較少的背面也逐漸開始與O2反應,生成Ga2O3;氧化時間達到30 min 時,GaAs 完全被氧化為Ga2O3,厚度為425 μm。
根據Langmuir 理論,當氧化溫度高于600 ℃時,As 會優先蒸發,而在GaAs 表面留下Ga[20]。如圖2(f)插圖所示,在900 ℃、壓強133 Pa(1 Torr)下低氧退火30 min 的樣品表面產生了大量的Ga 液滴。驗證熱氧化過程與Langmuir 蒸發有關。另外,從樣品表面的痕跡可以得出,GaAs 表面連續分解生成的Ga 原子是聚集的,并表現出特定的趨向性。
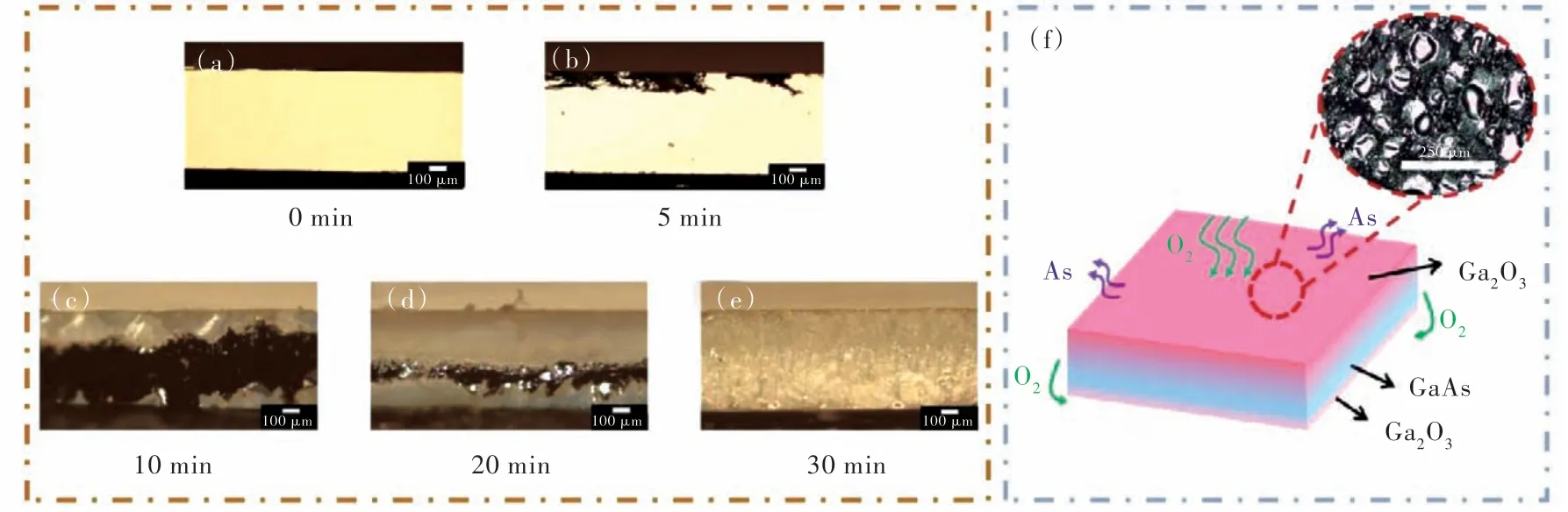
圖2 (a)~(e)不同氧化時間的樣品斷面顯微照片;(f)樣品氧化過程示意圖。Fig.2 (a)-(e)Micrographs of sample sections at different oxidation time.(f)Schematic diagram of sample oxidation process.
3.2 X 射線衍射結果
圖3為樣品a~d 的X 射線衍射圖譜。從圖中可以看出,當O2流速為0.2 L/min 時,樣品a 存在4個衍射峰。其中,位于29.6°、42.6°、45.3°的衍射峰分別對應β-Ga2O3的(400)、(311)以及(-312)晶面(JCPDS,No. 76-0573)。此外,樣品a 存在位于65.6°的屬于GaAs 的衍射峰,說明在低氧氣氛下,O 原子濃度較低、反應速率較慢,短時間內O 原子無法取代全部的As 原子,存在一定的GaAs 殘留。而樣品b~d 只存在β-Ga2O3對應的3 個衍射峰,說明當O2流速大于0.4 L/min 時,GaAs 被全部氧化為β-Ga2O3;另外,晶面取向少說明熱氧化法將含鎵襯底直接轉化為β-Ga2O3,結晶質量高。當O2流速由0.4 L/min 提高到0.6 L/min 時,β-Ga2O3各晶面的衍射峰強度明顯升高,晶體質量顯著增強。這表明在0.4 L/min 的O2流速下,GaAs 雖然被全部轉化為β-Ga2O3,但由于O2濃度較低,結晶質量較差。當O2流速提高到0.6 L/min 時,各晶面生長速度加快,使得一些較弱的衍射峰強度迅速增強。當O2流速為0.8 L/min 時,(400)晶面的衍射峰增強,而(311)以及(-312)晶面的衍射峰強度降低。GaAs 在熱氧化的過程中,As 原子被O 原子取代形成Ga2O3,因此Ga2O3應該與GaAs 有著最小的晶格失配。β-Ga2O3在(400)晶向上的氧原子密度很高,排列呈近似的菱形或方形,這種排列與GaAs中的Ga 原子排列相對應[20]。在氧化過程中,O 原子與GaAs 表面的Ga 立方體成鍵,形成Ga2O3。因此,在(100)GaAs 上生長的β-Ga2O3的優選取向合理為(400)。此時(400)晶面的擇優生長一定程度上削弱了其他晶面的生長。
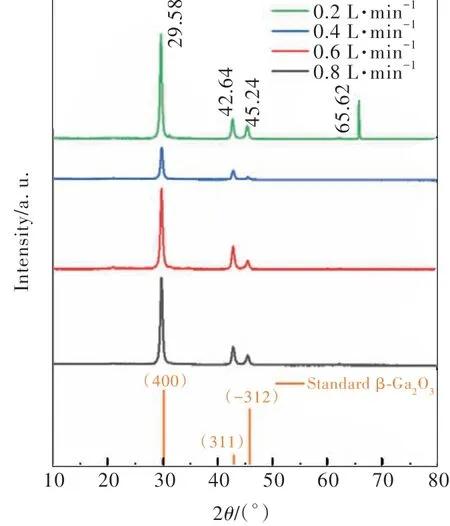
圖3 β-Ga2O3薄膜的XRD 測試圖Fig.3 XRD test image of β-Ga2O3 films
3.3 拉曼光譜
為了進一步分析β-Ga2O3納米體塊薄膜的結構特性,將樣品a ~d 進行拉曼光譜測試,結果如圖4 所示。從圖中可以看出,樣品a ~d 的拉曼振動峰全部由β-Ga2O3產生。將實驗中得到的拉曼模頻率與標準的β-Ga2O3、標準的GaAs 拉曼模相比 較,結 果 如 表1、2 所 示。位 于113.1,144.2,169.7,200.5 cm-1位置處的振動峰分別對應低頻模Bg(1)、Bg(2)、Ag(2)、Ag(3),位于321.1,346.2,417.2,477.2 cm-1位置處的振動峰對應中頻模Ag(4)、Ag(5)、Ag(6)、Ag(7),位 于632.2,651.2,658.0,767.5 cm-1位 置 處 的 振 動 峰 對 應 高 頻 模Ag(8)、Bg(5)、Ag(9)、Ag(10)[21-23]。氧 氣 流 速 為0.2 L/min 時,樣 品a 未 見GaAs 特征峰,這是由于測試取得信號位于光斑聚焦點所在薄層微區,可以觀測樣品同一層面內不同微區的拉曼光譜信號[24];另外,樣品a 納米結構表面強散射激發的表面增強拉曼散射效應也具有放大樣品表面的拉曼信號的現象[25]。當O2流速由0.4 L/min 提 高 到0.8 L/min 時,β-Ga2O3各拉 曼 振動峰強度增大,特別是低頻模200.5 cm-1位置處的振動峰強度明顯增強,與四面體-八面體鏈的釋放和平移程度有關[26]。表明O2濃度的增加改善了β-Ga2O3體塊薄膜的排列結構。同時,隨著O2濃度的增加,樣品的拉曼振動峰峰位偏移較小,與β-Ga2O3標準拉曼模頻率相吻合,表明樣品的應變較小, 晶體質量高。拉曼測試結果進一步驗證了所制備的樣品為β 晶相氧化鎵體塊薄膜。
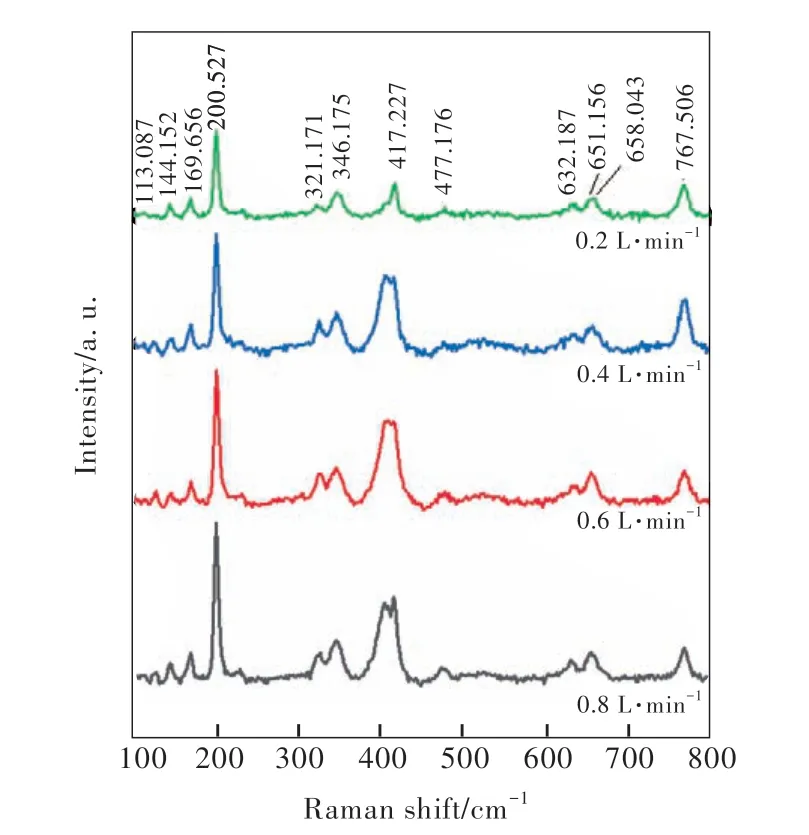
圖4 β-Ga2O3薄膜的拉曼位移測試圖Fig.4 Raman shift test image of β-Ga2O3 films

表1 標準的β-Ga2O3拉曼模頻率與實驗中得到的拉曼模頻率比較Tab.1 Comparison of the standard β-Ga2O3 Raman mode frequencies with those obtained from experiment

表2 標準的GaAs 拉曼模頻率Tab.2 Standard GaAs Raman mode frequencies
3.4 光致發光性能
圖5為在波長為235 nm 的激光激發下樣品的光致發光譜。從圖中可以看出,樣品a ~d 在紫外光波段和藍光波段均有明顯的發光峰。位于357 nm 處的紫外發光峰由β-Ga2O3自陷激子復合產生[27],位于410 nm 處的藍光發光峰由β-Ga2O3內施主-受主對復合產生[28]。O2流速為0.2 L/min 時,樣品的發光峰較弱,且藍光發光強度高于紫外發光,表明晶體質量差,具有更多的藍光發射相關的缺陷能級。當O2流速從0.2 L/min 提高到0.4 L/min時,光致發光峰強度增大,說明作為陷阱中心的O空位濃度降低,缺陷導致的非輻射復合低,晶體質量高。另外,β-Ga2O3的生長模式從納米線生長轉變為納米島生長,界面態密度降低,抑制了光生載流子的散射,發光峰強度增強,即β-Ga2O3納米島薄膜相對于β-Ga2O3納米線薄膜具有更低的光生載流子的散射與陷阱中心濃度。當O2流速從0.4 L/min 提高到0.8 L/min 時,紫外發光峰強度沒有明顯變化,藍光發光峰強度逐漸降低,此時外界環境中氧分壓較高,抑制了薄膜中O 原子的溢出[29],降低了β-Ga2O3中作為施主的氧空位濃度,施主-受主對復合減少,從而抑制了藍光發射。O2流速為0.8 L/min 時,樣品的藍光發射峰藍移可能與過量氧氣引起的新缺陷態的輻射復合有關。
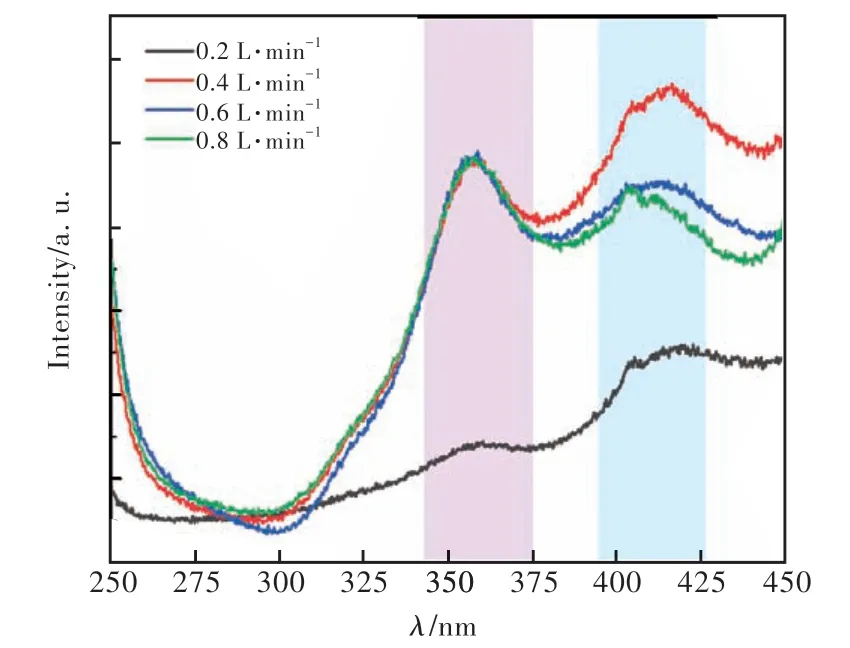
圖5 β-Ga2O3薄膜的PL 測試圖Fig.5 PL test image of β-Ga2O3 films
4 結 論
我們利用p 型GaAs 單晶襯底的熱氧化法制備了納米島狀的β-Ga2O3體塊薄膜。其反應過程與Langmuir 蒸發有關:當溫度超過600 ℃時,As 原子從襯底表面優先析出,O 原子順濃度梯度取代As 原子,在高溫下遷移到穩定的位置,與Ga 原子結合成β-Ga2O3。探討了O2流速對β-Ga2O3體塊薄膜晶體質量的影響。實驗發現,當O2流速為0.2 L/min 時,GaAs 不能被完全氧化,所制備的β-Ga2O3表面呈現為納米線狀結構,薄膜質量較差。當O2流速超過0.4 L/min 時,GaAs 被完全氧化為納米島狀的β-Ga2O3體塊薄膜,薄膜質量得到改善。Raman 測試發現,隨著O2濃度增加,出現了新的振動峰,且振動峰強度逐漸增強,β-Ga2O3體塊薄膜的排列結構得到改善。通過XRD 測試發現,所制備的β-Ga2O3是以(400)晶面優先取向的多晶薄膜,隨著O2濃度增加,各晶面衍射峰強度增大。Raman 和XRD 測試結果進一步驗證了所制備的樣品為β 晶相氧化鎵體塊薄膜。在235 nm波長激光激發下,在357 nm 和410 nm 處出現光致發光峰,且410 nm 處的藍光發光峰強度隨O2流速增大而降低。本文提出的熱氧化法制備β-Ga2O3可以高效、低成本地獲得較高結晶質量的β-Ga2O3體塊薄膜,為制備納米結構β-Ga2O3提供了一種新思路。
本文專家審稿意見及作者回復內容的下載地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20210399.

