高純四氟化硅中金屬雜質及硫化氫的測定研究
栗廣奉,許勝霞,鄭安雄
(浙江中寧硅業有限公司,浙江 衢州 324000)
高純四氟化硅(SiF4)氣體是電子、半導體集成電路行業的重要原料之一,因具有較高的氟硅比而被廣泛應用于半導體、太陽能電池和光纖等領域。另外,可用于等離子刻蝕、硅的外延生長、非晶硅膜生長及化學氣相沉積等。在半導體材料及器件的制備過程中,需要使用高純度SiF4 的氣體,但其中仍存在各種金屬雜質和氣體雜質[1]。當高純氣體中微量金屬雜質容易被吸收,會增加半導體器件表面的金屬離子含量,嚴重影響半導體器件的性能和產率[2];另外,還容易造成硅片的電學性質惡化、降低載流子遷移率和使用壽命[3]。高純度SiF4氣體中主要氣體雜質有H2、O2、N2、CO、CO2、HF、H2S及烴類等各種氣體雜質,對半導體材料性能有影響。目前對于高純SiF4 氣體中雜質的檢測及純化技術的研究,已有相關報道[4-5]。
文獻報道的高純四氟化硅氣體中金屬雜質的常見測定方法有原子吸收光譜法(AAS)、電感耦合等離子體原子發射光譜法(ICP-AES)。BULANOV 等對四氟化硅氣體中的非揮發性雜質進行預濃縮處理,然后用ICP-AES 進行檢測分析,共測得15種金屬雜質[6]。ICP-AES具有低檢出限、穩定性和靈敏度高、工作曲線范圍寬、有效消除自吸現象、無電極放電和污染等優點;但是儀器昂貴,操作成本高。
高純四氟化硅氣體中氣體雜質的檢測方法主要有氣相色譜法、高/低分辨率傅里葉紅外光譜法、質譜法及微波波普法。氣相色譜法主要用于檢測CH4、C2H6、C2H4和C3H8等雜質,針對低分子化合物及不穩定易揮發的化合物,具有低成本、高選擇性及高靈敏度等優點。VAKS等利用氣相色譜在SiF4氣體中檢測到了CH2F2、C2H6、CF4和CH3F 等雜質[7]。質譜法主要用于檢測雜質Si2F6O、Si3F8O2、Si2F5HO、SiF3H、SiF2H2等雜質,REENTS 等利用樣品器直接向質譜儀中注入SiF4氣體進行檢測,發現SiF4氣體樣品在質譜儀中發生電離,進而檢測到雜質SiF3H[8]。紅外光譜法主要用于檢測Si2F6O、CO2、SF6、SiF3H、HCl等雜質,針對四氟化硅氣體中硫化氫雜質的檢測方法的研究未見相關文獻報道。
因此本文針對高純四氟化硅中金屬雜質的電感耦合等離子質譜儀(ICP-MS)檢測方法和硫化氫雜質的離子色譜(IC)檢測法進行研究。
1 實驗部分
1.1 儀器及試劑
1) 金屬雜質測定用。ICP-MS,安捷倫7700s;重金屬混標溶液,質量濃度10 mg/L:Multi-element Calibratoin Standad 2,質量分數5%HNO3;PFA 瓶:100 mL;超純水:電阻率不小于18.2 MΩ·cm。
2)硫化氫測定用。離子色譜儀,瑞士萬通色譜儀930型;電子天平,最小分度0.1 mg;氫氧化鈉,硫化鈉九水化合物,優級純;PFA 瓶:300 mL、100 mL;超純水:電阻率不小于18.2 MΩ·cm。
1.2 實驗方法
1.2.1 金屬雜質含量的測定
1)四氟化硅氣體吸收液收集。首先配置2 個100 mL 的超純水作為吸收液,并稱量m0。再將氬氣瓶(質量分數≥99.999%)和四氟化硅氣體連接,持續1 h,充分置換裝置內的空氣。通四氟化硅氣體到吸收瓶中,在溶液中開始出現絮狀物時,停止四氟化硅氣體的通入,稱量m1,樣品質量m1-m0。
2)四氟化硅氣體吸收液前處理。移取適量(約50 g)的四氟化硅吸收液與鉑皿中,加熱蒸發至2~3 mL后,加入2 mL硝酸,8 mL氫氟酸繼續加熱蒸發至2~3 mL,最后用超純水定容到50 mL容量瓶中,待測。
3)混標溶液的配制(質量濃度500μg/L)。取100 mL 容量瓶,清洗干凈,裝入約50 mL 水,用5 mL的移液槍,分別取不同編號的標液各5 mL于容量瓶內,定容搖勻,此標準溶液質量濃度為500 μg/L。取100 mL PFA 瓶,洗凈,用配好的標準溶液潤洗至少3次,將容量瓶內的標準溶液倒入PFA瓶中,貼上標簽。
4)建立標準曲線。取4 個洗凈并已干燥的100 mL PFA 瓶,分別置于萬分之一天平上稱量,加50 g 的水(精確至0.1 mg),采用標準加入法分別加入質量濃度為500 μg/L 的混標溶液,加入點分別為質量濃度0、0.5、1、2 μg/L,建立曲線,線性要求達到R≥0.998 0,若不滿足,重新建立曲線,直至合格后,測定雜質元素含量。
5)ICP-MS 測試。打開ICP-MS,選擇最佳工作條件,待儀器穩定后,測試水空白檢查儀器及進樣管路無異常,首先開始按順序進行標準溶液的測定,建立標準溶液各元素和質量濃度和強度對應關系的工作曲線。過段時間再檢測水空白檢查儀器及進樣管路無異常,開始進行樣品空白和樣品檢測,測出的待測溶液中各檢測元素的結果。稀釋倍數直接輸入儀器中,結果直接輸出,并記錄結果。
6)結果計算。金屬雜質的質量分數:

式中,ρ和ρ0分別曲線上查得的測試溶液中和空白溶液金屬的質量濃度,V為測定溶液體積,m0為試樣的質量,R為稀釋系數。
1.2.2 硫化氫含量的測定
1)準備工作。吸收液的準備2 個空白吸收液:200 mL 超純水,稱量吸收瓶1 和吸收瓶1+200 mL 超純水的質量;2 個樣品吸收液1:各200 mL超純水,稱量吸收瓶1和吸收瓶1+200 mL超純水的質量。2 個樣品吸收液2:各200 mL 超純水;稱量吸收瓶1 和吸收瓶1+200 mL 超純水的質量。尾氣吸收瓶:質量濃度10 g/L氫氧化鈉溶液。
2)空白的制備。氬氣吹掃PFA管路5 min,體積流量50 mL/min。連接2 個空白吸收液通入氬氣10 min,體積流量50mL/min,取吸收瓶1 上清液10 mL待測。
3)樣品的制備。用氬氣吹掃PFA 管路5 min,體積流量50 mL/min。連接2 個樣品吸收液通入氬氣5 min;再切換為四氟化硅吸收5 min,時搖晃吸收瓶1,確保氣體被吸收瓶1 吸收;最后再切換氬氣吸收5 min。氣體流速均為體積流量50 mL/min。定容到250 mL 容量瓶中。取上清液10 mL,用孔徑為0.22 μm的水相濾膜過濾,待測。
4)測試條件。色譜柱,填料為具有季銨基團的聚苯乙烯/二乙烯基苯共聚物的陰離子色譜柱和陰離子保護柱。淋洗液,100 mmol/L 的NaOH+0.01 mmol/L 的EDTA 的水溶液。體積流量1.0 mL/min,進樣體積100 μL。安培檢測器。
5)標準溶液制備。①配置質量濃度10 g/L 氫氧化鈉水溶液1 L。②配置質量濃度1 g/L Na2S 標準貯備溶液:稱取0.750 0 g Na2S·9H2O 溶于100 mL 質量濃度10 g/L 氫氧化鈉中,貯存于塑料容器中,4 ℃冷藏存放。③移取Na2S 標準貯備溶液用氫氧化鈉稀釋液逐級稀釋,配制Na2S 的質量濃度分別為0.1、0.2、0.4、1、2 μg/L 的標準溶液做標準曲線。質量濃度由低到高依次進樣進行測試,以峰面積為縱坐標,標準溶液中S2-的質量濃度為橫坐標,繪制標準曲線并計算回歸方程。
6)結果計算。四氟化硅中H2S 的質量分數w(H2S):

式中,ρ為儀器測得S2-的質量濃度,m為被吸收的四氟化硅質量,V為四氟化硅定容體積,M(S2-)為S 的相對原子質量,M(H2S)為H2S 的相對分子質量。
2 結果與討論
2.1 S2-標準曲線
圖1為S2-標準曲線。
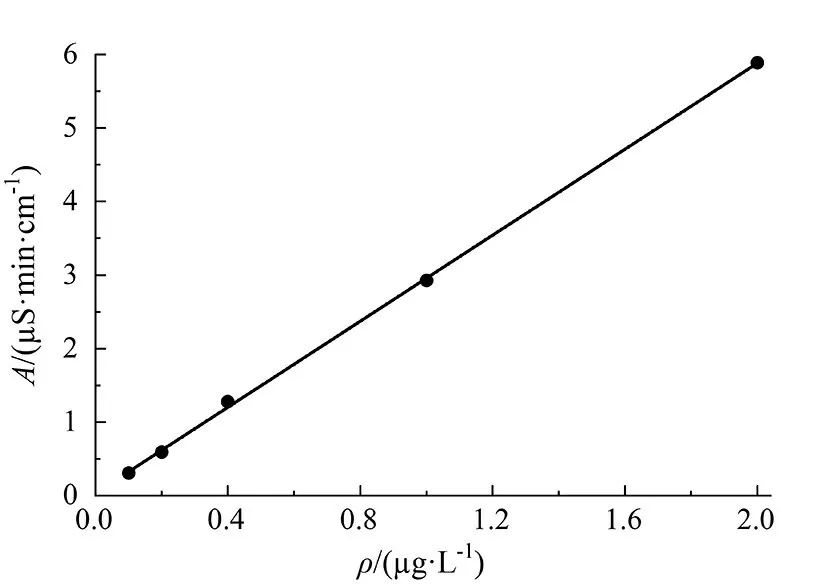
圖1 硫離子標準曲線Fig 1 Standard curve of sulfur ion
由圖1可知,線性擬合方程為A/(μS·min·cm-1)=2.925ρ/(μg·L-1)+0.033 74,相關系數為R2=0.999 6,滿足分析要求。
2.2 金屬雜質
表1和表2分別為金屬離子含量及回收率(加標質量分數均為0.5 ng/g)測定結果。

表1 金屬離子的回收率Tab 1 Experimental results of metal ion recovery
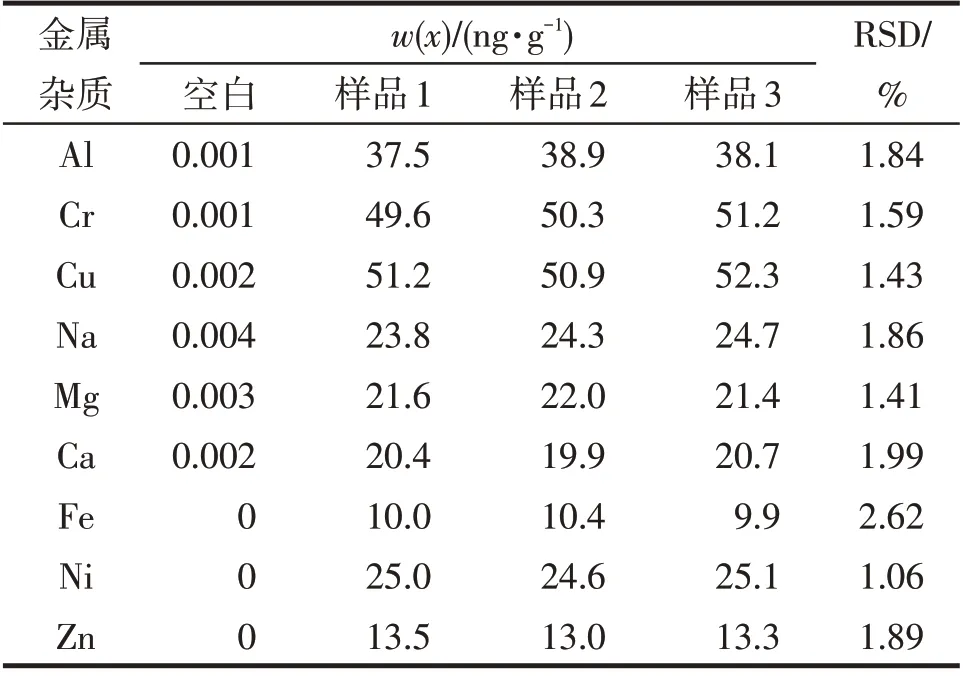
表2 金屬雜質含量Tab 2 Determination results of metal impurity content
由表1和表2可知,金屬離子含量的標準偏差(RSD) 在1.41%~2.62%,回收率在96.46%~100.2%,滿足RSD<3%、回收率在80%~120%的要求,說明儀器和方法的重復性和精密度都比較好,能滿足檢測要求。
2.3 硫化氫
表3和表4分別為硫化氫回收率(加標質量分數均為1 ng/g)和含量測定結果。

表3 硫化氫回收率Tab.3 Experimental results of H2S recovery
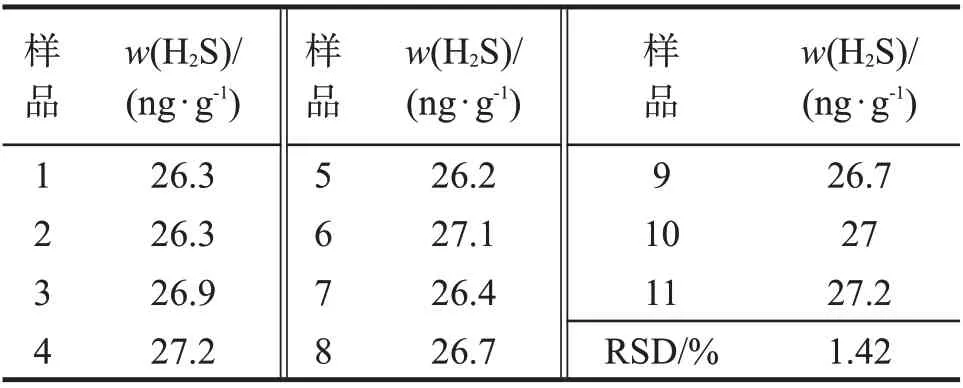
表4 硫化氫相對標準偏差Tab.4 Experimental results of relative standard deviation of H2S
由表3 和表4 可知,H2S 含量的RSD 在1.42%,回收率在93.6%~92.3%,滿足RSD<3%,回收率在80%~120%的要求,說明儀器和方法的重復性和精密度都比較好,能滿足檢測要求。
3 結 論
對高純四氟化硅中金屬雜質采用ICP-MS檢測方法、硫化氫雜質采用離子色譜檢測法進行實驗研究,表明高純四氟化硅中金屬離子含量的RSD在1.41%~2.62%,回收率在96.46%~100.2%;H2S 含量的RSD 在1.42%,回收率在93.6%~92.3%,滿足RSD<3%,回收率在80%~120%的要求。
采用的對高純四氟化硅中金屬雜質和硫化氫雜質的檢測方法具有高精確度、高靈敏度和低成本等優點,為高純四氟化硅的純化工藝研發及產業化提供可靠的工作基礎,可推動高純四氟化硅雜質測定技術。

