新型抑制劑對(duì)銅膜CMP 后碟形坑與蝕坑的影響
李子豪 ,周建偉 ,王辰偉 ,馬慧萍,張?jiān)?/p>
(1.河北工業(yè)大學(xué) 電子信息工程學(xué)院,天津 300130;2.天津市電子材料與器件重點(diǎn)實(shí)驗(yàn)室,天津 300130)
在集成電路(IC)制造中,隨著特征尺寸的不斷縮小,工業(yè)上對(duì)晶圓表面平整度有了更高的要求。化學(xué)機(jī)械平坦化(CMP)是集成電路制造過(guò)程中關(guān)鍵技術(shù)之一,是目前唯一能夠?qū)崿F(xiàn)晶圓局部和全局平坦化的技術(shù)[1-4]。從原理上講,CMP 是化學(xué)反應(yīng)和機(jī)械效應(yīng)通過(guò)協(xié)同作用實(shí)現(xiàn)晶圓最佳平坦化效果的一種拋光技術(shù),在銅互連CMP 過(guò)程中,拋光液的組分是獲得高質(zhì)量晶圓表面的決定性因素[5-8]。銅互連布線本身存在的凹凸結(jié)構(gòu)會(huì)導(dǎo)致CMP 后圖形片表面產(chǎn)生碟形坑、腐蝕坑等缺陷,如圖1 所示。這些缺陷會(huì)對(duì)產(chǎn)品良率造成極大的影響,因此如何解決這些缺陷至關(guān)重要,目前國(guó)際上通常采用在拋光液中加入抑制劑來(lái)解決這一難題[9-11]。
苯并三氮唑(BTA) 是目前應(yīng)用最廣泛的抑制劑,在CMP 過(guò)程中,BTA 能夠與Cu 結(jié)合形成一種吸附膜附著在Cu 表面,使Cu 表面的腐蝕效果大幅減弱[12]。但是,BTA 本身具有毒性,不符合拋光液添加劑環(huán)境友好性的要求;而且Cu-BTA 膜附著力極強(qiáng),在之后的CMP 清洗過(guò)程中很難去除[13]。Hu 等[14]采用了可溶性的TT-LYK 作為抑制劑,但TT-LYK 材料的獲取受進(jìn)口限制,不易獲得[15]。Jiang 等[16]采用電化學(xué)的方法測(cè)試了1,2,4-三氮唑(TAZ) 在銅表面的鈍化特性,通過(guò)對(duì)比1,2,4-三氮唑與苯并三氮唑的鈍化特性參數(shù),發(fā)現(xiàn)其可作為一種可行的CMP 抑制劑。Wang 等[17]采用TAZ 作為抑制劑,但其鈍化能力較弱,對(duì)于平坦化效果不理想。因此本文基于上述抑制劑存在的問(wèn)題提出了一種新型抑制劑,3-巰基-1,2,4-三氮唑(TAT),其易溶于水且符合拋光液添加劑環(huán)境友好性的要求,同時(shí)具有更強(qiáng)的鈍化能力以及更加便捷的獲得途徑,是一種極具潛力的抑制劑。
本文研究了新型抑制劑TAT 在不同pH 值條件下對(duì)Cu 去除速率(RR)和靜態(tài)腐蝕速率(SER)的影響,揭示了抑制劑TAT 濃度和pH 值與Cu 去除速率、靜態(tài)腐蝕速率之間的關(guān)系。其次研究了TAT 對(duì)Cu/Ru/TaN 互連結(jié)構(gòu)圖形片中心、中間、邊緣三個(gè)位置處不同布線寬度/間距(L/S)的碟形坑和蝕坑的控制效果,并對(duì)其控制機(jī)理進(jìn)行了分析。最后通過(guò)X 射線光電子能譜技術(shù)(XPS)驗(yàn)證了TAT 在Cu 膜表面的吸附機(jī)理。
1 實(shí)驗(yàn)
1.1 材料的制備
采用直徑100 mm、初始厚度約1 μm 的銅鍍膜片用于去除速率實(shí)驗(yàn);將銅鍍膜片切割成尺寸為1 cm×1 cm 的正方形樣片,用于靜態(tài)腐蝕和表面狀態(tài)表征實(shí)驗(yàn);直徑為100 mm 的Cu/Ru/TaN 互連結(jié)構(gòu)圖形片用于平坦化實(shí)驗(yàn)及碟形坑與蝕坑的測(cè)試。
本文拋光液組成: 質(zhì)量分?jǐn)?shù)3%的SiO2水溶膠(粒徑約60 nm)作為磨料,質(zhì)量分?jǐn)?shù)2.5%的甘氨酸(Gly)作為絡(luò)合劑,體積分?jǐn)?shù)3%的H2O2作為氧化劑,不同濃度的TAT 作為抑制劑。TAT 的結(jié)構(gòu)示意圖如圖2 所示。

圖2 抑制劑TAT 的分子結(jié)構(gòu)Fig.2 Molecular structure of the inhibitor TAT
1.2 拋光及靜態(tài)腐蝕實(shí)驗(yàn)
拋光實(shí)驗(yàn)采用Universal-300B 型拋光機(jī)(華海清科股份有限公司) 進(jìn)行,拋光墊為美國(guó)陶氏電子材料公司生產(chǎn)的IC1010 型,修整器為美國(guó)3M 公司生產(chǎn)的C4 型。每組拋光實(shí)驗(yàn)開(kāi)始之前修正拋光墊2 min,重復(fù)三次以恢復(fù)拋光狀態(tài),具體拋光工藝參數(shù)見(jiàn)表1。

表1 CMP 工藝參數(shù)Tab.1 Process parameters of the CMP
采用4D Four Point Probe 333A 型四探針測(cè)試儀測(cè)量Cu 鍍膜片的去除速率。該測(cè)試儀在Cu 鍍膜片的直徑上選取81 個(gè)測(cè)試點(diǎn),分別測(cè)量拋光前后Si 襯底表面Cu 膜覆蓋的厚度,并通過(guò)計(jì)算拋光前后各點(diǎn)的差值最終計(jì)算出整體的去除速率。
靜態(tài)腐蝕實(shí)驗(yàn)是將規(guī)格為1 cm×1 cm 的Cu 鍍膜樣片在100 mL 不含磨料的拋光液中充分浸泡1 min,隨后用去離子水沖洗,使其干燥后再用四探針測(cè)試儀測(cè)量其靜態(tài)腐蝕速率。
利用美國(guó)AMBIOS 公司生產(chǎn)的XP-300 臺(tái)階儀測(cè)試Cu/Ru/TaN 互連結(jié)構(gòu)圖形片上碟形坑和蝕坑深度。為了取樣豐富和更具說(shuō)服力,本實(shí)驗(yàn)在晶圓上選擇中心(C)、中間(M)、邊緣(E) 三個(gè)位置進(jìn)行碟形坑和蝕坑的測(cè)試,C/M/E 在晶圓上的位置如圖3 所示。

圖3 碟形坑和蝕坑在圖形片上的測(cè)試位置(測(cè)試點(diǎn)位置從左到右: 中心、中間和邊緣)Fig.3 Measured die locations of dishing and erosion on patterned wafer (Die location left to right:center,middle and edge)
2 結(jié)果與討論
2.1 拋光和靜態(tài)腐蝕實(shí)驗(yàn)
圖4 為在拋光液不同pH 值條件下,TAT 濃度對(duì)Cu 去除速率以及靜態(tài)腐蝕速率的影響。從圖4 可以看出,在pH 值確定時(shí),隨著TAT 濃度的增加,Cu 的去除速率和靜態(tài)腐蝕速率急劇下降。同時(shí),在相同TAT濃度條件下,隨著pH 值的增大,Cu 的去除速率和靜態(tài)腐蝕速率都增大,這說(shuō)明拋光液pH 值的增大能夠減弱TAT 鈍化的效果。因此,想要獲得較好的抑制效果,可以采用較低的拋光液pH 值配合較大濃度的TAT 來(lái)實(shí)現(xiàn)。

圖4 不同pH 值條件下TAT 濃度對(duì)Cu 膜的影響。(a)去除速率;(b)靜態(tài)腐蝕速率Fig.4 Effect of TAT concentration on Cu film under different pH conditions.(a) Removal rate;(b) Static erosion rate
為了能夠在Cu 膜高去除速率條件下獲得較淺的碟形坑和蝕坑深度,需要進(jìn)一步分析所得數(shù)據(jù),從而獲得較優(yōu)的抑制劑配比及拋光液pH 值。從圖4 可以發(fā)現(xiàn),在pH=8 的條件下,采用不添加TAT 的拋光液拋光時(shí),Cu 去除速率為1257 nm/min,靜態(tài)腐蝕速率為261 nm/min,在拋光液中添加質(zhì)量分?jǐn)?shù)為0.1%的TAT 后,Cu 去除速率迅速降低至415 nm/min,靜態(tài)腐蝕速率降至7 nm/min,可見(jiàn)TAT 的加入會(huì)極大地抑制Cu 的去除速率以及靜態(tài)腐蝕速率,但此時(shí)Cu 的去除速率較低,不能符合工業(yè)上粗拋階段對(duì)Cu 膜快速去除的要求;在pH=9 的條件下,當(dāng)拋光液中含有質(zhì)量分?jǐn)?shù)為0.1%的TAT 時(shí),Cu 去除速率為512 nm/min,靜態(tài)腐蝕速率降為53 nm/min,此時(shí)的Cu 去除速率雖然滿足工業(yè)要求,但其靜態(tài)腐蝕速率較高,在拋光過(guò)程中會(huì)導(dǎo)致碟形坑的延深程度較大;在pH=8.5的條件下,在拋光液中添加質(zhì)量分?jǐn)?shù)為0.1%的TAT后,Cu 去除速率為482 nm/min,靜態(tài)腐蝕速率降為9 nm/min,此時(shí)Cu 的去除速率基本符合工業(yè)上粗拋階段450~550 nm/min 的要求,且靜態(tài)腐蝕速率較低可以較好地控制碟形坑和蝕坑的深度。因此,選定拋光液pH值為8.5,抑制劑TAT 質(zhì)量分?jǐn)?shù)為0.1%。
2.2 TAT 對(duì)Cu 表面碟形坑、蝕坑的影響
為了獲得抑制劑TAT 對(duì)拋光后碟形坑和蝕坑的影響,分別采用拋光液A 和拋光液B 進(jìn)行拋光實(shí)驗(yàn),并對(duì)其結(jié)果進(jìn)行對(duì)比,A、B 拋光液的具體配方如表2 所示。

表2 A、B 拋光液配方Tab.2 A,B slurry formula %
圖5 是在拋光液pH=8.5 的條件下,分別采用拋光液A、B 對(duì)Cu/Ru/TaN 互連結(jié)構(gòu)圖形片拋光后,圖形片上C/M/E 處不同布線寬度/間距(L/S)的碟形坑深度。

圖5 圖形片拋光前和采用拋光液A、B 拋光后不同線寬/間距的碟形坑深度測(cè)試結(jié)果Fig.5 Test results of different L/S dishing depths before polishing and after polishing with slurry A and B
由圖5 可以看出,Cu/Ru/TaN 互連結(jié)構(gòu)圖形片在進(jìn)行拋光實(shí)驗(yàn)前,位于中心位置的L/S=100 μm/100 μm 碟形坑深度為355 nm,L/S=50 μm/50 μm 碟形坑深度為349 nm。采用拋光液A 拋光即當(dāng)拋光液中不含抑制劑時(shí),位于中心位置的L/S=100 μm/100 μm 碟形坑深度為229 nm,L/S=50 μm/50 μm 碟形坑深度為217 nm,可以發(fā)現(xiàn)不加抑制劑時(shí),拋光后碟形坑較深,原因是當(dāng)拋光液中不添加抑制劑時(shí),Cu 表面完全暴露于拋光液中,能夠與氧化劑和絡(luò)合劑充分接觸,化學(xué)反應(yīng)強(qiáng)烈,因此在機(jī)械研磨和化學(xué)反應(yīng)的共同作用下,Cu 膜表面凸出處和凹陷處的去除速率都很快,不存在較大的速率差,因此不會(huì)對(duì)碟形坑有較好的控制效果。從圖5 中還可以發(fā)現(xiàn),采用拋光液B 拋光后,中間和邊緣處的碟形坑較深,這可能是由于拋光過(guò)程中圖形片受力不均勻所導(dǎo)致的,即中心壓力略微大于邊緣壓力。
圖6、圖7 分別是晶圓中心處L/S=100 μm/100 μm 和L/S=50 μm/50 μm 的碟形坑深度輪廓圖,通過(guò)圖6、圖7 可以更加直觀地看到采用不同拋光液拋光后碟形坑的深度變化。可以發(fā)現(xiàn)當(dāng)采用拋光液B 對(duì)圖形片進(jìn)行拋光,即在拋光液中加入質(zhì)量分?jǐn)?shù)為0.1%的TAT 時(shí),位于中心位置的L/S=100 μm/100 μm 碟形坑深度為76 nm,L/S=50 μm/50 μm 碟形坑深度為77 nm,拋光后的碟形坑深度相較于拋光液中不添加TAT時(shí)的變淺。這可能是由于TAT 的加入在Cu 膜表面形成了一層能夠阻擋化學(xué)反應(yīng)的鈍化膜,這層鈍化膜緊緊吸附在Cu 膜表面,使得Cu 膜不能完全暴露于拋光液中與氧化劑及絡(luò)合劑進(jìn)行化學(xué)反應(yīng),同時(shí)由于Cu膜本身存在凹凸結(jié)構(gòu),凸處較凹處會(huì)受到更大的機(jī)械作用,因此凸處吸附的鈍化膜在機(jī)械作用下能夠被快速去除,使凸處Cu 能夠繼續(xù)進(jìn)行效率更高的化學(xué)反應(yīng),從而導(dǎo)致去除速率較快;而凹處Cu 鈍化膜受到的機(jī)械作用較小,覆蓋的鈍化膜不太容易去除,化學(xué)反應(yīng)效率被大大降低,導(dǎo)致凹處的Cu 去除速率較低,最終在Cu 膜表面獲得一個(gè)速率差,即凸處的去除速率遠(yuǎn)遠(yuǎn)大于凹處的去除速率,進(jìn)而在晶圓表面獲得良好的平坦化效果。

圖6 線寬/間距為100 μm/100 μm 的碟形坑拋光前及采用拋光液A、B 拋光后的深度輪廓示意圖Fig.6 Schematic diagram of the depth profile of dishing with L/S of 100 μm/100 μm before polishing and after polishing with slurry A and B

圖7 線寬/間距為50 μm/50 μm 的碟形坑拋光前及分別采用拋光液A、B 拋光后的深度輪廓示意圖Fig.7 Schematic diagram of the depth profile of dishing with L/S of 50 μm/50 μm before polishing and after polishing with slurry A and B
圖8 為Cu/Ru/TaN 互連結(jié)構(gòu)圖形片上C/M/E 處不同L/S(1 μm/9 μm,5 μm/5 μm,9 μm/1 μm) 的蝕坑深度結(jié)果圖。當(dāng)采用拋光液A 拋光后,圖形片L/S=5 μm/5 μm 蝕坑深度為68 nm,L/S=9 μm/1 μm的蝕坑深度為139 nm,蝕坑較深。從圖8 中還可以發(fā)現(xiàn)蝕坑的深度隨著銅線條布線寬度的增加而增加,這可能是由于布線寬度增加會(huì)導(dǎo)致線條間距減小,從而導(dǎo)致銅線條相鄰較為緊密,最終使得線條更多地暴露于拋光液中,腐蝕變得更易出現(xiàn)。

圖8 圖形片拋光前和采用拋光液A、B 拋光后不同線寬/間距的蝕坑深度測(cè)試結(jié)果Fig.8 Test results of the depth of erosion with different L/S before polishing and after polishing with slurry A and B
圖9 為晶圓中心處L/S=9 μm/1 μm 的蝕坑分別采用拋光液A 和拋光液B 拋光后的蝕坑深度輪廓示意圖。通過(guò)圖9 可以更加直觀地看到采用不同拋光液拋光后蝕坑的深度變化。可以發(fā)現(xiàn),當(dāng)采用拋光液B 拋光后,L/S=9 μm/1 μm 的蝕坑深度為80 nm,這說(shuō)明在拋光液中加入TAT 可以控制Cu/Ru/TaN 互連結(jié)構(gòu)圖形片上的蝕坑深度,獲得良好的圖形片平坦化效果。

圖9 線寬/間距為9 μm/1 μm 的蝕坑采用不同拋光液拋光前后深度輪廓示意圖。(a) 拋光液A;(b) 拋光液BFig.9 Schematic diagram of the depth profile of erosion with L/S of 9 μm/1 μm before and after polishing with(a) slurry A and (b) slurry B
根據(jù)Cu 去除速率和碟形坑深度控制的結(jié)果,推測(cè)在拋光過(guò)程中可能會(huì)存在以下化學(xué)反應(yīng):


2.3 XPS 表面分析
XPS 是電子材料與元器件顯微分析中的一種先進(jìn)分析技術(shù),對(duì)于分析研究金屬表面的化學(xué)成分有很大的幫助。利用Casa XPS 軟件對(duì)得到的原始數(shù)據(jù)進(jìn)行分析處理,在NIST X 射線光電子能譜數(shù)據(jù)庫(kù)中對(duì)擬合出的峰值進(jìn)行查找,尋找與峰值對(duì)應(yīng)的化合物成分,從而判斷樣片表面的化學(xué)成分構(gòu)成。
圖10(a)、(b)為銅表面分別經(jīng)過(guò)C、D 兩組溶液處理后的XPS 光譜,溶液C 由10 mmol Gly 組成,溶液D 由10 mmol Gly 和5 mmol TAT 組成。圖10(a)為溶液C 處理Cu 膜后的Cu 2p3/2光譜,圖中擬合出結(jié)合能分別為932.6 eV 和933.9 eV 的兩個(gè)峰,對(duì)照之后發(fā)現(xiàn)第一個(gè)峰與Cu/Cu2O 有關(guān),第二個(gè)峰與CuO 有關(guān)。從圖10(b)中可以發(fā)現(xiàn),在采用加入TAT 的D 溶液處理后,代表CuO 和Cu/Cu2O 成分?jǐn)M合峰的強(qiáng)度發(fā)生了明顯下降,這代表著TAT 的加入在Cu 表面發(fā)生了化學(xué)反應(yīng),從而影響了這兩個(gè)擬合峰的強(qiáng)度;此外還在圖中發(fā)現(xiàn)了結(jié)合能為935.2 eV 的新峰,在已知的數(shù)據(jù)庫(kù)中無(wú)法查詢到這種物質(zhì),因此可合理推測(cè)是TAT 分子吸附在銅表面形成Cu-TAT,從而產(chǎn)生了的新擬合峰。
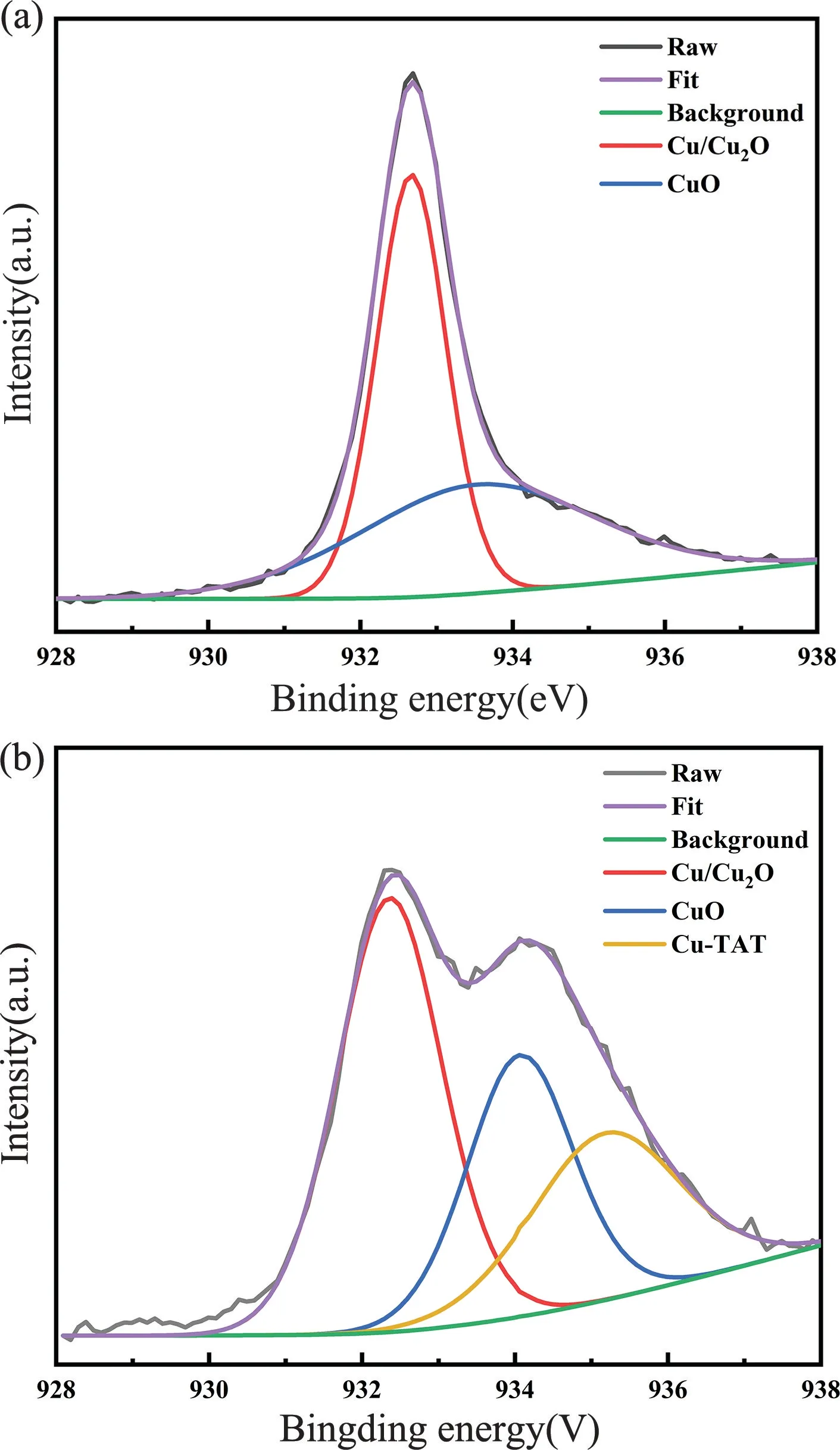
圖10 銅膜表面在兩組不同溶液中處理后的XPS 光譜。(a) C 溶液;(b) D 溶液Fig.10 XPS spectra of Cu surface treated with two different solutions.(a) C solution;(b) D solution
表3 中顯示了采用C、D 兩組溶液處理后Cu 膜表面的Cu 及其氧化物和化合物所占的比例,可以看到采用溶液C 處理后的Cu 膜表面CuO 的比例為46.65%,采用溶液D 處理后的Cu 膜表面CuO 的比例為28.25%,這證明加入TAT 后Cu 膜表面確實(shí)發(fā)生了化學(xué)反應(yīng),還可以通過(guò)該占比進(jìn)一步推斷TAT 分子應(yīng)是與Cu2+形成化合物吸附在銅表面。并且,Cu-TAT所占的比例為25.28%,這表明TAT 在銅表面形成的化合物膜的吸附保護(hù)作用較強(qiáng)。

表3 Cu 在不同溶液浸泡后表面成分各峰值占比Tab.3 Peak percentage of surface components of Cu soaked in different solutions
3 結(jié)論
本文研究了新型抑制劑TAT 對(duì)銅膜去除速率、靜態(tài)腐蝕速率以及CMP 后圖形片表面碟形坑和蝕坑的影響。結(jié)果表明,隨著TAT 濃度的增加,Cu 去除速率和靜態(tài)腐蝕速率均大幅度下降,TAT 對(duì)其有明顯的抑制效果,而隨著拋光液pH 值的增加,TAT 的抑制效果會(huì)被削弱。當(dāng)拋光液pH 值為8.5,TAT 質(zhì)量分?jǐn)?shù)為0.1%時(shí),Cu 去除速率為482 nm/min,基本符合工業(yè)要求,且靜態(tài)腐蝕速率較低,對(duì)圖形片進(jìn)行拋光后,L/S=100 μm/100 μm 的碟形坑深度由拋光前的355 nm 降為76 nm,L/S=9 μm/1 μm 的蝕坑深度由拋光前的172 nm 降為81 nm。抑制劑TAT 能夠很好地控制拋光后圖形片上不同線寬/間距的碟形坑和蝕坑的深度,使圖形片在拋光后獲得良好的平坦化效果。

