MRAM 空間粒子輻射效應關(guān)鍵技術(shù)研究
(中科芯集成電路有限公司,江蘇無錫 214072)
1 引言
空間輻射環(huán)境中存在多種能量極高的粒子[1-2],這些高能粒子可以很容易地穿透航天器外部的屏蔽材料,入射到內(nèi)部的電子元器件中,從而產(chǎn)生輻射效應。輻射效應已成為導致電子元器件出現(xiàn)功能錯誤最重要的原因之一,嚴重降低了微電子器件的可靠性[3-4]。在惡劣的空間環(huán)境中,當輻射粒子入射到半導體材料中后,會使硅原子產(chǎn)生電離,在粒子的入射路徑附近產(chǎn)生電子-空穴對。如果這些電子-空穴對在反偏PN結(jié)中被電場分離,就會在晶體管的漏極產(chǎn)生瞬時電流脈沖,進而在存儲單元或邏輯觸發(fā)器中引入錯誤的狀態(tài)信息,產(chǎn)生單粒子效應;在半導體器件中,不同材料的交界處由于晶格失配、原子缺失等會引入陷阱能級,粒子輻射產(chǎn)生的電子-空穴對還會被這些陷阱所捕獲,進而導致器件閾值電壓漂移、亞閾值導通等總劑量效應。
磁阻隨機存儲器(MRAM)是一種通過磁場或自旋極化電流實現(xiàn)數(shù)據(jù)寫入的新型非易失存儲器,與傳統(tǒng)存儲器(SRAM、FLASH 等)相比,MRAM 在讀寫速度、存儲密度、使用壽命和功耗等方面有著獨特的優(yōu)勢[5-6]。此外,磁隧道結(jié)(MTJ)被證明對空間粒子輻射具有天然的免疫能力[7-8]。與FLASH 數(shù)據(jù)存儲的機制不同,MRAM 是通過磁阻狀態(tài)的切換來實現(xiàn)數(shù)據(jù)功能。因此,MRAM 擺脫了數(shù)據(jù)存儲對電荷的依賴,抗輻射能力更強。此外,MRAM 在數(shù)據(jù)存儲的過程中沒有擦除操作,讀寫操作工作電壓也一致,因此不需要電荷泵電路,從而降低了輻射敏感面積和功耗。影響MRAM 功能的輻射敏感區(qū)域主要是數(shù)據(jù)讀操作所用到的敏感放大器電路和寫操作中的雙向電流控制電路。本文對MRAM 輻射效應的研究背景、物理機制、研究方法等內(nèi)容進行了論述,重點分析了MRAM 芯片輻射實驗評價結(jié)果及電學表征方法。
2 MRAM 存儲單元結(jié)構(gòu)及其工藝制備
2.1 MRAM 存儲單元結(jié)構(gòu)
根據(jù)存儲單元數(shù)據(jù)寫入方式的不同,MRAM 可分為兩類:磁場誘導開關(guān)和自旋極化電流誘導開關(guān)。圖1為兩種不同數(shù)據(jù)寫入方式的存儲單元結(jié)構(gòu)示意圖。圖1(a)為第一代場致開關(guān)式MRAM[9],它是由通過位線(BL)和寫字線(WWL)的電流所感生的交叉磁場實現(xiàn)數(shù)據(jù)寫入。其中,SL、WL 分別為源線和字線,IBL 為流經(jīng)位線的寫入電流,IWWL為流經(jīng)寫字線的電流。MTJ 的熱穩(wěn)定性隨尺寸的減小而降低。因此,在MTJ 尺寸進一步微縮化的同時,為了保持器件的熱穩(wěn)定性,就必須增加器件自由層的矯頑力。矯頑力的增加會使得驅(qū)動器件開關(guān)的磁場增加,進而提高了開關(guān)電流密度。因此,磁場寫入式MRAM 的開關(guān)電流與MTJ 尺寸成反比,無法滿足集成電路高密度、低功耗的發(fā)展需求。圖1(b)為一種基于自旋轉(zhuǎn)移矩磁化開關(guān)的STT-MRAM 單元[10]。在這種新型的MRAM 中,寫入操作可以通過流過MTJ 的自旋極化電流(IBL)來實現(xiàn),不需要額外的寫字線,從而減少了單元的面積開銷、降低了功耗。此外,由于寫入電流與MTJ 的面積成正比,STT-MTJ 尺寸微縮能力較強,逐漸成為MRAM 的主流。
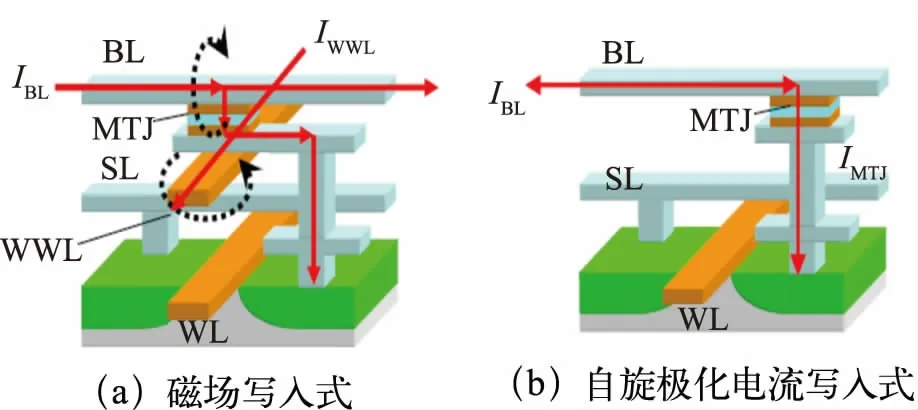
圖1 MRAM 單元結(jié)構(gòu)示意圖
2.2 MTJ 工藝制備
MTJ 作為MRAM 的核心存儲結(jié)構(gòu),通常是由十幾層甚至幾十層薄膜材料堆疊而成,其電學特性很大程度上取決于工藝制備的水平。早期MTJ 中的金屬氧化物勢壘層是由非晶態(tài)的氧化鋁(AlOx)組成的,在室溫下I-MTJ 的隧穿磁電阻(TMR)超過10%。理論上來講,TMR 僅取決于兩個鐵磁層的相對自旋極化率,無法突破Julliere 公式所預測的理論上限[11],很難獲得70%以上的TMR。2001 年,BUTLER 等[12]從理論上預測了全晶體的(001)Fe/MgO/Fe MTJ 可以獲得1000%以上的TMR。如此大的TMR 主要歸因于Δ1能帶中高度自旋極化的電子在bcc-Fe/MgO/Fe(001)方向上的隧穿率遠大于其他能帶(Δ2和Δ5)。DJAVAPRAWIRA 通過磁控濺射技術(shù)制備了Co60Fe20B20/MgO/Co60Fe20B20的I-MTJ,其室溫下的TMR 值達到了230%,單元結(jié)構(gòu)如圖 2 所示。此外,HAYAKAWA 等制備了Co40Fe40B20/MgO/Co40Fe40B20的I-MTJ,其室溫下的TMR 值達到了260%。
目前,MTJ 的工藝制備仍然是制約STT-MRAM容量提高的難題之一。特別是存儲單元之間的工藝偏差極大地降低了其均一性,從而阻礙了整個存儲器的性能提升。為了從根本上解決這一難題,Applied Materials 公司為下一代大容量STT-MRAM 的制備推出了新的解決方案。Applied Materials 通過Endura 平臺將多種材料工程技術(shù)與機載計量學結(jié)合起來,創(chuàng)造出新的薄膜和器件結(jié)構(gòu)。
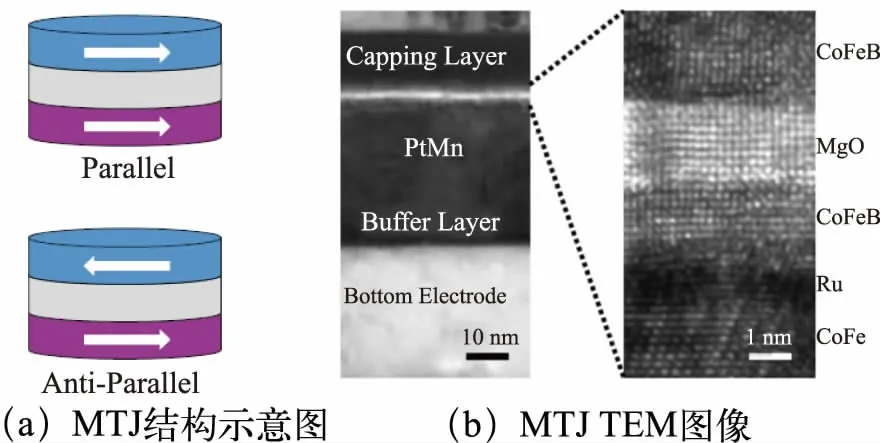
圖2 MTJ 結(jié)構(gòu)示意圖和TEM 圖像
Applied Materials 新的Endura Clover MRAM PVD 平臺由所有集成在原始、高真空條件下的9 個獨特的芯片處理室組成,如圖3 所示。Applied Materials表明,這是業(yè)界首款300 mm 制造高容量MRAM 的系統(tǒng),能夠獨立沉積多達5 種不同材料。Clover MRAM PVD 平臺包括機載計量儀,用于測量并監(jiān)測具有亞埃靈敏度的MRAM 層的厚度,以確保原子級的均勻性。同時,Applied Materials 還宣布了一種稱為Endura 脈沖PVD 平臺的RRAM 和PCRAM 的制備系統(tǒng)。

圖3 Endura Clover MRAM PVD 平臺
3 MRAM 輻射效應研究現(xiàn)狀
目前對于MRAM 輻射效應的研究主要包括輻射試驗和模擬仿真兩部分。輻射試驗主要是針對目前商用的MRAM 芯片進行輻射性能評估,并借助于TEM、XRR、AFM、MFM 等電學表征方法對MRAM 核心存儲結(jié)構(gòu)MTJ 的輻射損傷進行研究。Nguyen 等采用原位輻照的方法研究了MRAM 的SEL 和TID 誘導的器件失效情況。實驗結(jié)果表明當輻射劑量大于60 krad(Si)時,信息位將產(chǎn)生錯誤的翻轉(zhuǎn)。中國科學院張浩浩等研究了16 Mbit 商用MRAM 的質(zhì)子輻射效應,當質(zhì)子輻射劑量累積到2.5×1011/cm2時,觀察到數(shù)據(jù)位的讀錯誤和電學失效。
在MTJ 輻射損傷機理的研究方面,主要還是集中在傳統(tǒng)的具有Al2O3勢壘層的MTJ 上[13-18]。相關(guān)的研究重點關(guān)注輻照前后MTJ 的磁化翻轉(zhuǎn)和磁化傳輸特性,很少有人對MTJ 輻射后的微觀結(jié)構(gòu)的變化,特別是輻照過程中的界面態(tài)進行深入研究。TMR 是衡量MTJ 性能的一個關(guān)鍵指標,在輻射環(huán)境下MTJ 的TMR 值隨著輻射類型、能量、劑量的變化有著很大的差異。BANERJEE 等研究了輻射效應對Co/Al2O3/Ni80Fe20TMR 的影響,如圖4 所示。隨著離子輻射劑量的增加,TMR 逐漸減小,當離子的能量大于200 MeV 時,TMR 值幾乎為零,此時MTJ 數(shù)據(jù)存儲功能失效。
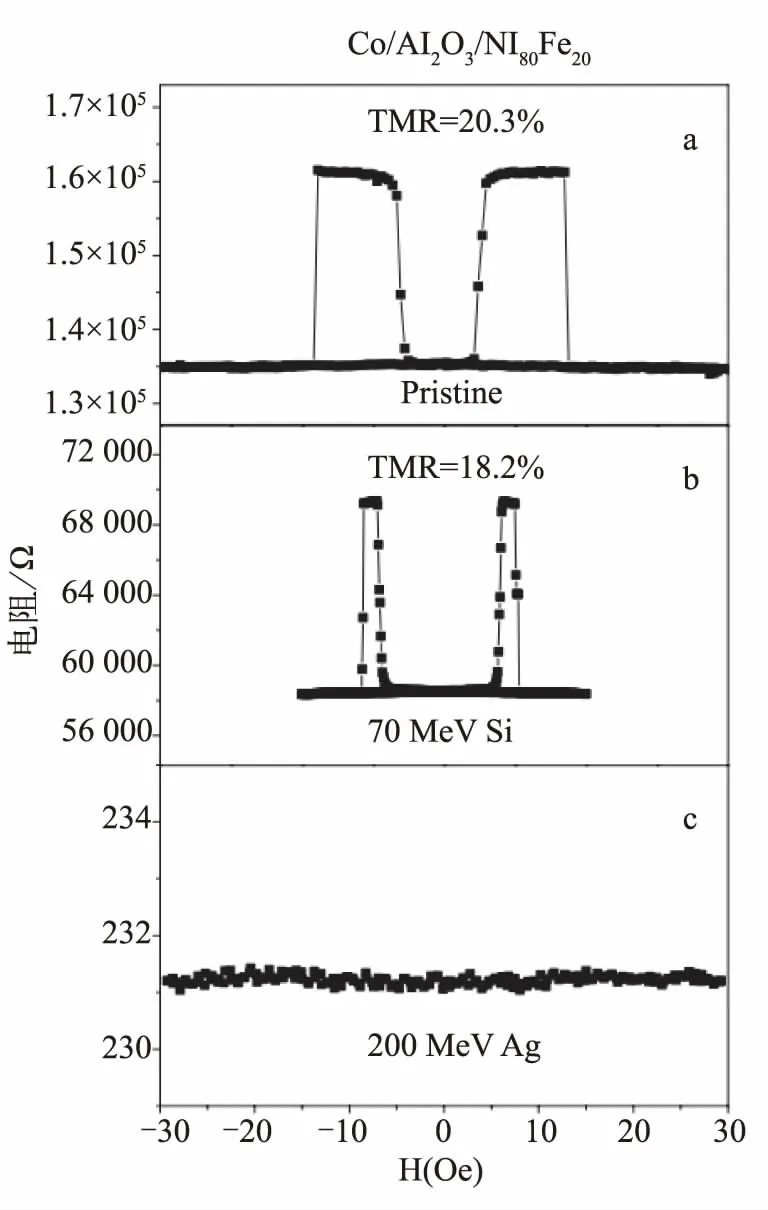
圖4 不同輻射劑量下Co/Al2O3/Ni80Fe20中的TMR
綜上,對MTJ 輻射效應的研究主要針對其宏觀的功能性開展,包括輻射效應對數(shù)據(jù)的存儲狀態(tài)、數(shù)據(jù)位翻轉(zhuǎn)過程以及TMR 值的影響等。與Al2O3隧穿層相比,MgO 勢壘層對于輻射效應的敏感度要低很多。但是對于器件中的不同薄膜結(jié)構(gòu)層的輻射損傷機理的研究還是比較少的,比如CoFeB 材料的自由層、釘扎層以及其他過渡材料層。因此,為了進一步完善理論體系,該部分的研究也是必不可少的。
從存儲單元結(jié)構(gòu)類型角度分析,目前對于MRAM輻射效應的研究主要集中在磁場寫入式MRAM,對于第二代STT-MRAM 的研究相對較少。考慮到STT-MRAM 逐漸成為MRAM 的主流,因此需要重新評估它們的抗輻射性能。尤其是在STT-MTJ 中,MgO勢壘層的厚度比場致開關(guān)的MTJ 低很多,其勢壘層厚度通常為1~2 nm,很容易在粒子輻射下產(chǎn)生位移損傷。此外,具有強垂直磁各向異性的新型磁性材料開始取代傳統(tǒng)的CoFeB,這些新材料對超晶格結(jié)構(gòu)的一致性以及界面態(tài)要求更高。所以,新型STT-MTJ 技術(shù)的出現(xiàn)使其結(jié)構(gòu)更容易受到空間粒子電離和位移損傷的影響。
傳統(tǒng)MTJ 的開關(guān)過程是通過單元內(nèi)部導線所產(chǎn)生的環(huán)形磁場來驅(qū)動的,對于磁化層及勢壘層的晶格一致性要求不是很高,因此在數(shù)據(jù)寫入過程中外界輻射環(huán)境對其影響較小。新型STT-MTJ 的數(shù)據(jù)寫入是通過自旋轉(zhuǎn)移力矩效應來實現(xiàn)的,數(shù)據(jù)寫入的速度取決于自旋轉(zhuǎn)移力矩的效率。而自旋轉(zhuǎn)移力矩效率對于MTJ 的界面態(tài)極為敏感,因此更容易受到輻射環(huán)境的影響。
隨著第二代STT-MRAM 的出現(xiàn),對MRAM 輻射效應的研究逐漸轉(zhuǎn)移到具有MgO 勢壘層的STT-MTJ上[19-21],其中自由層和固定層通常是非晶態(tài)的CoFeB。HUGHES 等首次研究了Grandis 公司的MTJ 在輻射環(huán)境下的自旋轉(zhuǎn)矩開關(guān)和狀態(tài)保持。用能量為220MeV、劑量為1×1012/cm2的質(zhì)子輻照MTJ 器件,結(jié)果表明STT-MTJ 在輻射前后的磁化開關(guān)過程無明顯變化,如圖5 所示。同時,也沒有觀察到離子輻射對狀態(tài)保持的影響。KOBAYASHI 等[17]研究了重離子輻照(15 MeV Si 離子)對基于CoFeB-MgO 的STT-MTJ 電阻變化的影響。結(jié)果表明離子輻射會使得MTJ 電阻產(chǎn)生一個微弱的退化(阻值變化范圍在1%左右),但輻照前后數(shù)據(jù)的存儲狀態(tài)和時間無明顯變化。

圖5 不同能量的質(zhì)子輻射前后STT-MTJ 磁化翻轉(zhuǎn)過程
上述研究主要集中在輻射效應對MTJ 的數(shù)據(jù)存儲及開關(guān)過程等器件功能上的影響,很少有對MgO勢壘層輻射電離損傷(STT-MTJ 中的MgO 通常為1 nm 厚)的研究。HUGHES 等對具有1.2 nm 厚的MgO 勢壘的MTJ 進行Co60γ 射線輻射實驗,射線劑量高達10 Mrad(Si),沒有觀察到TMR、電阻面積(RA)值以及自旋轉(zhuǎn)矩開關(guān)行為的明顯變化。
4 MRAM 輻射效應研究方法
4.1 電鏡表征
MTJ 作為MRAM 數(shù)據(jù)存儲的核心結(jié)構(gòu),諸多學者對其輻照環(huán)境中電阻的變化進行了研究。研究發(fā)現(xiàn),在高劑量的重離子暴露環(huán)境中,大部分器件均會產(chǎn)生位移損傷。特別是MTJ 中的界面態(tài)對于重離子輻射引起的器件結(jié)構(gòu)微觀變化極為敏感。一般來說,MTJ的磁性和磁傳輸性能隨著輻射劑量的增加而降低。MTJ 的橫截面TEM 圖像和X 射線反射是研究其內(nèi)部相鄰層之間晶格混合結(jié)構(gòu)的有效方法。與重離子相反,高能質(zhì)子和Co60γ 射線照射對MTJ 的磁性能及其STT 開關(guān)行為的影響很小,這使得MTJ 成為這些輻射環(huán)境中輻射加固的極具競爭力的器件。
基本的MRAM 元件MTJ 一般由兩個鐵磁層和中間的薄絕緣層組成。存儲的信息位取決于這兩種磁化的相對方向,平行或反平行使得MTJ 表現(xiàn)出兩種穩(wěn)定的電阻狀態(tài),分別代表不同的數(shù)據(jù)[9]。圖6 為TEM拍攝的MR4A08B MRAM 的剖面圖,存儲單元為1M1T 結(jié)構(gòu)。訪問晶體管的柵氧厚度為2.8 nm,寬長比W/L=0.8 μm/0.8 μm。淺槽隔離(STI)用于相鄰晶體管之間的電氣隔離,深度約為380 nm。MRAM 的工作電壓為3.3 V,具有8 位字寬和SRAM 兼容的35 ns 訪問時間,以及幾乎無限的重復讀寫次數(shù)。
輻射效應引起的器件損傷或功能失效往往是通過對材料界面態(tài)的影響導致的。通過透射電鏡可以直接觀測到界面態(tài)晶格結(jié)構(gòu)的變化,如圖7 所示[17]。但是由于樣品面積有限,很難量化混合/粗糙界面態(tài)的變化。除了TEM,原子力顯微鏡也可以用來表征薄膜界面粗糙度的變化。表面粗糙度可以用來推斷MTJ 結(jié)構(gòu)中多層膜的混合結(jié)構(gòu),但仍然不能量化界面處的混合狀態(tài)。
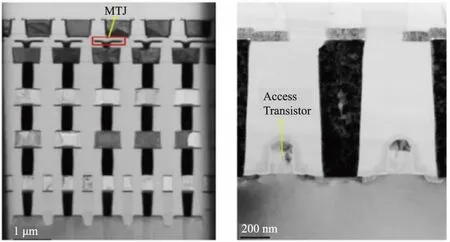
圖6 1M1T 存儲單元的TEM 橫截面
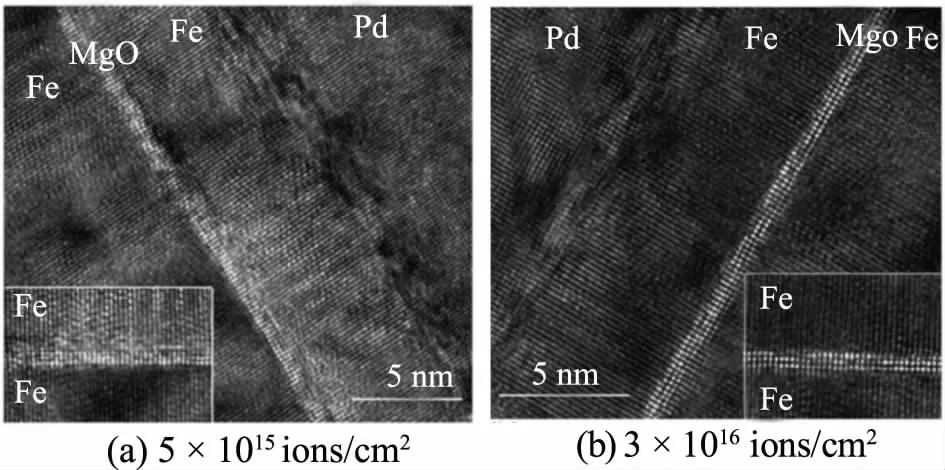
圖7 輻射后Pd/Fe/MgO/Fe 隧道結(jié)TEM 圖像
X 射線反射率(XRR)利用不同界面反射的X 射線光束的干擾,形成了一種反射模式,提供了薄膜厚度的重要信息[22]。對于臨界角以下的入射角,入射X 射線光束被樣品表面完全反射。臨界角與材料的折射率有關(guān),這取決于材料的電子密度。一般情況下,大多數(shù)材料的臨界角小于1°。當入射角逐漸增大超過臨界角時,入射X 射線束穿透到材料中,在樣品不同界面處反射產(chǎn)生干涉條紋,也稱為Kiessig 條紋。條紋的幅度取決于電子密度差,界面處電子密度的差異越大,振幅越高。此外,由于漫散射的存在,反射強度隨著表面和界面粗糙度的增加而大幅衰減[23]。薄膜厚度t 可以從條紋的周期性來估算:

其中λ 是X 射線波長,Δ2θ 是連續(xù)干擾峰之間的2θ角分離。圖8 展示了Co/AlOx/Co 結(jié)構(gòu)在Ar+輻射前后的XRR 變化。可以通過模擬提取關(guān)于密度和厚度以及表面/界面粗糙度的信息。反過來,單個層的混合結(jié)構(gòu)可以通過厚度、密度和每層粗糙度的變化來量化[18,22]。
通過TEM、AFM、XRR 等表征方法,可以很好地觀測到離子輻射對MTJ 界面態(tài)產(chǎn)生的影響,從而更好地解釋輻射誘導數(shù)據(jù)翻轉(zhuǎn)、寫失效及TMR 退化等現(xiàn)象。結(jié)合退火后器件功能的恢復情況可以進一步明確失效的物理機制。

圖8 Co/AlOx/Co 多層膜結(jié)構(gòu)XRR
4.2 TCAD 仿真
除了輻射試驗外,模擬仿真也是研究MRAM 輻射效應很重要的一部分。模擬仿真可以更加直觀系統(tǒng)地展示輻射效應的深層物理機制,有助于系統(tǒng)地分析各項輻射損傷或失效產(chǎn)生的原因。模擬仿真領(lǐng)域主要包括MTJ 的行為及模型創(chuàng)建和電路系統(tǒng)的仿真。建模領(lǐng)域以北京航空航天大學趙巍勝教授為代表,創(chuàng)建了MTJ 的Verilog-A 模型,并基于此開展了大量的電路功能仿真以及抗輻射加固技術(shù)的研究工作。HEINZ 等使用快速Airy 函數(shù)方法實現(xiàn)了MTJ 磁化動力學和自旋相關(guān)的隧穿行為,MTJ TCAD 混合模型如圖9 所示。
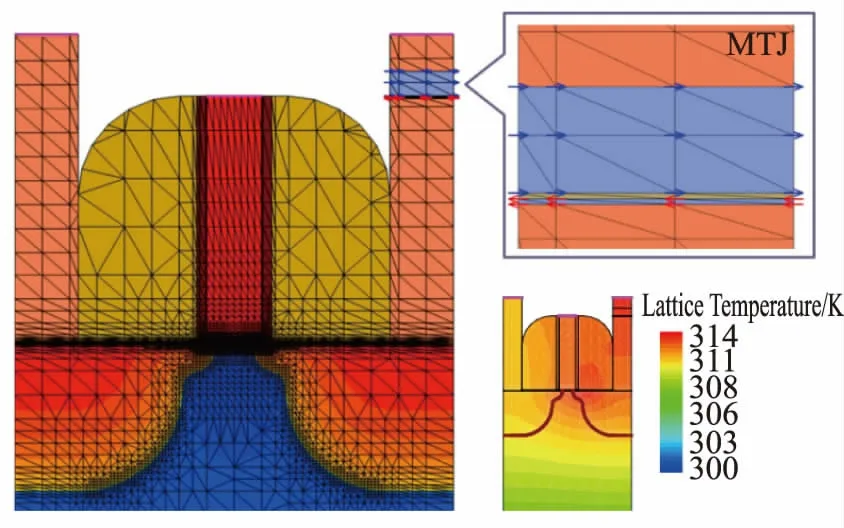
圖9 MTJ TCAD 混合模型
通過集成到通用的TCAD 框架中,可以模擬單個STT 單元和小型混合電路,基于MTJ 的NV-SRAM 單元如圖10 所示。同時與先進的深亞微米器件的TCAD模型相結(jié)合將成為可能。通過該模型,可以更加真實地模擬MRAM 存儲單元輻射效應,進而可以更加深入地揭示出器件的輻射損傷機制。但是,目前基于Airy 的MTJ 模型還不是很完善,磁化分布狀態(tài)等諸多關(guān)鍵項還無法很好地集成進去,因此進一步完善MTJ TCAD 模型是急需解決的一個關(guān)鍵技術(shù)難題。
5 MRAM 外圍電路抗輻射加固設(shè)計
常規(guī)輻射環(huán)境條件中,MRAM 中MTJ 的失效概率是比較低的,主要還是其外圍讀寫電路的錯誤所致。由于MRAM 的數(shù)據(jù)讀寫是通過外圍CMOS 電路來實現(xiàn)的,因此輻射所誘導的外圍電路失效才是MRAM 出現(xiàn)故障的主要原因,為此需要對MRAM 的外圍讀寫電路特別是敏感放大器進行抗輻射加固設(shè)計。
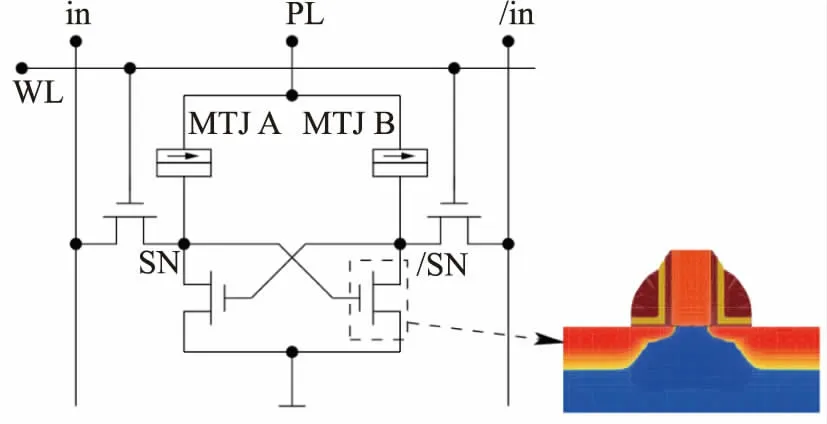
圖10 基于MTJ 的NV-SRAM 單元
為了實現(xiàn)基于MRAM 的大規(guī)模集成電路仿真,首先要創(chuàng)建MTJ 的集總模型。基于現(xiàn)有的基本物理模型,STT-MTJ 的集總模型可以用Spice 或者Verilog-A進行創(chuàng)建,并在相應的仿真平臺進行模擬。圖11(a)為趙巍勝等創(chuàng)建的STT-MTJ 模型的符號圖,圖11(b)為直流仿真的結(jié)果。首先對靜態(tài)行為模型的功能進行驗證,MTJ 的直徑設(shè)置為40 nm。在此模擬中,從P 態(tài)到AP 態(tài)的臨界電流開關(guān)磁化強度約為72 μA,而反向開關(guān)臨界電流約為28 μA。這些結(jié)果表明靜態(tài)行為物理模型與實測數(shù)據(jù)之間有很好的一致性,并證實了CoFeB/MgO PMA MTJ 的實驗測量結(jié)果所顯示的兩種狀態(tài)之間強烈的開關(guān)不對稱性[24]。這是由于P 和AP狀態(tài)下自旋極化效率因子g 的不同所致。同時也可以描述這兩個MTJ 狀態(tài)不對稱的電壓相關(guān)性,這是由于TMR 的電壓相關(guān)性所引起的。
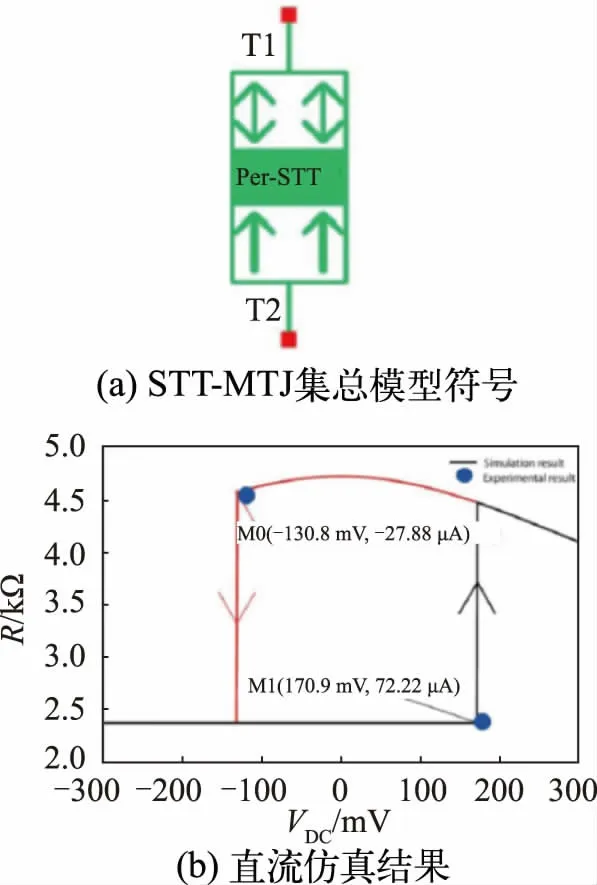
圖11 STT-MTJ 集總模型及直流仿真結(jié)果
圖12 為瞬態(tài)仿真結(jié)果。瞬態(tài)仿真可以驗證物理模型與實驗測量之間動態(tài)行為的一致性。從分析仿真結(jié)果不難看出,開關(guān)延遲與寫入電流成反比,這與前面的動態(tài)物理模型相一致。PMA MTJ 作為邏輯和存儲器芯片的基本單元,有著巨大的應用前景。對于邏輯計算,可以提供大電流以保證高速度,但對于內(nèi)存應用,可以使用小電流來提供高密度。

圖12 STT-MTJ 瞬態(tài)仿真結(jié)果
由于TMR 效應,MTJ 呈現(xiàn)出不同狀態(tài)下的電阻差異特性。這種電阻特性使得MTJ 與CMOS 敏感放大器電路兼容,該電路檢測MTJ 的電阻狀態(tài)并將它們放大到邏輯電平。在幾種不同的敏感放大器中,預充敏感放大器(PCSA)不僅可以實現(xiàn)讀可靠性和功耗之間的平衡,而且還保證了高速性能。圖13 是STT-MRAM 中PCSA 的電路原理圖。
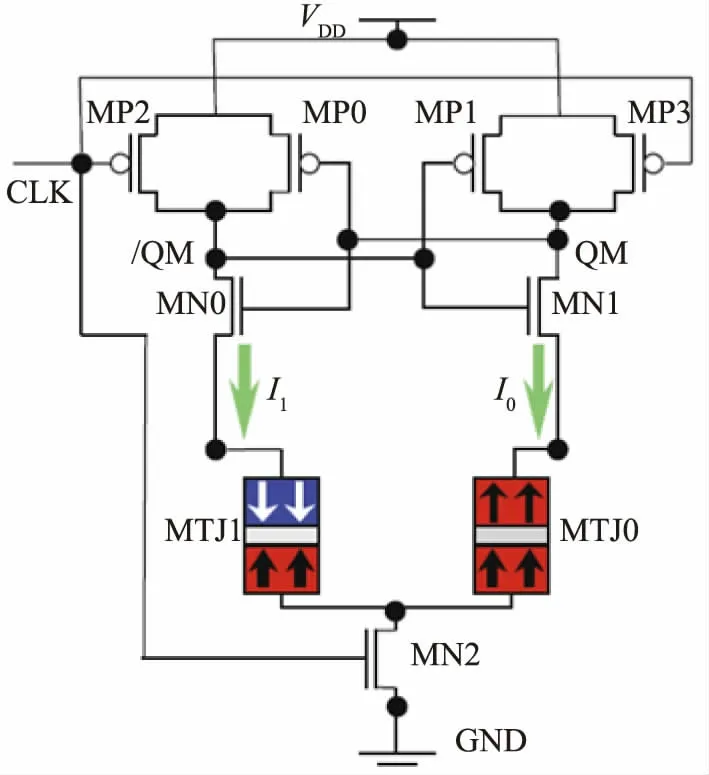
圖13 預充敏感放大器電路原理圖
PCSA 電路包括預充子電路(MP2、MP3)、放電子電路(MN2)和作為放大器的一對交叉互鎖的反向器(MN0、MN1 和MP0、MP1)。它的兩個分支通常連接到幾個具有互補態(tài)的MTJ。它的工作過程分為兩個階段:“預充電”和“評估”。在第一階段,“CLK”被設(shè)置為“0”,輸出(“QM”和“/QM”)通過MP2、MP3 被拉到“VDD”或邏輯“1”,而MN2 保持關(guān)閉。在第二階段,“CLK”變成“1”,MP2、MP3 被關(guān)閉,MN2 打開。由于兩個支路之間的電阻差異,放電電流是不同的。較低的電阻支路將被拉下,以更快地達到晶體管(MP0 或MP1)的閾值電壓。此時,另一個支路將被拉到“VDD”或邏輯“1”,而這個低阻支路將繼續(xù)下降到“GND”或邏輯“0”。
根據(jù)STT-MTJ 的開關(guān)機制,需要雙向電流以實現(xiàn)MTJ 的自由層中磁化方向的切換。為了實現(xiàn)高速邏輯設(shè)計,要求高電流以確保速度。與讀電路的低功率、低面積相反,用于PMA STT-MTJ 的寫入電路占整個電路的主要面積和功耗。因此,對寫入電路的研究是混合MTJ/CMOS 電路設(shè)計的重點。
與具有互補狀態(tài)的雙MTJ 讀電路相對應,寫電路是通過一組控制雙向電流寫入的組合邏輯電路所完成的,如圖14 所示。兩個NMOS(MN0、MN1)和兩個PMOS(MP0、MP1)晶體管構(gòu)成主電路。每次只有對角線上的一對NMOS 和一個PMOS 處于打開狀態(tài),而另一對則關(guān)閉,從而使得寫入電流從“VDDA”經(jīng)由兩條不同的路徑進入到“GND”,進而實現(xiàn)MTJ 的狀態(tài)寫入。由于兩個MTJ 是首尾相接的連接方式,因此它們的存儲信息位始終相反。通過兩個或非門和三個反向器,輸入數(shù)據(jù)“Input”和使能信號“EN”分別控制電流的寫入方向和電路的使能。
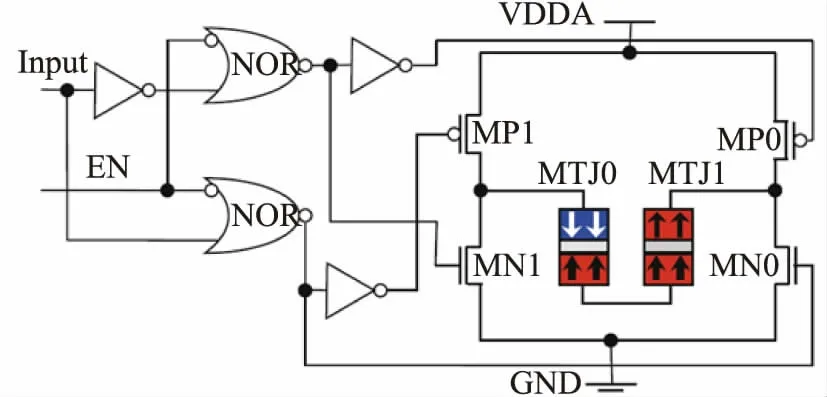
圖14 STT-MRAM 數(shù)據(jù)寫入電路原理圖
由于MTJ 數(shù)據(jù)存儲具有非易失的特點,輻射效應只對進行讀寫操作狀態(tài)下的外圍電路產(chǎn)生影響。圖15為STT-MRAM 讀寫電路的輻射敏感點電路原理圖,其中A、B、C 和D 點分別為敏感放大器和雙向電源網(wǎng)絡(luò)電路的輻射敏感點。該區(qū)域在受到粒子輻射后容易產(chǎn)生瞬時電流脈沖,從而使得數(shù)據(jù)讀寫操作失效。
針對敏感放大器中的輻射敏感點通常采用雙交叉互鎖結(jié)構(gòu)(DICE)進行加固設(shè)計,如圖16 所示[25]。DICE 結(jié)構(gòu)可以保證數(shù)據(jù)在讀寫的過程中不會因粒子的輻射效應而產(chǎn)生單粒子翻轉(zhuǎn),從而降低MRAM 在數(shù)據(jù)讀寫的過程中受到輻射影響而產(chǎn)生的軟錯誤。由于MRAM 的非易失性,在靜態(tài)工作狀態(tài)時可以將數(shù)據(jù)存儲到MTJ 中,并切斷電源,可以進一步降低輻射效應對外圍電路的影響。同時,由于電源的關(guān)斷也可以降低系統(tǒng)功耗。

圖15 STT-MRAM 讀寫電路輻射敏感點
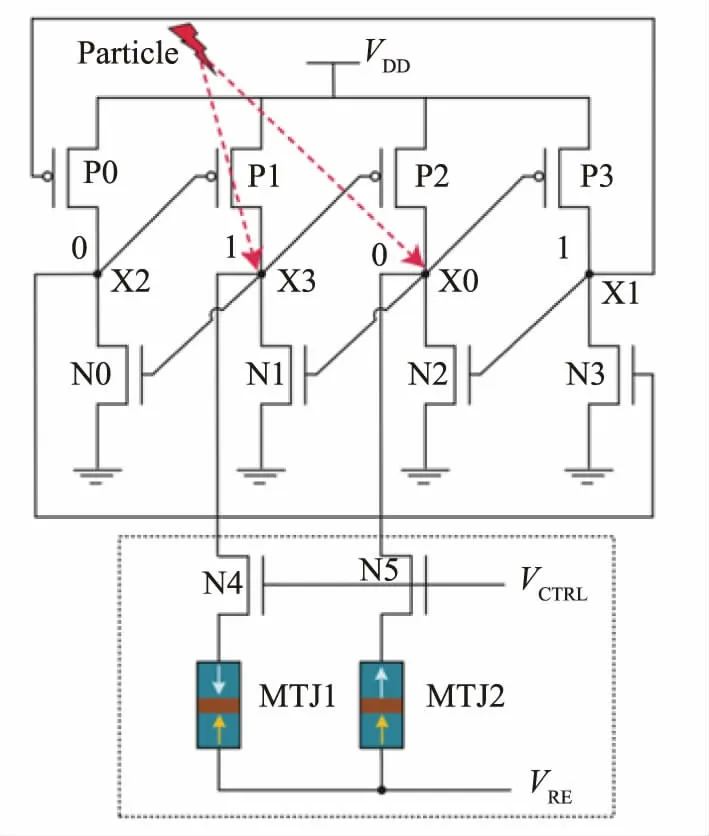
圖16 抗輻射加固DICE 鎖存器電路原理圖
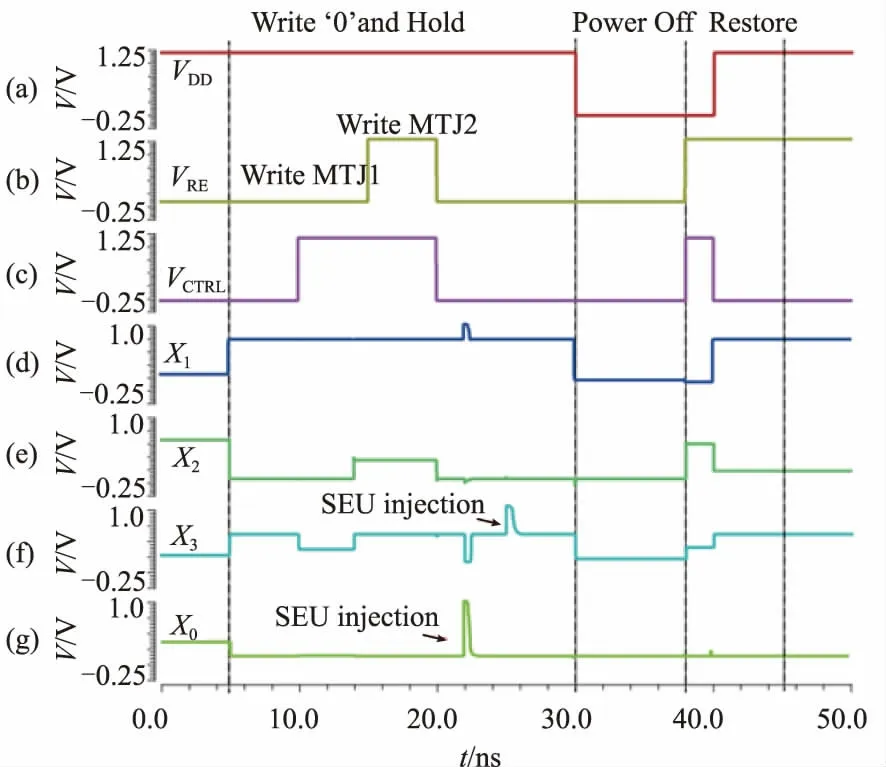
圖17 抗輻射加固NV-DICE 瞬態(tài)波形圖
圖17 為非易失DICE 輻射加固電路的瞬態(tài)波形圖。通過設(shè)置仿真文件,在數(shù)據(jù)存儲節(jié)點X1、X2、X3及X0 中注入SEU 脈沖波形,模擬電路的抗SEU 性能。由仿真波形圖不難看出,由于DICE 結(jié)構(gòu)的數(shù)據(jù)恢復特性SEU 脈沖并沒導致數(shù)據(jù)產(chǎn)生翻轉(zhuǎn)。此外,在電路不工作的狀態(tài)下可以將數(shù)據(jù)存儲到MTJ 單元中,關(guān)斷電源,降低功耗。當需要對數(shù)據(jù)進行讀寫操作時又可以將數(shù)據(jù)由MTJ 重新讀回DICE 結(jié)構(gòu)中,如圖17中Restore 部分波形所示。上述電路結(jié)構(gòu)的設(shè)計及功能仿真均可通過Spectre 等電路仿真EDA 工具實現(xiàn),通過仿真得到的波形圖可以很直觀地分析輻射效應對外圍電路的功能影響。
6 結(jié)論
目前對MRAM 輻射效應的研究主要集中在當前商用的主流MRAM 芯片上,通過輻射試驗及電鏡表征相結(jié)合的方式開展空間粒子輻射效應研究。通過對商用MRAM 芯片的輻射實驗評價可以得到其抗單粒子瞬態(tài)、單粒子翻轉(zhuǎn)及單粒子位移損傷等輻射效應的性能。結(jié)合電鏡表征,可以得到粒子輻射對MTJ 單元造成的物理損傷,從而揭示出輻射誘導的寫失效等物理機制。借助于EDA 仿真工具創(chuàng)建MTJ 電路模型及TCAD 模型,可以實現(xiàn)電路系統(tǒng)級的輻射效應模擬。同時,對于不同的輻射效應有針對性地提出電路系統(tǒng)級的設(shè)計加固方案,從而提高MRAM 的抗輻射性能。開展MRAM 輻射效應的研究,為設(shè)計具有自主知識產(chǎn)權(quán)的抗輻射MRAM 芯片奠定了理論基礎(chǔ),使抗輻射MRAM 芯片的研制成為可能。

