不同工藝下TaN薄膜中殘余應力的研究*
楊高峰
(榆林化工能源學院 陜西 榆林 718100)
前言
表面薄膜科學是微電子、光電子和磁工業的物理基礎,是現代社會技術進步的科學保證[1]。在微觀以至原子水平上研究和操縱表面讓我們能夠理解許多具有重要技術意義之器件的制作與運行[2]。表面技術,從廣義上講,它是一個十分寬廣的科學技術領域,是具有極高使用價值的基礎技術[3]。隨著我國工業的現代化、規模化、產業化,以及高新技術和現代國防用先進武器的發展,對各種材料表面性能的要求愈來愈高[4]。20世紀80年代,被列入世界10項關鍵技術之一的表面技術,經過20余年的發展,已成為一門新興的、跨學科的、綜合性強的先進基礎與工程技術,形成支撐當今技術革新與技術革命發展的重要因素[5]。材料表面技術與工程是把材料的表面與基體作為一個統一系統進行設計和改性,以最經濟、最有效的方法改善材料表面及近表面區的形態、化學成分、組織結構,并賦予材料表面新的復合性能[6];使許多新構思、新材料、新器件,實現了新的工程應用。我們把這種綜合化的,用于提高材料表面性能的各種新技術,統稱為現代材料表面技術[7]。
運用現代的表面沉積方法,在部件或襯底表面上沉積出厚度為100 nm至數微米厚的一種沉積技術,稱為薄膜沉積技術[8]。薄膜技術的內容包括薄膜材料、薄膜沉積制備技術、薄膜分析表征[9],結合實際應用或工程應用,還包括薄膜設計與選擇技術等[10]。從現代表面薄膜沉積制備技術方法上講,這里所指的現代表面薄膜沉積方法主要是“氣相沉積”的薄膜制備,它包括物理氣相沉積和化學氣相沉積2大類[11]。在筆者研究中采用物理氣相沉積的方法制備了TaN薄膜,研究其制備工藝對殘余應力的影響,從而得出最優工藝,為薄膜的制備提供借鑒。
薄膜的變形和脫落使其在實際應用中受到很大限制。一般說來,薄膜脫落是因拉伸應力所致,而壓縮應力主要引起薄膜產生變形[12]。對制取薄膜的某一性質的要求,會因應用對象的不同而有所偏重,但希望薄膜內應力小的要求往往是一致的。筆者通過對制備氮化鉭薄膜工藝中的基體溫度、反應氣體流量、功率、工作氣壓等工藝參數對薄膜的組織、成分、結構、殘余應力的影響進行研究,以期探索出使得薄膜殘余應力最小的制備工藝。
1 實驗部分
1.1 實驗設備
JGP450-PECVD200型高真空磁控濺射鍍膜系統;FEI Quanta 200 FEG型電子掃描顯微鏡;超聲波清洗器KQ5200型;菲利普公司生產的X’Pert PRO型X射線衍射儀;X-350A型X射線應力測量儀。
1.2 實驗材料
靶材:Ta;純度:99.99%;工作氣體:Ar;純度:99.99%;反應氣體:N2:純度:99.99%;基片:單晶Si片,鍍膜前用酒精超聲清洗10 min;
1.3 薄膜的制備過程
1.3.1 薄膜制備條件
本底真空5×10-4Pa;直流反應磁控濺射;靶基距:70 cm;基體溫度:25~300 ℃;
1.3.2 基材前處理
基材前處理的目的是清除基材表面的油污積垢、氧化物、銹蝕等污物,確保基材表面平整、清潔、光亮、提高膜層和基材的附著強度[13]。如果基材表面拋光不平,未徹底清潔,存在附著物、銹斑或氧化層,鍍膜時這些缺陷處易出現點狀針孔、剝落、“發花”等現象。
一般而言,基材的前處理工藝流程大致相同,但對具體的基材,考慮到其自身特性,其前處理方法要適當調整。本實驗所用的材料是Ni-Ti合金和載玻片。
對于載玻片:由于其表面光滑,光潔,基本干凈,只需要進行表面清洗即可。將試樣放到超聲波清洗器中,加入酒精,清洗15 min取出烘干,裝入基片夾即可。
1.3.3 濺射
首先用機械泵將工作室內的氣壓抽至1×10-1Pa,開熱偶規和分子泵電源,但分子泵顯速器到達400時,關V4開閘板閥再開電離規,由分子泵將工作室內的氣壓抽至5×10-4Pa,氣壓值由ZDF-520復合真空計來測量。當需要在制備過程中加溫時,打開烘烤單元進行加溫,用溫控儀將溫度控制在設定溫度,由室溫至300 ℃之間變化。當溫度升至設定溫度,真空度達到要求時,關電離規,打開氣體流量顯速儀清洗后調至閥控,再開Ar、N2氣瓶,往真空室內充入工作氣體氬氣和反應氣體氮氣,氮氣的流量由質量流量計來控制,單位是SCCM(mL/s),通過調節閘板閥來控制總壓,總壓由壓強控制儀來控制,一般設定為0.5 Pa左右。采用直流金屬靶進行濺射時,應打開電源先預熱5~10 min,此后開啟電源,逐漸增加電壓直至起輝,然后將功率調至所需要的數值。然后無論是直流濺射還是射頻濺射,在打開擋板之前,最好都先預濺射2 min,目的是將表面的雜質及其它污染物濺射在擋板上,以增加基片上薄膜的純度,然后移開擋板進行濺射[14]。濺射之后,關閉直流或射頻電源,停止充入工作氣體,如果在濺射沉積薄膜過程中有加溫行為的話,此時可以關閉烘烤單元,停分子泵。最后,把制備好的薄膜樣品從濺射室內取出來,編號封裝,以待進行各項性能的檢測。
1.4 薄膜的表征
1.4.1 物相的測定
本工作利用菲利普公司生產的X’Pert PRO型X射線衍射儀來分析薄膜的相及膜厚。測試條件如下:銅靶;電壓40 kV;電流40 mA;掃描角度范圍30°~80°;步長0.05°/s;掃描速度0.1°/s。利用標準的PDF卡片對膜的物相進行標定。
1.4.2 組織形貌觀察
分辨率:高真空模式與環境真空模式:30 kV時3.5 nm;低真空模式:30 kV時<15 nm;最大樣品電流2 μA;真空<6×10-4~4 000 Pa(高真空、環境真空、低真空模式);自動對中樣品臺,X=Y=50 mm;Z=50 mm(其中電機驅動25 mm),可連續旋轉360°,可傾斜-15°~+75°。
1.4.3 殘余應力測試
采用X-350A型X射線應力測定儀,隨機選取試樣表面區域,測試沉積樣品表面的殘余應力數值,由儀器自動生成相應的殘余應力值。試驗時X管高壓22 kV,管流6 mA,根據材料選擇掃描范圍139°~126°,2θ掃描步距為0.1°,計數時間為6s,重復掃描范圍兩次得衍射峰,選取Ψ角分別為0°、45°,入射、發散狹縫分別為2 mm。其中K為應力常數。
計算原理根據公式:
(1)
式中:E——彈性模量,單位為MPa,采用納米壓痕法直接測得;
μ——薄膜材料的泊松比(查得TaN的泊松比μ為0.22);
θ0——無應力下的布拉格角(取實測值),根據以上數據求得試樣的K值。
根據布拉格衍射方程2dsinθ=λ和立方晶系面間距公式,求出殘余應力。根據布拉格定律及彈性理論可以導出,應力值σ正比于2θ隨siN2ψ的斜率M,即:σ=K×M此處由應力測定儀自動完成測量并給出最終結果。
2 實驗結果及分析
薄膜材料是由它所附著的基體支承著,薄膜與基體之間構成了相互約束相互作用的統一體。這種相互作用宏觀上以兩種力的形式表現出來:一是表征薄膜與基體接觸界面間結合強度的附著力;二是反映薄膜單位截面所承受的來自基體約束的作用力——薄膜應力,通常指內應力,即應力是由薄膜本身的微觀結構所決定的,而不是由外力加載所引起的,薄膜與基體間附著力的存在是薄膜應力產生前提條件。
膜基結合力的大小是衡量薄膜性能的一項重要指標,膜基結合力的大小與薄膜制備過程中的很多因素有關:反應氣體流量、基片溫度、功率、工作壓力、偏壓等。因此,研究工藝參數對薄膜性能的影響是十分必要的。筆者就以上面描述的幾個工藝參數為變量,通過掃描電鏡(SEM)、能量散射譜(EDS)、X射線衍射儀(XRD)、殘余應力測試儀等方法,研究了工藝參數變化對薄膜殘余應力、組織、成分、相結構等的影響。
2.1 反應氣體流量的影響
表1列舉了不同反應氣體流量即不同氮分壓下的TaN薄膜制備工藝。其中Ar:N2比值如表所示,但氣體的總流量是恒定的,均為20sccm,目的是為保證濺射TaN薄膜過程中的工作壓力。根據表1制得3種不同TaN薄膜后對其進行SEM、EDS、XRD及殘余應力測試,其結果將在以下的內容中進行分析。

表1 不同反應氣體流量下TaN薄膜制備工藝
2.1.1 薄膜組織形貌及成分
采用FEI Quanta 200 FEG型電子掃描顯微鏡對薄膜進行分析,所得不同氮分壓下的組織形貌和表面成分分別如圖1和2所示。
由圖1可知:N2流量越高,薄膜的晶形越好。在氮化鉭薄膜的生長初期,沉積原子凝結聚集成直徑達1~10 nm的島狀晶核,隨著沉積原子的到來,有些島與島可合并生長,有些島則不能合并,而是按各自結晶方向生長、橫向擴展和彎曲延長,在島與島之間留有狹窄的“空道”裸露在襯底表面,使薄膜表面看上去呈網狀或稱溝道結構。隨著島狀結構的繼續生長,“空道”被沉積原子逐漸填充,需要一定填充時間才能消除絕大部分空隙,形成生長晶柱與空隙相互圍繞的蜂窩狀連續體薄膜,構成連續體薄膜需要生長的薄膜厚度至少約100 nm。

(a)Ar∶N2=18∶2 (b)Ar∶N2=16∶4 (c)Ar∶N2=12∶8
圖1不同氮分壓下薄膜的表面形貌FESEM照片

(a) Ar∶N2=18∶2

(c) Ar∶N2=12∶8
由圖1結合以上的分析認為可能是由于隨著氮氣流量的升高,島合并變得越來越容易,使得留有的空隙減少,從而使薄膜變得更加致密,薄膜內部的缺陷增加,薄膜的機械性能發生改變。

表2 氮分壓與TaN薄膜中成分關系
由圖2和表2可知:N2流量越高,薄膜中氮含量越高。當N2增加時薄膜成分向化學計量比的TaN靠近。在磁控濺射薄膜過程中,低壓氣體放電效應使得真空環境中的Ar、N2成為能量很高的等離子體狀態,與Ta靶碰撞發生能量的交換和化學反應,當入射離子的能量在100 eV~10 keV范圍時,離子會從靶表面進入靶的內部,與構成靶材的原子和電子發生碰撞。如果反沖原子的一部分到達靶的表面,且具有足夠的能量,那么這部分反沖原子就會克服逸出功而飛離靶表面沉積在基片表面。由于反沖原子和等離子體的能量都很高,不同原子間會發生鍵合反應。升高反應氣體的流量,那么發生反應的幾率也就隨之升高。氮氣流量的升高,使得濺射在基片上的薄膜中氮化鉭的含量升高。

圖3 不同氮分壓下薄膜相結構
2.1.2 不同氮分壓的TaN薄膜相結構
根據表1制得不同氮分壓下的TaN薄膜,采用菲利普公司生產的X’Pert PRO型X射線衍射儀進行相結構的分析結果如圖3所示。
峰按角度從小到大依次為(111)、(200)、(220)。由圖可以看出當Ar∶N2為18∶2時雖然有衍射峰出現但峰強很小,說明薄膜大部分是處于非晶態的。隨著N2含量的增加當Ar∶N2達到16∶4時(111)衍射峰的強度很高并且比較尖銳這說明TaN薄膜已經基本完成了非晶態向立方晶態的轉變。氮分壓進一步升高可以發現(200)峰有所增強而(111)峰和(220)峰的峰強明顯降低,TaN薄膜的擇優取向發生了明顯的變化。同時根據SEM對于表面形貌的觀察發現,氮分壓的升高使得晶粒尺寸變細,隨著氮含量的增大使得薄膜的結晶狀態變好。與以往的研究相似,隨著氮含量的增加膜的結晶結構的變化為:原始為單質β-Ta隨N2含量的增加首先轉變為密排六方的Ta2N,隨氮分壓的進一步提高產生面心立方TaN與密排六方Ta2N這兩相,如再增加氮氣的含量將得到單一的面心立方結構相,這與EDS的測試結果是相符合的隨著氮分壓的增加,Ta與N的原子比逐步有2∶1趨向1∶1。
2.1.3 反應氣體流量對殘余應力的影響

表3 不同反應氣體流量下TaN薄膜殘余應力測試結果
表3為不同反應氣體流量下TaN薄膜殘余應力的測試結果,根據表3得到了如圖4殘余應力的變化曲線。
由圖4可見,隨著氮氣分壓的升高,薄膜的殘余應力也隨之升高,且殘余應力均表現為拉應力。升高N2分壓,高能的N2與Ta反應的幾率增大,薄膜中TaN的含量就增高由于N2原子的半徑與Ta的原子半徑比0.75/2.09=0.359<0.59形成的化合物具有簡單的晶體結構稱為間隙相。這種間隙相的TaN的密度為14.4 g/cm3,與金屬Ta的密度16.6 g/cm3相比,略為減小。所以增高反應氣體N2的流量使得薄膜的密度減小,表現為薄膜所受的拉應力越來越大。

圖4 不同氮氣分壓下殘余應力
2.2 基體溫度的影響
2.2.1 薄膜組織形貌與相結構
不同基體溫度的薄膜濺射工藝如表4所示。圖5和圖6分別為不同基體溫度下的薄膜表面形貌以及基體溫度為300 ℃時的截面形貌。

表4 不同基體溫度下TaN薄膜制備工藝
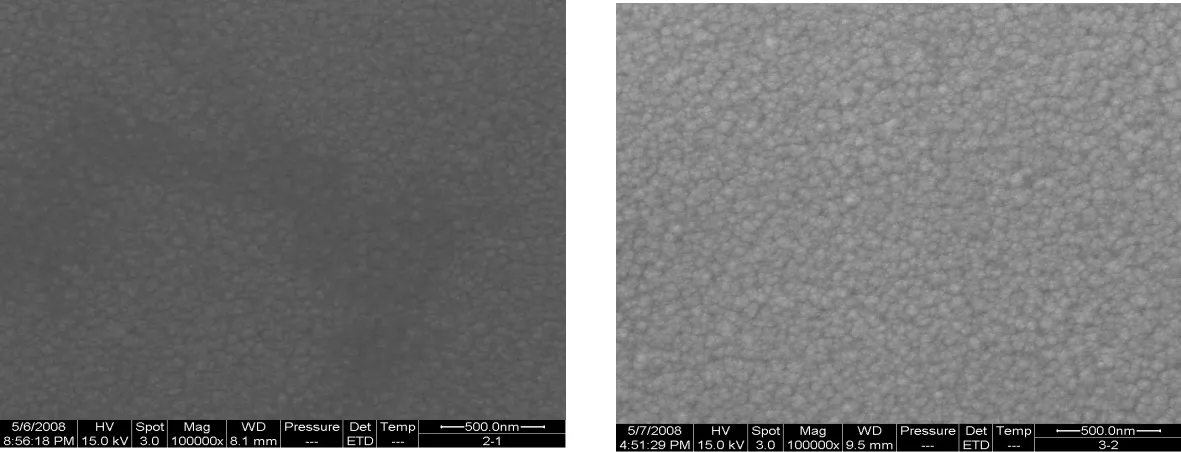
(a) 300 ℃ (b)25 ℃
圖5不同基體溫度下薄膜的表面形貌FESEM照片
在不同的基體溫度下濺射TaN薄膜,用SEM對TaN薄膜進行微觀結構分析發現:高溫下有利于薄膜的生長,可以產生較大晶粒,結晶致密。觀察圖5基體溫度300 ℃下的截面形貌發現,高溫下的制備的薄膜表面平坦,除一突起處外,無明顯缺陷。而由于較低的溫度不利于薄膜的生長和結晶,因此所濺射的薄膜晶粒細小,微觀缺陷略大,如果對室溫下的TaN薄膜截面進行觀察它的平整度應略次于300 ℃時的形貌。
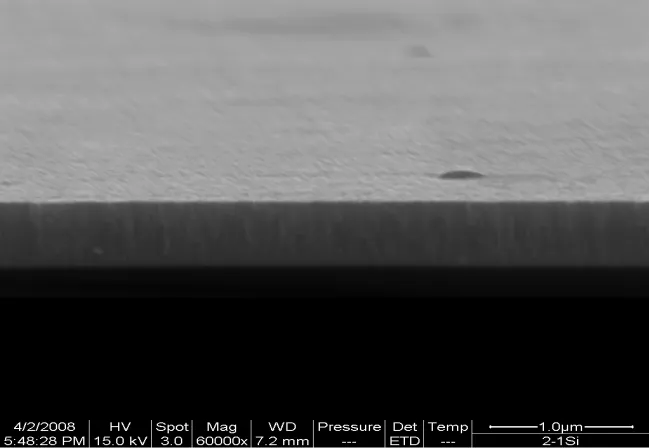
圖6 基體溫度300℃下薄膜的截面形貌FESEM照片

圖7 不同基體溫度下薄膜的相結構
由圖7不同基體溫度下薄膜的相結構可知,薄膜結晶狀態很好,且兩溫度下,薄膜具有相同的晶體結構。通過各個衍射峰的對比,并沒有出現有明顯擇優取向的晶面,說明在不同基體溫度下,沉積的TaN薄膜的晶體結構沒有變化。均為面心立方結構。
2.2.2 基體溫度對殘余應力的影響

表5 同基體溫度下TaN薄膜殘余應力測試結果
表5為不同基體溫度下TaN薄膜殘余應力的測試數據,由此可以得到如圖8所示的曲線。
由圖8可知:基片溫度升高,薄膜殘余應力也隨之升高。莫夫章和迪姆森首次提出了可按沉積薄膜的條件將生長薄膜結晶特征劃分為3種晶帶區域的模型,簡稱為M-D模型。該模型提出:沉積薄膜的結構取決于薄膜生長的條件和隨后出現的演變,包括初始形成的分立晶核、晶粒邊界遷移和結晶過程中發生的所有變化。M-D模型認為薄膜的生長溫度是決定其晶型的一個重要參數。通過觀測多種材料的薄膜的晶粒的生長及再結晶過程發現,基片溫度Ts與薄膜材料的熔點Tm之比Ts/Tm是決定晶型結構的一個共性參量。M-D模型按Ts/Tm比值將沉積薄膜結構劃分為3個晶帶區域,其基本特點為[15]:
晶帶區域Ⅰ:0.1 晶帶區域Ⅱ:0.25~0.30 晶帶區域Ⅲ:Ts/Tm>0.45,薄膜大多由各向同性的等軸晶粒構成,具有明亮的表面和密實的膜體,基本上接近材料的晶型特征。 在本工藝下,基片的溫度25 ℃和300 ℃均較低。薄膜的生長按晶帶區域Ⅰ的特點生長。即薄膜由帶圓頂的錐狀晶柱構成,晶柱隨溫度升高而變粗,晶柱間產生貫通薄膜的空隙。產生的應力為拉應力,且隨溫度的升高,應力增大。 圖8 不同基體溫度下殘余應力 2.3.1 薄膜組織形貌與相結構 不同功率下薄膜濺射的工藝如表6所示。采用SEM、XRD等方法得到的表面形貌及相結構如圖9、圖10所示。 表6 不同濺射功率下TaN薄膜制備工藝 由圖9可見:濺射功率越高,薄膜的顆粒越大。150 W濺射的薄膜的顆粒比50 W的要大好幾倍。濺射的功率越大,使得濺射沉積的原子能量越大,其對應的溫度也越高,也就有利于沉積晶柱變粗和晶粒的長大。 (a)150 W (b)100 W (c)50 W 圖9不同濺射功率的組織形貌 由圖10可知:隨著濺射功率的增大,濺射沉積薄膜的結晶態越好,50 W時由于功率太低,濺射離子的能量不是特別高,N2還不能夠斷裂其自身的共價鍵而與Ta鍵合。所以在50 W功率下,XRD只測得沒有發生化學反應的Ta。隨著功率的升高,在100 W和150 W時,離子的能量足以使化學反應順利進行,但由于兩種功率相差不大,所以該反應也無多大變化。反應生成的產物具有相同的相結構。 圖10 不同濺射功率的相結構 編號實測彈性模量E (GPa)實測θ0值應力常數K殘余應力(MPa)(a)155.2130.359-51373(b)136.8132.297-4151480(c)171.7129.398-58179 2.3.2 濺射功率對殘余應力的影響 表7為不同功率下TaN薄膜殘余應力測試結果,由此可以得到濺射功率對薄膜殘余應力的影響曲線如圖11所示。 圖11 不同濺射功率下殘余應力 由圖11可見:隨著沉積功率的降低,薄膜的殘余應力不是呈線性變化的,而是先增大后減小,呈拋物線形式變化。這是因為,不同功率下沉積的速率是不同的,功率越大沉積速率越大,減小沉積功率沉積速率也就隨之減小。但由于在本實驗中,除功率這一變量外其他工藝參量均相同,即沉積濺射時間等參數均相同。因此,減小功率使得濺射的薄膜厚度也在減小。而薄膜的厚度和殘余應力并不是呈線性關系變化的,薄膜厚度的變化,使薄膜結晶狀態與基體界面性質發生變化。就本實驗而言,厚度對應力的影響和功率相同,即保持同向變化。 表8 不同工作氣壓下TaN薄膜制備工藝 不同工作壓力的薄膜制備工藝如表8所示。不同工藝下制得的薄膜表面形貌如圖12。由圖12可以看出,可知工作氣壓越高,薄膜相對越致密,顆粒也越細。 (a)0.3 Pa (b)1.0 Pa 圖12不同工作壓力的薄膜形貌 采用X-350A型X射線應力測量儀測得不同工作壓力下的殘余應力如表9所示,由此可得曲線如圖13所示。 表9 不同工作壓力下TaN薄膜殘余應力測試結果 圖13 不同工作壓力下殘余應力 由圖13曲線可知:工作壓力的增大,薄膜的殘余應力也增大。即使對同一物質而言,不同的工作氣體壓強可以使薄膜內產生性質完全不同的內應力。一般說來,薄膜的脫落是有拉伸應力所致,而壓縮應力主要引起薄膜產生變形。對制取薄膜的某一性質的要求會因應用對象的不同而有所偏重,但希望薄膜內應力小的要求往往是一致的。經前人對工作Ar氣壓強對濺射沉積W薄膜殘余應力的影響顯著,所以,這項研究薄膜殘余應力與工作氣體壓強相關性的分析很具有代表性。反應氣體不是自然性的摻入薄膜內,或是被沉積原子層埋入薄膜內。而是低工作壓強條件使那些轟擊生長薄膜的快速Ar分子或是反射Ar離子運行足夠長的自由程和保持更大比分的攜帶能量,因而具有較大的貫穿深度和摻入薄膜的幾率[15~16]。正是由于大量的Ar元素摻入薄膜內產生大的晶格常數,使低工作Ar氣壓強條件生長的TaN薄膜呈現了較高的原子密度和較低的拉伸應力。 基于薄膜殘余應力的重要性,研究薄膜殘余應力是很有意義的。從量子力學的角度通過原子云模型來解釋應力的產生機理,從而促進薄膜應力產生機理的理論研究。為了使分析問題簡化,在此進行的殘余應力產生機理分析都是基于簡單立方晶體結構。通過類比電子云,假設晶體中的原子以原子云的形式存在,把處于束縛態的原子的概率分布定義為原子云,晶體的晶格常數的變化是由于原子云的變化所引起的。 在原子云假設的基礎上,建立勢能函數,用來求原子的概率分布的變化即原子云的變化,通過討論原子云的變化來討論基體以及薄膜晶格常數的變化,從而確定薄膜應力的產生機理。對于三維的薄膜和基體,在討論其內應力的產生時,一般只需考慮其二維的勢能函數即可,但是二維的勢能函數建立以及計算分析也是很復雜,因此建立一維的勢能函數,把一維線性諧振子模型作為要建立的勢能函數,易于理論分析。 定義勢能函數表達式為:U=1/2(mω2χ2) 其中U為勢能,m為原子的質量,ω為常量,表示振子的固有角頻率,x為此一維坐標。其函數圖形如圖14,其中a為晶體的晶格常數。 圖14 一維線性諧振子勢能函數圖 理論推導 根據勢能函數:U=1/2(mω2x2) 其薛定諤方程為: 則薛定諤方程可改寫成: 解這個方程可以得到: (2) (3) 圖15 n=1和n=2時原子的概率分布 圖15示出了n=1和n=2時原子的概率分布。 由式(2)可知,在晶體中原子的能量是量子化的,而且其存在一個零點能,這在很多文獻中均有討論。對于式(3),聯系圖15中原子的概率分布,可以得出,隨著原子能級的增大,原子云將變大,就使晶體的晶格常數變大以及上述勢能函數發生變化。但是對于晶體中的原子,還受到原子間的鍵合力影響,這個鍵合力的作用將使原子變小,這樣由于鍵合力的作用,原子云并不會變為無窮大,而是增大最終達到一個平衡的狀態,最終導致原子能級增大會使晶體的晶格常數變大,也就會使晶體出現熱脹冷縮現象。而當這個鍵合力不能夠束縛住這兩個原子云的時候,將使兩原子云之間的鍵斷裂或變成其它類型的鍵。對于不同的晶體材料,其勢能函數、鍵合方式、鍵合力以及兩原子云的勢能最低點都不同,這就導致了其溫度降低時,不同的晶體材料從某一溫度到另一溫度的熱脹冷縮量一般都會不同。 通過類比電子的能帶理論,認為原子在晶體中也會出現能級分化,進而出現能帶,兩能帶之間也將其稱為禁帶,并且提出一個假設,在不考慮電子的熱運動的前提下,晶體的熱導是和原子能帶的帶寬度有關的,就好像導體、半導體、絕緣體和電子能帶的禁帶寬度有關類似;也就是說禁帶寬度寬的晶體的導熱能力差,禁帶寬度窄的晶體的導熱能力好,晶體的導熱系數是由其原子的禁帶寬度決定。 在一些薄膜制備過程中,要求基體溫度一般都較低,而在物理氣相沉積的過程中,入射原子只有在很大動能的情況下才能到達基體,這樣就使吸附原子、成核原子的能量一般都大于基體原子的能量,而吸附成核原子的能量大意味著其能級較基體原子能級高。 首先不考慮本征應力,假設薄膜與基體原子相同來分析熱應力的產生。薄膜的生長方式是通過入射原子在基體表面運動、成核、長大成島、島的聯并最終形成薄膜的。在薄膜與基體原子相同的情況下,由于入射原子能量高,吸附原子的原子云就比基體原子的原子云大,就使薄膜比基體晶體的晶格常數大,出現了薄膜與基體晶格的不匹配,并且它與基體的晶格是由匹配到不匹配再到匹配這樣一個循環的過程(如圖16所示,圖中圓圈表示原子云的大小),當冷卻以后,薄膜與基體的溫度趨于一致,二者原子云一樣大,于是就產生了熱應力。而且在那些薄膜與基體的晶格不匹配處,產生的殘余張應力是最大的,也是薄膜最有可能開裂的地方,這就說明了薄膜開裂為什么大多都不在一處。在本實驗中在以氮氣分壓為單一變量的工藝中,制備的TaN薄膜為單一的面心立方結構。其晶格常數為a=0.433 99 nm與金屬Ta相比(Ta的晶格常數為a=0.329 59 nm),TaN的晶格常數較大,其對應的原子云也比Ta大。在實驗中增大N2流量,TaN的含量也隨之升高。估且把TaN和Ta混合的膜看做是由一種原子構成的。那么TaN的含量越高,假設這種原子的原子云就越大,其對應的晶格常數就越大,與基體的晶格常數相差就越大。所以升高N2的流量所制備的薄膜的殘余應力就越大。與實驗所得數據相吻合。同時也說明了為什么在濺射制備薄膜的時候,加大功率因素,就更加容易出現薄膜開裂,因為加大了功率因素,也就加大了入射原子的能量,這樣吸附原子的原子云就會更大,薄膜與基體的晶格不匹配度就會加大,這就增加了薄膜的張應力,增加了薄膜開裂的可能性。在本實驗中,在以濺射功率為單一變量的工藝中,所制薄膜的殘余應力測試結果表明,在功率由50 W增大到100 W時,殘余應力增大,與該理論吻合。從100 W增大到150 W時所測結果與該理論不符,分析認為這可能是由薄膜厚度的迅速增加引起的。對于工作壓力對殘余應力影響的解釋,已在前文中詳細介紹,這里不在贅述,亦可采用本節采用的機理對其進行解釋。由此可見,原子云的概念可以很好地解釋熱應力的形成。 圖16 熱應力的形成機制 其次分析本征應力的產生。當基體原子與吸附成核原子不同的時候,由于原子類型的不同,它們兩原子間的鍵合力就不同,導致兩原子云之間的勢能最低點不同,使薄膜與基體在相同溫度下的勢能函數不同,于是即使在相同的溫度下薄膜與基體原子的原子云的大小也會不同,最終導致基體與薄膜的晶格常數不匹配。但這并不能說明只要基體材料與薄膜材料不同就會出現晶格不匹配,因為晶格常數有很多因素所共同決定,只有在基體與薄膜的晶格常數不同的情況下,由于晶格常數的不匹配才會有本征應力的出現。由此可以得出,本征應力的產生是由于基體與薄膜的晶格常數不匹配造成的,而晶格常數的不匹配是由于薄膜與基體的不同(導致勢能函數、鍵合力和勢能最低點的不同)和原子云大小的不同所共同作用的結果。 而不同材料的原子云隨著溫度的增大(減小)的比例一般是不相同的,這樣溫度的不同對于不同的材料一般也會有熱應力的出現,這就是膨脹系數導致薄膜熱應力出現的根本原因。薄膜的殘余應力還受其結構的影響,薄膜的晶化條件的變化必然會引起薄膜結構的改變,從而引起薄膜殘余應力的變化。就如以基體溫度為變量的實驗所表明的那樣,隨著薄膜晶化溫度升高,薄膜的晶化條件發生改變從而導致薄膜殘余應力呈變大的趨勢。 筆者通過實驗研究了磁控濺射沉積制備薄膜的工藝參數:反應氣體流量、基體溫度、濺射功率和工作壓力對TaN薄膜殘余應力、組織形貌、成分、相結構等的影響。 實驗中利用掃描電鏡對所制備的薄膜進行了表面形貌觀察,用EDS進行了表面成分分析,利用XRD進行了物相分析,用X射線應力衍射儀進行了殘余應力的表征,并從量子力學角度闡述了在物理氣相沉積制備薄膜過程中應力產生的機理。 通過對實驗數據的分析,得到了磁控濺射法制備具有最小殘余應力TaN薄膜的工藝參數,即反應氣體流量為2 sccm,基體溫度在25 ℃,濺射功率為150 W,工作壓力為0.3 Pa。 TaN薄膜以其優異的機械性能,良好的生物相容性和電學性能,必將在未來的科技發展中占據重要的地位。
2.3 功率對薄膜殘余應力的影響

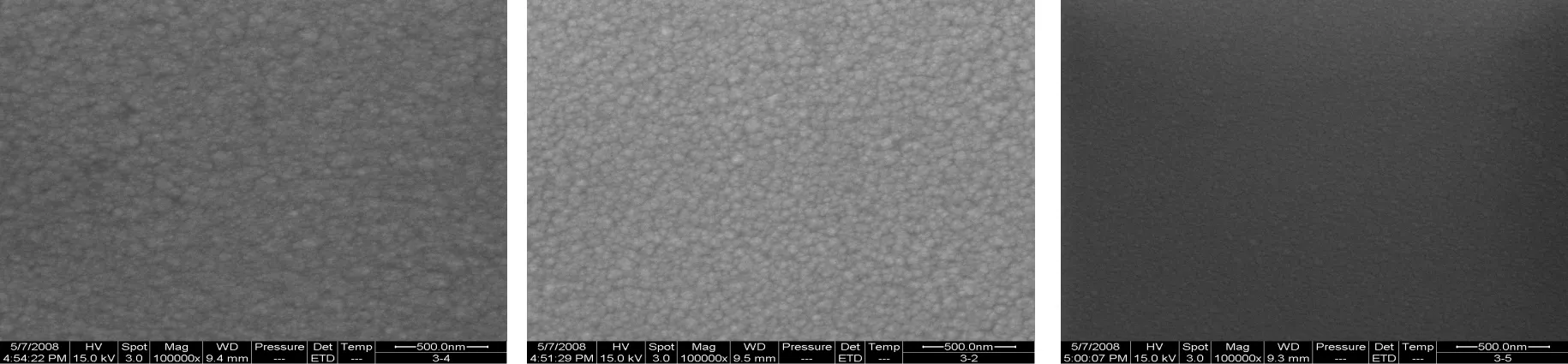



2.4 工作壓力的影響




2.5 殘余應力機理分析



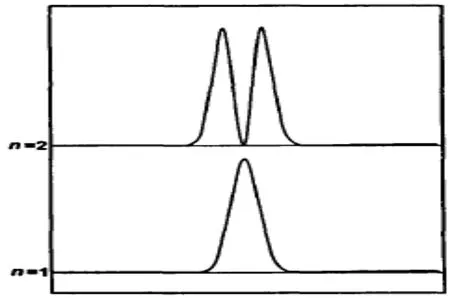

3 結論

