半導體上轉換單光子探測技術研究進展?
白鵬張月蘅 沈文忠
1)(上海交通大學,人工結構與量子調控教育部重點實驗室,上海 200240)
2)(人工微結構科學與技術協同創新中心,南京 210093)
(2018年4月8日收到;2018年5月24日收到修改稿)
1 引 言
單光子探測是指單個光子量級的光吸收就能夠引起宏觀可觀測電學變化,是極限靈敏程度的光子探測技術.單光子探測在量子信息處理、量子保密通信、激光雷達、宇宙學等領域具有重要意義[1?6].近年來,量子通信技術取得了卓越的進步和發展,隨著空間量子通信[7,8]和海水量子通信[9]的相繼實現,量子通信距離實際應用越來越近.而針對1550 nm的單光子探測器則是基于當前光纖通信系統的量子通信中至關重要的一部分.由于上述應用的牽引,單光子探測技術取得了令人矚目的進步,同時大大促進了“少數光子”科學與技術的發展.當前針對1550 mn的主流單光子探測器包括超導探測器[10]、單光子雪崩二極管[11]以及基于光參量頻率上轉換的單光子探測器[12].
經過多年的發展,超導納米線單光子探測器(superconducting nanowire single photon detector,SNSPD)各方面的性能指標均接近或者達到了理想單光子探測器的極限,包括極高的系統探測率(>90%),極低的暗計數(無背景輻射情況下DCR<1 cps),極短的時間抖動(~150 ps)和極短的重置時間(~40 ns)[10].但是,SNSPD大規模推廣應用的最大阻礙是其極低的工作溫度(<3 K).頻率上轉換單光子探測器是通過非線性光學晶體中的和頻功能將通信波段的光子轉換為可見光子,再利用商用的Si-雪崩二極管來探測[12,13?17].強抽運光作用下,這種探測器可以實現高探測效率(PDE),高計數率(>60%),并且沒有后脈沖的影響.但是其暗計數可以達到~105cps[12,18].關于這一探測器的最新研究顯示其可以在弱光泵浦條件下實現20—100 cps的暗計數,但是對應的PDE僅為5%—25%[19].此外,相對復雜的光路設計和相對較窄的光譜響應也不可避免地限制了這一探測器的應用范圍.
在300—900 nm波段,硅單光子雪崩二極管(Si-SPAD)性能優異.單光子量子探測效率最高可達70%,暗計數率小于50 Hz,后脈沖效應小,可連續計數,光子到達時間抖動半高全寬在數百皮秒量級[20].如果采用合適的驅動電路,Si-SPAD可以具有一定的光子數分辨能力[21].Si-SPAD優異的單光子探測性能主要來源于高質量的Si材料.但是Si的禁帶寬度較大,當探測波長大于1μm時,其量子效率迅速降低至1%以下,失去實際應用價值[20].
InGaAs/InP SPAD與現有光纖通信系統相容性高、工作溫度處于熱電制冷區,在量子保密通信應用中具有較為明顯的優勢.然而,由于InP倍增層中的深能級中心密度遠高于Si,使InGaAs/InP SPAD的后脈沖效應遠高于Si SPAD.這一特性使得Si-SPAD必須工作于門控模式下,Comandar等[22]報道的門控模式InGaAs-SPAD實現了55%的探測率,幾乎接近APD的探測極限,但是其后脈沖效應接近10%.必須指出的是,門控模式的InGaAs-SPAD只適用于少數場合,當不確定光子到達精確時間時,器件必須工作在自由運行模式下[23].然而自由運行的InGaAs-SPAD的效率只有10%,對應的后脈沖效應仍接近2%[23,24].
以InGaAs為吸收層、Si為倍增層是一種有益的嘗試.Si倍增層具有電子空穴電離比率高、缺陷態密度低、缺陷能級少等特點,與InGaAs/InP相比暗電流更小.InGaAs與Si晶格常數差異較大(7.5%),無法通過外延生長直接制備集成.有報道采用晶片鍵合技術制備InGaAs/Si p-i-n探測器[25,26]和InGaAs/Si雪崩二極管[27],實現了820 MHz頻率下10倍增益、600 MHz頻率下135倍增益的器件,量子效率低于40%,器件性能有待優化,尚且不能滿足高性能單光子探測器的實際需要.
在各種紅外上轉換技術中,半導體紅外上轉換技術受到了廣泛關注.半導體紅外上轉換器件通常由紅外探測器和發光二極管兩部分組成,其中紅外探測器吸收紅外光,產生的光生載流子遷移至發光二極管工作層,發生輻射復合產生近紅外或者可見光子,從而實現光子頻率上轉換.迄今為止,人們研制了基于帶間躍遷、內光發射、子帶間躍遷等不同機制,面向近紅外、中紅外、遠紅外和太赫茲等不同波段的半導體上轉換器件,并且在此基礎上實現了無像元半導體上轉換成像[28?33].應用于光纖通信波段的半導體紅外上轉換技術具備一系列獨特優點:可以工作在低激發光強,熱電制冷溫度甚至室溫等情況下,并且結構緊湊,而且可以實現大規模生產.更重要的是,半導體上轉換器件極高的上轉換內量子效率(>80%)[34]為近紅外單光子探測提供了一種新的選擇和思路.
本文聚焦當前基于半導體材料的可見光或近紅外單光子探測器,對其各自的原理、性能、優勢及劣勢進行相關評述.基于我們在半導體光電器件與物理、尤其是半導體紅外上轉換成像器件方面的前期工作,提出一種1.3—1.55μm光纖通信波段半導體上轉換單光子探測方案[35];詳細地闡述了上轉換近紅外單光子探測器(USPD)的基本原理,細致地討論了其器件結構及其優化,給出了USPD器件的性能指標;給出了USPD單光子探測方案的最新實驗進展及器件制備工藝,并且對這一新型單光子探測器的發展趨勢和未來研究方向進行總結和展望.
2 半導體單光子探測器
半導體作為20世紀四大發明之一,在過去的近百年時間里有力地支撐了信息時代的技術要求及相關產業發展.其應用領域囊括集成電路、計算機、光通信、無線通信、清潔能源、白光照明、發光二極管(LED)、激光測距[36]等諸多方面.在近年來新興的量子計算和量子通信領域,半導體單光子探測器更是起著至關重要的作用.當前的量子計算和量子通信均基于對光子的操縱,通信性能或者計算指標都嚴重依賴于接收端的單光子探測器.目前應用最廣泛、技術最成熟的單光子探測器是半導體單光子探測器.主要有硅單光子雪崩二極管(Si-SPAD)、銦鎵砷單光子雪崩二極管(InGaAs-SPAD)和半導體量子點探測器(QDOGFET).本節對上述三種探測器從技術原理、性能指標、應用范圍三個方面進行簡要評述,并分析其各自優勢及劣勢.
2.1 Si單光子雪崩二極管
Cova等[37]在1983年首次報道了在非線性工作模式(蓋革模式)下,利用Si雪崩二極管(APD)實現了單光子探測.雪崩二極管工作于蓋革模式時,每對光生電子-空穴都能引發可維持的雪崩電離,形成宏觀電流.引入雪崩淬滅電路后,單個光子的吸收對應一個可測量的宏觀電脈沖,其增益大于106,從而實現單光子的探測.與其他單光子探測方案相比,單光子雪崩二極管探測器(SPAD)具備單光子探測效率高、功耗低、可靠性高等優點[17].根據探測波段的不同,用于制備雪崩二極管吸收層的材料有Si,Ge和In0.53Ga0.47As(以下簡寫為InGaAs)等,在滿足晶格匹配條件下,雪崩層采用Si,Ge和InP等.
Si-SPAD是工作于二極管雪崩電壓之上的極靈敏光電探測器.光子通過探測器光學窗口進入Si材料內部,然后被內部材料吸收后,產生一對電子-空穴對.產生的光生載流子在電場加速作用下遷移到探測器倍增區,在特定條件下,光生載流子會在倍增區與晶格發生碰撞電離,不斷產生新的光生載流子.正是基于此原理,Si-SPAD可以探測微弱的光子信號(線性模式).為了可以探測單光子級別的極微弱光信號,Si-SPAD的工作偏置電壓必須高于二極管的雪崩電壓(蓋革模式)[38].蓋革模式下,單個光子被吸收后產生的光生載流子在倍增區發生更加劇烈的碰撞電離.由于二極管發生雪崩效應時,內部瞬時功率急劇上升,因此必須加入相關抑制電路對器件進行保護.實際應用中采用主動淬滅[39]和被動淬滅[40]兩種方式對器件偏置電壓進行復位,避免其長時間處于雪崩狀態,從而損毀器件.
經過多年的發展,Si-SPAD至今已經相當成熟.圖1(a)所示為一種經過優化的雙外延結構的Si-SPAD.這種結構的優勢在于[39,42]:1)在n型襯底上外延生長~10 mm的p型高質量硅,較于直接在襯底上進行器件制備,對于器件性能會有很大的提升;2)耗盡層的厚度主要由外延生長的p型襯底中的p-n結決定;3)p++buried layer為雪崩電流提供了一個低阻通道;4)耗盡區域外部的p型輕摻雜區相當于提供了一個防止邊緣雪崩效應的保護環;5)薄耗盡層的結構大幅度提升了器件的時間分辨率(時間抖動<40 ps).但是由于耗盡層相對較薄,這種結構的最大缺點就是犧牲了器件的光子探測效率(PDE<40%).
為了獲得更高的光子探測效率(PDE>70%),可以采取厚耗盡層結構[43],如圖1(b)所示.這種厚耗盡層結構的SPAD并非平面結構,因此其與薄耗盡層結構的SPAD制作工藝有較大差異.經過多年的發展,這一結構的Si-SPAD已經相當成熟.得益于其厚的耗盡層結構,該SPAD的光子探測范圍覆蓋可見和近紅外波段,其中540—800 nm的光子探測率均超過50%,并且對1μm的光子都有顯著的響應[44].

圖1 i-SPAD器件示意圖 (a)薄耗盡層雙外延結構[39];(b)厚耗盡層結構[41]Fig.1.Schematic cross-section of Si-SPAD:(a)Double epitaxial SPAD device structure[39];(b)thick depletion layer SPAD device structure for high PDE[41].
耗盡層有幾十微米的量級,但是器件的暗計數率(DCR)卻并不高,在零下15?C的工作溫度下,器件DCR可以保持在幾十到幾百的范圍內[44].得益于Si材料的高質量,這一結構的SPAD的后脈沖效應可以被抑制到最大不超過1%[44].盡管多個性能指標都極佳,但是這一結構也有其不可避免的缺點.與薄耗盡層結構相比,這一結構的時間分辨率并不高(~400 ps)[45],但是可以通過聚焦光到器件中心感光區域或者使用電流收集電路的方式來得到顯著提高[46].此外,由于這一結構的雪崩電壓格外高(200—500 V).雪崩過程中的功率損耗相當嚴重(損耗功率約為5—10 W),因此器件工作時的有效制冷措施是必不可少的[47].再者,其特殊的結構決定了其制作工藝的特殊性,這也導致了這一結構Si-SPAD造價不菲,成本頗高.
2.2 InGaAs單光子雪崩二極管
較寬的帶隙限制了Si-SPAD的探測范圍,僅限于可見或者近紅外波段,對1100 nm以上光子的響應基本可以忽略不計.若要探測1100 nm以上的光子信號,吸收層材料的帶隙必須小于1.1 eV.作為光纖通信和傳感系統的兩個重要窗口,針對1330 nm和1550 nm兩個波段的高性能單光子探測器對于當前光纖通信和量子保密傳輸起著至關重要的作用.最常用的近紅外單光子探測器為SAGCM(separate absorption,grading,charge and multiplication)結構的InGaAs-SPAD(如圖2(a)所示).InGaAs-SPAD中,InGaAs作為整個器件的吸收層,常溫下In0.53Ga0.47As的禁帶寬度為Eg=0.75 eV,對應的截止波長約為1700 nm,涵蓋1330 nm和1550 nm.與InGaAs晶格常數相匹配的InP作為器件倍增層.器件工作時內部電場分布如圖2(b)所示,倍增層中的極高電場是為了確保一個高的碰撞電離效率,從而提供一個高的雪崩增益.而吸收層中的電場相對較低,這是為了減少場致漏電.n型的電荷層則是被設計用來調控倍增層和吸收層中的電場強度.漸變的InGaAsP層則是為了減小InP-InGaAs界面處的能帶突變,避免載流子在界面集聚形成二維電子氣[48].

圖2 (a)InGaAs/InP-SPAD器件結構圖;(b)器件內部電場分布圖[11]Fig.2.(a)The SAGCM structure of InGaAs/InP SPAD;(b)corresponding electrical field in device[11].
InGaAs-SPAD的探測原理與Si-SPAD類似,入射光子透過寬帶隙的InP進入到InGaAs的吸收層被吸收產生電子空穴對.光生載流子在電場的作用下遷移進入InP倍增層中,與晶格碰撞電離發生雪崩效應,進而產生宏觀電流.值得注意的是,由于高純度高質量的InP很難生長制備,InGaAs-SPAD的暗計數和后脈沖效應均比Si-SPAD高出許多[49].為了抑制暗計數和后脈沖效應,InGaAs-SPAD一般工作在門控模式下,即只有在光子數到達極短的時間里使得SPAD的反向偏壓高于雪崩電壓.經過優化,當前門控模式的InGaAs-SPAD的光子探測率可以達到55%,測得對應的外量子效率,可以推算出80%被吸收的光子可以得到有效探測[22].但同時后脈沖在10%以上,暗計數率仍為kHz以上.由于必須精確知道光子到達探測器的時間,因此門控模式的InGaAs-SPAD僅限于量子密鑰分發系統(QKD).絕大多數的應用情況均無法得知光子到達探測器的精確時間,因此需要用自由運行模式(free running mode)[23].但是這一模式的InGaAs-SPAD還尚未成熟,往往探測率和暗計數(或者后脈沖)不可兼得,Korzh等[23]提出的自由模式的InGaAs-SPAD可以將暗計數抑制到1 Hz,但是對應的PDE僅僅只有10%,后脈沖仍然高達2%,遠不到實際應用的階段.
2.3 半導體量子點單光子探測器
基于半導體量子點的單光子探測器件是近年來新興的單光子探測方案[50].其中量子點光學門控場效應晶體管(quantum dot optically gatedfield-effect transistor,QDOGFET)為一種探測效率較佳的半導體探測器,其結構示意圖及探測原理見圖3.該器件在GaAs襯底上自下而上生長200 nm的GaAs緩沖層、2.5 μm的Al0.2Ga0.8As、Si δ摻雜層、70 nm的Al0.2Ga0.8As、100 nm的GaAs吸收層、密度為400—500μm?2的InGaAs量子點、200 nm的Al0.2Ga0.8As、最后為10 nm的n型摻雜(~ 6×1017cm?3)的GaAs帽層.源極和漏極金屬為Ni/Au/Ge,柵極金屬為Pt,光學窗口約為0.7μm×0.7μm,Al2O3一方面可以對器件表面鈍化,降低噪聲,另一方面可以將外部光學窗口金屬與器件分離.
器件的單光子探測原理如圖3所示,入射的805 nm的光子進入器件,首先在GaAs區域被吸收,產生的電子空穴對在柵極反向電壓的作用下,電子注入二維電子氣中,而空穴則遷移至量子點處被俘獲,俘獲空穴的量子點將改變源極和漏極之間的溝道電流Ids,從而實現對光子信號的探測.
值得注意的是,即使是單個空穴的俘獲,也會引起Ids的宏觀變化,這一獨特的性能決定了QDOGFET與生俱來的光子數分辨能力[50].這種單光子探測器件的效率可以達到60%(~820 nm)以上,同時又能保證極低的暗計數[51].但是受GaAs帶隙所限,其吸收光波長無法拓展至1μm以上,對于通信波段的(1330 nm和1550 nm)的光子幾乎沒有響應.此外,該器件的探測原理是基于量子點對空穴的俘獲,因此這類型器件對于溫度極其敏感,必須工作在極低的溫度下(~4 K)[51],這也限制了其應用范圍.
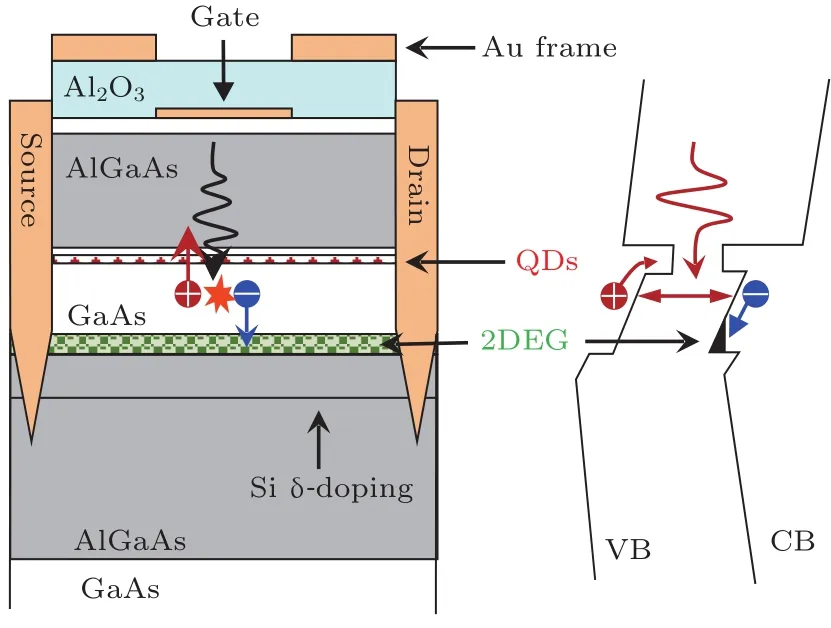
圖3 光學門控場效應晶體管器件結構示意圖及能帶結構圖[50,51]Fig.3.Schematic diagrams of the composition and band structure of the QDOGFET[50,51].
3 上轉換單光子探測器
上轉換單光子探測器(USPD)[35]是一種基于近紅外半導體上轉換技術[30]的新型的單光子探測器,是一種全新的針對通信波段(1.33—1.55μm)的上轉換單光子探測方案.具體思路如下:以InP或者GaAs材料為襯底,利用分子束外延生長技術或者金屬有機化學氣相沉積生長1.3—1.55μm光纖通信波段p-i-n近紅外探測器,其光吸收層為InGaAs;然后通過晶片鍵合方式將近紅外探測器與GaAs LED集成,制備半導體紅外單光子上轉換器件.1.3—1.55μm波長光子被p-i-n近紅外探測器吸收后,形成的電子空穴對在外加偏壓作用下遷移至GaAs發光二極管功能層并復合發光,實現1.3—1.55μm波長光子向0.87μm波長光子的轉換.隨后,通過晶片鍵合技術或者光黏膠將半導體紅外單光子上轉換器件與Si SPAD黏合集成,上轉換而成0.87μm波長光子耦合進入Si SPAD并為其所探測,進而實現1.3—1.55μm波長單光子的探測.
3.1 基本原理
3.1.1 器件模型
USPD的結構示意圖如圖4(a)所示.整個單光子探測器件由一個半導體上轉換器件(upconverter)和一個Si-SPAD組成.上轉換器件由一個InGaAs光電探測器(PD)和一個GaAs LED通過晶片鍵合的方式制備而得.InGaAs-PD為傳統p-i-n結構,工作時需要施加反向偏壓.GaAs-LED是AlGaAs/GaAs/AlGaAs雙異質結構,工作在正向偏壓下.整個單光子探測器工作原理為:入射的1550 nm的光子首先被InGaAs-PD吸收產生光生載流子,光生載流子在電場的驅動下進入到LED的激活層發生輻射復合并且發光產生870 nm的近紅外光子.然后產生的近紅外光子再被Si-SPAD探測,進而實現單光子探測.USPD的器件等效電路圖和能帶示意圖分別如圖4(b)和圖4(c)所示.

圖4 上轉換單光子探測器示意圖[35] (a)器件結構示意圖;(b)器件等效電路圖;(c)器件能帶結構圖Fig.4.Device model schematic diagram of USPD[35]:(a)Structure of the USPD device;(b)equivalent circuit diagram of the USPD;(c)band diagrams of USPD.
值得注意的是,上轉換后的光子必須經過一個光學耦合過程然后進入到Si-SPAD中.耦合效率的高低直接影響著單光子探測效率,這將在接下來的章節中詳細討論.能帶結構圖闡明了上轉換和單光子探測過程的微觀機制,上轉換所需的額外能量來自外加電場.
從器件原理上,我們可以看出USPD同時結合了InGaAs-PD對于1550 nm光子的高吸收率和Si-SPAD的高的單光子探測率.器件這樣設計的一大優勢就是可以把傳統的InGaAs-SPAD的吸收層和倍增層分離,只利用InGaAs吸收層,轉而利用Si-SPAD當作器件的倍增層,這樣就可以大幅抑制暗計數和后脈沖效應.光子在上轉換器件中被吸收并且上轉換為短波光子,然后短波光子在Si-SPAD中被雪崩放大,進而實現單光子探測.由于上轉換器件和Si-SPAD工作模式的不同,兩部分器件可以用兩個獨立的電路分別控制.理論上來講,得益于Si材料的高質量,這樣的設計可以將傳統的InGaAs-SPAD的暗計數和后脈沖效應抑制到Si-SPAD的量級.如此一來,USPD既可以工作在自由運行模式下,又能保證不犧牲探測率.
3.1.2 器件輸運性質
為了更好地認識USPD的單光子探測機制,必須清楚器件的載流子輸運過程.原理上來看,USPD中上轉換器件和Si-SPAD是電絕緣的,二者之間是光耦合連接在一起,因此我們只需考慮上轉換器件的載流子輸運特性.計算機輔助設計技術(TCAD)被采用研究上轉換器件的能帶結構和輸運特性.計算過程中,我們考慮了不同的復合機制,包括俄歇復合、Shockley-Read-Hall(SRH)復合和輻射復合.以典型的半導體上轉換器件[29]為例,圖5(a)所示為其在5 V偏壓下的能帶結構(QFL代表準費米能級).很明顯,只要1550 nm的光子進入上轉換器件,就會被InGaAs層所吸收,產生的電子-空穴對將在耗盡區電場作用下迅速分離.由于PD和LED的界面處幾乎沒有勢壘,空穴將順利地抵達LED中,而電子將被迅速遷移至陽極中.與此同時,為了保持整個上轉換器件中的電平衡,將有對應數目的電子從陰極注入LED激活層中并與空穴發生復合.從這一角度來看,上轉換器件好像是一個電學泵.為了保證高的輻射復合效率,LED的激活層需要重型p摻雜[34],因此LED的激活區中有大量的空穴“等待”電子過來復合.此外,LED激活層中的重摻雜也保證了USPD可以獲得一個很好的時間分辨率.

圖5 TCAD計算結果[35] (a)5 V偏壓下上轉換器件的能帶圖;(b)不同偏壓下的InGaAs p-i-n探測器光電流和上轉換器件光電流;(c)凈光電流(光電流扣除暗電流)Fig.5.Calculated results[35]of(a)band diagram of the up-converter under 5 V forward bias,(b)photocurrent of PIN and up-converter at different bias voltage,(c)net photocurrent(subtract dark current from the photocurrent)of PIN and up-converter at different bias voltages.
需要注意的是,即使光生空穴要穿過鍵合界面,但是上轉換過程卻并不依賴于產生的光生空穴.由于鍵合界面兩側無論是LED還是PD均為重型p摻雜,所以空穴在結合界面處屬于多子.低注入情況下,多數載流子壽命可以近似看作是一個常數.吸收少數光子后轉換而得到的少數空穴進入這一區域仿佛進入一個“空穴海”一樣.由于是在極弱光條件下,產生的載流子很少屬于低注入條件,因此多數載流子的壽命理論上是無限長的.另一方面,電子并不需要穿過結合界面,因此結合界面的質量對于上轉換過程幾乎沒有影響.
計算而得的上轉換器件的I-V特性曲線如圖5(b)和圖5(c)所示,可以看出上轉換器件的I-V特性和普通的p-i-n光電探測器完全不同.施加反向偏壓,由于PD相當于是正向偏壓而LED是反向偏壓,因此器件是不能工作的.施加正向偏壓,則PD和LED均為正常工作條件.LED的p-n結結構決定了上轉換器件的開啟特性,施加的偏壓首先滿足LED的開啟特性,多余的電壓施加在PD部分.中紅外上轉換器件中也發現有類似的開啟特性[52].可以看出,USPD工作時的光電流和單個p-i-n PD的幾乎一致(圖5(b)).扣除背景暗電流后,二者的凈光電流結果也一致(圖5(c)).這一結果再次表明了鍵合的異質結界面對于上轉換器件性能的影響微乎其微,和此前的實驗結果表現一致[29,30].
3.1.3 LED出光效率
器件原理表明,上轉換器件效率和LED的光子提取效率是成正比的.然而,LED的光輻射是各向同性的,對于平面結構LED,會有接近50%的光子損失在器件襯底當中.但是對于USPD而言,其特殊的結構可以確保一個極高的光子提取效率.首先,由于半導體空氣界面的反射,從PD一端出射的光子的逃逸概率僅為~2%.也就是說,有98%的光子將被局限于上轉換器件中.其次,反向傳播進入PD的光子將會被InGaAs層重新吸收并且產生光生載流子然后重復上轉換過程,這一過程稱為“光子循環”過程(如圖6所示).InGaAs的高吸收系數可以確保對于反向傳播光子的高效重吸收.
得益于光子循環效應,幾乎不會有光子從PD一端逃逸出去.因此上轉換器件中的InGaAs探測器部分不僅僅起著對于1550 mn入射光的吸收作用,更是相當于是870 nm光子的一個電學反射鏡.因此,惟一限制USPD光子探測率的因素就是上轉換器件和Si-SPAD之間的光耦合效率.

圖6 上轉換器件中LED部分發光原理及光子循環效應[35]Fig.6.Schematic diagram of the luminescence of the LED in the up-converter and photon recycling[35].
3.2 器件結構及優化
3.2.1 PD和LED性能優化
上轉換器件由InGaAs PD和GaAs LED通過晶片鍵合的方式集成得到,為了確保上轉換器件具備高的上轉換效率,必須首先對PD和LED兩部分分別進行優化.其中,InGaAs PD器件性能的決定因素有很多,包括其器件結構、吸收層摻雜濃度、工作溫度、器件制備工藝、表面鈍化工藝等.2012年以來,我們項目組嘗試過不同結構的InGaAs PD器件[53?58],對其帽層材料、吸收層摻雜以及表面鈍化工藝進行了詳細系統的研究.其中帽層材料對于器件暗電流和響應率都有較大的影響,采用p-InP可以獲得83%以上的峰值量子效率,但是對應其暗電流較大,?0.1 V的偏壓下可以達到10.2μA/cm2;采用p-InAlAs+InGaAs的帽層結構暗電流相較于p-InP結構可以減少50%,同時獲得90%的峰值響應率;而采用原位摻雜的p-InAlAs可以降低一個量級的暗電流,但是對應的峰值響應率可以達到60%;通過優化工藝,采用二次摻雜的p-InAlAs,可以將暗電流抑制在~400 nA/cm2(?0.1 V)的同時,獲得99%的峰值量子效率.
圖7(a)所示為不同吸收層摻雜濃度對于器件響應率的影響.四個器件均為臺面結構,S1為本征吸收層結構的InGaAs p-i-n PD,在1550 nm處的響應率約為0.8 A/W;S2在S1的基礎上進行了器件表面鈍化(SiO2),相較器件S1,S2不僅提高了近10%的響應率,其常溫下暗電流較之S1降低了接近3個量級;FGA21為由美國Thorlabs公司生產的校準的商用InGaAs探測器,在1550 nm的響應率為0.96 A/W,對應74%的量子效率;M79為項目參與單位——上海技術物理研究所(SITP)制備的臺面結構InGaAs p-i-n PD,帽層材料為InP,可以獲得1.05 A/W的響應率,對應81%的量子效率.

圖7 (a)不同結構InGaAs p-i-n探測器的響應情況,其中器件S1和S2為上海交通大學(SJTU)采用的本征吸收層結構,M79為上海技術物理研究所采用的n型摻雜濃度為7×1016cm?3的結構,FGA21為美國Thorlabs公司校準的InGaAs探測器;(b)不同激活層摻雜濃度的LED響應情況Fig.7.(a)Response of InGaAs p-i-n detector with different structures,where S1,S2 adopt intrinsic absorption layer fabricate by SJTU,M79 use an n-doped absorption layer with 7×1016cm?3fabricated by SITP,FGA21 is a commercial detector from Thorlabs.(b)LED response at different doping concentrations in the activation layer.
GaAsLED為n-AlGaAs/p-GaAs/p-AlGaAs的雙異質結結構,其中關鍵為p-GaAs的激活層,即LED電子空穴發生復合進而發光的功能層.半導體中SRH復合、俄歇復合、表面復合、輻射復合等多種復合機制并存,LED工作時要求輻射復合占據主導,并且盡可能地抑制非輻射復合.這一點對于上轉換器件中的LED部分尤其重要,因為輻射復合的效率直接決定了上轉換效率.圖7(b)所示為不同結構和不同激活層摻雜濃度的LED響應率測試結果.結果表明,隨著激活層摻雜濃度的升高,LED的量子效率先增大后減小,這主要是因為隨著摻雜濃度變化,激活層內的主要復合機制也發生變化[34].其中當激活層摻雜濃度為1×1018cm?3時,LED的量子效率達到峰值,且在低注入電流密度條件下也能保持一個很高的量子效率.
為了進一步提高LED量子效率,我們在摻雜濃度為7×1017cm?3的激活層內加入了一層9 nm厚的In0.1Ga0.9As量子阱,結果顯示在低溫下LED的量子效率較之不加量子阱結構的LED提升了一倍以上,但是在常溫下,量子效率反而低于不加量子阱結構的LED.其主要原因是,在低溫下量子阱可以局限更多的載流子,使得其載流子濃度更高,從而獲得更高的輻射復合系數.但是常溫下,由于熱激發的存在,量子阱的局限載流子的效果被大大削弱,而且由于In0.1Ga0.9As的和GaAs的晶格失配造成了大量缺陷,這就使得其非輻射復合概率極大地上升,從而降低了其量子效率.值得一提的是,雖然這一結構的LED在常溫下表現不盡如人意,但是其在低溫下的高性能對于中紅外[28]或者遠紅外[59]上轉換有著重大意義.
3.2.2 上轉換器件優化
前文所述的光子循環效應可以保證所有的反向傳播光子均被InGaAs層重吸收,從而再次利用進行上轉換.但是這個過程中,我們忽略了p-i-n PD中的p-InP帽層對于870 nm的光子也有一個很高的吸收系數(~104/cm).而且由于p-InP帽層并非處于耗盡層,電場強度相對而言很低,因此吸收870 mn的光子并不能有效地產生光生載流子.因此,在實際操作中,可以考慮在進行鍵合集成上轉換器件之前將p-InP帽層去除.鍵合之后,LED中的p-AlGaAs也可以充當p-i-n結構的p型區.根據我們計算得到的去除p-InP帽層前后的上轉換器件能帶圖(如圖8所示),可以發現去除p-InP帽層之后,對于器件基本沒有影響.
忽略光子在器件中的傳播速率和載流子遷移速率,并且考慮3次光子循環,接近90%(第一次50%,第二次25%,第三次12.5%)的光子將被從上轉換器件中耦合而出.光子循環的一大弊端就是會增加器件的時間抖動,這一問題將在3.3.1節中進行詳細的討論.

圖8 上轉換器件能帶結構圖 (a)包含p-InP帽層結構;(b)不包含p-InP帽層結構Fig.8.Band diagram of the up-converter:(a)With p-InP cap layer;(b)without p-InP cap layer.
3.2.3 光耦合結構優化
USPD中的上轉換器件和Si-SPAD是通過光學方法耦合在一起的.最簡單直接的光學耦合方法是通過非球面鏡將LED端出射的光子準直聚焦到Si-SPAD的感光面上,這種耦合方式稱為空間光耦合.這種耦合方式簡單方便,但是多余的光學系統的引入使得整個器件不是特別緊湊,并且由于光子在半導體空氣界面的低的光子逃逸概率(只有~2%),所以USPD的單光子探測率相對過低.
為了提升USPD的光子探測率,一種有效的嘗試是將上轉換器件和Si-SPAD通過晶片鍵合的方式集成起來,由傳統光學理論可以推算出這種耦合方式的效率可以比空間光耦的方式高出一個量級,達到24%:
其中θc是GaAs與Si界面的臨界角;nSi,nGaAs分別為Si和GaAs的折射率.
另一種方法通過光纖陣列中常用的光膠耦合(optical adhesive)的方式將上轉換器件和Si-SPAD集成在一起.由于Si(n=3.58)和GaAs(n=3.42)的折射率非常接近,理論上這二者之間是可以獲得一個很高的耦合效率的.但是已知光膠的折射率均小于3.通常的光膠折射率大約為1.55左右.當光膠厚度較厚時,對應的耦合效率也不夠理想,可是當光膠厚度和光波長相比擬時,就會發生所謂的“光子隧穿”效應,進而獲得一個很高的耦合效率.理論上,光子隧穿效應可以達到100%,實驗上已經做出了81%的光耦合效率[60].因此,通過光膠耦合的方式將上轉換器件和Si-SPAD耦合在一起效率可以至少達到70%以上.
3.3 性能指標
3.3.1 時間分辨率
時間分辨率(time resolution),也叫時間抖動(time jitter),是單光子探測器的一個很重要的指標,在激光測距等實際應用中直接決定了整個系統的性能[61],因此在評估USPD的性能之前必須計算其時間抖動.USPD器件的時間抖動可以表示為

其中tpin為InGaAs探測器的光響應時間;ttrans為光生載流子的傳輸時間;tspont為GaAs LED的自發輻射壽命;tph是GaAs LED發出光子的傳輸時間;tSi為Si-SPAD的時間抖動.
對于一個傳統的InGaAs-SPAD,時間抖動大約為50 ps[62],其中包括了器件光響應時間和對應的電路響應時間.考慮到InGaAs的高吸收率和InGaAs-SPAD的極低的時間抖動,我們有理由認為InGaAs探測器的光響應時間可以忽略不計,即tpin≈0.再考慮到上轉換過程的微觀機制,一旦入射光被吸收并且產生光生載流子,LED一端就會立即注入同樣數量的電子進入LED的激活區.光生載流子的產生和電子的注入可以看作是同步的.因此在計算USPD時間抖動的過程中ttrans可以忽略不計.考慮到器件僅在微米尺度,光子在器件中的傳播時間(tph)計算的結果大約為飛秒量級.而對于高質量的Si-SPAD,時間抖動大約也為tSi≈50 ps.至于LED的自發輻射壽命,則由自發輻射系數(BT)和LED激活區多數載流子濃度(NA)決定(tspont=(BT×NA)?1).在USPD器件中,為了獲得一個高的輻射復合效率,LED激活層通常為重摻雜(~1019cm?3).輻射復合系數在90,185和300 K的情況下分別為:BT=1.8×10?8,1.9×10?9,7.2×10?10cm3/s,對應的自發輻射壽命分別為5.6,53和138 ps.因此USPD在90,185和300 K情況下的時間抖動分別估算為50.3,72.9,147 ps.考慮到光子循環效應,則在90,185和300 K的情況下對應的時間抖動為150,219和441 ps,也是與Si-SPAD相比擬的量級.
3.3.2 光子探測效率

光子探測效率PDE是指探測到的光子數和入射光子數的比值,是衡量單光子探測器的一個重要指標.USPD器件的光子探測率主要由InGaAs PD,LED,Si-SPAD以及LED和Si-SPAD之間的光耦合效率決定:其中ηPD和ηLED分別為InGaAs PD和GaAs LED的外量子效率;ηSi是Si-SPAD的光子探測效率;R是InGaAs PD的表面反射率;α為InGaAs的吸收系數;d為InGaAs吸收層的厚度;為InGaAs PD的光電轉換效率;為LED的內量子效率;ηcouple為Si-SPAD和LED之間的光耦合效率.In-GaAs PD表面通常會有一層減反鈍化膜,反射率為R=13%.由于InGaAs吸收層足夠厚(1—2μm)并且吸收系數極高,1? e?αd≈1.再者,得益于成熟的半導體工藝,可以接近100%.同時,經過優化的LED在極低注入密度條件下的ηLinED也可以高達95%以上[34].此前的實驗結果表明,集成的上轉換器件并不會減弱LED和PD各自的性能.因此,在PD和LED分別優化并且完美鍵合的條件下,理論上PD-LED的上轉換內量子效率可以達到或者接近100%.這樣,USPD器件的單光子探測率就僅僅依賴于LED和Si-SPAD之間的光耦合效率.
USPD光子探測率隨Si-SPAD的探測率及光耦合效率變化的關系如圖9(a)所示,很顯然,實現高的光耦合效率是獲得高性能USPD的先決條件.圖9(b)所示為不同光耦合方式情況下的光子探測率,一旦光耦合方式確定,USPD的光子探測率就只依賴于Si-SPAD的性能.而Si-SPAD的光子探測率又隨波長變化,目前Si-SPAD在870 nm的PDE約為40%,但是在其峰值波長(650 nm)處的PDE可以超過70%.如果LED的發光波長可以調至Si-SPAD的峰值探測波長附近,并且采用光膠耦合,USPD將實現約為42.6%的探測率,這一數值是當前InGaAs-SPAD探測率的2倍.此外,USPD的PDE在870 nm和650 nm的理論極限可以分別達到35%和61%.
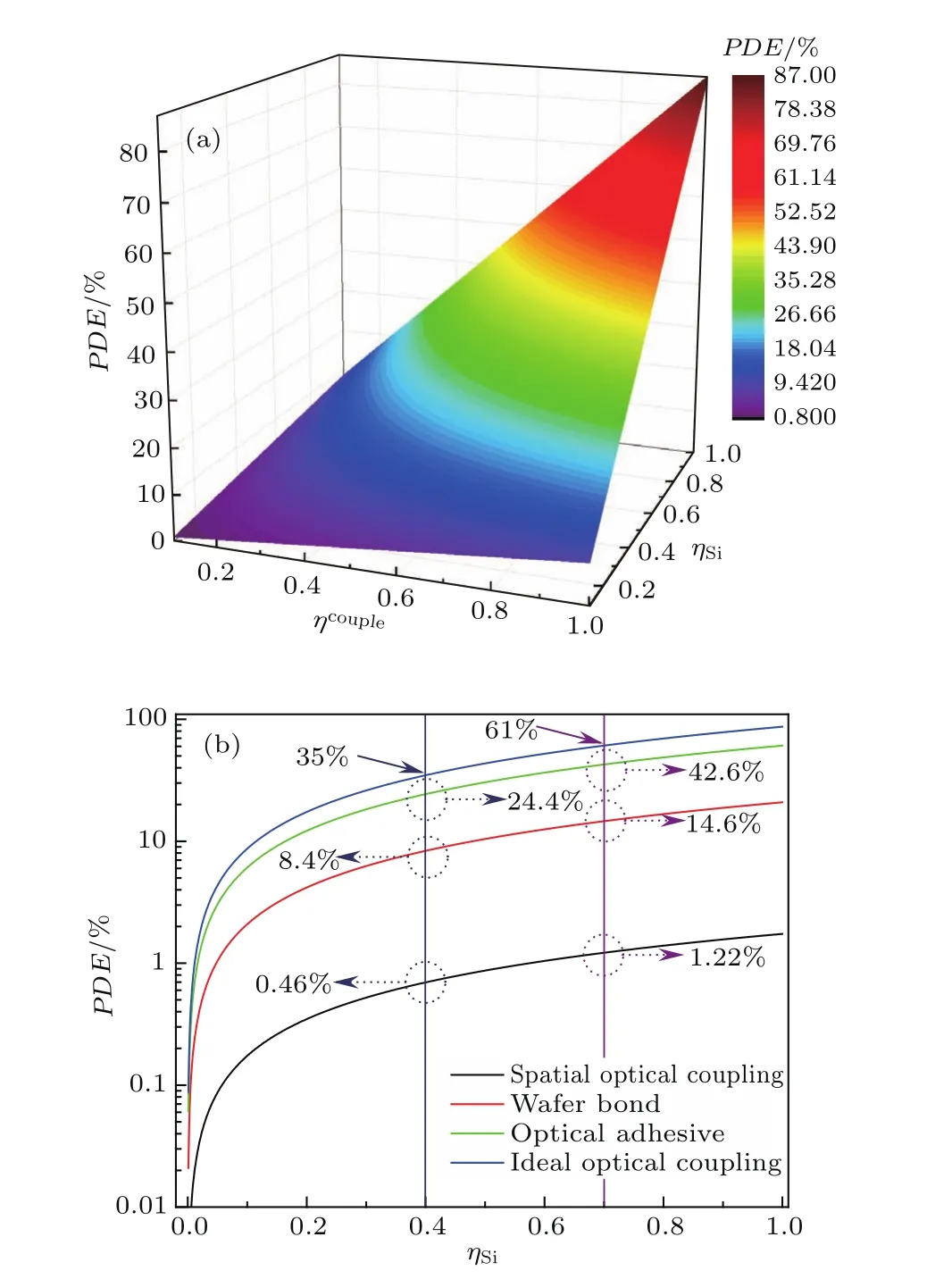
圖9 (a)光子探測率隨光耦合效率和Si-SPAD光子探測率的變化關系;(b)三種不同光學耦合方式的光子探測率Fig.9.(a)Dependence of photon detection efficiency on optical coupling efficiency(ηcouple)and photon detection efficiency of Si-SPAD(ηSi);(b)photon detection efficiency for three different ways of optical coupling.
3.3.3 暗計數和暗發光
半導體上轉換單光子探測器(USPD)的暗計數,其主要來源于兩部分.首先Si單光子雪崩二極管本身具有一定的暗計數,成熟的Si-SPAD可以將暗計數控制在50 Hz以下,其次則是來源于上轉換器件中LED的暗發光.這一點和傳統的單光子雪崩二極管的暗計數有本質區別,傳統的SPAD的暗計數主要由其材料的質量所決定,并且背景輻射通過屏蔽的方式可以被有效抑制,可以忽略.然而,USPD中的Si-SPAD是和前端的上轉換器件耦合在一起的,即使在沒有入射光的情況下,Si-SPAD依舊可以被上轉換器件的暗發光所觸發.暗發光是由上轉換器件的暗電流所引起,而由于上轉換器件特殊的n-p-n結構,其暗電流主要由其中反偏的PD部分暗電流構成.具體包括PD器件本身的暗電流和由背景輻射導致的背景光電流.必須指出的是,一般而言探測器的背景光電流會被忽略掉,但是在USPD中,由于其會導致暗發光進而引發暗計數,因此不能忽略.目前,已知的通過特殊設計和鈍化處理的InGaAs-PD(25μm直徑)可以在室溫下將暗電流抑制到4 fA(0.1 V).而對于同樣的PD由(4)式計算而得的180?視場角300 K背景輻射引起的光電流僅有約10?5fA.

其中e是元電荷,h為普朗克常數,gPD=1為InGaAs-PD的增益,λ為光波長,kB為玻爾茲曼常數,A為器件面積,c是真空光速,T是開氏溫度.很明顯,器件的暗電流遠遠大于背景光電流,因此,總的暗電流主要由器件的暗電流決定.而器件的暗電流對于溫度極其敏感,例如在熱電制冷溫度(200 K)下工作的探測器暗電流要比室溫下低4—6個數量級以上.如此微弱的暗電流情況下,由暗發光造成的暗計數可以被抑制到和Si-SPAD本身暗計數的量級,但是前提是PD須經過嚴格的優化工藝.這樣,整個USPD的暗計數可以被控制在與Si-SPAD同一個量級.再者,由PD的反偏工作原理可以知道,其光響應率是不依賴于偏壓的,即施加更大的反向偏壓并不會增加其光響應率,這一點從后邊的實驗中上轉換器件的發光光譜上可以明顯看出.但是PD的暗電流卻是嚴重依賴于器件偏壓,大的反向偏壓會導致暗發光劇增(這一點從后邊的實驗中上轉換器件的發光光譜上也可以明顯看出),從而導致大的暗計數.因此,實驗中必須選擇合適的工作電壓,從而避免額外電壓所產生的不必要的暗計數.
3.3.4 噪聲等效功率
噪聲等效功率(noise equivalent power,NEP)表示探測器可以分辨的最小入射光功率,代表了探測器的信噪比水平,是應用最廣泛的衡量光電探測器的品質因數[2].對于USPD而言,其NEP可以表示為[35]

其中,in,UD為USPD的器件總噪聲;RUD=Iph,UD/Pin=eλoutηSiηUP/hc為USPD的響應率;e為電荷;h為普朗克常數;c為光速;λout為LED的發光波長;ηSi和ηLED分別為Si-SPAD和LED內量子效率;gSi為Si-SPAD的增益;?f為帶寬;Idark,PD,Ibg,PD,Idark,Si分別為InGaAs-PD的器件暗電流、背景光電流和Si-SPAD暗電流.需要指出的是,(5)式的結果是從器件響應率和噪聲來源推導而出,其計算所得結果和傳統的單光子探測器的NEP(NEP=其中D為單光子探測器暗計數,η為單光子探測器的PDE,ν為光子頻率)的計算結果基本一致.圖10所示為USPD探測率和噪聲等效功率與現有近紅外單光子探測器的對比結果.理論上,優異的單光子探測器應當同時具有高的探測效率和低的噪聲等效功率,可以看出USPD無論是光子探測率還是噪聲等效功率,均處于相對領先地位.

圖10 不同類型單光子探測器的NEP和PDE統計,其中黑色方形表示自由模式InGaAs-SPAD[23,63?65],紅色圓形和藍色三角形分別表示門控模式InGaAs-SPAD[22,66,62,48]和光參量上轉換單光子探測器[11,19,67,68],虛線圓圈框起來的綠色菱形表示USPD;括號里的第一項表示工作條件,第二項為報道年份Fig.10. The NEP and PDE achievements for different kind of single photon detectors.Free-running In-GaAs SPADs[23,63?65]were plotted as black squares.Gate-mode InGaAs SPADs[22,66,62,48]and optical upconversion SPADs[11,19,67,68]were shown as red circles and blue triangles respectively.The diamond in the dash circle representative the calculated results of USPD.Thefirst item in the bracket is the operating condition and the second one in the bracket is the time of report.
3.4 器件制備工藝
USPD的器件通用工藝主要包括以下幾部分:
1)InGaAs p-i-n結構外延片,GaAs-LED結構外延片以及Si-SPAD外延片生長;
2)InGaAs p-i-n PD與GaAs-LED集成上轉換器件,并且制備Si-SPAD器件;
3)上轉換器件和Si-SPAD耦合集成USPD器件.
制備好的器件如圖11左所示,整個器件的制備工藝中最關鍵的當為上轉換器件的制備以及上轉換器件和Si-SPAD器件的耦合集成.其中上轉換器件的制備工藝[29,30]如圖11右流程所示,具體為:
1)在InP襯底片上外延生長InP/InGaAs p-in結構,在GaAs襯底上生長GaAs/AlGaAs雙異質結結構;
2)材料原片解理,其中GaAs LED片進行光刻然后濕法腐蝕刻槽;

圖11 集成的USPD器件示意圖(左)及上轉換器件制備工藝流程圖(右),紅色虛線框所示為鍵合界面局部放大圖及SEM電鏡照片Fig.11.The schematic diagram of the integrated device(left)and fabrication process flow(right).The magnification of the wafer bonding interface and SEM photograph.
3)刻槽后的LED與PD片經過深度清洗,去除表面氧化膜,再經過表面等離子體激活,進行范德瓦耳斯鍵合;
4)給經過范德瓦耳斯鍵合的器件施加壓力,并且在N2環境中進行退火處理;
5)通過減薄拋光化學腐蝕的方法移除LED襯底;
6)經過光刻,進行上轉換器件的Mesa臺面刻蝕;
7)臺面上下電極的金屬沉積及剝離;
8)電極引線及封裝.
集成的上轉換器件通過光學耦合的方式和Si-SPAD集成在一起即形成了USPD器件.可以通過鍵合的方式將二者集成,但是鑒于二者工作模式的不同,鍵合前電隔離層的設計必不可少;也可以通過光膠耦合的方式將二者集成,通過接觸式掩膜對準技術[69],可以精確實現1μm以下的光膠鍵合.
3.5 USPD空間光耦合實驗
圖12(a)所示為最近的USPD空間光耦合實驗光路圖,1550 nm的光纖激光器發出來的光子首先經過衰減,然后通過非球面鏡的準直,在通過透鏡聚焦到上轉換器件的光敏面上;上轉換器件將吸收的1550 nm的光子轉換為870 nm的光子,由于LED出射光是空間彌散的,因此也需要非球面鏡的準直;準直后的光再被聚焦到Si-SPAD的光敏面上進而被雪崩放大.上轉換器件前端的衰減片主要起到保護Si-SPAD的作用,防止入射光過強致使Si-SPAD飽和.

圖12 (a)USPD空間光耦合實驗光路圖;(b)上轉換信號光譜和上轉換響應;(c)上轉換單光子計數測試及光子探測效率Fig.12.(a)The optical setup of the spatial optical coupling of USPD;(b)the up-conversion spectrum and response of the up-converter;(c)the single photon count and PED of the USPD with spatial optical coupling.
圖12(b)所示為上轉換器件弱光條件下的光譜測量結果和響應結果(插圖).可以看出,同一入射光強不同偏壓下的上轉換信號強度基本不變,而隨著入射光強變化上轉換強度也基本保持線性變化,其中上轉換內量子效率可以達到35%.值得注意的是,在不同偏壓下,上轉換器件的背景信號不同,隨著器件工作偏壓升高,上轉換器件的暗發光急劇上升.這是由于用于測量的上轉換器件并未進行嚴格的鈍化處理和封裝,嚴重的表面復合和漏電造成了器件暗電流過高,從而導致暗發光過強,這一現象可以通過器件鈍化工藝得到顯著改善.圖12(c)所示為Si-SPAD計數率隨入射光功率的變化情況以及整個USPD系統的光子探測效率,所給出的結果為扣除暗發光所致暗計數后的結果.光子探測效率約為理論預測的30%,與理論預期差異的主要原因是由于上轉換器件的效率只有35%,表面復合和漏電流不僅僅會增大上轉換器件的暗電流,更會降低其上轉換量子效率.此外,鍵合工藝的相對不成熟也可能會導致大量缺陷態的引入,進而增加了器件漏電和非輻射復合,光路中的光學損耗也是造成誤差的一個因素.作為USPD器件的初步嘗試,并且上轉換器件未經優化處理和封裝,最小光響應就可以測到fW量級,并且光子探測效率達到了理論預期量級,這充分說明了USPD的可行性.但是必須指出的是,該器件的各方面性能均未達到理論預期的最佳值,都僅僅處于初步嘗試階段,作為實際應用,還遠遠達不到當前主流單光子探測器的水平.更加完善的USPD器件制備和測試還需要更多的嘗試和努力.
4 總結與展望
本文回顧了三種目前常用的半導體單光子探測器,就其器件原理、工作模式、優勢和劣勢等方面進行了相關評述.其中,Si-SPAD受硅的帶隙所限,只能探測300—900 nm波段的光子,對于光纖通信波段光子幾乎無響應;InGaAs/InP-SPAD則受限于材料質量,暗計數和后脈沖效應過高,大大影響了器件性能;基于量子點的單光子探測器雖然探測率高且暗計數小,但也僅限于匹配GaAs帶隙寬度的光子(820 nm),對于通信波段的光子響應過低.在此基礎上,著重介紹了本研究組所提出的一種新型半導體近紅外上轉換單光子探測技術(USPD)的研究進展.從USPD的器件基本原理、器件結構、性能指標等多方面闡述了其可行性和優越性,并給出了USPD最新的空間光耦合實驗結果.必須指出的是,我們所提出的1.3—1.55μm波長單光子探測方案目前在世界范圍內未見公開報道,屬于首次提出.該方案的關鍵特性在于:它將不是采用InP結構實現信號的放大,而是利用成熟的SPAD器件來實現信號的放大和采集,從而規避了InP結構在暗計數率和后脈沖效應方面的問題.我們所提出的這一方案不僅是現有半導體紅外上轉換和紅外上轉換成像方面工作的簡單延續,它同時具備重要的科學研究價值,其主要目的是為了實現單光子層面的紅外上轉換,同時涉及到紅外單光子吸收、極少數載流子輸運和復合等各方面的關鍵科學問題.此外,USPD的單光子探測方案的核心即為將近紅外光子上轉換為短波近紅外或者可見光子,再用商用Si-SPAD進行探測,這拓寬了單光子探測的思路,打開了另一扇單光子探測的窗口.受其啟發,不僅僅是基于III-V族化合物半導體上轉換,有機-無機上轉換[31,70]、高增益上轉換發光晶體管等[71]高效上轉換器件均可用來嘗試作為USPD的上轉換器件部分,進而嘗試單光子探測,至于其各自優勢及可行性,還需更加深入的研究和探索.
關于半導體上轉換單光子探測的最初設想由劉惠春教授提出,但在項目實施第一年劉惠春教授不幸離世,項目具體由課題組成員實施完成.在課題實施過程中,得到了上海微系統研究所曹俊誠教授、上海理工大學郭旭光教授、梁焰老師,華東師范大學曾和平教授、吳光教授的幫助.謹以此文向劉惠春教授致敬!向提供幫助的老師表示誠摯的感謝!

