功率晶閘管的浪涌性能研究
,,, ,, (.國網四川省電力公司電力科學研究院,四川 成都 6004;.四川大學電氣信息學院,四川 成都 60065;.華中科技大學電氣與電子工程學院,湖北 武漢 40074)
0 引 言
隨著高壓直流輸電、柔性交流輸電、高速鐵路、脈沖功率等技術的發展與推廣,IGBT、IGCT、GTO、晶閘管等功率半導體開關[1-8]一直是研究的熱點領域。其中晶閘管由于其通流能力大、耐壓水平高、使用壽命長、性能穩定、控制相對簡單等優點得到了廣泛的應用和持續的改進。
通態不重復浪涌電流ITSM(以下簡稱浪涌電流)作為表征晶閘管極限通流容量的參數,能夠反映該型號晶閘管承受故障電流的能力。一般的器件生產商僅提供工頻情況(10 ms脈寬)或者特定波形下的浪涌電流值,而晶閘管的浪涌電流能力和浪涌脈寬密切相關。隨著晶閘管應用環境的改變,流過晶閘管的電流波形也不是固定不變的,僅用單個數據點來描述其浪涌電流能力,信息十分有限。尤其對應用于變頻電源、脈沖功率等非工頻條件下的晶閘管,該指標并不能有效評價晶閘管實際工況中能夠承受的浪涌電流能力。
為提高晶閘管實際應用時的可靠性,需要對其在不同脈寬下的浪涌電流性能進行研究,得出兩者的關系,以便為晶閘管的選型提供參考和依據。
1 晶閘管的原理與結構
晶閘管是一種四層三端(A陽極、K陰極、G門極)的可控型半導體器件,共3個PN結。通常用雙晶體管等效模型來進行分析,如圖1所示。
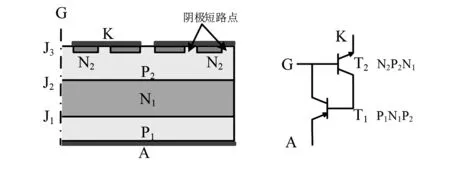
圖1 晶閘管芯片結構與等效模型
功率晶閘管一般采用雙面冷卻的扁平圓盤形封裝,又被稱為冰球型封裝,如圖2所示。在此封裝中,芯片被固定在2個鉬層中間。因為兩者膨脹系數接近,能夠防止芯片被熱應力破壞。而上下2個鉬片固定在兩個銅基座間。銅基座作為對外電極,并兼做散熱器。管殼內充入略低于大氣壓的惰性氣體,用以防止內部芯片被氧化[9]。
晶閘管在開斷的動態過程以及完全導通狀態下都存在著電壓降落,因此并不是理想開關。晶閘管工作時會伴隨功率損耗,生成焦耳熱,當熱量超過晶閘管芯片的熱極限,就會損壞。一般認為晶閘管的平均耐受結溫為125℃,超過這個溫度晶閘管將因熱損壞而失效[10]。所以浪涌電流實際反映的是晶閘管的暫態熱極限,并且和浪涌電流的脈寬相關聯[11]。

圖2 冰球型封裝晶閘管剖面圖
2 試驗平臺的搭建
設計所使用的浪涌電流測試平臺如圖3所示。為避免晶閘管在進行浪涌電流能力測試時受到其他因素的影響,應該要求測試平臺中晶閘管的斷態重復峰值電壓VDRM、通態電流上升率di/dt盡量小于其額定值。并且為了降低試驗成本,每次測試僅用單片晶閘管做測試,因此試驗電壓不能選擇太高。結合上述原因,測試平臺必須具備在較低電壓下(遠低于晶閘管額定電壓)能夠輸出大電流的能力。
圖 3 a)為該測試平臺電路圖。根據仿真軟件計算結果,圖中電容器組容量為儲能元件,最大值設置為5 000 μF。電感、電阻分別起到調波和阻尼的作用,其值根據所需浪涌電流的脈寬逐級調整。因為測試過程中,浪涌電流的脈寬跨度較大,續流二極管在電路中的位置也根據浪涌電流脈寬進行調整。脈寬較短的情況下,二極管支路被連接在晶閘管陰極側,如圖3 b);脈寬較長的情況下,二極管支路被連接在晶閘管的陽極側。為防止故障時電容器的能量無法釋放,必須設計泄能裝置用于釋放能量。這里采用高壓真空陶瓷繼電器作為平臺的泄能開關、水電阻作為泄能電阻。試驗時由高壓恒流充電機對電容器組充電,并采用Pearson 4427作為電流傳感器。
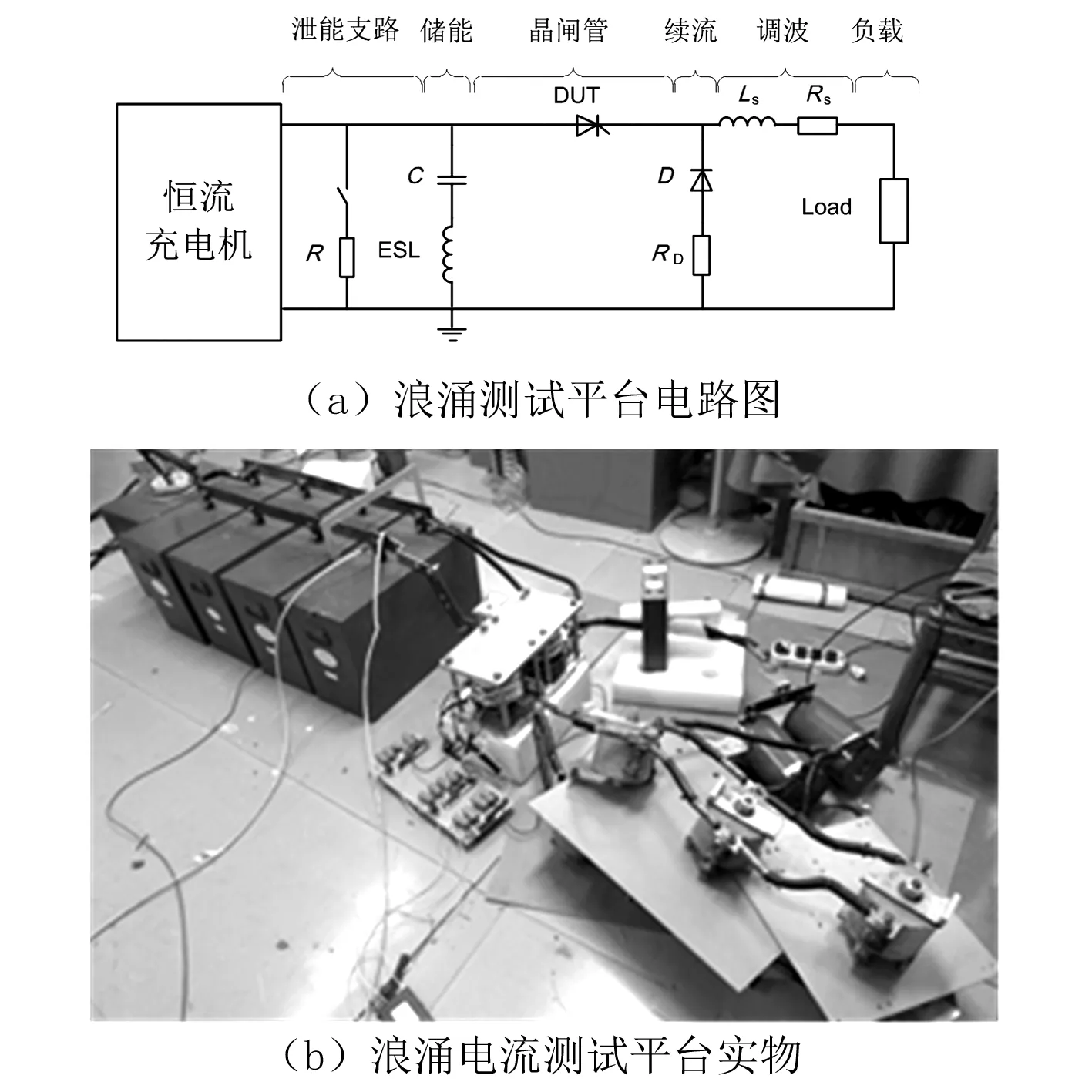
圖3 晶閘管浪涌電流測試平臺

圖4 實驗波形
因為測試平臺輸出的浪涌電流值與電容器組的充電電壓為線性關系,所以通過調節充電機的輸出電壓來控制浪涌電流幅值。
短脈寬測試條件下,由于續流回路不包含晶閘管,因此可以直接根據流過晶閘管的電流波形來判斷晶閘管是否已經被浪涌電流損壞。圖4 a)為晶閘管尚未損壞時的電流波形,圖4 b)為晶閘管已經被浪涌損壞后的振蕩電流波形,說明晶閘管已經沒有阻斷能力。長脈寬測試條件下,因為續流回路包含晶閘管,所以晶閘管損壞前后的電流波形沒有差異,不能依靠電流波形判別晶閘管的好壞。因此必須在每次試驗后對晶閘管進行一次耐壓試驗。
3 數據分析
利用此浪涌電流測試平臺,對某型5 inch功率晶閘管產品進行浪涌電流測試。通過調整平臺充電電容器與調波電感的參數,獲得了該型號晶閘管在不同脈寬下的浪涌電流,具體測試數據如表1所示。
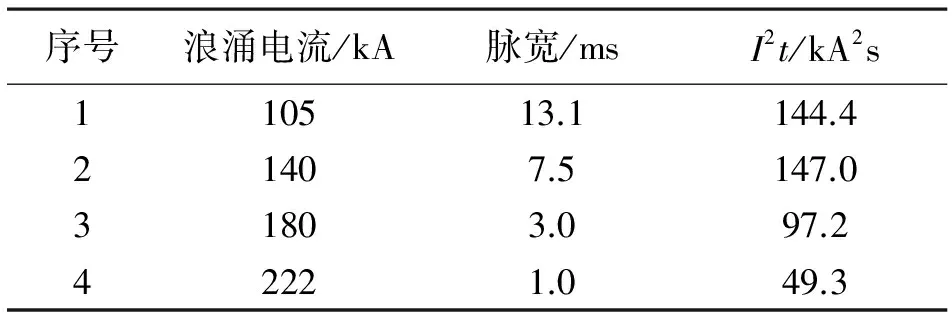
表1 試驗數據
試驗對該型晶閘管進行了4種脈寬條件下的浪涌電流測試。從表1的數據可以看出,隨著電流脈寬的減小,晶閘管的浪涌電流值是增加的,但同時晶閘管能夠承受的熱積分是在逐漸下降的。
由于浪涌電流試驗是破壞性試驗,每測試出一組浪涌電流,就要損壞一片晶閘管。為了排除其他因素的影響,此次試驗采用的晶閘管為同一型號同一批次的產品。
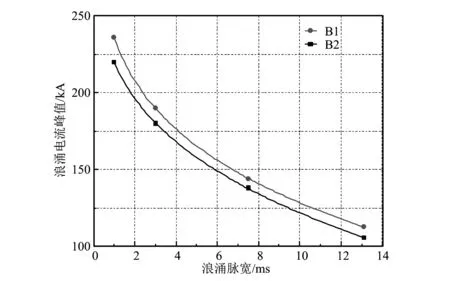
圖5 某型晶閘管的安全工作曲線
根據表1的數據,將浪涌電流與脈寬的關系繪制出圖5中的B2曲線,同時將各種脈寬下的損壞電流繪制出圖5中B1曲線。當晶閘管工作在B2曲線左側區域時,能夠保證晶閘管不會被浪涌電流損壞。如果晶閘管的工作狀態落在了B1曲線的右側區域,則晶閘管就一定會被浪涌電流損壞。B1曲線和B2曲線之間的區域則是一個由于試驗平臺充電電壓分辨率導致的測試盲區。
用冪函數f(t)=a·tb+c去擬合圖5中曲線B2,可得a=-110.8,b=0.274 1,c=330.1,即
f(t)=-110.8t0.274 1+330.1
(1)
對該型晶閘管,凡是符合f(t)-Ip≤0的工作情況,晶閘管就可以保證不會因為浪涌電流而熱損壞。

圖6 被損壞的晶閘管芯片
4 結 語
通過設計低斷態電壓、低通態電流上升率和高浪涌電流的測試平臺,測試出不同脈寬條件下晶閘管的浪涌電流。通過對試驗數據分析,繪制出被測型號晶閘管的浪涌電流和脈寬的對應關系曲線。該曲線將有助于控制晶閘管使用時的安全裕量,為晶閘管的選型提供了更加全面的參考依據。
[1] 丁榮軍,劉國友. ±1 100 kV特高壓直流輸電用6英寸晶閘管及其設計優化[J]. 中國電機工程學報,2014,34(29):5180-5187.
[2] 錢照明,盛況. 大功率半導體器件的發展與展望[J]. 大功率變流技術,2010(1):1-9.
[3] 王兆安,黃俊.電力電子技術[M].北京:機械工業出版社,2005.
[4] 周金明,莫正康.可控硅技術[M].北京:機械工業出版社,1978.
[5] 劉國友. IGCT-GTO技術的最新進展[J]. 半導體技術,2000,25(3):9-11.
[6] 王彩琳. 門極換流晶閘管(GCT)關鍵技術的研究[D].西安: 西安理工大學,2006.
[7] 戴玲,董漢彬,林福昌,等.脈沖功率晶閘管的小型化[J]. 電工技術學報,2012,27(8):120-125.
[8] 魯萬新. 脈沖晶閘管的放電特性及熱特性研究[D].武漢:華中科技大學,2010.
[9] 維捷斯拉夫·本達,約翰·戈沃,鄧肯 A·格蘭特.功率半導體器件——理論及應用[M].北京:化學工業出版社,2005.
[10] Taylor P. D.著,龐銀鎖譯.晶閘管的設計與制造[M].北京:中國鐵道出版社,1992.
[11] 董漢彬. 功率晶閘管的暫態熱特性研究及應用[D].武漢:華中科技大學,2012.

