PCB電鍍銅添加劑作用機理研究進展
彭 佳, 程 驕,王 翀, 肖定軍, 何 為
(1.電子科技大學 應用化學系,四川 成都 610054; 2.廣東光華科技股份有限公司,廣東 汕頭 515061)
?
PCB電鍍銅添加劑作用機理研究進展
彭 佳1,2, 程 驕2,王 翀1,2, 肖定軍2, 何 為1,2
(1.電子科技大學 應用化學系,四川 成都 610054; 2.廣東光華科技股份有限公司,廣東 汕頭 515061)
添加劑是PCB鍍銅溶液中的重要組成部分,在電鍍過程中發揮著不可替代的作用。添加劑能有效改善電鍍過程中的電流分布,提高鍍液的均鍍能力,控制銅離子從溶液本體到反應界面的運輸與電結晶過程,從而影響PCB板面微觀凹處和微觀凸處的電化學沉積速率。然而添加劑的作用并不是單一組分添加劑所發揮作用的簡單疊加,它們之間存在著復雜的協同作用或對抗競爭作用。為了更好地指導電鍍銅添加劑配方的研發,提高電鍍工藝水平,結合目前國內外相關的文獻報道對電鍍工藝中添加劑間的相互作用進行分析和概述。其中包括氯離子、加速劑、抑制劑、整平劑之間的相互作用。
添加劑; 電鍍銅; 作用機理; 印制線路板
引言
金屬銅具有電阻率低、可靠性高及延展性好等特性,目前被廣泛用作超大集成電路和PCB板制造中的互連材料。實現PCB層間電氣互連主要有三種方式:盲孔、通孔和埋孔。而電鍍銅工藝作為PCB制造中重要工序之一,常常用于電鍍銅層加厚(通孔,圖形電鍍)或電鍍盲孔填充,以實現PCB層間電氣互連。添加劑是PCB電鍍液中的重要組成部分,在電鍍過程中發揮著不可替代的作用。添加劑能有效改善電鍍過程中的電流分布,提高鍍液的均鍍能力,影響銅離子從溶液本體到反應界面的運輸與電結晶過程,從而改變板面微觀凹處和微觀凸處的電化學沉積速率[1]。
PCB電鍍銅添加劑一般包括氯離子、加速劑、抑制劑和整平劑。添加劑的作用效果并不是單一組分所發揮作用的簡單疊加,它們之間存在著復雜的相互作用(協同作用或對抗競爭作用)。只有在特定種類添加劑組合及合適的配比下,才能實現電鍍板面光亮、整平,且孔內電鍍效果良好的目的[2]。因此,為了更好地指導電鍍銅添加劑配方的研發,提高電鍍工藝水平,本文結合目前國內外相關的文獻報道對電鍍工藝中添加劑及其間的相互作用進行分析和綜述。
1 電鍍添加劑作用
PCB電鍍銅添加劑一般由氯離子、加速劑(accelerator)、抑制劑(suppressor)和整平劑(leveler)組成,其中加速劑、抑制劑、整平劑的典型結構類型如圖1所示。

圖1 鍍銅添加劑結構簡圖
1.1 氯離子
氯離子是酸性鍍銅液中必不可少的物質,通常以氯化鈉或鹽酸的形式添加到鍍銅液中。氯離子在電鍍過程中主要發揮三個方面的作用:1)作為銅離子與金屬銅之間電子傳遞橋梁;2)適量的氯離子可以降低陰極極化,與有機添加劑相互作用,實現鍍層的光亮、整平;3)提高陽極活性,在陽極表面形成一層均勻的陽極膜,幫助均勻溶解咬蝕磷銅球。
在無其他有機添加劑存在時,氯離子能表現出一定的加速性能,但它能與亞銅離子絡合,形成不溶性“Cu(Ⅰ)-chloride”絡合物薄膜,該絡合物薄膜將會沉積在銅表面從而阻礙銅沉積過程。此時銅電鍍沉積過程可以用四個基元步驟來表示[如反應(1)~(4)]。而有其他有機添加劑的加入時,它將與各添加劑相互作用,形成更復雜的絡合物以實現盲孔的超共形填充。
Cu2++2Cl-+e-→CuCl2-
(1)
CuCl2-+e-→Cu2++2Cl-
(2)
Cu++Cl-→CuCl
(3)
CuCl+Cl-→CuCl2-
(4)
1.2 加速劑
加速劑通常是小分子脂肪族含硫有機物。在電鍍過程中,加速劑有利于晶核的形成,發揮著細化晶粒的作用,使晶核分布致密,促使鍍銅層變得平滑并得以反光。但單獨使用時其不能起到加速的作用,反而會阻化金屬銅的沉積。加速劑只有在復合添加劑中才能發揮加速效果。其典型功能化官能團有二硫鍵(—S—S—)、磺酸基團(—SO3—)以及巰基(—SH)。目前研究較多的光亮劑為聚二硫二丙烷磺酸鈉(SPS)和3-巰基丙烷磺酸鈉(MPS)。有研究表明在電鍍銅的電位范圍內,SPS分子本身的化學特性和電化學特性都不活潑,其在電鍍反應過程中所發揮的加速作用主要是由于SPS分子中的二硫鍵在電場作用下發生裂解,形成MPS;而MPS則曾被認為是電鍍過程中真正的加速劑[3]。DOW等[4]認為MPS或是SPS能加速電鍍銅沉積是因為MPS或是SPS利用其硫醇官能基吸附在陰極銅面上,然后其末端的磺酸根陰離子會捕捉鍍液中被水合的銅離子,使其先破水合作用,然后再與吸附在陰極表面上的氯離子產生交互作用,讓電子透過氯離子傳遞給被磺酸根陰離子捕捉的銅離子,因而可以大幅提升銅離子的電化學還原速率。相關具體吸附模型及作用機制如圖2所示。

圖2 MPS加速作用機理及遷移作用機制[4]
1.3 抑制劑
整體上可把抑制劑分為兩種類型,如圖3所示。type Ⅰ是第一類抑制劑,是典型的抑制劑。在氯離子協同作用下,抑制劑在陰極表面吸附,最終達到抑制板面金屬銅沉積的作用。同時,使高低電流區的差異降低(亦即增加極化電阻),讓電鍍銅能均勻的持續沉積。抑制劑可充當潤濕劑,降低界面的表面張力(降低接觸角),讓鍍液更容易進入孔內而增加傳質效果。研究表明,抑制劑的抑制性能取決于它在銅/電解液界面上形成的那一層致密聚合物膜,在電鍍過程中,此致密聚合物膜不會被大量并入到沉積銅層里,而是持續一個吸附-解吸過程(從舊銅層上解吸,到新銅層上吸附),從而不斷吸附在新沉積的銅層表面,以作為一擴散阻擋層限制銅離子到銅表面的擴散。抑制劑的抑制效果歸因于其或由其產生的中間產物在陰極表面吸附而產生“堵塞效應”(blocking effect),導致銅沉積活性位點的堵塞。目前研究最多的典型的抑制劑為聚醚類有機高分子,如聚乙二醇(PEG)、聚丙二醇(PPG)以及環氧已烷(EO)與氧化丙烷(PO)的三嵌段聚合物(EPE)。抑制劑的抑制效果與它們自身分子結構有關。一般來說,抑制劑的抑制效果會隨著聚合物鏈中PO重復單元比例的增加而增加。但是作為一種疏水性基團,長PO鏈將會使聚合物分子不溶于水,因此常需要一些EO基團來增加其親水性。有研究發現[5],抑制劑鏈中EO與PO的比值將直接決定其在電鍍過程中的抑制效果大小。
type Ⅱ是第二類抑制劑,是通常說的整平劑。它是一種含氮的有機單體或者是聚合物,帶有很強的正電性,包括多胺以及胺類與環氧烷或氯代醇衍生物的合成產物。整平劑表現出來的作用也是抑制作用。抑制劑類型Ⅰ(如PAG)有選擇性形成有效阻擋銅擴散膜的特性,從而阻擋亞銅離子擴散到銅表面。抑制劑類型Ⅱ(如PEI)則沒有選擇性,但因其本身帶有正電荷,基于陰陽離子對效應,它會與所有化學吸附在銅面上的陰離子相互作用。目前也有另一種抑制劑的合成,該抑制劑同時兼具抑制劑類型Ⅰ和抑制劑類型Ⅱ的功能團,如圖3中抑制劑IBDGE。
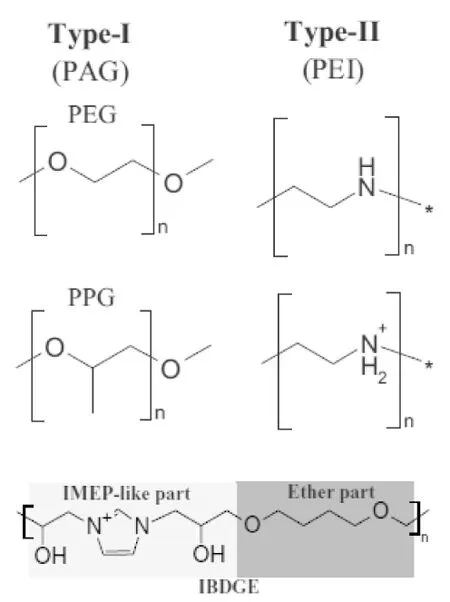
圖3 不同類型抑制劑基本結構
2 電鍍添加劑間的相互作用
添加劑在電鍍過程中發揮的作用各不相同,通常描述的添加劑的加速能力或抑制能力都不只是它們自身的固有能力,而是添加劑相互作用的結果,單一添加劑所發揮作用的簡單疊加也并不能達到良好的電鍍效果。有研究表明[6]各添加劑之間存在著相互作用,它們間的協同作用或對抗作用將導致它們在反應界面上形成更多、更復雜的分子絡合物,而這些復雜的分子絡合物才是使它們發揮加速效果或抑制效果的原因。而各添加劑活動行為之間的相互作用具有時間依賴性,不同的時間段它們間的作用模式也會不同[7]。
2.1 氯離子與加速劑間的作用
氯離子與加速劑之間存在著協同作用。研究證明[8],吸附物與基質間存在強烈的相互作用,當SPS或MPS單獨加入電鍍槽液中時,加速劑作為一種吸附物質將強烈吸附在銅表面,吸附的硫醇(RSH)分子將會改建最表面一層(M)的基質,形成不溶性的硫醇-銅絡合物(RS-M)薄膜[反應式(5)],這種不溶性絡合物薄膜將起到抑制作用,阻化銅沉積過程。而氯離子的加入,則將SPS或MPS由這種具有微弱抑制特性的抑制劑變為溫和的加速劑[9],因為氯離子的存在不但能有效阻止硫醇-銅絡合物沉淀的產生,而且能與亞銅離子、加速劑形成更穩定的、溶于水的配位復合體[Cu(Ⅰ)-Cl-thiolate]-[反應式(6)]。Vereecken等[10]研究認為,這種穩定后的亞銅離子絡合物能夠加速電鍍銅沉積過程。
2Cu+SPS→2Cu(Ⅰ)(thiolate)
(5)
CuCl+SPS→CuCl(thiolate)-+H+
(6)
CuCl+SPS→Cu(Ⅰ)(thiolate)+Cl-+H+
(7)
如反應式(7)所示,氯離子與加速劑之間也存在著競爭吸附作用。因銅表面的吸附位點有限,SPS與氯離子在銅表面的吸附存在競爭吸附的關系,這種競爭吸附會引起化學吸附在金屬銅表面的陰離子層發生變化,能使抑制劑(典型抑制劑,如PAG)失去活性。首先提出這種競爭吸附關系的是Bae等[11],他們認為氯離子形成的c(2×2)-Cl點陣結構能夠有效阻擋SPS的吸附。他們用氯修飾后的銅(100)晶面作為模型基質,再加入SPS,但STM觀察發現最先吸附形成的c(2×2)-Cl表面結構沒有發生明顯變化。而Moffat等[12]揭示了大多數情況下SPS的吸附構型,他們發現在完整的c(2×2)-Cl晶格點陣上存在一橫向移動的SPS物理吸附層,當改變電極電位使其接近或超過c(2×2)-Cl結構斷裂電位范圍時,SPS將會吸附在裸露的銅表面,吸附分解后形成p(2×2)-MPS層。而這一SPS物理吸附層Bae等是沒有觀察到的。Hai等[13]也同意此競爭狀態的存在,他們認為在無反應發生時,氯離子比SPS更快地在銅(100)晶面吸附、排序,形成c(2×2)-Cl吸附層,有效地阻擋了SPS的吸附。此時,游離SPS如要在銅面上吸附,就需要在氯離子距陣基體上產生缺陷位點。而在有反應發生時,不斷沉積的銅表面使得陰離子不斷重復著快速吸附/解吸/吸附過程,此過程就將導致氯離子吸附層上產生缺陷位點,而缺陷位點一旦產生,SPS將會吸附在裸露的銅表面,其在銅表面的分解產物MPS就會與氯離子共吸附在銅表面形成混合的、有更多缺陷位點的c(2×2)Cl-MPS吸附層。
2.2 氯離子與抑制劑間的作用
2.2.1 氯離子與典型抑制劑間的相互作用
在電鍍過程中,氯離子作為一種必不可少的成分,極大地影響著抑制劑的抑制效果。它能夠與抑制劑和亞銅離子交互作用形成Cu+-抑制劑-Cl-絡合物,如反應式(8)所示。
nCuCl+HO((CH2)XO)yH→
HO((CH2)xOCuCl)n((CH2)XO)y-nH
(8)
該絡合物將吸附在陰極表面,產生堵塞釘扎效應,阻擋銅離子或亞銅離子擴散到銅板面,從而抑制銅離子的還原。當基本鍍液中缺少氯離子時,抑制劑僅能靠靜電作用力或范德華力吸附在陰極表面,但這種吸附強度是很弱的,以致不能有效地抑制銅沉積[14]。有大量文獻對聚醚類抑制劑與氯離子在銅電極表面上的合作吸附關系進行了報道,認為聚醚類抑制劑與氯離子的這種合作吸附作用能夠增加銅電極表面的過電位。因為氯離子的存在為抑制劑的吸附提供強的結合位點[15],剛開始沉積銅時,氯離子首先快速特性吸附在銅表面[16],化學吸附后的氯離子作為配位結合的離子[8,17],再與抑制劑進行配位。Xiao N等[18]提出了EPE2900具體吸附作用模型,如圖4所示,此模型揭示了目前大多數聚醚類抑制劑的作用機制。Feng Z V等[19]用表面增強拉曼光譜等分析手段證明Cl-Cu-PEG絡合物確實存在于電極表面,此外,他們通過理論計算與詳細的推理過程發現在這種復雜的絡合物中,銅除與一個Cl配位外,還與PEG中的兩個氧原子O進行配位。

圖4 EPE2900在陰極表面可能存在的吸附模型
2.2.2 氯離子與整平劑間的相互作用
氯離子作為一種陰離子,可通過陰陽離子對效應與帶有正電荷的整平劑發生靜電耦合作用。從電化學的觀點來看,整平劑是一種不會被加速劑去活化的抑制劑。因此,類似于氯離子與抑制劑間的相互作用,氯離子與整平劑間也存在著協同作用,最大限度的增加過電位,使電鍍填孔后板面得以整平。
2.3 加速劑與抑制劑間的作用
在盲孔電鍍的過程中,光亮劑作為一種去極化劑,主要分布在盲孔的底部,降低該位置的銅還原過電位,從而加速盲孔底部銅沉積。有研究發現隨著光亮劑濃度的增加,其降低陰極銅還原電位的能力也持續增加[20]。但隨著加速劑濃度越來越大,陰極電位會增加到一個最大值,意味著加速劑在陰極上達到了飽和吸附的狀態,這時再增加其濃度對陰極電位沒什么影響。此外,陰極電位越大并不意味著盲孔填充效果越好,Lu X等[21]證明了一定范圍內的光亮劑含量增加,能增大盲孔填充率,但過高的光亮劑含量會影響抑制劑對板面銅沉積的抑制效果,從而使填充率下降。
2.3.1 光亮劑與典型抑制劑的相互作用
典型的抑制劑如第一類抑制劑與光亮劑之間存在對抗作用。加速劑作為抑制劑的去活化劑,對抑制劑有去極化作用,即滅活作用。Joshua W等[22]在研究不同抑制劑條件下SPS的加速效果時,發現無加速劑存在時抑制劑的抑制效果更強。
抑制劑的作用功效主要在板面上,而加速劑的貢獻主要體現在盲孔底部,因為某些物理原因及電鍍液強制對流等因素的差異,抑制劑與加速劑在銅表面上存在競爭吸附的關系。相對于加速劑,抑制劑先在板面上特性吸附形成一層CuCl-抑制劑薄膜,隨后加速劑吸附在板面上,與抑制劑產生競爭吸附關系,部分抑制劑吸附位點就會被加速劑吸附取代。如反應式(9)所示。
HO((CH2)xOCuCl)n((CH2)xO)y-nH+nMPS→HO((CH2)xO)yH+nCl-+nCu(Ⅰ)(thiolate)
(9)
目前,已建立各種關系模型來描述加速劑與抑制劑之間的這種相互作用。Hebert等[23]利用加速劑與抑制劑之間的競爭吸附關系來描述于循環伏安測試過程中出現的遲滯現象,認為一旦銅表面從抑制劑形成的膜中裸露出來,加速劑就會在裸露的銅面吸附形成Cu(Ⅰ)(thiolate)ad膜,阻止CuCl的形成。而CuCl絡合物對于抑制劑重新吸附是至關重要的[24][反應式(4)],CuCl的減少將影響抑制劑的吸附過程,最終導致滯后現象的發生。Huynh等[25]用表面覆蓋模型來描述加速劑與抑制劑的這種相互作用,他認為有效表面覆蓋度等于抑制劑或其中間體所覆蓋的受抑制部分區域減去因加速劑作用而恢復到無抑制效果的區域。也有研究[26]認為SPS在氯點陣的表面的物理吸附將空間阻擋抑制劑與氯離子的相互作用。同時,氯作為抑制劑與銅表面的鏈接劑,物理吸附上一層加速劑后,將會造成抑制劑復合產物的瓦解。而這種瓦解作用,有研究[27]認為是游離MPS通過絡合抑制劑絡合物中的Cu(Ⅰ)而在結構上瓦解PAG-Cu(Ⅰ)-Cl抑制劑薄膜,因為陰離子MPS對Cu(Ⅰ)具有很強的絡合能力。Tan M等[28]用示意圖5來描述SPS對PAG-Cu(Ⅰ)-Cl抑制劑薄膜的滅活作用,此模型目前已被大多數人所認同接受。

圖5 SPS結構上瓦解PAG-Cu(Ⅰ)-Cl抑制劑薄膜反應機理示意圖[28]
除此之外,加速劑對抑制劑還存在一定的性能依賴性。之前已經提到加速劑和氯離子的交互作用能加速銅沉積速率,但Moffat T等[29]在研究中發現無抑制劑存在時,即使有氯離子加入,小濃度的SPS仍起抑制效果,而無加速作用。目前已有大量的實驗事實證明Hung的研究發現是正確的,在無抑制劑存在的條件下,加速劑沒有明顯的加速效果。為解釋該現象產生的原因,有研究發現[30]抑制劑的加入能夠增加加速劑的吸附量。他們認為加速劑的吸附具有電位依賴性,而抑制劑的加入會導致電位轉移,過電位的增加將引起加速劑吸附量的增加。同時,抑制劑的加入也將使得加速劑并入消耗速率減小。
2.3.2 光亮劑與整平劑(抑制劑類型Ⅱ)的相互作用
整平劑含有帶正電的氮陽離子,加速劑擁有帶負電的磺酸基團,他們之間可通過靜電吸引而產生離子對間的相互作用。作為另一種抑制劑類型(typeⅡ),整平劑不會被SPS光亮劑滅活(相對于SPS對PAG典型抑制劑的滅活作用)。Dow W P等[31]在研究十二烷基三甲基溴化銨(DTAC)控制“bump”形成的作用效果時認為,DTAC通過離子對效應對SPS具有減活化作用。Broekmann等[8]發現在往含有整平劑的電鍍液中加入SPS時,電極過電位有了不可忽視的增大。這說明,不同于與典型抑制劑間的相互作用,加速劑與整平劑之間存在著協同作用而無對抗作用。隨后Tan M等[28]也同樣發現和聚乙烯亞胺(PEI)與SPS間的協同作用,為此他們提出了可能的理論模型來解釋此協同作用機制,如圖6所示。

圖6 SPS與整平劑PEI間協同作用生成PEI-Cu(Ⅰ)-MPS抑制劑反應機理示意圖[28]
同時,加速劑與整平劑間也存在著競爭吸附的關系,這種競爭吸附作用很大程度上取決于對流強度,因為整平劑具有“convection-dependent”的特性。一般來說,在低流速下,起主導作用的主要是光亮劑,而在高轉速下,整平劑將發揮其主導作用,取代光亮劑吸附于金屬表面。Kim等[32]對此競爭吸附關系進行了解釋。
2.4 整平劑與抑制劑間的相互作用
Dow W P等[31]認為整平劑JGB與抑制劑PEG間存在協同作用,形成一復合抑制劑,這種復合抑制劑對銅沉積的抑制效果比PEG和JGB的作用效果更強,并強調該協同作用的強度與對流有關。也有文獻報道了一種以膽堿為基礎、含有兩個季銨結構的整平劑,在強對流條件下,此整平劑能與抑制劑共吸附在金屬表面,該共吸附作用(也可稱協同抑制作用)能有效增強對銅沉積的抑制效果。
3 結 論
本文結合目前國內外相關的文獻報道對PCB電鍍工藝中添加劑間的相互作用進行分析和綜述。添加劑之間的相互作用復雜且多變。目前關于這方面的研究有很多,但還沒有完全的定論。隨著添加劑的不斷開發,特別是多功能化添加劑的合成,添加劑間的作用將會更多樣化,其在電鍍過程中的作用機理也將會更復雜。
[1] Pasquale M A,Gassa L M,Arvia A J.Copper electrodeposition from an acidic plating bath containing accelerating and inhibiting organic additives[J].Electrochimica Acta,2008,53(20):5891-5904.
[2] Andricacos P C,Uzoh C,Dukovic J O,et al.Damascene copper electroplating for chip interconnections[J].IBM Journal of Research and Development,1998,42(5):567-574.
[3] Broekmann P,Mayer D.Function through structure:An atomistic view on the additive action at copper/electrolyte interfaces[C].2010 IEEE International Interconnect Technology Conference.IEEE,2010:1-3.
[4] Dow W P,Chiu Y D,Yen M Y.Microvia filling by cu electroplating over a au seed layer modified by a disulfide[J].Journal of The Electrochemical Society,2009,156(4):D155-D167.
[5] Gallaway J W,Willey M J,West A C.Acceleration kinetics of PEG,PPG,and a triblock copolymer by SPS during copper electroplating[J].Journal of The Electrochemical Society,2009,156(4):D146-D154.
[6] Akolkar R,Landau U.Mechanistic analysis of the "bottom-up" fill in copper interconnect metallization[J].Journal of The Electrochemical Society,2009,156(9):D351-D359.
[7] Moffat T P,Wheeler D,Edelstein M D,et al.Superconformal film growth:Mechanism and quantification[J].IBM Journal of Research and Development,2005,49(1):19-36.
[8] Broekmann P,Fluegel A,Emnet C,et al.Classification of suppressor additives based on synergistic and antagonistic ensemble effects[J].Electrochimica Acta,2011,56(13):4724-4734.
[9] Chen H M,Parulekar S J,Zdunek A.Interactions of chloride and 3-mercapto-1-propanesulfonic acid in acidic copper sulfate electrolyte[J].Journal of The Electrochemical Society,2008,155(5):D349-D356.
[10] Vereecken P M,Binstead R A,Deligianni H,et al.The chemistry of additives in damascene copper plating[J].IBM Journal of Research and Development,2005,49(1):3-18.
[11] Bae S E,Gewirth A A.In situ ec-stm studies of mps,sps,and chloride on cu (100):Structural studies of accelerators for dual damascene electrodeposition[J].Langmuir,2006,22(22):10315-10321.
[12] Moffat T P,Yang L Y O.Accelerator surface phase associated with superconformal Cu electrodeposition[J].Journal of The Electrochemical Society,2010,157(4):D228-D241.
[13] Hai N T M,Huynh T T M,Fluegel A,et al.Competitive anion/anion interactions on copper surfaces relevant for Damascene electroplating[J].Electrochimica Acta,2012,70:286-295.
[14] Kelly J J,West A C.Copper deposition in the presence of polyethylene glycol I.Quartz crystal microbalance study[J].Journal of The Electrochemical Society,1998,145(10):3472-3476.
[15] Healy J P,Pletcher D,Goodenough M.The chemistry of the additives in an acid copper electroplating bath:part I.Polyethylene glycol and chloride ion[J].Journal of Electroanalytical Chemistry,1992,338(1):155-165.
[16] Suggs D W,Bard A J.Scanning tunneling microscopic study with atomic resolution of the dissolution of Cu (100) electrodes in aqueous chloride media[J].The Journal of Physical Chemistry,1995,99(20):8349-8355.
[17] Kelly J J,West A C.Copper deposition in the presence of polyethylene glycol II.Electrochemical impedance spectroscopy[J].Journal of The Electrochemical Society,1998,145(10):3477-3481.
[18] Xiao N,Li D,Cui G,et al.Adsorption behavior of triblock copolymer suppressors during the copper electrodeposition[J].Electrochimica Acta,2014,116:284-291.
[19] Feng Z V,Li X,Gewirth A A.Inhibition due to the interaction of polyethylene glycol,chloride,and copper in plating baths:a surface-enhanced Raman study[J].The Journal of Physical Chemistry B,2003,107(35):9415-9423.
[20] Qin Y,Li X H,Xue F,et al.Effect of additives on shape evolution during electrodeposition -III.Trench infill for on-chio interconnects[J].Journal of The Electrochemical Society,2008,155(3):D223-D233.
[21] Lu X,Yao L,Ren S,et al.A study of bottom-up electroplated copper filling by the potential difference between two rotating speeds of a working electrode[J].Journal of Electroanalytical Chemistry,2014,712:22-32.
[22] Gallaway J W,Willey M J,West A C.Acceleration kinetics of PEG,PPG,and a triblock copolymer by SPS during copper electroplating[J].Journal of The Electrochemical Society,2009,156(4):D146-D154.
[23] Hebert K R.Analysis of current-potential hysteresis during electrodeposition of copper with additives[J].Journal of The Electrochemical Society,2001,148(11):C717-C732.
[24] Teerlinck I.Electrochemical Copper Deposition in IC Manufacturing[D].Ph.D.Thesis,Universiteit Gent in collaboration with IMEC,Leuven,Belgium,2002,Chapter 5.
[25] Huynh T M T,Weiss F,Hai N T M,et al.On the role of halides and thiols in additive-assisted copper electroplating[J].Electrochimica acta,2013,89:537-548.
[26] Hai N T M,Kramer K W,Fluegel A,et al.Beyond interfacial anion/cation pairing:The role of Cu(I) coordination chemistry in additive-controlled copper plating[J].Electrochimica Acta,2012,83:367-375.
[27] Hung C C,Lee W H,Chang S C,et al.Suppression effect of low-concentration bis-(3-sodiumsulfopropyl disulfide) on copper electroplating[J].Journal of The Electrochemical Society,2008,155(2):D133-D136.
[28] Tan M,Harb J N.Additive behavior during copper electrodeposition in solutions containing Cl-,PEG,and SPS[J].Journal of The Electrochemical Society,2003,150(6):C420-C422.
[29] Moffat T,Kim S K,Josell D.Control of overfill bumps in damascene cu electrodeposition[J].ECS Transactions,2007,2(6):93-106.
[30] Moffat T P,Wheeler D,Kim S K,et al.Curvature enhanced adsorbate coverage model for electrodeposition[J].Journal of The Electrochemical Society,2006,153(2):C127-C132.
[31] Dow W P,Huang H S,Yen M Y,et al.Influence of convection-dependent adsorption of additives on microvia filling by copper electroplating[J].Journal of The Electrochemical Society,2005,152(6):C422-C434.
[32] Kim M J,Seo Y,Kim H C,et al.Galvanostatic bottom-up filling of TSV-like trenches:Choline-based leveler containing two quaternary ammoniums[J].Electrochimica Acta,2015,163:174-181.
Research Progress of the Interactions among the Additives of Copper Electroplating in PCB Manufacturing
PENG Jia1,2, CHENG Jiao2, WANG Chong1,2, XIAO Dingjun2, HE Wei1,2
(1.Department of Applied Chemistry,University of Electronic Science and Technology of China,Chengdu 610054,China; 2.Guangdong Guanghua Sci-Tech Co.,Ltd.,Shantou 515061,China)
As the important components in copper electroplating solution for PCB manufacturing,additives play irreplaceable roles in the electroplating process.The additives can effectively improve the current distribution in the electroplating process,increase the throwing power of the plating solution and control the electrical transportation of copper ions and the crystallization process from plating solution to reaction interface,which will affect the electrochemical deposition rate in micro concave and micro convex of the PCB panel.But the additive function is not a simple sum of the function of each additive,there are complex synergistic and antagonistic interplay existed between them.For the sake of better guidance of copper electroplating additive formulation research and development,and improving the level of electroplating process,combined with the related literatures both at home and abroad,the interactions between the additives in the electroplating process are analyzed and summarized in this paper.
additives; copper electroplating; interaction; PCB
2016-06-06
2016-07-05
廣東省引進創新科研團隊計劃(項目編號201301C0105324342);國家自然科學基金會資助(No. 61474019)
10.3969/j.issn.1001-3849.2016.12.004
TQ153.14
A

