垂直式MOCVD中生長參數(shù)對Ga N材料生長的影響
馮蘭勝,過潤秋,張進成
(1.西安電子科技大學(xué)機電工程學(xué)院,陜西西安 710071; 2.西安電子科技大學(xué)微電子學(xué)院,陜西西安 710071)
垂直式MOCVD中生長參數(shù)對Ga N材料生長的影響
馮蘭勝1,過潤秋1,張進成2
(1.西安電子科技大學(xué)機電工程學(xué)院,陜西西安 710071; 2.西安電子科技大學(xué)微電子學(xué)院,陜西西安 710071)
為了更好地研究GaN材料生長過程,筆者對一種垂直噴淋式金屬有機物化學(xué)氣相淀積系統(tǒng)生長GaN材料過程中反應(yīng)物的傳遞和反應(yīng)過程進行了模擬.模擬結(jié)果表明,反應(yīng)室壓力和進入反應(yīng)室的氣流速度對Ga N的生長速率和厚度均勻性均有影響.隨著反應(yīng)氣體進入反應(yīng)室的速度升高,反應(yīng)室內(nèi)預(yù)反應(yīng)會增強,GaN生長速率升高,同時GaN厚度的不均勻性也會升高;在同樣的進氣速率下,反應(yīng)室壓強減小,可在一定范圍內(nèi)提高GaN生長速率,但同時增加襯底中央?yún)^(qū)域厚度,導(dǎo)致厚度不均勻增加.
GaN;金屬有機物化學(xué)氣相淀積;生長速率;反應(yīng)動力學(xué)
Ga N是重要的寬帶隙半導(dǎo)體材料,在光電器件、高功率器件等眾多領(lǐng)域有著廣泛的應(yīng)用.金屬有機物化學(xué)氣相淀積(Metal Organic Chemical Vapor Deposition,MOCVD)方法是制備GaN材料的主要手段之一.為了提高GaN的材料質(zhì)量,國內(nèi)外很多學(xué)者針對MOCVD生長GaN材料的生長動力學(xué)過程做了大量研究.文獻[1-2]使用fluent軟件對垂直噴淋式MOCVD中生長GaN的氣體流動、表面反應(yīng)過程、襯底溫度分布以及生長速率進行了模擬.文獻[3-5]使用分子動力學(xué)方法、離散傅里葉變換(Discrete Fourier Transform,DFT)等方法在分子運動層面分析了GaN生長過程.文獻[6-9]對GaN生長過程中的化學(xué)反應(yīng)路徑和反應(yīng)過程進行了分析.目前,對于GaN生長過程的模擬主要分為宏觀參數(shù)模擬和微觀分子運動模擬兩大類.宏觀參數(shù)模擬主要用來模擬反應(yīng)過程中反應(yīng)物的氣體流動、化學(xué)反應(yīng)濃度分布等過程;微觀分子運動模擬主要用來模擬分子在襯底表面的吸附、擴散、脫附等過程.筆者通過對垂直噴淋式MOCVD系統(tǒng)生長Ga N的生長過程進行模擬,分析對比不同的反應(yīng)物流速以及不同的反應(yīng)室壓力對于Ga N生長化學(xué)反應(yīng)過程和生長速率的影響.其主要目的是為優(yōu)化GaN生長條件、提高GaN生長質(zhì)量提供參考.
1 化學(xué)生長模型與反應(yīng)室模型
Ga N生長過程中的實際化學(xué)反應(yīng)過程非常復(fù)雜,目前很難通過實驗確定其詳細的化學(xué)反應(yīng)過程及相關(guān)參數(shù).總體上說,GaN生長涉及的化學(xué)反應(yīng)過程可以分為加合反應(yīng)和熱解反應(yīng).兩類反應(yīng)的反應(yīng)條件不同.在氣相傳輸過程中由于環(huán)境溫度相對較低,多發(fā)生加合反應(yīng).隨著反應(yīng)物接近襯底,溫度逐漸升高,加合反應(yīng)轉(zhuǎn)變?yōu)闊峤夥磻?yīng).文中所涉及的MOCVD系統(tǒng)由于其反應(yīng)室結(jié)構(gòu)特點,在GaN材料生長過程中,反應(yīng)氣體在到達襯底之前會充分地進行混合,然后混合氣體逐漸接近襯底,再通過化學(xué)反應(yīng)生成Ga N材料.因此,在氣相傳輸中和襯底表面均發(fā)生明顯的化學(xué)反應(yīng).為了全面地分析GaN材料生長過程,筆者分別模擬了反應(yīng)物在氣相傳輸過程中和到達襯底后在襯底表面發(fā)生的化學(xué)反應(yīng),其中既有加合反應(yīng),也有熱解反應(yīng).其化學(xué)模型如表1和表2所示.
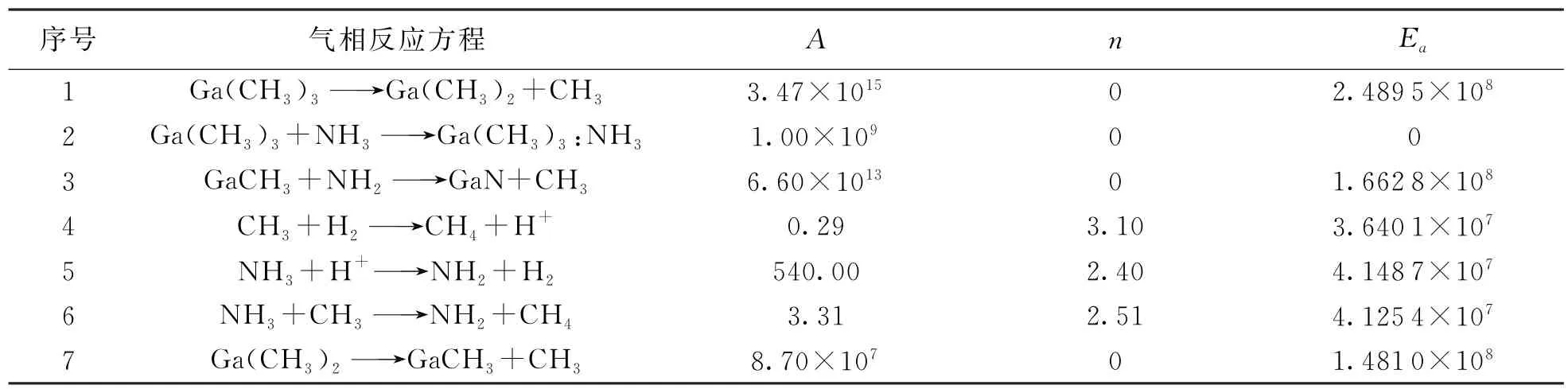
表1 GaN氣相化學(xué)反應(yīng)

表2 GaN表面化學(xué)反應(yīng)
表1中每種化學(xué)反應(yīng)的反應(yīng)速率k均遵循Arrhenius公式:k=ATnex( p-Ea/(RT)).指前系數(shù)A的單位為cm3/(mol·s).n為溫度指數(shù).Ea為反應(yīng)發(fā)生所需要的活化能,單位為J/(kg·mol),R為理想氣體常數(shù).
文中所涉及的MOCVD設(shè)備為西安電子科技大學(xué)自行研制的120型MOCVD.該反應(yīng)室為垂直噴淋式,其模型如圖1(a)所示.對應(yīng)其內(nèi)部結(jié)構(gòu),建立模擬所使用的模型如圖1(b)所示.模型包括反應(yīng)室進氣口、側(cè)壁、石墨上表面(襯底)以及石墨側(cè)面的氣流出口.
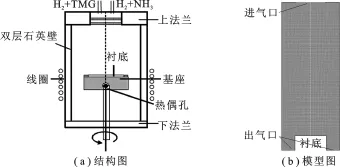
圖1 120型MOCVD反應(yīng)室結(jié)構(gòu)圖以及模型圖
2 模擬結(jié)果及討論
筆者在模擬中使用的主要反應(yīng)條件包括:襯底溫度為1 000℃,襯底旋轉(zhuǎn)速度為60 r/m,V/Ⅲ為2 000,襯底半徑為25 mm,氣體入口半徑為25 mm,入口至襯底高度為225 mm,反應(yīng)氣體為TMGa、NH3,載氣為H2.
2.1入口氣體流速對GaN生長速率及厚度均勻性的影響
在上述條件下,反應(yīng)室壓力為40torr(1torr≈133.322 Pa)時,模擬了不同的入口氣體流速下,Ga N的生長過程.圖2所示為入口氣體流速分別為0.01 m/s,0.10 m/s,0.30 m/s,0.50 m/s,0.70 m/s,0.9 m/s時,Ga N沿襯底表面方向的生長速率分布.
根據(jù)圖2的模擬結(jié)果,隨著入口氣體流速的升高,GaN生長速率因單位時間內(nèi)反應(yīng)物增加而升高,但是其生長速率并未與入口氣體流速成比例的升高,同時在襯底表面的分布逐漸趨向不均勻.中心部位和邊緣生長速率相對較低,而且速率增長緩慢,其余區(qū)域沿半徑逐漸升高.為了分析原因,筆者對比了不同情況下的GaN表面反應(yīng)過程.在襯底表面生成Ga N的化學(xué)反應(yīng)過程主要為熱解反應(yīng),熱解反應(yīng)的反應(yīng)物主要是MMGa(單甲基鎵GaCH3),根據(jù)化學(xué)反應(yīng)模型,這是生成GaN材料最主要的物質(zhì).MMGa的濃度和分布直接決定了Ga N的生長速率以及厚度分布.不同氣體進口速度所對應(yīng)的MMGa在襯底表面的分布規(guī)律如圖3所示.通過對比發(fā)現(xiàn),MMGa只分布在襯底表面高溫區(qū)域中,說明只有在這個高溫區(qū)域內(nèi)發(fā)生熱解反應(yīng).同時,隨著入口氣體流速的升高,反應(yīng)物MMGa的分布區(qū)域逐漸向邊緣地帶移動,從而引起生長速率分布的變化.

圖2 GaN在不同入口速率下生長速率分布
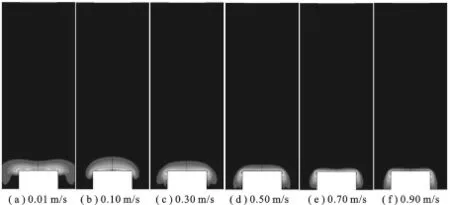
圖3 不同入口氣流速度下MMGa沿襯底表面的分布
此外,通過對圖3的對比發(fā)現(xiàn),在流速過低或者過高的情況下,進入反應(yīng)室的反應(yīng)物質(zhì)所生成的MMGa都不能很好地分布在襯底表面,從而進一步生成Ga N.筆者對比了不同進口速度下,反應(yīng)室內(nèi)的流場分布,其結(jié)果如圖4所示.
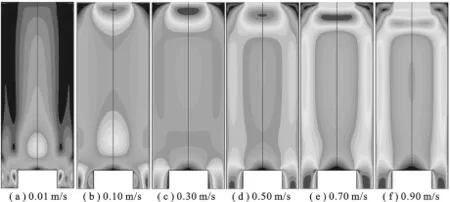
圖4 不同入口氣流速度下反應(yīng)室內(nèi)的流場速度分布圖
通過圖4的流場分布對比圖發(fā)現(xiàn),流速過低時,反應(yīng)氣體到達襯底表面的難度增加,大部分會在氣體傳輸中發(fā)生預(yù)反應(yīng).流速較高時,根據(jù)流場分布圖,反應(yīng)物會更多地經(jīng)過襯底邊緣,同樣使得到達中央?yún)^(qū)域的反應(yīng)物質(zhì)減少.因此,適當(dāng)?shù)臍怏w入口速度不僅對于材料厚度的均勻性有影響,同時影響反應(yīng)物的利用率.在Ga N生長中,應(yīng)該合理調(diào)整入口氣體速度,從而獲得更好的GaN材料厚度均勻性,同時提高反應(yīng)物的利用率.根據(jù)實際實驗數(shù)據(jù),文中針對的MOCVD系統(tǒng)采用進口氣體速度在0.1~0.3 m/s之間,生長速率在2μm/h左右.同時,其表面厚度分布大致為中心厚度較小,沿半徑方向厚度升高,邊緣地帶又有所降低.特征基本與模擬結(jié)果吻合.
2.2入口氣體流速對預(yù)反應(yīng)的影響
圖5為不同的入口氣體流速下,沿反應(yīng)室高度方向反應(yīng)物質(zhì)TMGa∶NH3的分布情況.橫軸代表反應(yīng)室垂直方向中心線.通過模擬結(jié)果發(fā)現(xiàn),反應(yīng)氣體進入到反應(yīng)室后,在接近襯底并不斷混合的過程中,逐漸生成TMGa∶NH3,該物質(zhì)是主要的預(yù)反應(yīng)生成物之一.模擬結(jié)果表明,隨著氣流速度的升高,反應(yīng)產(chǎn)生的TMGa∶NH3增多,從而使得預(yù)反應(yīng)增強,這一方面會降低原材料的利用率,另一方面也會影響材料的質(zhì)量.從這個角度出發(fā),也應(yīng)該限制反應(yīng)過程中的入口氣體流速.
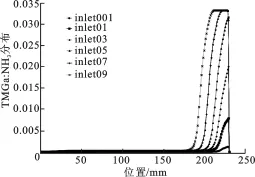
圖5 不同入口氣體速率下的TMGa∶NH3分布

圖6 不同反應(yīng)室壓力下GaN生長速率
2.3反應(yīng)室壓力對GaN生長速率的影響
確定了反應(yīng)室的進口氣體流速后,筆者還通過改變反應(yīng)室的壓力來對比不同壓力對反應(yīng)過程的影響.在其他模擬條件不變的情況下,將入口流速設(shè)置為0.3 m/s.將反應(yīng)室壓力分別設(shè)置為10,20,40,60,80,單位為torr,對Ga N反應(yīng)過程進行模擬.根據(jù)模擬結(jié)果得到不同反應(yīng)室壓力下Ga N生長速率沿襯底表面的分布曲線如圖6所示.通過曲線可以看出,在不同壓力下,生長速率的分布規(guī)律基本相同,均為沿半徑先有增加的趨勢,然后到邊緣部分再降低.但是不同壓力下也有所不同.在低壓下,襯底中央?yún)^(qū)域的反應(yīng)速率相對較高,這是由于在壓力低的情況下,反應(yīng)室內(nèi)壓力較低,反應(yīng)物更容易抵達襯底表面中心區(qū)域.而在壓力升高時,反應(yīng)室內(nèi)氣體密度大,反應(yīng)物到達襯底表面的區(qū)域逐漸外移.因此,適當(dāng)?shù)卦O(shè)置生長過程中反應(yīng)室的壓力,既有利于生長速率的提高,又有利于材料厚度的一致性.
3 結(jié) 論
筆者針對一種垂直噴淋式MOCVD系統(tǒng)建立了化學(xué)反應(yīng)模型和仿真結(jié)構(gòu)模型.模擬在不同反應(yīng)條件下,Ga N生長時在傳輸過程中發(fā)生的氣相化學(xué)反應(yīng)過程和在襯底表面生成Ga N的表面反應(yīng)過程.在此基礎(chǔ)上,分別對不同的反應(yīng)室進口氣體流速和反應(yīng)室壓力進行了模擬仿真.模擬結(jié)果表明,反應(yīng)室壓力和進入反應(yīng)室的氣流速度對GaN的生長速率和厚度均勻性均有影響.隨著反應(yīng)氣體進入反應(yīng)室的速度升高,反應(yīng)室內(nèi)預(yù)反應(yīng)會增強,GaN生長速率升高,同時Ga N厚度的不均勻性也會升高;在同樣的進氣速率下,反應(yīng)室壓強減小,可在一定范圍內(nèi)提高Ga N生長速率,但同時增加襯底中央?yún)^(qū)域厚度,導(dǎo)致厚度不均勻增加.模擬結(jié)果與實際實驗得到的Ga N材料特征相符合,進一步驗證了模擬的準確性,是優(yōu)化Ga N生長條件、提高GaN生長質(zhì)量的有效方法.
[1]TSENG C F,TSAI T Y,HUANG Y H,et al.Transport Phenomena and the Effects of Reactor Geometry for Epitaxial GaN Growth in a Vertical MOCVD Reactor[J].Journal of Crystal Growth,2015,432:54-63.
[2]ZHANG Z,FANG H S,YAN H,et al.Influencing Factors of GaN Growth Uniformity through Orthogonal Test Analysis[J].Applied Thermal Engineering,2015,91:53-61.
[3]ZHOU A,XIU X Q,ZHANG R,et al.Effect of Lattice Defects on the Property of GaN Crystal:a Molecular Dynamics Simulation Study[J].Superlattices and Microstructures,2015,88:679-684.
[4]KEMPISTY P,STRAK P,SAKOWSKI K,et al.DFT Study of Ammonia Desorption from the GaN(0001)Surface Covered with NH3/NH2 Mixture[J].Journal of Crystal Growth,2014,403:105-109.
[5]TOKOI H,OHTAKE A,TAGO K,et al.Development of GaN Growth Reaction Model Using Ab Initio Molecular Orbital Calculation and Computational Fluid Dynamics of Metalorganic Vapor-phase Epitaxy[J].Journal of the Electrochemical Society,2012,159(5):270-275.
[6]于海群.GaN沉積的化學(xué)反應(yīng)動力學(xué)進展[J].材料導(dǎo)報,2012,26(17):21-24. YU Haiqun.The Progress of Chemical Reaction Kinetics with Ga N Deposition[J].Materials Review,2012,26(17): 21-24.
[7]王國斌,張永紅,王懷兵.氮化鎵生長反應(yīng)模型與數(shù)值模擬研究[J].人工晶體學(xué)報,2010,139(增刊):160-163. WANG Guobin,ZHANG Yonghong,WANG Huaibing.Reaction Model and Numerical Simulation of Gallium Nitride Growth[J].Journal of Synthetic Crystal,2010,139(S1):160-163.
[8]PARIKH R P,ADOMAITIS R A.An Overview of Gallium Nitride Growth Chemistry and Its Effect on Reactor Design: Application to a Planetary Radial-flow CVD System[J].Journal of Crystal Growth,2006,286:259-278.
[9]FU K,FU Y,HAN P,et al.Kinetic Monte Carlo Study of Metal Organic Chemical Vapor Deposition Growth Dynamics of Ga N Thin Film at Microscopic Level[J].Journal of Applied Physics,2008,103(10):103524.
[10]許晟瑞,段渙濤,郝躍,等.(11-02)r面藍寶石生成長(112-0)a面氮化鎵研究[J].西安電子科技大學(xué)學(xué)報,2009,36 (6):1049-1052. XU Shengrui,DUAN Huantao,HAO Yue,et al.Study of(112-0)Non Polar a-plane Ga N on the(11-02)r-plane Sapphire[J].Journal of Xidian University,2009,36(6):1049-1052.
(編輯:李恩科)
Effect of growth parameters on GaN in a vertical MOCVD reactor
FENG Lansheng1,GUO Runqiu1,ZHANG Jincheng2
(1.School of Mechano-electronic Engineering,Xidian Univ.,Xi’an 710071,China; 2.School of Microelectronics,Xidian Univ.,Xi’an 710071,China)
A simulation of reactants in the transfer and reaction process during the GaN growth in a vertical MOCVD reactor is presented.The results show that the Ga N growth rate and thickness uniformity are all affected by the chamber pressure and the velocity of reactants into the chamber.With the increasing velocity of reactants into the chamber,pre-reaction will be enhanced,Ga N growth rate will be increased and thickness uniformity decreased.With the inlet velocity remaining the same and chamber pressure decreasing,the growth rate is improved within a certain scope,but the thickness uniformity may be increased at the same time with the thickness of the central region of the substrate increased.
GaN;MOCVD;GaN growth rate;reaction kinetics
TN204
A
1001-2400(2016)05-0178-05
10.3969/j.issn.1001-2400.2016.05.031
2016-01-22
國家自然科學(xué)基金資助項目(61334002);國家重大科技專項資助項目(2011ZX01002-001)
馮蘭勝(1978-),講師,西安電子科技大學(xué)博士研究生,E-mail:fenglansheng001@163.com.

