未退火InGaZnO作為緩沖層的InGaZnO薄膜晶體管性能研究
茍昌華,武明珠,郭永林,楊永強,關曉亮,段羽,王紅波
未退火InGaZnO作為緩沖層的InGaZnO薄膜晶體管性能研究
茍昌華,武明珠,郭永林,楊永強,關曉亮,段羽,王紅波*
(吉林大學電子科學與工程學院集成光電子學國家重點聯合實驗室,吉林長春130012)
銦鎵鋅氧化物薄膜晶體管(IGZO TFT)因具有場效應遷移率高,大面積均勻性好,無定型態等特點,被認為是顯示器朝著大尺寸、柔性化方向發展的新型背板技術。源漏電極與有源層之間的接觸氧化會增大器件的接觸電阻,從而導致器件的性能降低。利用未退火IGZO具有氧含量低、氧空位多、電導率高的特點,提出采用未退火IGZO作為源漏電極緩沖層,以減少源漏電極與有源層之間的接觸氧化。研究發現插入4 nm未退火IGZO緩沖層時,相對于未采用緩沖層的器件,其飽和區場效應遷移率提高了11.6%,閾值電壓降低了3.8 V,器件性能有所提高。此外,該方法還可以在原位退火之后繼續使用與有源層相同的材料濺射生長緩沖層,能夠使得在采用矩形靶濺射方式的工業生產中,制備緩沖層工藝更加簡單。
薄膜晶體管;InGaZnO;接觸電阻;緩沖層
1 引言
近年來,隨著顯示器的像素尺寸不斷變小,圖像刷新頻率不斷提高,傳統的非晶硅薄膜晶體管因遷移率低而難以滿足這種發展需求;盡管多晶硅薄膜晶體管的遷移率很高,但是其制作工藝復雜、成本較高、大面積均勻性差,也很難得到進一步應用[1-2]。自從2004年,K.Nomura等人[3]報道以銦鎵鋅氧化物半導體作為有源層的銦鎵鋅氧化物薄膜晶體管(InGaZnO Thin Film Transistor,IGZO TFT)以來,它就以場效應遷移率高(≥10 cm2/(V·s))、工藝簡單、大面積沉積均勻性好、響應速度快、可見光范圍內透過率高等特點[4-6],引起了學術界和工業界的廣泛關注。目前,IGZO TFT被認為是顯示器朝著大尺寸、柔性化方向發展的最有潛力的背板技術[7-9]。
在IGZO TFT中,氧空位是載流子的主要來源,然而過多的氧空位會導致有源層內部缺陷態多,進而影響器件性能[10-12]。因此,IGZO TFT必須在大氣或者氧氣環境中,通過退火來消除過多的氧空位[13-15],同時有源層內部的缺陷減少。退火后的IGZO薄膜內部和表面的氧含量將增大[16],進而其電阻率增大了2~3個數量級。隨著源漏電極的制備完成,源漏電極的金屬原子很容易與有源層中的氧形成接觸氧化[17]。A.Kiani等人解釋了接觸氧化對器件性能的影響,以常見的電極材料Al作為源漏電極為例,Al原子向有源層擴散,與有源層內部或表面的氧在界面處結合,形成類似氧化鋁的基團[18],這將大大增加源漏電極與有源層之間的接觸電阻,使得器件的性能降低[19]。
本文從降低接觸電阻入手,研究源漏電極緩沖層對IGZO TFT性能的影響。我們利用未退火IGZO薄膜的內部及表面氧含量少、導電性好的特點,提出采用未退火IGZO作為緩沖層,避免源漏電極與富氧的有源層直接接觸,可以有效減少接觸氧化,從而提高器件的性能。
2 實驗
2.1材料及儀器
本實驗所用到的主要材料有:銦錫氧化物玻璃(ITO glass)、三甲基鋁(Trinethyluminium,TMA)、IGZO靶材(In∶Ga∶Zn∶O=1∶1∶1∶4)。
絕緣層材料利用原子層沉積(ALD)工藝生長,有源層IGZO薄膜利用磁控濺射工藝制備,器件的電學性能在室溫條件下采用Keithley 2400半導體參數測試系統進行測試,樣品的表面形貌采用原子力顯微鏡(AFM)進行分析。
2.2實驗過程
本文制備的四個器件結構如圖1所示。器件的具體結構為:ITO glass/Al2O3(150 nm)/IGZO (40 nm)/IGZO buffer layer(X nm,without annealing)/Al;其中:X是未退火IGZO緩沖層的厚度。在器件A、B、C和D中,X的值分別為0、2、4和6。
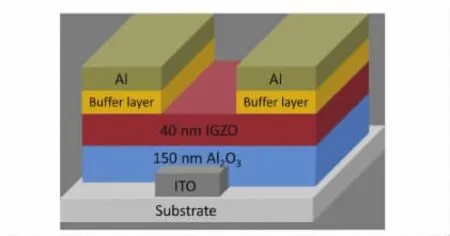
圖1 器件結構示意圖Fig.1Structure of the devices
所有器件制備之前,先將帶有ITO導電薄膜的玻璃襯底,用清洗液超聲清洗兩次,每次5 min;然后用去離子水超聲6次,每次5 min;最后烘干、紫外處理分別10 min。
首先,以三甲基鋁為源,利用ALD在ITO玻璃襯底上,生長150 nm Al2O3作為絕緣層,ITO作為器件的柵電極。然后,利用磁控濺射儀生長IGZO薄膜作為有源層,時間40 min,生長過程中維持濺射功率50 W,工作氣壓0.5 Pa,氬氣流量30 mL/min不變,IGZO經橢偏儀測定為40 nm。再將樣品放入烘箱中,在大氣環境下,200℃退火處理一小時。生長源漏電極之前,在器件B、C、D中,采用掩膜的方法,分別濺射2 nm、4 nm、6 nm未退火的IGZO薄膜作為源漏電極緩沖層,器件A是無緩沖層的對比器件。最后蒸鍍Al作為源漏電極。四個器件的溝道寬長比均為:1 000 μm/100 μm。
3 結果和討論
3.1器件的電學性能
器件工作在飽和區(VDS≥VGS-Vth)時,源漏電流(IDS)的表達式為:由(1)式可以推導出,器件工作在飽和區時的場效應遷移率:


圖2 (a)、(b)、(c)和(d)分別是器件A、B、C、D的輸出特性曲線Fig.2(a),(b),(c)and(d)are output characteristic curves of Device A,B,C and D,respectively

其中:K為IDS1/2-VGS曲線中擬合出的斜率、W/L為導電溝道的寬長比、Vth為閾值電壓、μFE為場效應遷移率、Ci為單位面積柵電容、εr為絕緣層材料的相對介電常數、ε0為真空介電常數、dinsulator為絕緣層的厚度。計算得到本實驗中Ci為4.66 nF/cm2。圖2中(a)、(b)、(c)和(d)分別為器件A、B、C和D的輸出特性曲線圖。
由圖2可得在VDS為30V時的IDS-VGS曲線及IDS1/2-VGS曲線,如圖3所示。根據器件的IDS-VGS曲線可以確定器件的開關電流比。經過擬合得到每個器件IDS1/2-VGS曲線中直線段的斜率依次為1. 68×10-2、1.63×10-2、1.78×10-2和1.71×10-2,結合式(2),可以計算出器件的飽和區的場效應遷移率。IDS1/2-VGS曲線的直線段擬合出的直線與橫坐標的交點為器件的閾值電壓。4個器件的電學參數如表1所示。

表1 器件A、B、C和D的電學性能參數Tab.1Electrical parameters of Device A,B,C and D

圖3 源漏電壓為30 V時,器件A、B、C和D的IDS-VGS以及IDS1/2-VGS曲線Fig.3IDS-VGSand IDS1/2-VGScurve at 30 V drain voltage of Device A,B,C and D
3.2接觸電阻分析
為了分析器件性能存在差異的原因,我們對器件的接觸電阻進行分析。W.S.Kim等人[18]報道的計算薄膜晶體管總電阻的模型為:

其中:RT為IGZO TFT的總電阻,Ractive為薄膜晶體管的有源層電阻,RS/D為源漏電極與有源層之間的接觸電阻。我們制備的四個器件的有源層材料和工藝都相同,因此可以認為四個器件擁有相同的有源層電阻(Ractive)。所以源漏電極與有源層之間的接觸電阻(RS/D)與4個器件總電阻(RT)具有相同的變化趨勢,可以通過總電阻的變化來反應出接觸電阻的變化。
我們利用傳輸線法(TLM)[20]計算出了在60 V的柵壓下,器件A、B、C和D的總電阻分別為: 8.12、9.24、7.17和7.92 kΩ,其中器件C的總電阻最小。器件A中沒有緩沖層,源漏電極與富氧的有源層直接接觸,形成接觸氧化,導致器件A的總電阻比器件C和D大。但是我們注意到,與器件A相比,插入2 nm緩沖層的器件B的接觸電阻反而增大,而器件C和D的接觸電阻均減小。
為了進一步探究不同厚度緩沖層對器件性能影響的原因,在源漏電極生長之前,采用AFM技術對樣品表面形貌進行分析,AFM圖像如圖4所示。對AFM數據結果進行分析發現,四個器件表面粗糙度分別為1.30 nm、3.09 nm、2.01 nm和1.36 nm。當插入2 nm未退火IGZO作為緩沖層時,表面粗糙度由1.30 nm增大到3.09 nm,這主要是由于2 nm的IGZO還沒有形成連續均勻的薄膜,而以島狀形式存在,因而粗糙度較大。而較大的粗糙度不利于源漏電極與有源層之間形成理想的接觸[21],因此器件B的總電阻較大,從而導致器件B的性能相比于器件A反而降低。
當緩沖層厚度繼續增大時,可以看出界面處的粗糙度逐漸降低,然而器件的總電阻在經歷器件B到器件C的降低后,器件D的總電阻又開始升高。我們分析認為,器件D中的緩沖層過厚,相對于器件C,引入額外無意義的串聯電阻。實驗結果表明,插入4 nm未退火IGZO緩沖層時,器件的性能最好,飽和區場效應遷移率為13.5 cm2/(V·s),閾值電壓為17.5 V,開關電流比為3.1×104。

圖4 (a)、(b)、(c)和(d)分別為器件A、B、C和D的原子力顯微鏡圖像(掃描面積:1 μm×1 μm)Fig.4(a),(b),(c)and(d)are AFM images of Device A,B,C and D,respectively(scan area:1 μm×1 μm)
4 結論
為了研究未退火IGZO作為源漏電極緩沖層對IGZO薄膜晶體管性能的影響,我們考察了不同緩沖層厚度的器件性能。研究發現,在有源層和源漏電極之間,插入適當厚度的未退火IGZO作為緩沖層,能夠有效減少接觸氧化,從而使得接觸電阻降低。當緩沖層厚度為4 nm時,器件性能最優,與無緩沖層的對比器件相比,其飽和區場效應遷移率由12.1 cm2/(V·s)提高到13.5 cm2/ (V·s),閾值電壓由21.3 V降低到17.5 V。且本文采用與有源層相同的材料作為緩沖層,可在原位退火后繼續濺射生長緩沖層,與其他材料作為緩沖層相比,制備工藝更加簡單,方便采用大型矩形靶的工業生產。
[1]詹潤澤,謝漢萍,董承遠.采用不同透明電極的非晶銦鎵鋅氧化物薄膜晶體管[J].液晶與顯示,2013,28(1):55-58.
Zhan R Z,Shien H P,Dong C Y.Amorphous InGaZnO thin film transistors with different transparent electrodes[J].Chinese Journal of Liquid Crystals and Display,2013,28(1):55-58.(in Chinese)
[2]劉翔,薛建設,賈勇,等.金屬氧化物IGZO薄膜晶體管的最新研究進展[J].現代顯示,2010,117(10):28-32.
Liu X,Xue J S,Jia Y,et al.The recent research progress of amorphous Indium Gallium Zinc Oxide thin film transistors[J].Advanced Display,2010,117(10):28-32.(in Chinese)
[3]Nomura K,Ohta H,Takagi A,et al.Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors[J].Nature,2004,432(7016):488-492.
[4]Yabuta H,Sano M,Abe K,et al.High-mobility thin-film transistor with amorphous InGaZnO4channel fabricated by room temperature rf-magnetron sputtering[J].Applied Physics Letters,2006,89(11):112123-1-3.
[5]Park J S,Maeng W J,Kim H S,et al.Review of recent developments in amorphous oxide semiconductor thin-film transistor devices[J].Thin Solid Films,2012,520(6):1679-1693.
[6]Suresh A,Gollakota P,Wellenius P,et al.Transparent,high mobility InGaZnO thin films deposited by PLD[J].Thin Solid Films,2008,516(7):1326-1329.
[7]MiuraK,Ueda T,Nakano S,et al.Low-temperature-processed IGZO TFTs for flexible AMOLED with integrated gate driver circuits[C].SID Symposium Digest of Technical Papers.Blackwell Publishing Ltd,2011,42(1):21-24.
[8]Nakata M,Sato H,Nakajima Y,et al.Low-temperature fabrication of flexible AMOLED displays using oxide TFTs with polymer gate insulators[C].SID Symposium Digest of Technical Papers.Blackwell Publishing Ltd,2011,42(1):202-205.
[9]馮魏良,黃培.柔性顯示襯底的研究及進展[J].液晶與顯示,2012,27(5):599-607.
Feng W L,Huang P.Advances in flexible displays substrates[J].Chinese Journal of Liquid Crystals and Display,2012,27(5):599-607.(in Chinese)
[10]Takagi A,Nomura K,Ohta H,et al.Carrier transport and electronic structure in amorphous oxide semiconductor,a-In-GaZnO4[J].Thin Solid Films,2005,486(1):38-41.
[11]Fuh C S,Sze S M,Liu P T,et al.Role of environmental and annealing conditions on the passivation-free in-Ga-Zn-O TFT[J].Thin Solid Films,2011,520(5):1489-1494.
[12]Nomura K,Kamiya T,Kikuchi Y,et al.Comprehensive studies on the stabilities of a-In-Ga-Zn-O based thin film transistor by constant current stress[J].Thin Solid Films,2010,518(11):3012-3016.
[13]Hsieh H H,Kamiya T,Nomura K,et al.Modeling of amorphous InGaZnO4 thin film transistors and their subgap density of states[J].Applied Physics Letters,2008,92(13):133503-133503-3.
[14]Nomura K,Kamiya T,Ohta H,et al.Defect passivation and homogenization of amorphous oxide thin-film transistor by wet O2annealing[J].Applied Physics Letters,2008,93(19):192107-192107-3.
[15]Kimura M,Nakanishi T,Nomura K,et al.Trap densities in amorphous-InGaZnO4 thin-film transistors[J].Applied Physics Letters,2008,92(13):133512-133512-3.
[16]Trinh T T,Nguyen V D,Ryu K,et al.Improvement in the performance of an InGaZnO thin-film transistor by controlling interface trap densities between the insulator and active layer[J].Semiconductor Science and Technology,2011,26(8):085012-1-8.
[17]Kiani A,Hasko D G,Milne W I,et al.Analysis of amorphous indium-gallium-zinc-oxide thin-film transistor contact metal using Pilling-Bedworth theory and a variable capacitance diode model[J].Applied Physics Letters,2013,102(15): 152102-1-2.
[18]Kim W S,Moon Y K,Kim K T,et al.An investigation of contact resistance between metal electrodes and amorphous gallium-indium-zinc oxide(a-GIZO)thin-film transistors[J].Thin Solid Films,2010,518(22):6357-6360.
[19]Park J,Kim C,Kim S,et al.Source/drain series-resistance effects in amorphous gallium-indium-zinc-oxide thin film transistors[J].Electron Device Letters,IEEE,2008,29(8):879-881.
[20]Schroder D K.Semiconductor Material and Device Characterization[M].John Wiley&Sons,2006.
[21]王小燕,董桂芳,喬娟,等.溶液法制備的氧化鋅多層膜及其場效應性質[J].物理化學學報,2010,26(1): 249-252.
Wang X Y,Dong G F,Qiao J,et al.Preparation and field-effect property of solution-processed multilayer Zinc Oxide[J].Acta Phys.-Chim.Sin,2010,26(1):249-252.(in Chinese)
Effects of using InGaZnO without annealing as buffer layer on the performance of InGaZnO thin film transistors
GOU Chang-hua,WU Ming-zhu,GUO Yong-lin,YANG Yong-qiang,GUAN Xiao-liang,DUAN Yu,WANG Hong-bo*
(State Key Laboratory on Integrated Optoelectronics,Jilin University Region,College of Electronic Science and Engineering,Jilin University,Changchun 130012,China)
Due to the characters of high field effect mobility,good uniformity on large area and amorphous,indium-gallium-zinc-oxide thin film transistors is considered to be a new drive technology for the displays with large size and flexible character.However,the metal contact oxidation between source/drain electrode and active layer will increase the contact resistance and cause performance degradation.IGZO film without annealing has the characters of low oxygen content,more oxygen vacancies and high electrical conductivity.This article proposed using IGZO film without annealing as drain/source electrode buffer layer to reduce the contact oxidation and reduce the contact resistance.Experimental results indicated that the best performance of device can be obtained,when inserting 4 nm IGZO buffer layer,the mobility improved by 11.6%and the threshold voltage reduced 3.8 V compared with the device without buffer layer.In conclusion,the buffer layer can effectively im-prove the performance of device.In addition,using the same material with active layer as buffer layer can simplify the process compared with other material as buffer layer in industrial production with single rectangular target.
thin film transistor;InGaZnO;contact resistance;buffer layer
TN321+.5
A
10.3788/YJYXS20153004.0602
茍昌華(1989-),男,四川廣安人,碩士,主要從事氧化物薄膜晶體管方面的研究。E-mail:gouch0819@sina.com
王紅波(1969-),女,吉林長春人,副教授,碩士生導師,主要從事有源有機發光顯示驅動電路的研究。E-mail: wang_hongbo@jlu.edu.cn
1007-2780(2015)04-0602-06
2014-12-30;
2015-01-07.
國家自然科學基金(No.61275033)
*通信聯系人,E-mail:wang_hongbo@jlu.edu.cn

