微波脈沖對硅基雙極型晶體管的損傷特性*
張存波,張建德,王弘剛,杜廣星
(國防科技大學光電科學與工程學院,湖南長沙 410073)
隨著電子設備的廣泛使用,目前的電磁環境復雜性增強,各種通信和無線電探測系統受到強電磁脈沖的威脅增大,射頻前端在強電磁脈沖下失效的可能性增大。文獻[1]報道了歐洲電氣化鐵路交通管理系統在微波信號輻射下的易損性實驗研究,結果表明低噪聲放大器是系統中的易損器件,研究微波脈沖對低噪聲放大器的損傷效應意義重大[2-3]。硅基雙極型晶體管是低噪聲放大器中應用廣泛的半導體器件,研究微波脈沖對硅基雙極型晶體管的損傷特性具有重要的意義。文獻[4-6]利用半導體仿真軟件,通過分析硅基雙極型晶體管器件內部電場強度、電流密度和溫度分布,研究了硅基雙極型晶體管器件在微波信號和階躍脈沖作用下的損傷效應和機理;文獻[7-9]研究報道了硅基雙極型晶體管型低噪聲放大器微波損傷的實驗研究,給出了微波脈沖參數以及不同管腳注入對晶體管損傷特性的實驗結果。實驗研究更加注重效應數據和規律的獲取,對損傷機制的分析較少,而仿真分析結果的實驗證據較少。為了進一步研究微波脈沖對硅基雙極型晶體管的損傷機理,需要從宏觀上分析晶體管損傷后的電特性,同時從微觀上觀測晶體管的損傷部位,為損傷機理的研究提供有力的實驗證據。
本文研究了基極注入微波脈沖對硅基雙極型晶體管的損傷特性,測量了硅基雙極型晶體管被損傷前后的PN結電性能,并利用光誘導電阻變化技術和掃描電子顯微鏡(Scanning Electron Microscope,SEM)進行失效定位和損傷部位觀測,推斷出器件的損傷機理。
1 損傷效應實驗
以NPN型硅基雙極型晶體管為核心元件制作了低噪聲放大器,圖1為其原理圖:器件采用共發射極放大電路結構,硅基雙極型晶體管發射極接地,基極接信號輸入端,集電極接信號輸出端,器件工作電壓為3V,放大器工作中心頻率為1.5GHz,增益 15dB。

圖1 低噪聲放大電路實物圖Fig.1 Picture of low noise amplifier circuit
圖2 為注入實驗裝置示意圖,將微波脈沖沿低噪聲放大器的輸入端注入放大器,研究微波脈沖對研制的低噪聲放大器損傷過程和損傷結果。注入微波脈沖的頻率為1.5GHz,脈寬為50ns,每次實驗注入一個微波脈沖,每次注入實驗后采用微波網絡分析儀測量放大電路的增益;放大器增益下降10dB以上認為器件損傷。逐步增加微波脈沖的注入功率,直到確認放大器被損傷。通過更換損傷放大器中的硅基雙極型晶體管,放大電路增益恢復正常,從而確定,低噪聲放大器損傷效應的實質是微波脈沖對低噪聲放大器中硅基雙極型晶體管造成損傷。
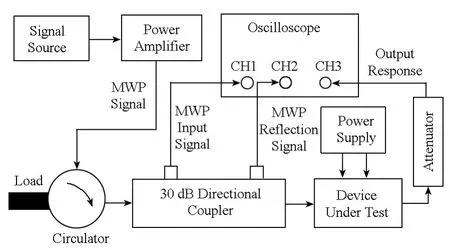
圖2 注入實驗裝置示意圖Fig.2 Schema of injecting experiment equipment
2 失效分析
為了分析微波脈沖對硅基雙極型晶體管的損傷特性,隨機抽取了8個被微波脈沖損傷的硅基雙極型晶體管進行了電特性測試和失效定位分析。對比測量了損傷前后硅基雙極型晶體管的電特性。并利用光誘導電阻變化技術和SEM對損傷的硅基雙極型晶體管進行失效定位和損傷部位觀測。
2.1 電特性測試
電特性測試主要通過測試雙極型晶體管的共基極集電結雪崩擊穿電壓VCBO、共發射極集電結雪崩擊穿電壓V以及發射結擊穿電壓CEO判斷損傷前后PN結的性能。
共基極反向截止電流(ICBO)是指發射極開路(IE=0)、集電結反偏(VCB>0)時的集電極電流。發射極開路時,使ICBO趨于無窮大的集電結反向電壓VCB稱為共基極集電結雪崩擊穿電壓,記為VCBO。圖3給出了損傷前后雙極型晶體管的VCBO測量結果,圖中橫坐標為發射極開路時的集電結電壓VCB,縱坐標為集電極電流。當VCB>0時,集電結反偏;當VCB<0時,集電結正偏。從圖3中可知,未損傷芯片的集電結表現出良好的正向導通,反向截止的PN結特性,晶體管的VCBO大于10V;損傷后晶體管的VCBO接近于0V,呈現為短路特性,集電結不再具有PN結特性。
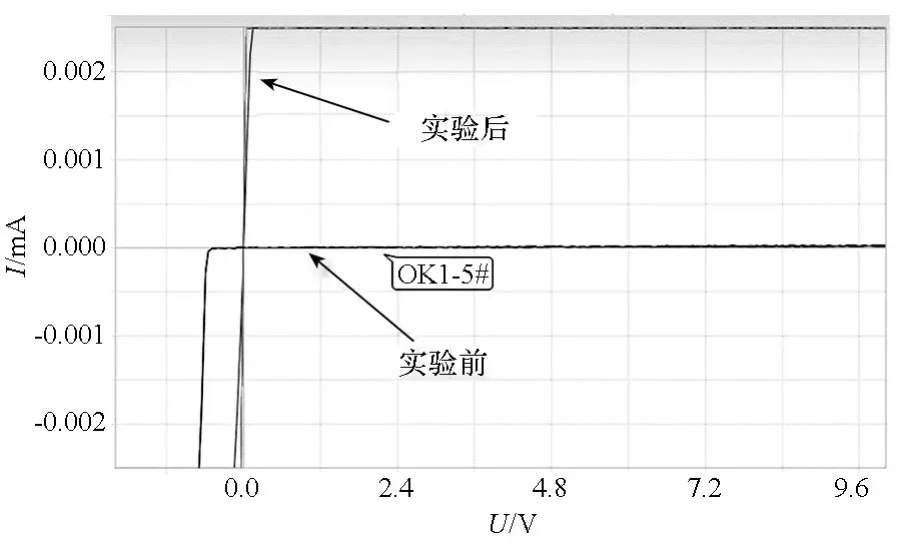
圖3 共基極集電結擊穿特性Fig.3 Breakdown characteristics of collector junction in common base
共發射極反向截止電流(ICEO)代表基極開路(IB=0)、集電結反偏(VCB>0)時從發射極穿透到集電極的電流。基極開路時,使ICEO趨于無窮大的集電極發射極間電壓VCE稱為共發射極集電結雪崩擊穿電壓,記為 VCEO,VCEO比 VCBO低得多[10]。圖4給出了損傷前后雙極型晶體管的VCEO測量結果,圖中橫坐標為基極開路時的集電極發射極間電壓VCE,縱坐標為集電極電流。當VCE>0時,集電結反偏,當VCE<0時,集電結正偏。從圖4結果進一步驗證,未損傷芯片的集電結表現出良好的正向導通,反向截止的PN結特性,晶體管的 VCEO大于4.5V;損傷后晶體管的VCEO接近于0V,呈現出短路特性,進一步顯示集電結不再具有PN結特性。
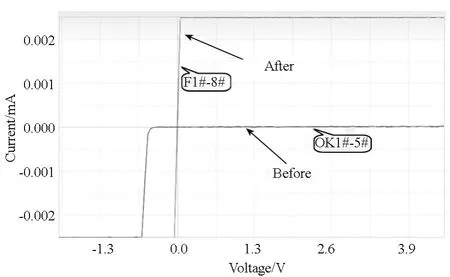
圖4 共發射極集電結擊穿特性Fig.4 Breakdown characteristics of collector junction in common emitter
IEBO代表集電極開路(IC=0)、發射結反偏(VEB>0)時的發射極電流。IEBO趨于無窮大時的發射結反向電壓稱為發射結擊穿電壓,記為VEBO。圖5給出了損傷前后雙極型晶體管的VEBO。圖中橫坐標為集電極開路時的發射結電壓VEB,縱坐標為發射極電流。VEB>0時發射結反偏,VEB<0時發射結正偏。從圖中可知,未損壞芯片的發射結表現出良好的正向導通,反向截止的PN結特性,晶體管的VEBO大于1V;損傷后的1#~7#晶體管的發射結呈現為短路特性,8#晶體管的發射結呈現電阻特性,均不再具有PN結的特性。
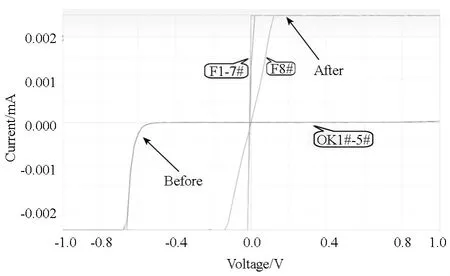
圖5 發射結擊穿特性Fig.5 Breakdown characteristics of emitter junction
通過測量硅基雙極型晶體管微波脈沖損傷前后的VCBO、VCEO和VEBO,發現微波脈沖損傷后硅基雙極型晶體管的發射結和集電結表現為短路特性或電阻特性,都不再具有PN結特性,導致晶體管出現永久性的功能喪失。
2.2 損傷部位觀測
為了進一步確定微波脈沖對雙極型晶體管芯片的損傷部位以及損傷的物理機制,在對晶體管芯片去封裝后,利用SEM對芯片表面進行微觀觀測,芯片去封裝后的顯微照片如圖6所示。進一步放大數倍對損傷芯片進行觀測,發現芯片表面和芯片金屬電極無明顯損傷。

圖6 晶體管顯微照片Fig.6 Micrograph of transistor
光誘導電阻變化技術能快速準確地定位集成電路中元件的短路、布線和通孔互聯中的空洞、金屬中的硅沉積等缺陷,具有高分辨能力,其測試精度可達nA級。利用光誘導電阻變化技術,分別設置發射極開路時的集電結電壓VCB、基極開路時的集電極發射極間電壓VCE以及集電極開路時的發射結電壓VEB為0.01V,利用激光束對芯片表面進行掃描,通過感應芯片局部電阻以及電流的微小變化,對器件損傷位置進行定位。通過觀測發現圖6中1處為掃描的異常處,該處金屬電極下方的硅材料很有可能出現了燒傷,其典型掃描照片如圖7所示。圖7中區域1處表示掃描過程中該處電流密度偏大,區域2處表示該處電流密度偏小,說明電極下方存在物理損傷。

圖7 失效定位顯微照片Fig.7 Micrograph of fault location
去除芯片表面鈍化層以及頂層金屬后,用SEM進行深入觀測,典型顯微照片如圖8所示。從圖中可以發現與圖7中區域1處異常對應處存在明顯的“月牙形”的熔蝕,基區的硅材料出現熱擊穿特征,該處燒傷使得晶體管的發射結和集電結出現短路,VCBO、VCEO和 VEBO都趨于0,喪失了PN結的特性,與前面的測量結果相呼應,晶體管功能喪失。
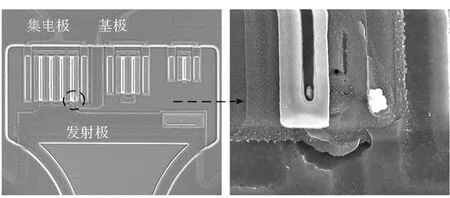
圖8 晶體管損傷顯微照片Fig.8 Micrograph of damaged transistor
PN結燒傷機制如下:微波脈沖作用下,當基極外加高的正偏壓時,發射結和集電結都處于正偏狀態,正偏狀態下PN結電流隨電壓的增加呈指數增加;當基極外加高的負偏壓時,發射結和集電結都處于反偏狀態,當反向偏壓增大到某一值時,PN結出現反向擊穿,反向電流會突然迅速增大。晶體管PN結的外加電壓主要降在PN結的勢壘區上,外加電壓使載流子在勢壘區中的電場下加速,通過碰撞把能量交給晶格,使晶格能量增加,從而使PN結的溫度升高。PN的正向和反向電流都具有正的溫度系數[10],溫度升高會使電流增加,在電流和結溫之間形成正反饋。結溫升高使電流增加,電流增加使功率損耗增加,功率損耗增加使結溫上升,從而導致電流的進一步增加。這一過程無限制地進行下去,將導致電流與溫度無限增加,最終導致PN結器件被燒傷。
3 結論
微波脈沖從基極進入硅基雙極型晶體管后,當注入微波功率足夠大時,導致基區的局部硅材料的熔蝕損傷,該損傷使得發射結和集電結短路,不再具有PN結特性,從而導致晶體管功能喪失,是雙極型晶體管的損傷機制。研究結果明確給出了硅基雙極型晶體管損傷后的電特性、損傷部位和損傷圖像,為深入研究微波脈沖對硅基雙極型晶體管損傷機理提供了有力的實驗證據,同時對硅基雙極型晶體管微波脈沖防護加固設計具有重要的參考價值。
References)
[1] Mansson D,ThottappillilR,Backstrom M,etal.Vulnerability of european rail traffic management system to radiated intentional EMI[J].IEEE Trans.Electromagn.Compat.2008,50(1):101-109.
[2] 王弘剛,張建德.高電子遷移率晶體管微波損傷仿真與實驗研究[J].強激光與粒子束,2014,26(6):65-70.Wang Honggang,Zhang Jiande.Simulation and experiment research on high electron mobility transistor microwave damage[J].High Power Laser Part Beam,2014,26(6):65-70.(in Chinese)
[3] Zhang C,Wang H,Zhang J,et al.Failure analysis on damaged gaAs HEMT MMIC caused by microwave pulse[J].IEEE Trans.Electromagn.Compat.2014,DOI:10.1109.
[4] 陳曦,杜正偉,龔克.基極注入強電磁脈沖對雙極型晶體管的作用[J].強激光與粒子束,2007,19(3):449-452.Chen Xi,Du Zhengwei,Gong Ke. Effects of high power electromagnetic pulse injected from base on the bipolar junction transistor[J].High Power Laser Part.Beam 2007,19(3):449-452.(in Chinese)
[5] 柴常春,席曉文,任興榮,等.雙極晶體管在強電磁脈沖作用下的損傷效應與機理[J].物理學報,2010,59(11):8118-8124.Chai Changchun,Xi Xiaowen,Ren Xingrong,et al.The damage effect and mechanism of the bipolar transistor induced by the intense electromagnetic pulse[J].Acta Physica Sinica,2010,59(11):8118 -8124.(in Chinese)
[6] 馬振洋,柴常春,任興榮,等.雙極型晶體管微波損傷效應與機理[J].物理學報,2012,61(7):078501.Ma Zhenyang,Chai Changchun,Ren Xingrong,et al.The damage effectand mechanism of the bipolar tansistor caused by microwaves.Acta Physica Sinica,2012,61(7):078501.(in Chinese)
[7] 范菊平,張玲,賈新章.雙極型晶體管高功率微波的損傷機理[J].強激光與粒子束,2010,22(6):1319-1322.Fan Juping, Zhang Ling, Jia Xinzhang. HPM damage mechanism on bipolar transistors[J].High Power Laser Part.Beam,2010,22(6):1319 -1322.(in Chinese)
[8] 柴常春,楊銀堂,張冰,等.硅基雙極低噪聲放大器的能量注入損傷與機理[J].半導體學報,2008,29(12):2403-2407.Chai Changchun, Yang Yintang, Zhang Bing, et al.Mechanism of energy-injection damage of silicon bipolar lownoise amplifiers[J].Journal of Semiconductors,2008,29(12):2403 -2407.(in Chinese)
[9] 柴常春,張冰,任興榮,等.集成Si基低噪聲放大器的注入損傷研究[J].西安電子科技大學學報,2010,37(5):898-903.Chai Changchun,Zhang Bing,Ren Xingrong,et al.Injection damage of the integrated silicon low-noise amplifier[J].Journal of Xidian University,2010,37(5):898 - 903.(in Chinese)
[10] 陳星弼,張慶中.晶體管原理與設計[M].第2版.北京:電子工業出版社,2006.Chen Xingbi,Zhang Qingzhong.Principle and design of transistor[M].2nd ed, Beijing:Publishing House of Electronics Industry,2006.(in Chinese)

