N+緩沖層對PT-IGBT通態壓降影響的研究
關艷霞,凌 宇
(沈陽工業大學 信息科學與工程學院,沈陽 110870)
N+緩沖層對PT-IGBT通態壓降影響的研究
關艷霞,凌 宇
(沈陽工業大學 信息科學與工程學院,沈陽 110870)
N+緩沖層設計對PT-IGBT器件特性的影響至關重要。文中利用Silvaco軟件對PT-IGBT的I-V特性進行仿真。提取相同電流密度下,不同N+緩沖層摻雜濃度PT-IGBT的通態壓降,得到了通態壓降隨N+緩沖層摻雜濃度變化的曲線,該仿真結果與理論分析一致。對于PT-IGBT結構,N+緩沖層濃度及厚度存在最優值,只要合理的選取可以有效地降低通態壓降。
Silvaco;PT-IGBT;N+緩沖層;通態壓降;仿真
IGBT因為擁有輸入阻抗高、損耗低、開關速度快、通態壓降低、通態電流大等優勢而成為現今功率器件發展的主流產品[1-2]。我國市場對IGBT的需求龐大,但國內還不能大規模生產自主設計的IGBT,大部分仍依靠進口,這是我國電力電子技術發展中面臨的重大瓶頸之一[3],IGBT的研發設計工作對我國各項事業的發展有十分重大的戰略意義。
與 NPT-IGBT(非穿通型 IGBT)相比,PT-IGBT(穿通型IGBT)因具有更好的開關速度及更小的功率損耗而被廣泛應用。PT-IGBT中N+緩沖層的結構參數對其特性的影響至關重要,因此要對其進行優化設計。在進行N+緩沖層設計中,原則上是在保證正向轉折電壓的前提下選擇合理的N+緩沖層的摻雜濃度和厚度,降低通態壓降。文中使用Silvaco軟件,在保證阻斷電壓的前提下,對不同N+緩沖層摻雜濃度的PT-IGBT的通態壓降進行了仿真分析,對PT-IGBT緩沖層的優化設計提供了有價值的參考。
1 PT-IGBT的結構與工作原理
1.1 PT-IGBT的結構
IGBT是在VD-MOSFET結構基礎上發展而來的器件[4],IGBT用P+層取代了VD-MOSFET漏極中的N+型摻雜區。PTIGBT就是在陽極側的P+區和N基區間加入一個N+區,如圖1所示,加入的這個N+區稱為N+緩沖層,緩沖層的作用是阻擋IGBT在正向阻斷時耗盡層的擴展[5-6],使得PT-IGBT能夠用較小的N基區寬度實現與NPT-IGBT相同的正向阻斷能力,提高開關速度的同時保持了較低的通態壓降[7]。
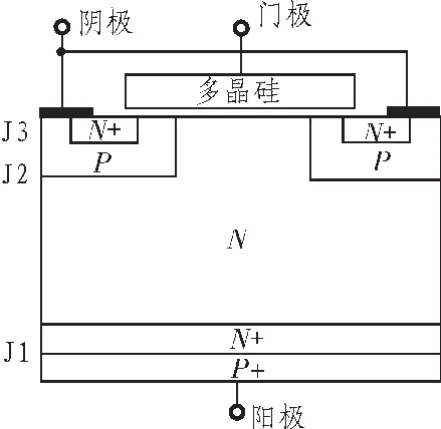
圖1 PT-IGBT結構Fig.1 Punch-through type IGBT structure
1.2 PT-IGBT的工作原理
當柵極電壓大于閾值電壓時,IGBT開始導通。在P基區表面形成導電MOS溝道,電子經MOS溝道注入N基區,同時推動了陽極P+的空穴注入。由于N基區寬度很大,大部分空穴在N基區中與從MOS溝道注入進來的電子復合。剩余的空穴從N基區擴散到 J2結,由于J2結輕微反偏,空穴被電場捕獲通過空間電荷區進入P基極。由于N基區為實現高阻斷電壓能力而采用了低摻雜濃度,所以中等電流密度下的空穴濃度甚至超過了N基區的摻雜濃度。因此,N基區處于大注入的狀態,伴隨著很強的電導調制效應[8-10]。這使得IGBT通態下得以保持很好的低通態壓降和高電流密度。
2 PT-IGBT的通態V-I特性
2.1 通態模型
當柵極電壓足夠大時,IGBT中所包含的MOSFET結構工作在線性模式下,IGBT的通態特性類似于PIN二極管的通態特性。因此用于分析PT-IGBT通態特性的等效模型可簡化為:一個PIN二極管串聯一個工作在線性區域的MOSFET。較大的正向柵極電壓促使導通狀態下的IGBT結構在柵極下面形成堆積層,與N基區重疊。通態時的電子電流通過MOSFET的溝道到達堆積層,可以被視作是在向N基區注入。相應地,空穴從陽極P+區注入,在N基區內形成大注入。柵極下N基區內的電子和空穴濃度分布與PIN二極管相似。此時IGBT的等效電路如圖2所示。
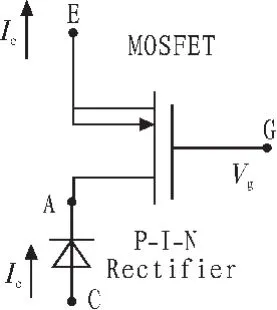
圖2 IGBT的MOSFET/PIN通態等效電路結構Fig.2 MOSFET/PIN equivalent circuit for the On-state IGBT structure
本次仿真使用的PT-IGBT結構參數:
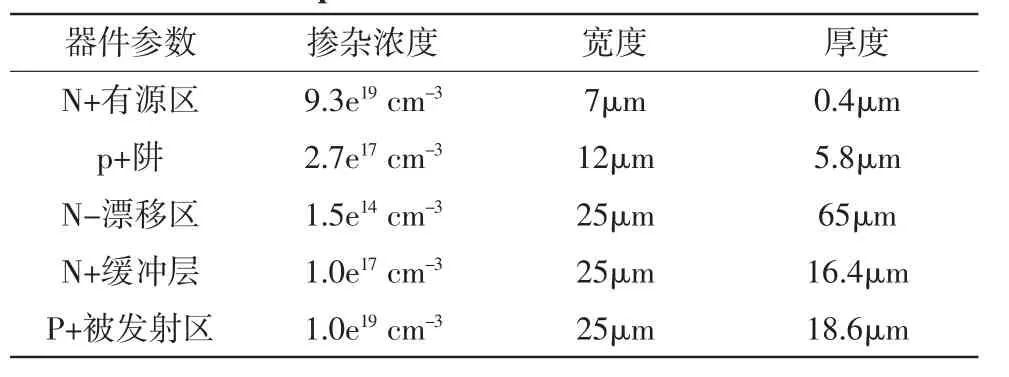
表1 600V PT-IGBT的仿真參數Tab.1 Simulation parameters of the 600 V PT-IGBT structure
2.2 通態特性的仿真
根據表1所示的結構參數,利用Silvaco軟件對PT-IGBT進行仿真。為了分析該結構的通態特性,施加不同的柵極電壓以掃描集電極電壓。仿真結果如圖3所示,該結構參數下IGBT的閾值電壓約5 V左右,IGBT的開啟電壓約為0.8 V。通態壓降隨柵極電壓的增加而減小,在較大的柵壓下,通態特性與PIN二極管相似。
3 N+緩沖層對通態壓降的影響
PT-IGBT結構中N+緩沖層的設計原則是:N+緩沖層的寬度大于正向轉折電壓下空間電荷區在其中的展寬。因此,N+緩沖層的濃度越高,保證阻斷特性所需要的寬度就越小,但N+緩沖層的濃度又影響著PT-IGBT的通態壓降,下面仿真分析N+緩沖層的濃度對通態壓降的影響。
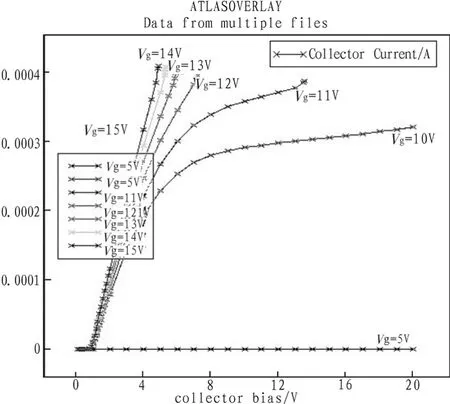
圖3 PT-IGBT的I-V輸出特性曲線Fig.3 Output I-V characteristics of the 600 V PT-IGBT structure
在其他參數不變的情況下,只改變N+緩沖層濃度,柵壓為15 V,陽極電壓從0 V逐漸增大到15 V,N+緩沖層濃度依次取 1e16、1e17、5e17、1e18、5e18及 1e19cm-3,仿真 IGBT 的轉移特性曲線,如圖4所示。提取相同電流3e-6A下的通態壓降,并繪制成曲線,如圖5所示。從圖5中我們可以觀察到,N+緩沖層摻雜濃度超過5e17cm-3時通態壓降迅速增加。由此可見,在緩沖層保持很窄的情況下,雖然可以提高N+緩沖層的摻雜濃度,使得電場在緩沖層區內降到零。但N+緩沖層摻雜濃度的上限不可能不受限制,因為過高的摻雜濃度將使J1結注入效率降低,導致正向導通特性變壞。所以N緩沖層的最佳摻雜濃度和厚度分別在 1e16~1e17cm-3和 10~15 μm。
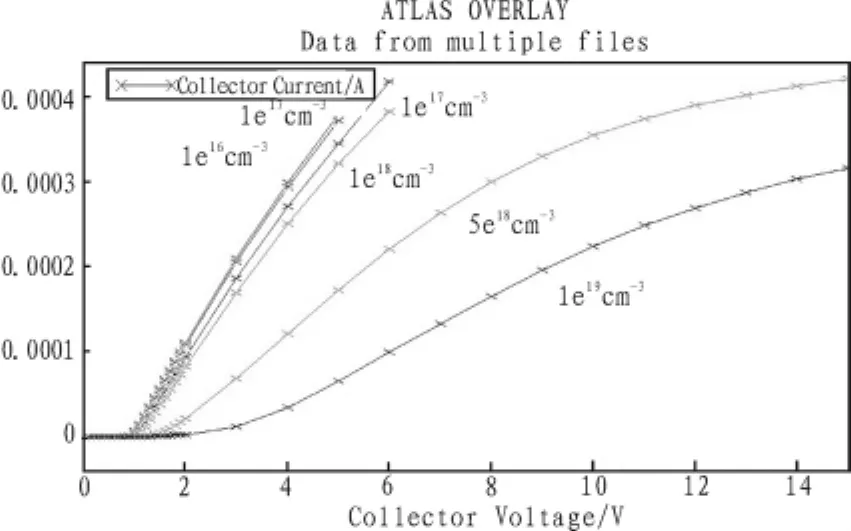
圖4 不同N+緩沖層濃度下的輸出I-V特性曲線Fig.4 Output I-V characteristics under different doping concentration of N+buffer
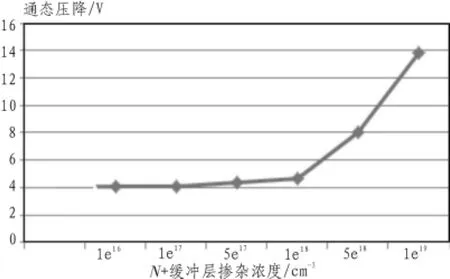
圖5 通態壓降隨N+緩沖層摻雜濃度變化的曲線Fig.5 Curve of on-state voltage drop varied with different doping concentration of N+buffer
4 結 論
IGBT是結構復雜的集成功率器件,微小的結構參數變化都可能會給器件性能帶來巨大影響。通過優化結構參數可以實現PT-IGBT在性能上的改進。在保證正向阻斷電壓的前提下選擇合理的N+緩沖層的摻雜濃度和厚度。N+緩沖層的最佳摻雜濃度和厚度分別在 1e16~1e17cm-3和 10~15 μm。 文中針對緩沖層摻雜濃度的改變仿真分析了PT-IGBT的通態特性,探討了緩沖層的優化問題,給PT-IGBT在緩沖層方面的優化設計提供了有價值的參考。
[1]王倩,鐘傳杰.150 V IGBT工藝模型設計[J].微計算機信息,2009,25(4-2):296-297.
WANG Qian,ZHONG Chuan-jie.Design of 150 V IGBT process model[J].Control and Automation,2009,25(4-2):296-297.
[2]王丹,關艷霞.功率器件的新結構及其性能特點[J].電子設計工程,2010,18(2):118-120.
WANG Dan,GUAN Yan-Xia.Thenew structureand performance characteristic of power devices[J].Electronic Design Engineering,2010,18(2):118-120.
[3]王樹振,單威,宋玲玲.IGBT絕緣柵雙極性晶體管發展簡述[J].微處理機,2008,29(2):41-46.
WANG Shu-zhen,SHAN Wei,SONG Ling-ling.Development of IGBT[J].Microprocessors,2008,29(2):41-46.
[4]王瑞,趙亞輝.IGBT Pspice靜態模型的建立與仿真[J].寶雞文理學院學報:自然科學版,2010,30(2):65-73.
WANG Rui,ZHAO Ya-hui.Establishment and simulation of pspice static model for IGBT[J].Journal of Baoji University of Arts and Sciences:Natural Science,2010,30(2):65-73.
[5]高琰,亢寶位,程序.一種具有新耐壓層結構的IGBT[J].半導體技術,2003,28(7):64-68.
GAO Yan,KANG Bao-wei,CHENG Xu.A kind of IGBT with the new structure ofvoltage-sustaining layer[J].Semiconductor Technology,2003,28(7):64-68.
[6]周文定,亢寶位.不斷發展中的IGBT技術概述[J].中國集成電路,2009,18(1):23-28.
ZHOU Wen-ding,KANG Bao-wei.The summary on continuous development of IGBT technology[J].China Integrated Circuit,2009,18(1):23-28.
[7]唐勇,胡安,陳明.IGBT柵極特性與參數提取[J].電工技術學報,2009,24(7):76-80.
TANG Yong,HU An,CHEN Ming.IGBT Gate Characteristics and parameter extraction methods[J].Transactions of China Electrotechnical Society,2009,24(7):76-80.
[8]許平.IGBT器件和相關制備工藝技術評述[J].電力電子,2010(2):6-13.
XU Ping.An overview of IGBT device and its process and Technology[J].Power Electronic,2010(2):6-13.
[9]葉立劍,鄒勉,楊小慧.IGBT技術發展綜述[J].半導體技術,2008,33(11):937-951.
YE Li-jian,ZOU Mian,YANG Xiao-hui. Review on DevelopmentofIGBT Technology [J].Semiconductor Technology,2008,33(11):937-951.
[10]程序,吳郁,劉興明,等.一種高性能的新結IGBT[J].半導體學報,2003,24(6):138-143.
CHENG Xu,WU Yu,LIU Xing-ming,et al.A new structure IGBT With high performance[J]. Chinese Journal of Semiconductors,2003,24(6):138-143.
Research of the N+buffer effect on state voltage drop of PT-IGBT
GUAN Yan-xia,LING Yu
(College of Information Science and Engineering, Shenyang University of Technology, Shenyang 110870, China)
The design of N+buffer plays an important role in characteristics of PT-IGBT devices.The I-V characteristics of PT-IGBT were simulated Using'Silvaco'in the paper.Comparing with the different values of on-state voltage drop under different doping concentration of the N+buffer at the same current density,the curves of on-state voltage drop with different doping concentration of the N+buffer was gained.The simulation results coincided with theoretical analysis.For PT-IGBT structure, there was an optimal value of the doping concentration of the N+buffer, and the on-state voltage drop would reduce through reasonable design.
Silvaco; PT-IGBT; N+buffer; on-state voltage drop; simulation
TN386.2
A
1674-6236(2013)07-0191-03
2012-11-28稿件編號201211241
關艷霞(1963—),女,遼寧海城人,博士,副教授。研究方向:電力半導體器件和微機電系統。

