功率VDMOS器件的新型SPICE模型
朱榮霞 黃 棟 馬德軍 王錦春 孫偉鋒 張春偉
(1 東南大學國家專用集成電路系統(tǒng)工程技術研究中心,南京210096)
(2 中國空空導彈研究院紅外探測器技術航空科技重點實驗室,洛陽471009)
垂直雙擴散金屬氧化物場效應晶體管(VDMOS 器件)是新一代的電力電子開關器件.由于具有獨特的高輸入阻抗、低驅動功率、優(yōu)越的頻率特性及低噪聲等優(yōu)點[1-3],VDMOS 器件成為當前半導體分立器件中的高端產品,應用范圍廣,市場需求大,發(fā)展前景好.目前,VDMOS 器件主要應用于電機調速、逆變器、電子開關及汽車電器等領域[4-5].而SPICE 模型是連接半導體器件物理與電路的橋梁,VDMOS 器件的廣泛應用使得人們對其SPICE 模型的需求越來越大.
針對VDMOS 器件的SPICE 模型,Sanchez等[6]初步建立了一種包含準飽和效應的模型,但是該模型沒有考慮積累區(qū)電阻寄生結型場效應晶體管(JFET)的溝道夾斷對于器件特性的影響.Victory 等[7]建立了一種基于表面勢的VDMOS 模型,但該模型僅考慮了寄生JFET 溝道未夾斷的情況,且對漂移區(qū)電阻的計算并不精確.Chauhan等[8]將VDMOS 器件看成一個普通的N 溝道金屬氧化物半導體(NMOS)串聯(lián)一個受柵壓和漏壓控制的電阻,該電阻僅僅由一個沒有物理意義的經驗公式給出,因此,該模型無法準確描述外界電壓的變化對VDMOS 器件內部特性造成的改變.鑒于已有VDMOS 模型精確度差等問題,至今為止,沒有一個標準的SPICE 模型可以描述VDMOS 器件的特性.
本文在經典的MOS 模型——BSIM3v3 模型的基礎上,建立了一套新的描述VDMOS 器件電學特性的SPICE 模型.為了準確描述VDMOS 器件的電學特性,除了考慮外部節(jié)點柵極、源極、漏極之外,還增加了4 個內部節(jié)點,并將VDMOS 器件視為1 個普通NMOS 與4 個電阻的串聯(lián).
1 VDMOS 器件結構及SPICE 模型
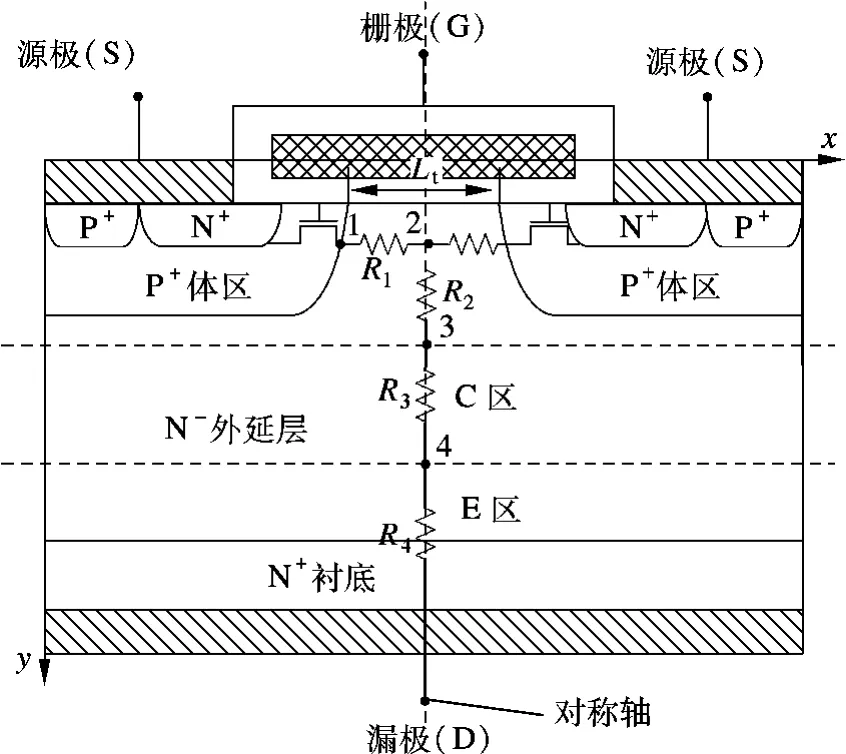
圖1 VDMOS 器件的元胞剖面圖
VDMOS 器件通常采用多元胞并聯(lián)的結構,以增大通態(tài)電流.圖1為VDMOS 器件的元胞結構圖.圖中,Lt為器件積累區(qū)的長度.可以看出,VDMOS 器件沿柵漏軸線對稱.如圖1所示,本文模型在源極(S)、柵極(G)、漏極(D)3 個外部節(jié)點的基礎上又增加了4 個內部節(jié)點,并分別將節(jié)點3 與節(jié)點4、節(jié)點4 與漏極D 之間的區(qū)域定義為C 區(qū)和E區(qū).不同的區(qū)域對于VDMOS 器件電學特性的影響是不同的.如圖2所示,可將VDMOS 器件視為1個普通NMOS 器件與4 個電阻R1,R2,R3,R4的串聯(lián).可將VDMOS 器件的源極、柵極及節(jié)點1 視為1 個普通的NMOS 器件.柵極電壓的變化可使積累區(qū)產生的電荷出現(xiàn)積累和耗盡2 種狀態(tài),故節(jié)點1,2 之間的區(qū)域對于VDMOS 器件的影響可被視為1 個積累區(qū)電阻R1.2 個P+體區(qū)與N-外延層組成1 個寄生JFET 結構,隨源極、節(jié)點2 與節(jié)點3 電壓的變化,寄生JFET 結構的溝道耗盡或夾斷,故在節(jié)點2,3 之間引入了寄生JFET 電阻R2.考慮到VDMOS 器件的電流路徑在C 區(qū)與E 區(qū)是不同的[7],故將這2 個區(qū)域的電阻分別用R3和R4表示.只需要建立這4 個電阻的模型,便可得到VDMOS 器件的SPICE 模型.

圖2 VDMOS 器件的SPICE 模型結構圖
2 模型建立
2.1 積累區(qū)電阻R1
2.1.1 電流模型
在VDMOS 器件內部,沿x 軸方向流過積累區(qū)的電流為

式中,W 為器件的寬度;μN-eff為積累區(qū)的有效遷移率;Vg2為器件在積累區(qū)內的準費米勢;QN-為積累區(qū)內載流子的電荷,由積累區(qū)雜質電離引入的自由電子和柵極感應電荷Qin兩個部分組成,即

式中,q 為電子電荷;NN-,tsi分別為積累區(qū)的摻雜濃度及厚度.
將式(2)代入式(1),沿x 軸從節(jié)點1 到節(jié)點2對式(1)進行積分可得[9]

式中,V1,V2分別為節(jié)點1 與節(jié)點2 的電壓;V21=V2-V1.由式(3)可以看出,只要計算出Qin所在的積分項,就可以得出積累區(qū)的電流.
柵氧及積累區(qū)組成的結構類似于一個N 阱-P溝道金屬氧化物半導體(PMOS)結構.通過解泊松方程,得到積累區(qū)的柵極感應電荷Qin為[10]

式中,Cox為單位面積的柵氧化層電容;γG2為與工藝相關的體效應系數(shù);ψs為積累區(qū)的表面電勢;φt為熱電壓.當ψs>0 時,積累區(qū)表面積累電子,Qin<0;反之,積累區(qū)表面耗盡或反型,Qin>0.
當積累區(qū)處于強反型狀態(tài)時,本文將Qin視為一個常數(shù)Qdep0,即

式中,Δφt為與熱電壓相關的參數(shù);φFg為積累區(qū)的費米勢.
當積累區(qū)處于積累狀態(tài)時,Qin幾乎隨柵壓VG與Vg2的電壓差VGg2線性變化.令VFBg2為積累區(qū)的平帶電壓,當積累區(qū)處于積累狀態(tài)時,柵極感應電荷為

為了使用統(tǒng)一的公式來描述積累區(qū)處于積累狀態(tài)和強反型狀態(tài)時柵極感應電荷與VGg2的關系,引入了表面等效電荷Qina[11],即

式中,VGg2q為VGg2的有效值;Δ 為與工藝相關的參數(shù);VGg2min為Qina=Qdep0時VGg2q的值.因此

將式(7)代入式(3)得

令VG1=VG-V1,VG2=VG-V2.當VGg2=VG1,VGg2=VG2時,VGg2的值分別為VG1q,VG2q.將式(8)代入式(10)中的積分項簡化積分結果,得到
式中,V21q=VG2q-VG1q.
2.1.2 遷移率模型
VDMOS 器件在積累區(qū)的遷移率受橫向、縱向電場影響.在一定范圍內,橫向電場越強,積累區(qū)自由電子的速度越快;但當橫向電場過強時,積累區(qū)自由電子的速度則會達到飽和.縱向電場越強,積累區(qū)自由電子的運動越趨近于積累區(qū)表面,有效遷移率越低.遷移率的經驗模型為

式中,μ0為不考慮橫向、縱向電場影響時的遷移率;Esat為載流子速度飽和時的橫向電場.
將式(11)和(12)代入式(10),即可得出完整的積累區(qū)電流,進而可由R1=V21/I21得到積累區(qū)的等效電阻.
2.2 寄生JFET 電阻R2
假設P+體區(qū)與N-外延層組成的寄生JFET的溝道(N-外延層)是線性緩變摻雜的,且其組成的PN 結為單邊突變PN 結.圖3為寄生JFET 電阻及C 區(qū)、E 區(qū)電阻的示意圖.圖中,寄生JFET 耗盡層的厚度為Xh(y),其溝道的半壁厚度為b(y)=Lt/2-Xh(y);L 為寄生JFET 的溝道長度;α≈45°為C 區(qū)電流路徑與y 軸的夾角[7];Wt為器件的長度;Wj為節(jié)點2 到P+體區(qū)下邊界的厚度;Wc為節(jié)點3 和節(jié)點4 之間區(qū)域的寬度;Le為節(jié)點2 到N-外延層底部的厚度;LV為節(jié)點2 到N+襯底底部的厚度;W1為PN 結產生的耗盡層的厚度.節(jié)點3 所在的垂直于y 軸的虛線表示電壓為V3的等勢線.
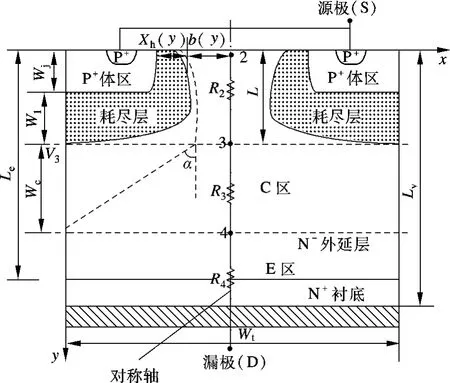
圖3 寄生JFET 電阻及C 區(qū)、E 區(qū)的電阻示意圖
寄生JFET 溝道的耗盡層厚度為

式中,ξ0為真空介電常數(shù);ξS為硅材料的介電常數(shù);ND為N-外延層的摻雜濃度;V(y)為以節(jié)點2為參考點的溝道電勢;VBJ為PN 結的接觸勢壘高度;VS2為源極電壓VS與V2之間的電壓差,即VS2=VS-V2.
2.2.1 線性區(qū)電流模型
根據歐姆定律,得到寄生JFET 的溝道電流密度為

式中,μn為寄生JFET 溝道的多數(shù)載流子遷移率.
考慮到該寄生JFET 為對稱柵結構,則寄生JFET 的溝道總電流為

將電流IC沿溝道從y=0 積分到y(tǒng)=L,即可得到肖克萊理論公式.將其簡化得到JFET 在線性區(qū)的電流方程為
式中,工藝參數(shù)β =ξ0ξSμn/Lt;VT為閾值電壓;V32為節(jié)點3 與節(jié)點2 之間的電壓差,即V32=V3-V2.
2.2.2 飽和區(qū)電流模型
當V32增加到寄生JFET 的溝道夾斷電壓V32sat時,寄生JFET 的溝道開始夾斷.隨著V32的增大,夾斷點到節(jié)點2 區(qū)域內(導電溝道區(qū))的壓差始終為V32sat,夾斷點向節(jié)點2 移動,電壓降V32-V32sat落在溝道夾斷區(qū),進入導電溝道區(qū)的載流子將受溝道夾斷區(qū)電場的作用而漂移到節(jié)點3.因此,夾斷區(qū)的漏極電流仍由導電溝道區(qū)的漂移電流決定.
當V32=V32sat時,I32lin的值即為飽和電流I32sat.將V32sat=VS2-VT替換式(16)中的V32得

為考慮溝道長度調制效應,引入溝道調制系數(shù)λ=(ΔLV32)/L,其中ΔL 為寄生JFET 溝道夾斷區(qū)的長度,則修正后的飽和電流為

為使寄生JFET 線性區(qū)電流與飽和區(qū)電流連續(xù),引入節(jié)點2 與節(jié)點3 之間的有效電壓V32eff[12],即

式中,δ 為V32eff的修正參數(shù).
最終得到寄生JFET 區(qū)的電流方程為

同樣,可由R2=V32/I32得到寄生JFET 電阻.
2.3 C 區(qū)電阻R3 及E 區(qū)電阻R4
在VDMOS 器件的C 區(qū),由式(13)可得,該處由PN 結產生的耗盡層的厚度為

C 區(qū)的電阻由耗盡區(qū)的邊界決定,根據Victory 等[7]提出的方法可以得到電阻R3為

式中,ρ 為N-漂移區(qū)的電阻率;η 為參數(shù).
在E 區(qū),電流路徑的橫截面保持不變,因此該區(qū)域的電阻R4只與節(jié)點3,4 之間區(qū)域的寬度Wc有關.本文忽略漏端金屬的電阻,則電阻R4可表示為

式中,ρN為N+襯底的電阻率.
3 模型驗證
本文采用關態(tài)擊穿電壓為625 V 的VDMOS器件來驗證所建立的模型.圖4給出了在提模軟件MBP 中,使用本文所建模型對VDMOS 器件提模得到的擬合結果.由圖可知,該VDMOS 器件的準飽和效應嚴重,同時,基于本文模型得到的仿真值可以精確地擬合器件的準飽和區(qū)、飽和區(qū)及線性區(qū).因此,本文提出的建模思路及方法是有效的.

圖4 仿真值與測試值的擬合結果
4 結語
本文建立了功率VDMOS 器件的SPICE 模型.在VDMOS 器件源極、漏極、柵極3 個外部節(jié)點的基礎上又增加4 個內部節(jié)點,分段考慮了各個節(jié)點之間器件的結構特征.通過將VDMOS 器件視為1 個普通NMOS 與4 個電阻的串聯(lián),準確有效地計算這4 個電阻的阻值,建立了精確的VDMOS 器件的SPICE 模型.經驗證,該模型具有高的精確度,可以準確地擬合VDMOS 器件線性區(qū)、飽和區(qū)、準飽和區(qū)的電學特性.
References)
[1]Zhang Long,Yu Huilin,Wu Yifan,et al.On state output characteristics and transconductance analysis of high voltage(600V)SJ-VDMOS[C]//Proceedings of 2012 IEEE International Conference on Solid-State and Integrated-Circuit Technology.Xi′an,China,2012:1-3.
[2]Messaadi Lotfi,Smail Toufik.The electro-thermal sub circuit model for power MOSFETs[J].Microelectronics and Solid State Electronics,2012,1(2):26-32.
[3]Duan Baoxing,Yang Yintang.Power VDMOS transistor with the step oxide trench breaks the limit line of silicon[J].Micro &Nano Letters,2011,6(9):777-780.
[4]Bao Jiaming,Qi Haochen,Zhang Jian,et al.VDMOS modeling for IC CAD[C]//Proceedings of 2011 IEEE Joint International Information Technology and Artificial Intelligence Conference.Chongqing,China,2011:245-249.
[5]Antonios Bazigos,F(xiàn)rancoins Krummenacher,Jean Michel Sallese,et al.A physics-based analytical compact model for the drift region of the HV-MOSFET[J].IEEE Transactions on Electron Devices,2011,58(6):1710-1721.
[6]Sanchez J L,Gharbi M,Tranduce H,et al.Quasisaturation effect in high-voltage VDMOS transistor[J].Solid-State and Electron Devices,1985,132(1):42-46.
[7]Victory J J,Sanchez J L,Demassa T A,et al.A static,physical VDMOS model based on the charge-sheet model[J].IEEE Transactions on Electron Devices,1996,43(1):157-164.
[8]Chauhan Y S,Anghel C,Krummenacher F,et al.A compact DC and AC model for circuit simulation of high voltage VDMOS transistor[C]//Proceedings of the 7th International Symposium on Quality Electronic Design.San Jose,CA,USA,2006:109-114.
[9]Jia Kan,Sun Weifeng,Shi Longxing.A novel surface potential-based short channel MOSFET model for circuit simulation[J].Microelectronics Journal,2011,42(10):1169-1175.
[10]Tsividis Yannis.Operation and modeling of the MOS transistor[M].New York:McGraw-Hill,1999.
[11]Shi Longxing,Jia Kan,Sun Weifeng.A novel compact high-voltage LDMOS transistor model for circuit simulation[J].Electron Devices,2013,60(1):346-353.
[12]Liu William.MOSFET models for SPICE simulation,including BSIM3v3 and BSIM4[M].New York:Wiley,2001.

