輻照加固SRAM型FPGA總劑量輻射效應研究
劉士全,季振凱
(中國電子科技集團公司第58研究所,江蘇 無錫 214035)
1 引言
在航天輻射環境中,電離輻射產生的輻射效應會對電子元器件性能產生影響,甚至出現功能失效,使得航天器工作的可靠性和安全性受到嚴重威脅,造成意想不到的損失,最終影響航天任務的順利進行。因此,對元器件的輻射損傷效應進行研究,全面了解元器件的輻射損傷機理具有重要的現實意義和必要性。FPGA(現場可編程門陣列)由于其自身集成度高、面積小、功耗低、實現功能多等特點,在航天領域的應用前景廣泛。國外在上世紀90年代就已對FPGA器件的輻射損傷及退火效應進行了深入的研究[1~6]。而目前國內對SRAM型FPGA的總劑量輻射損傷及輻照后退火效應的報道很少。為此,本文對自主研發的抗輻照SRAM型FPGA的總劑量輻射效應機理進行了研究,特別是探討了FPGA電參數退化與功能失效的相關性,為抗輻照加固技術打下了基礎。
2 器件選擇及實驗方法
在試驗中一共用了同一型號且性能參數基本相同的兩片國外樣品FPGA芯片和兩片我所自主研發的輻照加固FPGA芯片。輻照實驗板系統由FPGA、CPLD、XCF32P配置芯片組成。實驗系統從輻照室內引出兩組內核、端口電源,一組外圍電源,兩根片選信號,DONE配置成功顯示信號,輸出時鐘信號,同時對實驗系統引入Program控制信號和輸入時鐘信號。用硬件描述語言VerilogHDL對FPGA芯片編寫源程序,燒寫至FPGA配置芯片XCF32P內。同時用VerilogHDL對CPLD芯片編寫源程序,完成對配置芯片和FPGA的通道切換功能。總劑量輻照實驗系統如圖1所示,通過兩根片選信號對FPGA片選,使對應的FPGA芯片配置信號通過CPLD與配置芯片相連,通過從CPLD連到輻照室外部的Program信號控制對應FPGA重配置,通過從CPLD連到輻照室外部的DONE信號和輸出時鐘信號觀察對應FPGA的工作狀態,完成對芯片功能的檢測。
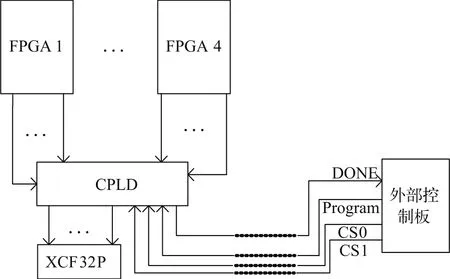
圖1 總劑量輻照實驗系統
輸入時鐘信號引入30MHz的標準時鐘,FPGA芯片利用寄存器實現16分頻電路功能,然后通過移位寄存器將信號輸出,測量輻照過程中FPGA的內核和端口電源電流、記錄電流變化與總劑量的關系。測量輻照過程中FPGA輸出波形,檢測FPGA在總劑量輻照過程中的功能失效情況。輻照前后對FPGA芯片用Teradyne公司J750 ATE測試系統進行測試,對比參數變化,得出器件隨總劑量輻射的變化關系。
實驗所用的輻射源是中科院上海應用物理研究所水儲式4.9×1015 (Bq)60Co-γ輻射源。這是一個由24根ф150mm×452mm源棒構成的直徑為20cm的圓形源盒。實驗過程中選擇15rad(Si)/s和10rad(Si)/s的劑量率。兩只國外器件輻照到100krad(Si)或功能失效為止,兩只輻照加固器件先輻照到100krad(Si)。觀察并記錄電路內核電流變化,并在30k和50k時進行啟動實驗,若能夠完成上電重配置,進行下一步實驗。100k的電路實驗完成后,用干冰保存,2h內帶回用J750進行測試,若電參數正常,則該組電路通過實驗;若功能失效,器件被判定不合格;若100krad(Si)器件測試合格,再追加50krad(Si),實驗完成后,用干冰保存,帶回進行高溫退火。高溫退火條件為:溫度100℃,時間168h,168h后測試參數,判斷退火后是否通過,退火期間通過輻照實驗板施加偏置。依據168h高溫退火后測得的參數作為最終判據,判斷該組器件是否合格。
3 實驗結果和討論
3.1 實驗結果
圖2為輻照實驗時電路輸出16分頻波形,測試示波器采樣點數設置為10 000。兩只輻照加固的FPGA在100krad(Si)輻照過程中FPGA功能正常,輸出波形穩定,未發生變化,干冰保存帶回用J750測試元件電參數均通過;兩只國外的FPGA在60krad(Si)時波形突然消失,功耗電流開始明顯增大,干冰保存帶回用J750測試元件多項電參數失效。在后面追加的50k試驗過程中,總計量累積到145krad(Si)時,兩顆電路輸出波形突然消失,功耗電流開始明顯增大。在總劑量30k和50k時進行啟動實驗,四片電路均能完成上電重配置,通過啟動實驗。兩組電路電流隨總劑量變化情況如圖3和圖4所示,輻照加固FPGA電路電流在100krad(Si)以內保持20mA不發生變化,在130krad(Si)時電流發生明顯增長,在150krad(Si)時電流變為90mA為原來的4.5倍。國外的FPGA電路電流在45krad(Si)以內保持不變,在60krad(Si)時電流發生明顯增長。此時對電路進行高溫退火,經過168h高溫退火后四只電路工作正常,通過所有測試,電流恢復到輻照前的數值。同時兩只輻照加固電路和兩只國外電路在150k和60k輻照結束后均無法完成上電配置,表現為內核電流過大。而在高溫退火后,四只電路均已能夠正常完成上電重配置。
3.2 實驗結果討論
帶電粒子、γ、X射線與MOS器件柵介質作用產生電離總劑量輻射效應。在電離輻射作用下,光子和帶電粒子將能量傳遞給原子,原子電離的同時產生電子空穴對。電子空穴對通過復合、漂移、擴散、積累在SiO2絕緣層中產生氧化物陷阱電荷,并且在Si/SiO2界面上產生輻射感生氧化物電荷,從而使集成電路性能參數發生顯著變化,甚至功能失效[7~8]。

圖2 輻照實驗電路輸出波形

圖3 60k總劑量實驗動態電流

圖4 150k總劑量實驗動態電流
從實驗結果可見,功耗電流隨總劑量積累到一定程度后呈逐漸增大趨勢,而與此同時器件功能卻仍舊正常,但無法進行重新配置。經分析可知,高劑量率輻射使得FPGA電路產生大量陷阱電荷,從而使電流增大。但此時功耗電流仍然在電路正常工作上限100mA之內,所以FPGA工作未受影響。但基于SRAM結構的FPGA的特點是配置過程會有大電流出現,在正常情況下該FPGA配置時對其內核電壓(Vccint)需要提供一個上電時間小于50ms、瞬間電流可達2A的電源。但該實驗過程中,隨著陷阱電荷的產生,使得上電過程中需要的瞬間電流增大,原實驗電源無法提供滿足配置需要的瞬間大電流,所以不能正常上電配置。同時從兩組試驗對比可知,輻照加固過的電路抗輻照能力明顯好于國外未進行輻照加固的電路,輻照加固技術是有效的。
在退火過程中,由于氧化物陷阱電荷迅速消失[7],N溝道MOS管負漂移的閾值電壓出現回漂,使得其耗盡層的反型層恢復,導致截止漏電流隨退火時間的增加而降低。而寄生N溝道MOS管是以鋁柵或硅柵的場氧為柵氧化層,以N溝道MOS管的漏、源為漏、源端的,因此寄生N溝管的場氧漏電流隨退火時間的關系與N溝道MOS管截止漏電流隨退火時間的關系相似。因此在退火過程后FPGA電路基本恢復正常。
4 總結
由實驗結果分析可知,功耗電流隨總劑量逐漸變化,反映了FPGA器件輻射損傷的大小和過程,更直觀反映了器件隨總劑量的變化關系,可作為判斷器件失效的一個敏感參數。而分頻功能、輸出高低電平功能隨總劑量是突然變化的,只反映了器件輻射損傷從量變到質變的結果,不能用于分析器件輻射損傷的機理,但可直觀形象地反映器件的失效。
通過實驗,得到以下結論:
(1)功耗電流隨總劑量累積到一定程度后線性增大,雖然功耗電流變大,但只要在極限范圍內,FPGA仍然能正常工作;
(2)SRAM型FPGA在配置過程中需要瞬間大電流,故輻照后不能立即配置;
(3)總劑量輻照實驗時功耗電流能直觀反映器件隨總劑量的變化關系,可作為判斷器件失效的一個敏感參數;
(4)輻照加固技術對元器件的抗輻射能力提升是有效的。
[1] FAROUK S, SIAS M. Total ionizing dose mitigation by means of reconfigurable FPGA computing [J]. IEEE Trans Nucl Sci, 2007, 54(4)∶ 1 343-1 349.
[2] LUM G K, MAY R J, ROBINETTE L E. Total dose hardness of field programmable gate arrays [J]. IEEE Trans Nucl Sci, 1994, 41(6)∶ 2 487-2 493.
[3] HEATHER Q, KEITH M, PAUL G, et a1. Domain crossing errors:Limitation on single device triple-modular redundancy circuits in Xilinx FPGAs [J]. IEEE Trans Nuel Sci, 2007, 54(6)∶ 2 037-2 043.
[4] MORGAN K S, MCMURTREY D L, PRATTB H, et a1.A comparison of TMR with alternative fault-tolerant design techniques for FPGAs [J]. IEEE Trans Nucl Sci,2007, 54(6)∶ 2 056-2 072.
[5] ALFKE P, PADOVANI R. Radiation tolerance of high density FPGAs [C]. Aerospace Applications of Programmable Devices and Technologies Conference(MAPLD’98), Militaryand, 1998.
[6] JOE F, HOWARD B. Total ionizing dose performance of SRAM based FPGAs and supporting PROMs [C]. The 3rd Annual Military and Aerospace Applications of Programmable Devices and Technologies International Conference, 2008.
[7] 任迪遠,余學鋒,郭旗,等.L82C87集成電路的總劑量輻射效應研究 [J].核技術,1997,20(2):119-122.
[8] 袁國火,楊懷民,徐曦,等.微電路FPGA的7電離總劑量效應與加固技術[J].強激光與粒子束,2006,18(3):487-490.

